纳米光刻是芯片制造和微纳加工中的一项关键技术。高性能、小型化、新概念纳米器件的研发对纳米光刻技术提出了越来越高的要求。传统的粒子束光刻工艺采用聚焦的光子束、电子束、keV离子束曝光产生高分辨纳米结构,但是受材料特性、粒子散射和非限域能量沉积等影响,制备超高长径比的亚10nm结构一直面临挑战。
湖南大学教授段辉高课题组与中国科学院近代物理研究所研究员杜广华课题组合作,利用兰州重离子加速器高能微束装置提供的2.15 GeV 氪离子作为曝光源,在光刻负胶HSQ(氢硅倍半环氧乙烷)中获得特征尺寸小于5nm的超长径比纳米线结构。这种由单个的高能氪离子曝光制备纳米结构的方法,既不同于传统微纳加工中的聚焦粒子束曝光方法,也不同于快重离子径迹蚀刻的微纳加工技术。通过离子在光刻胶中的径向能量沉积分布模拟计算,研究人员发现离子径迹中心纳米尺度内的致密能量沉积达数千戈瑞,这是HSQ纳米光刻结构形成的根本机制。此外,对比曝光实验证明,该方法得到的纳米结构极限尺寸与离子径向能量沉积和材料类型直接相关,为利用重离子精确制备微纳光刻结构提供了理论基础。
该工作首次展示了利用单个重离子进行单纳米光刻的潜力,证明了无机负胶HSQ具有可靠的亚5nm光刻分辨能力。通过利用先进的重离子微束直写技术和单离子辐照技术,单个重离子曝光技术有望在极小尺度加工中发挥独特作用,并可用于先进光刻胶分辨率极限的评价。
图1 利用氪离子束曝光制备的HSQ纳米线结构
图2 氪离子径迹中心能量沉积模拟计算及其在探测器中的显微观测
研究工作得到国家自然科学基金及大科学装置联合基金的支持,相关研究成果以Sub-5 nm Lithography with Single GeV Heavy Ions Using Inorganic Resist为题,发表在Nano Letters上。
责任编辑:lq
-
加速器
+关注
关注
2文章
841浏览量
40244 -
芯片制造
+关注
关注
11文章
735浏览量
30532 -
纳米线
+关注
关注
0文章
23浏览量
8148
原文标题:我国科学家利用GeV重离子曝光制备出亚5nm纳米线
文章出处:【微信号:MEMSensor,微信公众号:MEMS】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
中国打造自己的EUV光刻胶标准!
基于溶胶-凝胶法光刻胶的FsLDW微透镜制备与三维形貌表征

光刻胶液体吸收行为的椭圆偏振对比研究

国产光刻胶重磅突破:攻克5nm芯片制造关键难题

如何提高光刻胶残留清洗的效率
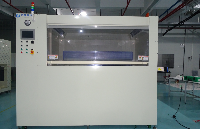
光刻胶旋涂的重要性及厚度监测方法

EUV光刻胶材料取得重要进展
国产光刻胶突围,日企垄断终松动
用于 ARRAY 制程工艺的低铜腐蚀光刻胶剥离液及白光干涉仪在光刻图形的测量

金属低刻蚀的光刻胶剥离液及其应用及白光干涉仪在光刻图形的测量

减少光刻胶剥离工艺对器件性能影响的方法及白光干涉仪在光刻图形的测量

光刻胶剥离液及其制备方法及白光干涉仪在光刻图形的测量




 无机负胶HSQ具有可靠的亚5nm光刻分辨能力
无机负胶HSQ具有可靠的亚5nm光刻分辨能力






评论