全球领先的高科技设备制造商Manz亚智科技,交付大板级扇出型封装解决方案于广东佛智芯微电子技术研究有限公司(简称佛智芯),推进国内首个大板级扇出型封装示范线建设,是佛智芯成立工艺开发中心至关重要的一个环节,同时也为板级扇出型封装装备奠定了验证基础,从而推进整个扇出型封装(FOPLP)行业的产业化发展。
5G、云端、人工智能等技术的深入发展,使其广泛应用于移动装置、车载、医疗等行业,并已成为全球科技巨擘下一阶段的重点发展方向。而在此过程中,体积小、运算及效能更强大的芯片成为新的发展趋势和市场需求,不仅如此,芯片封装正在朝将更多芯片整合于单一封装结构,实现异质多芯片整合的方向发展,即达到多芯片封装体积缩小同时效能大幅提升。
作为异质整合封装的新兴技术,扇出型封装技术发展至板级主要是能以更大面积进行生产,既可以进一步降低生产成本又能达到市场端的对芯片效能的需求,已成为先进封装技术中是最有潜力能够提供异质整合同时降低生产成本的技术平台。根据Yole的报告,板级扇出型封装未来全球5年的年复合成长率可高达30%,2024年全球产值预期可达457百万美元。
广东佛智芯微电子技术研究有限公司(简称佛智芯)是广东省半导体智能装备和系统集成创新中心承载单位,由广东省及其地方政府、国内半导体装备龙头企业、科研院所等共同出资建设,在产学研领域拥有雄厚实力。其重点目标是发展板级扇出型封装共性技术研发中心和建立产业化平台,近期建立的大板级扇出型封装示范工艺线,将成为该目标的重要里程碑之一,并奠定了国内板级扇出型封装产业链在制造、设备、材料的成长。
Manz此次交付于佛智芯的装备线,以坚实的设备能力,为其工艺开发中心导入黄光制程设备,完善了佛智芯在公共服务平台中至关重要的设备验证环节,不同的客户可依据其制程及材料在装备线得到产前打样验证,以此推动封装领域中制造成本相对较低的板级扇出型封装产业化解决方案。Manz在产业中的经验丰富,装备及制程稳定性高,也可与制造商共同发展配合不同产业、不同客户提供解决方案,如PCB 载板制造商/ 半导体封装厂/显示面板制造商可利用现有设备同时加上电镀线进行优化。连同佛智芯学、研、产的整合,还将实现示范工艺成果产业化落地,意味着Manz将与其共同推进FOPLP产业化发展。通过与佛治芯的合作,双方可为想要投入FOPLP开发的制造商进行先导计划的可行性评估、试验、专利、技术输出到量产前的测试。
此外,凭借在行业中的丰富经验,Manz还具备以下优势:
在FOPLP整体制程中,可提供后端黄光制程整体解决方案,并可提供量产前打样,使客户降低量产前的材料、制程、设备整合及验证投资,同时降低量产前风险。
可提供RDL黄光制程技术解决方案及自动化/CIM整合,设备可依客户需求提供批次式或是连续式,甚至可规划RDL制程段整线优化输出
FOPLP技术重点之一在于同质、异质多芯片整合,而其中RDL是实现该技术的重要环节,Manz掌握的RDL电镀及铜蚀刻技术的独特优势如下:
开创业界无治具垂直电镀线,具备优异的电镀均匀性(》90%)及填孔能力(孔径小于20um)
直电镀铜线不需使用治具,减少维修成本
模块化设计操作及维护具备便利性
适用于不同基板:FR4铜箔基板、钢板及玻璃基板。其中玻璃基板的应用,可让计划跨入先进封装领域的显示器面板制造商,补足其对于在线性电镀的工艺经验
铜蚀刻线:Manz的装备具有化学药液和工艺的最佳结合,可确保完全去除铜种子层并有选择性地进行铜蚀刻,铜蚀刻均匀性达93%.
以Manz 软硬件的整合实力,可提供传输设备及CIM系统(Computer Integrated Manufacture-计算机制程整合)为进一步走向工业4.0
Manz亚智科技总经理林峻生先生表示:“凭借30年的丰富行业经验,Manz认识到FOPLP技术的优势已成为业界不容忽视的重点。此次与佛智芯的合作无疑是推进FOPLP向下一阶段发展的最好方式,Manz将与其携手,通过产、学、研的整合,实现成果产业化落地,进一步推动FOPLP行业发展。“
广东佛智芯微电子技术研究有限公司副总经理林挺宇博士表示:“ 佛智芯是广东省半导体只能装备和系统集成创新中心承载单位,旨在通过整合产学研,将示范线公益成功产业化落地。携手Manz亚智科技打造工艺开发中心,能够全方位的推进国内板级扇出型封装建设,打造国际一流的研发中心和产业化平台。”
-
封装
+关注
关注
128文章
9398浏览量
149260 -
Manz
+关注
关注
0文章
17浏览量
8531
发布评论请先 登录
先进封装中铜晶粒控制方法综述

激光雷达在工业检测与测量场景的应用优势

AI芯片造不出的真相,CoPoS封装技术能否解这燃眉之急?
SiLM8265HB双通道隔离驱动器 10A大电流驱动,小封装引领高压应用

贴片电感相比于插件电感具有什么优势?
简述芯片原子钟的独特优势及应用范围
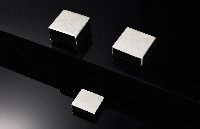
决战纳米级缺陷!东亚合成IXEPLAS纳米离子捕捉剂如何助力先进封装?

SOT-MRAM的独特优势




 Manz助力FOPLP封装发展 具有独特的优势
Manz助力FOPLP封装发展 具有独特的优势

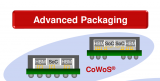




评论