LED正装芯片是最早出现的芯片结构,也是小功率芯片中普遍使用的芯片结构。该结构,电极在上方,从上至下材料为:P-GaN,发光层,N-GaN,衬底。所以,相对倒装来说就是正装。
2018-09-05 08:40:00 34717
34717 随着上游芯片产能不断扩产,封装行业已经步入微利时代,许多企业为了抢夺客户大打价格牌,激烈的价格竞争和无序的业内生态链促使行业开始需求新的封装工艺。而具有提升发光效率以及提高散热能力等优势的倒装LED芯片技术的革新与应用正是当今封装企业专注研发的重点。
2014-05-17 10:12:16 2286
2286 倒装芯片工艺是指通过在芯片的I/0 焊盘上直接沉积,或者通过 RDL 布线后沉积凸块(包括锡铅球、无铅锡球、铜桂凸点及金凸点等),然后将芯片翻转,进行加热,使熔融的焊料与基板或框架相结合,将芯片的 I/0 扇出成所需求的封装过程。倒装芯片封装产品示意图如图所示。
2023-04-28 09:51:34 3701
3701 
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
2023-07-21 10:08:08 3124
3124 
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
2023-08-01 11:48:08 1174
1174 
在半导体制造领域,芯片装配(Chip Mounting)是一个至关重要的环节。特别是在LED产业中,正装芯片和倒装芯片的选择会直接影响产品的性能、稳定性和成本。本文将详细对比正装芯片与倒装芯片的各方面区别,帮助您更准确地选择适合您需求的产品。
2023-09-04 09:33:05 2718
2718 
英飞凌科技股份公司(FSE: IFX / OTCQX: IFNNY)现已向最小型汽车电子电源迈进。英飞凌作为首家芯片制造商,创立了专门的倒装芯片封装生产工艺,完全符合汽车市场的高质量要求。英飞凌
2020-02-15 12:11:24 1027
1027 工艺,这其中就包括倒装芯片(FC)。为满足市场对提供“全方位解决方案”的需求,EMS公司与半导体封装公司不论在技术还是在业务上都有着逐步靠拢相互重叠的趋势,但这对双方均存在不小的挑战。当电子产品从板上组装向
2018-11-26 16:13:59
WLP的命名上还存在分歧。CSP晶片级技术非常独特,封装内部并没有采用键合方式。封装芯片的命名也存在分歧。常用名称有:倒装芯片(STMicroelectronics和Dalias
2018-08-27 15:45:31
对较小外形和较多功能的低成本电子设备的需求继续在增长。这些快速变化的市场挑战着电子制造商,降低制造成本以保证可接受的利润率。倒装芯片装配(flip chip assembly)被认为是推进低成本
2019-05-28 08:01:45
1.倒装芯片焊接的概念 倒装芯片焊接(Flip-chipBonding)技术是一种新兴的微电子封装技术,它将工作面(有源区面)上制有凸点电极的芯片朝下,与基板布线层直接键合。 2.倒装芯片
2020-07-06 17:53:32
本文作者:深圳大元倒装COB显示屏是真正的芯片级封装,摆脱了物理空间尺寸的限制,使点间距有了更进一步下钻的能力。倒装COB显示屏厂家--深圳大元倒装COB显示屏与LED小间距相比:1、倒装cob
2020-05-28 17:33:22
倒装晶片元件损坏的原因是什么?
2021-04-25 06:27:25
什么元件被称为倒装晶片(FC)?一般来说,这类元件具备以下特点。 ①基材是硅; ②电气面及焊凸在元件下表面; ③球间距一股为0.1~0.3 mm,球径为0.06~0,.15 mm,外形尺寸
2018-11-22 11:01:58
。然后再通过第二条生产线处理部分组装的模 块,该生产线由倒装芯片贴片机和回流焊炉组成。底部填充工艺在专用底部填充生产线中完成,或与倒装芯片生 产线结合完成。如图1所示。图1 倒装晶片装配的混合工艺流程
2018-11-23 16:00:22
由于倒装晶片韩球及球问距非常小,相对于BGA的装配,其需要更高的贴装精度。同时也需要关注从晶片被吸 取到贴装完成这一过程。在以下过程中,元件都有可能被损坏: ·拾取元件; ·影像处理
2018-11-22 11:02:17
倒装晶片(Flip Chip)贴装属于先进半导体组装(Advanced Semiconductor Assembly),常见的应用有无线天线、蓝牙、硬盘磁头、元件封装、智能传感器和一些医用高精密
2018-11-27 10:45:28
设计中四种最基本的芯片堆叠方式。 在实际应用的时候,这几种堆叠方式可以组合起来形成更为复杂的堆叠。另外,还有通过将键合芯片和倒装焊芯片进行堆叠,通过柔性电路折叠的方式对芯片进行堆叠,以及通过POP形式的堆叠等几种,这些芯片堆叠方式在SiP设计中也比较常见。
2020-11-27 16:39:05
与衬底的互连.硅片直接以倒扣方式安装到PCB从硅片向四周引出I/O,互联的长度大大缩短,减小了RC延迟,有效地提高了电性能.显然,这种芯片互连方式能提供更高的I/O密度.倒装占有面积几乎与芯片大小
2018-09-11 15:20:04
金鉴检测在大量LED失效案例总结的基础上,发现用硅胶封装、银胶粘结的垂直倒装芯片易出现漏电现象。这是因为,硅胶具有吸水透气的物理特性,易使导电银胶受潮,水分子侵入后在含银导体表面电解形成氢离子
2015-06-12 11:44:02
金鉴检测在大量LED失效案例总结的基础上,发现用硅胶封装、银胶粘结的垂直倒装芯片易出现漏电现象。这是因为,硅胶具有吸水透气的物理特性,易使导电银胶受潮,水分子侵入后在含银导体表面电解形成氢离子
2015-06-19 15:28:29
尊敬的先生/女士,我想找出所有VIRTEX-6的半导体安装技术,是倒装芯片安装技术的芯片吗?谢谢问候,缺口
2020-06-15 16:30:12
封装技术(倒装芯片接合和柔性载板)正好适用于这个应用。倒装芯片接合技术已经发展30多年了。此一技术的优点是体积小、接线密度高,而且因为引脚短而电性得以改善4。倒装芯片接合技术的另一个优势,是能够将多个
2018-09-11 16:05:39
金鉴检测在大量LED失效案例总结的基础上,发现用硅胶封装、银胶粘结的垂直倒装芯片易出现漏电现象。这是因为,硅胶具有吸水透气的物理特性,易使导电银胶受潮,水分子侵入后在含银导体表面电解形成氢离子
2015-05-13 11:23:43
请问在柔性电路板上的倒装芯片是怎样组装的?
2021-04-22 06:23:49
在消费类产品小型化和更轻、更薄发展趋势的推动下,厂商开发了更小的封装类型。实际上,封装已经成为新设计中选择还是放弃某一器件的关键因素。本文首先定义了“倒装芯片
2009-04-27 10:53:55 49
49 随着新型基底材料的出现,倒装芯片技术面临着新的挑战,工程师们必须解决裸片
2006-04-16 21:05:16 2034
2034 倒装芯片工艺挑战SMT组装原作者:不详 1
2006-04-16 21:37:59 1467
1467 摘要:欧盟最近颁布的限制有害物质指令(RoHS)禁止在电子电气元件中使用金属铅(Pb)。受该指令影响,装配流程也必须是无铅的(无Pb)。尽管DS2502倒装芯片在RoHS指令拥有豁免权,但其
2009-04-21 09:18:43 694
694 
摘要:欧盟最近颁布的限制有害物质指令(RoHS)禁止在电子电气元件中使用金属铅(Pb)。受该指令影响,装配流程也必须是无铅的(无Pb)。尽管DS2502倒装芯片在RoHS指令拥有豁免权,但其
2009-04-29 10:41:54 656
656 
摘要:欧盟最近颁布的限制有害物质指令(RoHS)禁止在电子电气元件中使用金属铅(Pb)。受该指令影响,装配流程也必须是无铅的(无Pb)。尽管DS2502倒装芯片在RoHS指令拥有豁免权,但其
2009-05-09 08:45:16 858
858 摘要:最近,欧盟已通过有害物质限制(RoHS)指令,严格禁止电气、电子产品中使用铅(Pb)元素。基于这一规范要求,装配流程也必须满足无铅要求。DS2761倒装芯片已豁免通过RoHS规范要
2009-05-09 08:47:54 839
839 柔性电路板上倒装芯片组装技巧 由思想来控制机器的能力是人们长久以来的梦想;尤其是为了瘫痪的那些人。近年来,工艺的进步加
2009-11-19 08:42:59 1378
1378 (Flip-Chip)倒装焊芯片原理
Flip Chip既是一种芯片互连技术,又是一种理想的芯片粘接技术.早在30年前IBM公司已研发使用了这项
2009-11-19 09:11:12 1795
1795 倒装焊芯片(Flip-Chip)是什么意思
Flip Chip既是一种芯片互连技术,又是一种理想的芯片粘接技术.早在30年前IBM公司已研发使用了这项技
2010-03-04 14:08:08 22394
22394 柔性电路板上倒装芯片组装技术解析
由思想来控制机器的能力是人们长久以来的梦想;尤其是为了瘫痪的那些人。近年来,工艺的进
2010-03-17 10:20:04 1488
1488 在倒装芯片制造过程中,非流动型底部填充剂主要应该考虑以下几个工艺,涂敷必须覆盖形成电气接点的区域,避免在底充胶中形成多余空隙
2011-07-05 11:53:30 2740
2740 倒装芯片的成功实现与使用包含诸多设计、工艺、设备与材料因素。只有对每一个因素都加以认真考虑和对待才能够促进工艺和技术的不断完善和进步,才能满足应用领域对倒装芯片技
2011-07-05 11:56:17 1673
1673 随着倒装芯片封装在成本和性能上的不断改进, 倒装芯片 技术正在逐步取代引线键合的位置。倒装芯片的基本概念就是拿来一颗芯片,在连接点位置放上导电的凸点,将该面翻转,有
2011-10-19 11:42:55 4889
4889 倒装芯片互连技术有诸多优点,但是由于其成本高,不能够用于大批量生产中,所以其应用受到限制。而本文推荐使用的有机材料的方法能够解决上述的问题。晶圆植球工艺的诞对于降
2011-12-22 14:35:52 86
86 器件的小型化高密度封装形式越来越多,如多模块封装(MCM)、系统封装(SiP)、倒装芯片(FC,Flip-Chip)等应用得越来越多。这些技术的出现更加模糊了一级封装与二级装配之间的界
2012-01-09 16:07:47 46
46 芯片级封装介绍本应用笔记提供指引使用与PCB安装设备相关的芯片级封装。包括系统的PCB布局信息制造业工程师和制造工艺工艺工程师。 包概述 倒装芯片CSP的包概述半导体封装提供的芯片级封装代表最小
2017-03-31 10:57:32 45
45 超级CSP——让倒装芯片获得最大可靠性一种晶圆片级封装
2017-09-14 11:31:37 22
22 LED正装芯片是最早出现的芯片结构,也是小功率芯片中普遍使用的芯片结构。该结构,电极在上方,从上至下材料为:P-GaN,发光层,N-GaN,衬底。所以,相对倒装来说就是正装。 LED倒装芯片和症状
2017-09-29 17:18:43 72
72 支架式倒装与FEMC的定义与关系 众所都知,当前LED芯片大体分为3种结构,第一种是正装芯片,第二种是垂直芯片,第三种是倒装芯片FC-LED,而目前以正装芯片居多。 正装的占有率居多,并不影响倒装
2017-10-09 16:03:18 9
9 要了解LED倒装芯片,先要了解什么是LED正装芯片 LED正装芯片是最早出现的芯片结构,也是小功率芯片中普遍使用的芯片结构。该结构,电极在上方,从上至下材料为:P-GaN,发光层,N-GaN,衬底
2017-10-23 10:01:47 49
49 过来,故称其为倒装晶片。 倒装芯片的实质是在传统工艺的基础上,将芯片的发光区与电极区不设计在同一个平面这时则由电极区面朝向灯杯底部进行贴装,可以省掉焊线这一工序,但是对固晶这段工艺的精度要求较高,一般很难达到较高的良率。 倒装晶片
2017-10-24 10:12:25 8
8 倒装芯片之所以被称为“倒装”是相对于传统的金线键合连接方式的工艺而言的。传统的通过金线键合与基板连接的芯片电极面朝上,而倒装芯片的电极面朝下,相当于将前者翻转过来,故称其为“倒装芯片”。
2018-01-16 13:49:45 19904
19904 -实现 300 度高温下的 220 lm/W 光效稳定性 LG Innotek 今天称已成功开发可承受300摄氏高温的焊接工艺而不影响其性能的高光效、高光通量“新一代倒装芯片 LED 封装”,并将
2018-02-12 18:24:00 2904
2904 
倒装芯片技术分多种工艺方法,每一种都有许多变化和不同应用。举例来说,根据产品技术所要求的印制板或基板的类型 - 有机的、陶瓷的或柔性的- 决定了组装材料的选择(如凸点类型、焊料、底部填充材料),并在
2019-05-31 10:16:45 5985
5985 
由于倒装芯片的出光效率高、散热条件好、单位面积的出光功率大、可靠性高、批量化制造成本低和能够承受大电流驱动等一系列优点,使得倒装LED照明技术具有很高的性价比。
2019-08-30 11:02:34 3429
3429 9月3日消息,倒装芯片封装技术不仅能减小产品的体积和重量,而且能有效地提高线路的信号传输性能,迎合了微电子封装技术追求更高密度、更快处理速度、更高可靠性和更经济的发展趋势。目前业内量产倒装芯片工艺
2019-09-10 17:42:44 3229
3229 倒装芯片(Flip chip)是一种无引脚结构,一般含有电路单元。 设计用于通过适当数量的位于其面上的锡球(导电性粘合剂所覆盖),在电气上和机械上连接于电路。
2019-10-22 14:21:06 11725
11725 正装小芯片采取在直插式支架反射杯内点上绝缘导热胶来固定芯片,而倒装芯片多采用导热系数更高的银胶或共晶的工艺与支架基座相连,且本身支架基座通常为导热系数较高的铜材.
2019-10-22 14:28:34 27507
27507 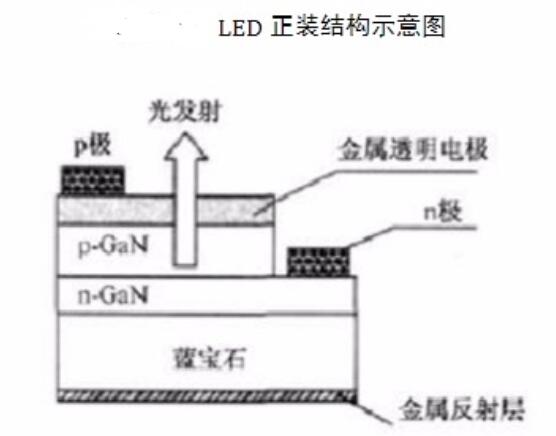
Led芯片倒装工艺制程应用在led芯片封装上,以期获得更高的生产效率,更小更轻薄的产品特征,大幅提高led产品的产能,降低生产制造成本,提高市场竞争力,倒装必然是led芯片封装的方向。
2020-03-19 15:40:27 4546
4546 对较小外形和较多功能的低成本电子设备的需求继续在增长。这些快速变化的市场挑战着电子制造商,降低制造成本以保证可接受的利润率。倒装芯片装配(flip chip assembly)被认为是推进低成本
2020-10-13 10:43:00 0
0 倒装芯片FC、晶圆级CSP、晶圆级封装WLP主要应用在新一代手机、DVD、PDA、模块等。 一、倒装芯片FC 倒装芯片定义为可能不进行再分布的晶圆。通常,锡球小于150um,球间距小于350um
2020-09-28 14:31:30 5719
5719 相信不少电子工程师都有拆焊芯片的经历,本文将介绍如何拆焊Flash芯片,设计及制作相应的分线板。
2020-09-19 11:08:00 6248
6248 传统VCSEL阵列都安装在基座上,并利用键合线进行电气连接。TriLumina的板载VCSEL器件结构紧凑,由单个VCSEL阵列芯片组成,可通过标准的表面贴装技术倒装焊到印刷电路板上,无需用于VCSEL芯片的基座载具。
2020-11-25 14:40:31 2941
2941 12月1日消息,据国外媒体报道,韩国Semiconlight周一宣布,已与LED芯片制造商华灿光电签署倒装芯片技术许可协议。
2020-12-01 11:13:28 2589
2589 近日,加拿大Micro LED初创企业VueReal宣布其专有的倒装芯片Micro LED结构研究获得突破,可实现垂直LED结构所具有的高良率和低成本特点,良率超99.9%。
2020-12-23 15:55:02 870
870 经过紧张的网络投票,兆元光电、晶元光电、兆驰半导体3家企业凭借较高票数成功入围。针对以上3家入围企业,高工LED特邀近40位专家评委进行打分,最终兆元光电凭借“倒装Mini LED背光芯片”摘得金球桂冠。
2021-01-05 15:59:30 4005
4005 倒装芯片回流焊是一种不用焊丝就可以直接与陶瓷基板连接的芯片。我们称之为DA芯片。现在的倒装芯片回流焊不同于早期需要用焊丝转移到硅或其他材料基板上的倒装芯片,传统的倒装芯片是正面朝上用焊线连接到基板
2021-04-01 14:43:41 3816
3816 倒装芯片技术正得到广泛应用 ,凸点形成是其工艺过程的关键。介绍了现有的凸点制作方法 ,包括蒸发沉积、印刷、电镀、微球法、黏点转移法、SB2 - Jet 法、金属液滴喷射法等。每种方法都各有其优缺点 ,适用于不同的工艺要求。可以看到要使倒装芯片技术得到更广泛的应用 ,选择合适的凸点制作方法是极为重要的。
2021-04-08 15:35:47 22
22 倒装芯片在产品成本、性能及满足高密度封装等方面体现出优势,它的应用也渐渐成为主流。由于倒装芯片的尺寸小,要保证高精度高产量高重复性,这给我们传统的设备及工艺带来了挑战。
2021-04-12 10:01:50 21
21 金鉴实验室在大量LED失效案例总结的基础上,发现用硅胶封装、银胶粘结的垂直倒装芯片易出现漏电现象。这是因为,硅胶具有吸水透气的物理特性,易使导电银胶受潮,水分子侵入后在含银导体表面电解形成氢离子
2021-07-15 15:53:59 1778
1778 电子工艺技术论文-反射层对倒装LED芯片性能的影响
2021-12-08 09:55:04 6
6 倒装芯片 CSP 封装
2022-11-14 21:07:58 19
19 替代引线键合最常用、先进的互连技术是倒装芯片技术称为C4,即可控塌陷芯片连接(Controlled Collapse Chip Connection)或FC(Flip Chip,倒装芯片)。这项技术
2023-01-12 17:48:05 3978
3978 由于RoHS指令,许多组装过程必须在无铅回流工艺中使用无铅焊料。虽然倒装芯片芯片不受RoHS指令的约束,但Maxim采用250°C峰值回流焊温度组装工艺组装了超过396个倒装芯片。组装后,倒装芯片
2023-01-14 11:36:10 1726
1726 
Flip-Chip BGA (FC-BGA)是指将芯片利用倒装(FC)技术焊接在线路基板上,并制成倒装芯片 BGA 封装形式。
2023-04-28 15:09:13 4504
4504 
正在开发新的凸点结构以在倒装芯片封装中实现更高的互连密度,但它们复杂、昂贵且越来越难以制造。
2023-05-22 09:46:51 578
578 
基本的倒装芯片工艺在电路制造之后开始,此时在芯片表面创建金属焊盘以连接到 I/O。接下来是晶圆凸块,将焊球沉积在每个焊盘上。然后晶圆被切割,这些芯片被翻转和定位,使焊球与基板焊盘对齐。然后焊球被熔化/回流,通常使用热空气,并且安装的芯片底部填充有电绝缘粘合剂,通常使用毛细管作用。
2023-05-22 16:13:55 650
650 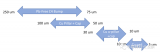
正在开发新的凸点(bump)结构以在倒装芯片封装中实现更高的互连密度,但它们复杂、昂贵且越来越难以制造。
2023-05-23 12:31:13 714
714 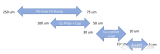
NU520倒装LED恒流驱动器芯片片来自数能Numen研发的,倒装COB恒流灯带无焊线封装工艺,恒流裸片(NU520)直接与PCB板一体化,整个流程更简洁化,封装层无焊线空间,封装层更轻薄,降低热阻,提升光品质.产品性能更稳定节能舒适等优势。
2023-05-25 10:22:40 832
832 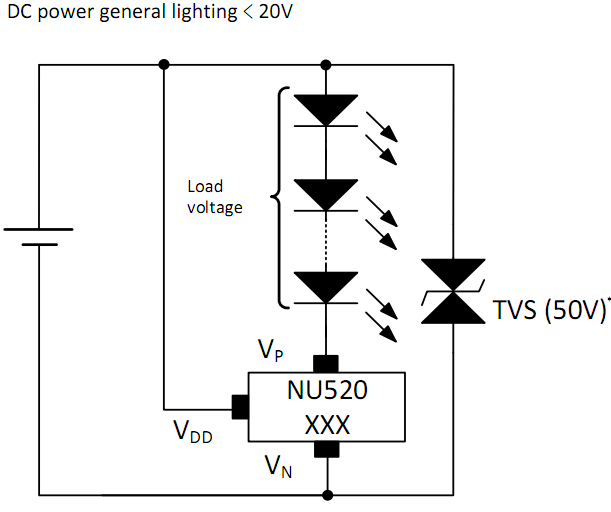
汉思新材料研发生产半导体(Flipchip)倒装芯片封装用底部填充材料为了解决一些与更薄的倒装芯片封装相关的问题,汉思化学研发了一种底部填充材料,作用在于通过控制芯片和基板的翘曲来降低封装产品的应力
2023-03-01 05:00:00 536
536 
本文要点将引线键合连接到半导体的过程可以根据力、超声波能量和温度的应用进行分类。倒装芯片技术使用称为凸块的小金属球进行连接。在倒装芯片QFN封装中,倒装芯片互连集成在QFN主体中。基于倒装芯片QFN
2023-03-31 10:31:57 1311
1311 
LED蓝灯倒装芯片底部填充胶应用由汉思新材料提供客户的产品是LED蓝灯倒装芯片。芯片参数:没有锡球,大小35um--55um不等有很多个,芯片厚度115um.客户用胶点:需要芯片四周填充加固
2023-05-26 15:15:45 631
631 
灯COB灯等。NU520倒装LED恒流驱动器芯片片来自数能Numen研发的倒装COB恒流灯带无焊线封装工艺,恒流裸片(NU520)直接与PCB板一体化,整个流程更简洁化,封装层无焊线空间,封装层更轻薄,降低热阻,提升光品质.产品性能更稳定节能舒适等优势。1:LED倒装芯片最佳伴侣2:倒装一
2023-06-20 16:17:03 0
0 先进的倒装芯片封装技术由于具有较高的单位面积内 I/O 数量、短的信号路径、高的散热性、良好的电学和热力学性能,在电子封装中被广泛关注。
2023-08-01 10:08:25 260
260 
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
2023-08-18 09:55:04 1632
1632 
从国家知识产权局官网获悉,华为技术有限公司日前公开了一项名为“具有改进的热性能的倒装芯片封装”专利,申请公布号为CN116601748A。
2023-08-18 15:19:06 528
528 
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
2023-08-21 11:05:14 524
524 
倒装芯片技术是通过芯片上的凸点直接将元器件朝下互连到基板、载体或者电路板上。引线键合的连接方式是将芯片的正面朝上,通过引线(通常是金线)将芯片与线路板连接。
2023-08-22 10:08:28 2166
2166 
相对于其他的IC元件,如BGA和CSP等,倒装晶片装配工艺有其特殊性,该工艺引入了助焊剂工艺和底部填充工 艺。因为助焊剂残留物(对可靠性的影响)及桥连的危险,将倒装芯片贴装于锡膏上不是一种可采用的装配方法 。
2023-09-22 15:13:10 352
352 
简单介绍倒装芯片封装工艺过程中选择锡膏的基本知识
2023-09-27 08:59:00 320
320 
在更小、更轻、更薄的消费产品趋势的推动下,越来越小的封装类型已经开发出来。事实上,封装已经成为在新设计中使用或放弃设备的关键决定因素。本文首先定义了“倒装芯片”和“芯片级封装”这两个术语,并阐述
2023-10-16 15:02:47 420
420 介绍倒装芯片封装选择什么样的锡膏?
2023-10-31 13:16:13 308
308 
详细介绍了FC技术,bumping技术,underfill技术和substrate技术,以及倒装封装芯片的热设计,机械应力等可靠性设计。
2023-11-01 15:25:51 3
3 由于倒装芯片比BGA或CSP具有更小的外形尺寸、更小的球径和球间距、它对植球工艺、基板技术、材料的兼容性、制造工艺,以及检查设备和方法提出了前所未有的挑战。
2023-11-01 15:07:25 388
388 封装)或散热片(非气密性封装)等组成。文章分别介绍外壳材料、倒装焊区、频率、气密性、功率等方面对倒装焊封装结构的影响。低温共烧陶瓷(LTCC)适合于高频、大面积的倒装焊芯片。大功率倒装焊散热结构主要跟功率、导热界面材料
2024-02-21 16:48:10 132
132 
LED倒装芯片的制备始于制备芯片的硅晶圆。晶圆通常是通过晶体生长技术,在高温高压的条件下生长出具有所需电特性的半导体材料,如氮化镓(GaN)。
2024-02-06 16:36:43 2623
2623 倒装芯片技术,也被称为FC封装技术,是一种先进的集成电路封装技术。在传统封装技术中,芯片被封装在底部,并通过金线连接到封装基板上。而倒装芯片技术则将芯片直接翻转并安装在封装基板上,然后使用微小的焊点
2024-02-19 12:29:08 480
480 
不断增加封装中的输入/输出(I/O)数量,封装解决方案正从传统的线键封装向倒装芯片互连迁移,以满足这些要求。对于具有多种功能和异构移动应用的复杂和高度集成的系统而言,倒装芯片封装(FCCSP)被认为一种有效的解决方案。
2024-03-04 10:06:21 176
176 
倒装芯片组装过程通常包括焊接、去除助焊剂残留物和底部填充。由于芯片不断向微型化方向发展,倒装芯片与基板之间的间隙不断减小,因此去除助焊剂残留物的难度不断增加。这不可避免地会导致清洗成本增加
2024-03-15 09:21:28 107
107 
 电子发烧友App
电子发烧友App




















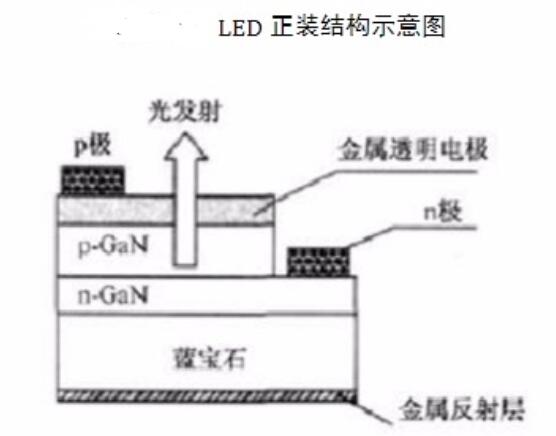



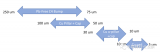
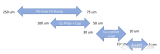
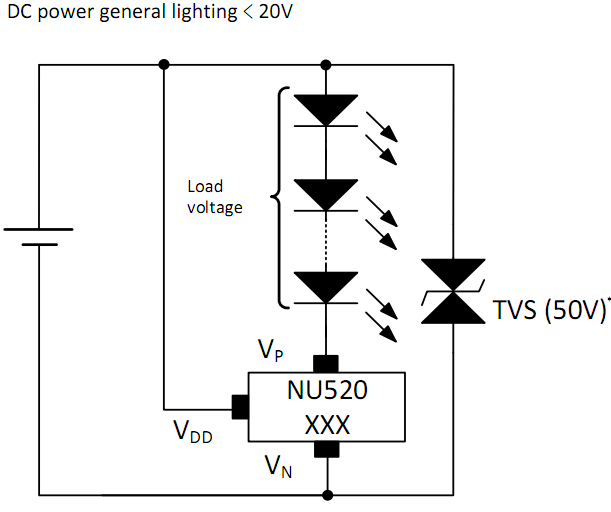

























评论