随着2D平面半导体技术渐入瓶颈,2.5D、3D立体封装普遍被视为未来大趋势,AMDFiji/Vega GPU核心与HBM显存、Intel Foveros全新封装、3D NAND闪存等等莫不如此。
但随着堆叠元器件的增多,集中的热量如何有效散出去也成了大问题,AMD就悄然申请了一项非常巧妙的专利设计。
AMD Fiji GPU与HBM显存
Intel Foveros立体封装
根据专利描述,AMD计划在3D堆栈的内存或逻辑芯片中间插入一个热电效应散热模块(TEC),原理是利用帕尔贴效应(Peltier Effect)。
它也被称作热电第二效应、温差电效应。由N型、P型半导体材料组成一对热电偶,通入直流电流后,因电流方向不同,电偶结点处将产生吸热和放热现象。
按照AMD的描述,利用帕尔贴效应,位于热电偶上方和下方的上下内存/逻辑芯片,不管哪一个温度更高,都可以利用热电偶将热量吸走,转向温度更低的一侧,进而排走。

不过也有不少问题AMD没有解释清楚,比如会不会导致上下的元器件温度都比较高?热电偶本身也会耗电发热又如何处理?
但总的来说,AMD的这个思路非常新奇巧妙,未来或许会有很光明的前景。
-
芯片
+关注
关注
462文章
53550浏览量
459264 -
amd
+关注
关注
25文章
5648浏览量
139037 -
半导体
+关注
关注
336文章
29999浏览量
258444
原文标题:动态 | AMD新专利思路清奇,芯片散热还能这么玩
文章出处:【微信号:wc_ysj,微信公众号:旺材芯片】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
亚马逊:调用跨境物流API追踪国际包裹清关状态,优化时效

浮思特|NMB散热风扇是什么品牌?为什么会被广泛使用?

两种散热路径的工艺与应用解析
清鹤科技与龙芯中科签署战略合作协议
三防漆与散热的关系:涂层会不会影响设备散热?

看点:AMD服务器CPU市场份额追上英特尔 华为Mate80主动散热专利曝光

苹果发布的主动散热专利,或将开启移动电影摄影的未来

【智能控温,性能全开!】峰岹科技推出FT3207手机主动散热芯片,降温效率提升15%






 AMD新专利思路清奇 芯片散热还能这么玩
AMD新专利思路清奇 芯片散热还能这么玩


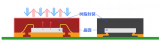










评论