华为技术有限公司8月15日在国家知识产权局官方网站公开了名为“cn116601748a”的涂装芯片包装专利。该专利被称为“具具有改进的热性能的倒装芯片封装”,提供芯片和散热器之间的接触方式,有助于提高散热器的防热性能。
综上所述,倒置的芯片被密封在基板上,芯片的上端是暴露的,但周围是环绕芯片侧面的模块化结构。散热器底部通过热界面材料与芯片表面接触。此外,芯片和结构材料周围和散热器之间也涂上粘合剂。
华为在专利中表示,最近由于半导体封装在处理性能方面的进步,对更高的热性能提出了要求,保证了稳定的操作。倒装芯片胶囊在热性能方面具有优势,其结构特征是芯片可以通过其下方的凸起与基板连接,使散热器位于芯片的顶层表面。为了提高冷却性能,将热界面材料(tim)涂抹在芯片顶部,并夹在芯片和散热器的至少一部分之间。从减少tim的热电阻,改善密封的热性能的观点来看,最好使tim的厚度更小。
以前的防热方案使tim层的厚度难以控制,产生厚度不均匀等问题。华为的新专利介绍说,在铸造模型的过程中,可以很容易地调整由铸造模型化合物组成的墙壁结构的高度,可以将热界面材料的厚度调整为必要的小厚度,从而提高了热性能。
该专利可应用于cpu、fpga、asic、gpu等芯片,支持智能手机、平板电脑、可穿戴移动设备以及pc、工作站、服务器、相机等。
-
芯片
+关注
关注
463文章
54422浏览量
469235 -
散热器
+关注
关注
2文章
1143浏览量
39794 -
模块化
+关注
关注
0文章
359浏览量
22792
发布评论请先 登录
中航光电推出可插拔式GPU液冷组件

超细间距倒装芯片灌封胶渗透与空洞控制 |铬锐特实业

电能质量在线监测装置的防尘设计是否会影响其散热性能?

浮思特 | NMB散热风扇静音如何?卓越静音效果提升散热性能

IGBT 封装底部与散热器贴合面平整度差,引发键合线与芯片连接部位应力集中,键合脆断

aQFN封装芯片SMT工艺研究
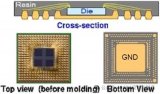
新品 | 采用顶部散热 Q-DPAK封装的 CoolSiC™ 1200V G2 SiC MOSFET




 华为倒装芯片封装专利公布,可改善散热性能
华为倒装芯片封装专利公布,可改善散热性能








评论