7月13日,蓝魔在北京举办“无所畏・有所为——2015蓝魔手机新品发布会”,正式发布了旗下首款智能手机MOS1。这一款新机携双面2.5D弧面玻璃、全球首创五面晶棱切割金属中框、比亚迪最新技术电池等多项新特性、新技术终于亮相。同时蓝魔发布会上宣布将于8月初在线上与线下渠道同步销售,售价为1999元。
蓝魔手机MOS1体验评测
蓝魔 MOS1(32GB/双4G)
基本参数
上市时间2015年
手机类型智能手机
外观设计直板式
屏幕技术双面2.5D玻璃
触摸屏支持
多点触摸支持多点触摸
智能手机是
拍照功能
拍照功能支持
摄像头类型内置摄像头
数据功能
WIFI功能支持WIFI
5.5寸屏+双2.5D弧面玻璃
外观方面, 蓝魔MOS1采用5.5 英寸1080P全贴合AHVA真彩屏,PPI为401,并采用1.9mm窄边框设计,屏占比比较不错。并且如约采用了双2.5D弧面玻璃设计,康宁大猩猩第三代。中框方面,MOS1采用了独创的“五面晶棱金属中框”,据称它历经CNC、纳米注塑、阳极氧化、喷砂等208道复杂工序,形成精度高达0.01mm的“五面中框”。
蓝魔手机MOS1
蓝魔手机MOS1机身正面
蓝魔手机MOS1机身正面
蓝魔手机MOS1
蓝魔手机MOS1机身背面
独特的五面晶棱金属中框
而视觉感受上来说, 五面晶棱金属中框与其他弧形边框有些不同,五个切面让它显得略微有些硬朗,比圆润弧形多了一分立体。实际握持感不如圆弧形中框,但比后者要多一分不易滑落的安全感。总的来说,中框算是蓝魔手机一个不错的创新点,为手机圈增添了一丝新鲜元素。
五面晶棱金属中框及底部细节
背部摄像头细节
侧边按键细节
轻便化的MOUI1.0
UI设计方面,蓝魔推出了基于Android 5.0系统深度优化的MOUI1.0 ,系统UI简洁流畅、轻便化风格突出。系统应用以圆角矩形与圆形图标交错使用,第三方APP应用图标则偏个性化,装载较多第三方应用显得比较凌乱。此外,MOUI1.0 对快捷开关与后台任务管理都进行了重设计,分页式与线条的应用同样遵循简洁原则。
锁屏界面及UI主界面
下拉状态栏与后台任务管理界面
底部上滑快捷开关与锁屏界面可查看最近活动通知
文件管理界面
1300万像素堆栈式镜头
在拍照方面,MOS1配备后置1300万像素堆栈式镜头和前置500万像素实时美颜镜头,可实现0.3秒极速对焦,F/2.0超大光圈。拍照界面设计比较简单,操作也相对比较简便,对于喜欢玩手机摄影的童鞋来说,是一个小的遗憾。实际拍摄体验中,MOS1在光线充足的情况下表现不错,鲜有色偏、测光不准的情况出现,但弱光下拍摄则要略逊一些,还有改进的空间。
拍照设置界面
蓝魔MOS1拍摄样张(点击查看原图)
蓝魔MOS1拍摄样张(点击查看原图)
蓝魔MOS1拍摄样张(点击查看原图)
蓝魔MOS1拍摄样张(点击查看原图)
蓝魔MOS1拍摄样张(点击查看原图)
蓝魔MOS1拍摄样张(点击查看原图)
蓝魔MOS1拍摄样张(点击查看原图)
蓝魔MOS1拍摄样张(点击查看原图)
蓝魔MOS1拍摄样张(点击查看原图)
硬件一览及总结
硬件方面,蓝魔MOS1搭载高通64位真8核高能低耗处理器,确保快速流畅。存储方面,配备32GB超大存储,2GB运行内存,支持联通移动双4G网络。相比其他常见的旗舰新品,蓝魔MOS1配置并不算突出,整体来说比较够用。在电池续航方面,MOS1则比较有亮点,其采用比亚迪3050mAh超安全电池,通过优化电池管理算法,支持高通QC2.0速充技术,10分钟即可充电15%左右,具体续航测试因时间有限,无法给出具体测试数据,不过短暂使用中,其耗电速度大约为1个小时的拍照重度使用,耗电12%左右,表现相当不错。
蓝魔MOS1硬件信息一览
总的来说,蓝魔MOS1算是非常有特色的产品,双2.5D玻璃与五面晶棱金属中框构成的独特外观也着实让人眼前一亮。另外值得肯定的是,作为一款转型之作,蓝魔MOS1不但摆脱了平板电脑的影子,而且确实为手机圈带来一丝创新。目前,该款新品将于7月31日开始预售,有流光金、烟云灰、皓月银三个颜色可选,8月初在线上商城、全国6000家线下渠道同步销售,如果对该款产品感兴趣的话,可以多多关注。
-
蓝魔
+关注
关注
0文章
11浏览量
7695
发布评论请先 登录
基于 HT 的 2.5D 组态可视化技术方案与场景实现

WT4203A-C02 dToF传感器实战:从原理到五大典型应用方案

台积电如何为 HPC 与 AI 时代的 2.5D/3D 先进封装重塑热管理

2D、2.5D与3D封装技术的区别与应用解析

TL-1685 玻璃-金属密封馈通端子现货库存
为你的STM32毕设项目加点“料”:“AI智能考勤系统”语音交互打卡系统

为你的STM32毕设项目加点“料”:“AI智能药盒提醒器”语音定时提醒系统

华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm

多芯粒2.5D/3D集成技术研究现状

【硬核开箱】ZX7981PM插卡CPE 实测:双卡切换+多模组适配,中小企业网络神器实锤!




 蓝魔手机MOS1评测 双2.5D玻璃与五面晶棱金属中框构成的独特外观让人眼前一亮
蓝魔手机MOS1评测 双2.5D玻璃与五面晶棱金属中框构成的独特外观让人眼前一亮


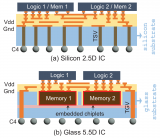




评论