近日,据韩媒报道,SK海力士在先进封装技术开发领域取得了显著进展,并正在考虑将其技术实力拓展至对外提供2.5D后端工艺服务。
若SK海力士正式进军以2.5D工艺为代表的先进OSAT(外包半导体组装与测试)市场,这将标志着其在AI芯片产业链上的布局进一步向下延伸。此举不仅有助于SK海力士扩大整体利润规模,更能在一定程度上缓解下游外部先进封装厂产能瓶颈对其HBM(高带宽存储器)销售的限制。
通过提供2.5D后端工艺服务,SK海力士将能够更灵活地应对市场需求变化,提升其在AI芯片领域的竞争力。同时,这也将为其与三星电子等竞争对手在全流程“交钥匙”方案领域展开对抗提供有力支持。
SK海力士在先进封装技术方面的突破,无疑为其未来的发展开辟了新的道路。随着其在OSAT市场的逐步深入,SK海力士有望在全球半导体产业链中扮演更加重要的角色,为行业的持续进步和发展贡献更多力量。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
封装技术
+关注
关注
12文章
605浏览量
69377 -
SK海力士
+关注
关注
0文章
1015浏览量
41955 -
AI芯片
+关注
关注
17文章
2168浏览量
36871
发布评论请先 登录
相关推荐
热点推荐
192GB,SK海力士开始为英伟达Vera Rubin量产SOCAMM2
了传统服务器内存的带宽与功耗瓶颈,更揭示了 AI 时代对内存技术的全新需求。 SK 海力士表示,SOCAMM2 相比传统 RDIMM,在带宽与功耗表现上均实现显著提升。 下一
SK海力士荣获2026年IEEE企业创新奖
SK海力士(或‘公司’)26日宣布,公司于当地时间24日在美国纽约举行的“2026年IEEE*荣誉颁奖典礼”上,荣获企业创新奖(Corporate Innovation Award)。
AI浪潮下的业绩狂飙:SK海力士2026年一季度财报深度解析
北京时间4月23日早间,全球存储芯片巨头SK海力士发布2026年第一季度财报,数据一经披露便引发资本市场热议。尽管营收52.6万亿韩元略低于市场预期的53.6万亿韩元,但净利润40.33万亿韩元
SK海力士投资19万亿韩元在韩国建设先进封装厂
近日,SK海力士宣布投资19万亿韩元(约合128.5亿美元)在韩国清州建设新一代先进封装工厂,专注于高带宽存储器(HBM)芯片的制造。该工厂预计2027年底完工,采用2.5D/3D封装
KV缓存黑科技!SK海力士“H³存储架构”,HBM和HBF技术加持!
据韩国经济日报报道,SK海力士近日在IEEE(电气与电子工程师协会)全球半导体大会上发表论文,提出了一种全新的存储架构。据悉,该架构名为“H³(hybrid semiconductor
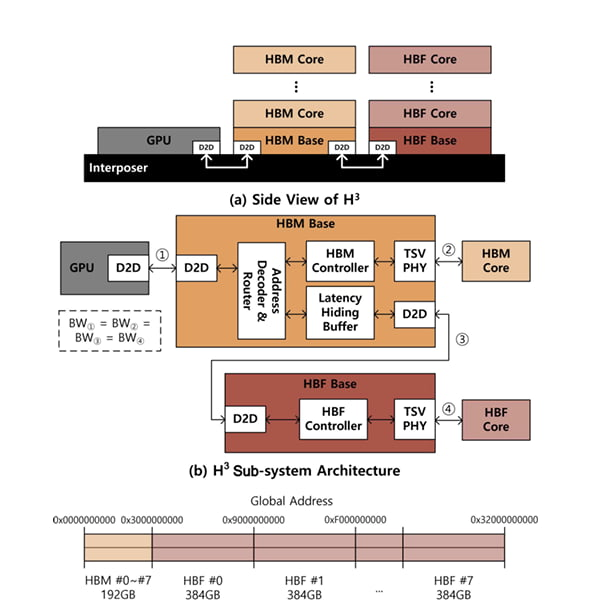
人均64万!SK海力士发出史上最高年终奖
,主要原因有两个方面,一是2025年9月SK海力士与工会达成历史性劳资协议,废除了此前“利润分享金不超过基本工资10倍”的上限,改为将年度营业利润的10%纳入奖金池,为奖金扩容奠定制度基础。 另一方面,公司业绩的爆发式增长提供
SK海力士HBS存储技术,基于垂直导线扇出VFO封装工艺
电子发烧友网综合报道,据韩媒报道,存储行业巨头SK海力士正全力攻克一项全新的性能瓶颈技术高带宽存储HBS。 SK海力士研发的这项HBS技术采用了创新的芯片堆叠方案。根据规划,该技术

SK海力士发布未来存储路线图
电子发烧友网综合报道,近日,韩国首尔举行的“SK AI Summit 2025”峰会上,SK海力士CEO郭鲁正(Kwak Noh-Jung)正式宣布了公司向 “全线AI存储创造者”(Full
SK海力士ZUFS 4.1闪存,手机端AI运行时间缩短47%!
电子发烧友网综合报道,SK海力士宣布,已正式向客户供应其全球率先实现量产的移动端NAND闪存解决方案产品ZUFS 4.1。 SK海力士通过与客户的密切合作,于今年6月成功完成了该产
SK海力士321层4D NAND的诞生
SK海力士致力于成为“全方位面向AI的存储器供应商(Full Stack AI Memory Provider)”,不仅在DRAM领域持续创新,在NAND闪存(NAND Flash,以下简称NAND
SK海力士在微细工艺技术领域的领先实力
SK海力士的成功神话背后,离不开众多核心技术的支撑,其中最令人瞩目的便是“微细工艺”。通过对肉眼难以辨识的微细电路进行更为精细化的处理,SK海力士
SK海力士HBM技术的发展历史
SK海力士在巩固其面向AI的存储器领域领导地位方面,HBM1无疑发挥了决定性作用。无论是率先开发出全球首款最高性能的HBM,还是确立并保持其在面向AI的存储器市场的领先地位,这些成就的背后皆源于SK
SK海力士宋清基TL荣庸发明日铜塔产业勋章
SK海力士宣布,5月19日于首尔COEX麻谷会展中心举行的“第60届发明日纪念仪式”上,来自HBM开发部门的宋清基TL荣庸铜塔产业勋章。
SK海力士如何成为面向AI的存储器市场领跑者
近年来,SK海力士屡获创新成果,这些成就皆得益于“一个团队”协作精神(One Team Spirit)”。无论是创下历史最佳业绩、开发出全球领先产品,还是跃升成为全球顶级面向AI的存储器供应商,这些
SK海力士UFS 4.1来了,基于321层1Tb TLC 4D NAND闪存
电子发烧友网综合报道,SK海力士宣布公司成功开发出搭载全球最高321层1Tb(太比特,Terabit)TLC(Triple Level Cell)4D NAND闪存的移动端解决方案产品UFS 4.1



 SK海力士考虑提供2.5D后端工艺服务
SK海力士考虑提供2.5D后端工艺服务




评论