超级AI芯片时代,电子元器件的进化方向
千瓦功耗的AI芯片正将电子元器件推向一场前所未有的技术革命。
随着单颗AI芯片功耗突破1000瓦大关,电子元器件行业正经历从“被动支撑”到“主动赋能”的角色转变。传统电子元件已无法满足超级AI算力对能效、密度与可靠性的严苛要求,一场围绕材料、架构和集成工艺的创新浪潮正在全球展开。
芯片制造商正在通过3D堆叠、CoWoS先进封装等技术突破单芯片性能极限,而电子元器件则向着小型化、高频化和高可靠性方向演进。
01 材料革命:第三代半导体与新型元件
AI芯片功耗飙升直接推动电子元器件材料的革新。第三代半导体材料碳化硅(SiC)和氮化镓(GaN)凭借其高击穿电压、高导热性和高开关频率的特性,正在快速取代传统硅基元件。
Wolfspeed、意法半导体和英飞凌等企业正扩大SiC和GaN元件产能,这些材料能够将最终产品的排放量降低高达30%。
在被动元件领域,村田制作所推出的创新“埋容”方案将电容集成到PCB内部,实现了垂直供电和更短的供电距离,降低了封装内损耗。
面对AI芯片核心电压已降至1V甚至更低的趋势,村田开发出厚度仅220微米的超薄电容,在05035尺寸实现22μF大容量,满足AI加速卡对高容量密度元件的需求。
02 架构革新:从平面到3D集成
为克服摩尔定律物理极限,电子元器件架构正从平面布局向三维堆叠转变。台积电的CoWoS封装技术通过将芯片垂直堆叠在基板上,显著提升了算力密度,已成为AI服务器芯片的主流封装方案。
三维集成不仅提高了计算性能,还大幅降低了功耗。
Chiplet技术将不同工艺、不同功能的芯片模块化集成,实现了“性能提升+成本降低”的双重目标。这一技术路径通过异构集成不同工艺芯片,大幅提高了设计灵活性和良品率。
2025年SEMICON Taiwan展会上,台积电推出的COUPE硅光平台集成了先进封装和硅光技术,预计2026年底问世,将首先应用于数据中心内部的交换机和AI服务器的光学互联模块。
03 系统协同:应对AI算力的全链条创新
超级AI芯片时代,电子元器件的创新不再是单点突破,而是全链条协同创新。从材料到制造再到封装,各环节必须紧密配合才能满足AI算力需求。
AI服务器对MLCC的需求量比传统服务器增长约100%,AIPC和AI手机分别增长40%-60%和20%,且对功率、频率、散热等性能要求更高。
在供电系统方面,AI芯片对电源稳定性的要求极为苛刻,电压波动容忍度从10%收紧至5%甚至更小。这促使村田等企业开发出小尺寸大容量的陶瓷电容方案和聚合物铝电容方案,其中MLCC产品最大容量可达330μF。
连接器与传感器也在同步进化。高速连接器需满足AI服务器、800G光模块需求,而MEMS传感器在压力、惯性领域市占率大幅提升。这些元件共同保障了AI系统在高速运算下的稳定运行。
未来五年,电子元器件将呈现高端化、智能化、绿色化三大趋势。国内企业在高性能芯片、高端传感器等领域逐步缩小与国际先进企业的差距。到2030年,AI领域用MLCC及芯片电感年均增速预计将超过30%。
电子元器件行业正在从“基础支撑”转向“价值核心”,成为全球科技革命的核心引擎。只有那些在材料科学、制造工艺和系统集成上持续创新的企业,才能在超级AI芯片时代保持领先地位。
-
电子元器件
+关注
关注
134文章
4017浏览量
114713 -
AI芯片
+关注
关注
17文章
2187浏览量
36896
发布评论请先 登录
AI驱动下电子元器件涨价潮来袭,全产业链承压与破局指南
电子元器件供应链升级!34万㎡超级平台全面赋能

老年份的电子元器件是否可买
【「AI芯片:科技探索与AGI愿景」阅读体验】+AI芯片的需求和挑战
【「AI芯片:科技探索与AGI愿景」阅读体验】+可期之变:从AI硬件到AI湿件
【「AI芯片:科技探索与AGI愿景」阅读体验】+内容总览
AI优化设计能否革新磁性元器件设计方案?
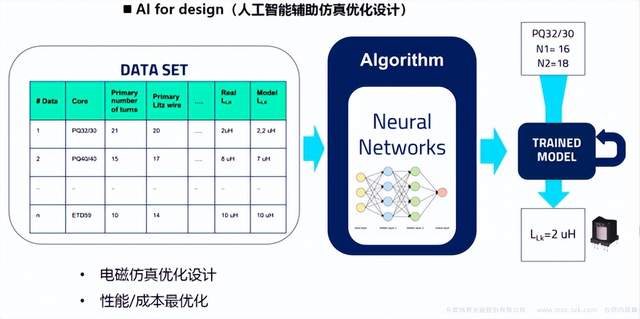
【书籍评测活动NO.64】AI芯片,从过去走向未来:《AI芯片:科技探索与AGI愿景》
AI平台能否终结磁性元器件“经验主义”设计




 超级AI芯片时代,电子元器件的进化方向
超级AI芯片时代,电子元器件的进化方向







评论