电阻率的测试方法多样,应根据材料的维度(如块体、薄膜、低维结构)、形状及电学特性选择合适的测量方法。在低维半导体材料与器件的研发和生产中,电阻率作为反映材料导电性能的关键参数,其精确测量对器件性能评估和质量控制具有重要意义。Xfilm 埃利四探针方阻仪凭借高精度和智能化特性,可为低维半导体材料的电学性能检测提供了可靠解决方案。下文将系统阐述常规四探针法、改进的四探针法、两探针法的原理与应用。

常规四探针法测试三维块体材料的电阻率
/Xfilm

四探针法测量半无限大半导体器件示意图
常规四探针法广泛应用于三维块体半导体材料的电阻率测量。该方法要求样品近似为半无限大均匀介质,四根探针以等间距直线排列。
实施需满足关键条件:样品表面平整;探针需有适当尖度,接触半径远小于间距。测量时需用高阻抗电压表测电压,确保电压探针间无电流,避免干扰电场分布。非半无限大样品还需引入修正因子校正结果。

改进的四探针法测试薄膜器件的电阻率
/Xfilm

改进的四探针法测试薄膜器件的示意图
对于薄膜材料,由于其尺寸有限,常采用改进的四探针法。该方法通过独立设置电流引线和电压引线,显著减小接触电阻和引线电阻的影响。
改进的四探针法通过四根导线固定器件于样品托,减少导线与接头对测量的影响:外侧两引线通电流,中间两独立引线测电位差。因电压表输入阻抗极高,电压引线电流可忽略,能准确测得样品真实电压降,分离电流与电压通路,彻底消除接触电阻影响,显著提升低维半导体器件的电阻率测量准确性。

两探针法测试高阻器件的电阻率
/Xfilm

两探针法测试薄膜器件的示意图
两探针法是高阻(>10MΩ)半导体器件电阻率测量的常用手段,核心是通过两根探针与样品形成欧姆接触,向样品注入μA 级恒定小电流,同时测量探针间电位差,依据欧姆定律计算电阻后推导电阻率。因高阻器件易受接触电阻和漏电流干扰,测量需采用输入阻抗≥10¹²Ω 的设备,且探针需经低电阻处理,该方法只适用于高阻器件电学性能初步表征。
四探针测量技术是低维半导体材料电阻率检测的关键手段,在材料研究与器件生产中不可或缺。常规四探针法、改进四探针法各有优势,需根据材料维度和电阻范围选择合适的测试方法。通过严格控制探针间距、接触压力、电流大小及环境因素等实验条件,可实现高精度电阻率测量,为低维半导体材料研发与器件性能优化提供支撑。

Xfilm埃利四探针方阻仪
/Xfilm

Xfilm埃利四探针方阻仪用于测量薄层电阻(方阻)或电阻率,可以对最大230mm 样品进行快速、自动的扫描, 获得样品不同位置的方阻/电阻率分布信息。
超高测量范围,测量1mΩ~100MΩ
高精密测量,动态重复性可达0.2%
全自动多点扫描,多种预设方案亦可自定义调节
快速材料表征,可自动执行校正因子计算
本文使用基于四探针法的Xfilm埃利四探针方阻仪,凭借智能化与高精度的表面电阻测量优势,助力低维半导体器件电阻率的测试,推动电子器件领域的材料检测技术升级。
#四探针#方阻测量#薄膜电阻#表面电阻测量
原文参考:《低维半导体器件电阻率的测试理论与实验研究》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
测试
+关注
关注
9文章
6527浏览量
131818 -
电阻率
+关注
关注
0文章
169浏览量
11375 -
半导体器件
+关注
关注
12文章
815浏览量
34388
发布评论请先 登录
【4200 SMU应用文章】之实例篇:测量范德堡法电阻率和霍尔电压
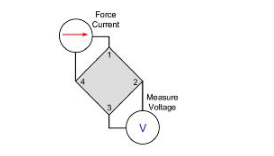
半导体电阻率的温度依赖性
半绝缘半导体电阻率无接触测试设备的研究

吉时利四探针法测试系统实现材料电阻率的测量

掺杂半导体的电阻率讲解
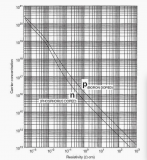
电阻率与温度的关系 电阻率和导电率的区别
电阻率对电力传输的影响 电阻率在半导体材料中的应用
如何用四探针测量半导体电阻率




 低维半导体器件电阻率的测试方法
低维半导体器件电阻率的测试方法







评论