近日,山东大学&华为联合报道了应用氟离子注入终端结构的1200V全垂直Si基GaN沟槽MOSFET(FIT-MOS)。氟离子注入终端(FIT)区域固有的具有负性电荷成为高阻区域,天然地隔离了MOSFET器件,取代了传统的台面刻蚀终端(MET),消除了台面边缘的电场聚集效应,从而将FIT-MOS的BV从MET-MOS的567 V提升到1277 V。此外,所制造的FIT-MOS表现出3.3 V的阈值电压(Vth),达到了107的开关比(ION/OFF),以及5.6mΩ·cm2的比导通电阻(Ron,sp)。这些结果表明,在高性价比Si基GaN平台制备的垂直晶体管在kV级应用中具有很大的潜力。相关成果以《1200 V Fully-Vertical GaN-on-Si Power MOSFET》为题发表在《IEEE Electron Device Letters》上。
标题:1200 V Fully-Vertical GaN-on-Si Power MOSFET
作者:Yuchuan Ma,Hang Chen, Shuhui Zhang,Huantao Duan,Bin Hu,Huimei Ma,Jianfei Shen,Minghua Zhu, Jin Rao and Chao Liu


图1:(a)具有氟注入端终端(FIT-MOS)的全垂直硅基氮化镓沟槽 MOSFET 的结构示意图和(b)沟槽栅极区域截面扫描电子显微镜(SEM)图像。

图2:全垂直沟槽MOSFET的NPN型外延结构材料表征结果

图3:全垂直硅基氮化镓FIT-MOS和MET-MOS的关态击穿特性。插图为FIT-MOS和MET-MOS的潜在漏电路径。
在VDS=10 V时FIT-MOS的转移特性曲线显示出Vth=3.3 V (IDS=1A/cm2)和ION/OFF=107。而FIT-MOS的输出特性曲线则是显示了8 kA/cm2的高漏极电流密度和相对较低的Ron,sp,经过输出曲线线性区域计算得到5.6 mΩ·cm2。
而FIT-MOS和MET-MOS的关态击穿特性比较可以知道,FIT-MOS具有1277 V的高击穿电压,而MET-MOS则是在567 V就已经发生击穿。而且击穿前器件的栅极漏电都保持在10-6 A/cm2以下,则是表明了栅介质叠层在高VDS下具有出色的稳定性。但是,因FIT-MOS具有额外的垂直漏电流路径,其在低VDS下表现出了比MET-MOS更大的关态漏电流,这可以对比通过MET与FIT横向测试结构的电流密度来确定。因为注入后的FIT区域中Ga空位的存在以及原子键能弱,F离子可能会在GaN晶格中扩散并逸出,这会干扰到F离子注入的热稳定性。采用优化的注入后退火工艺可以有效降低FIT-MOS的关态漏电流密度,提高器件的热可靠性。
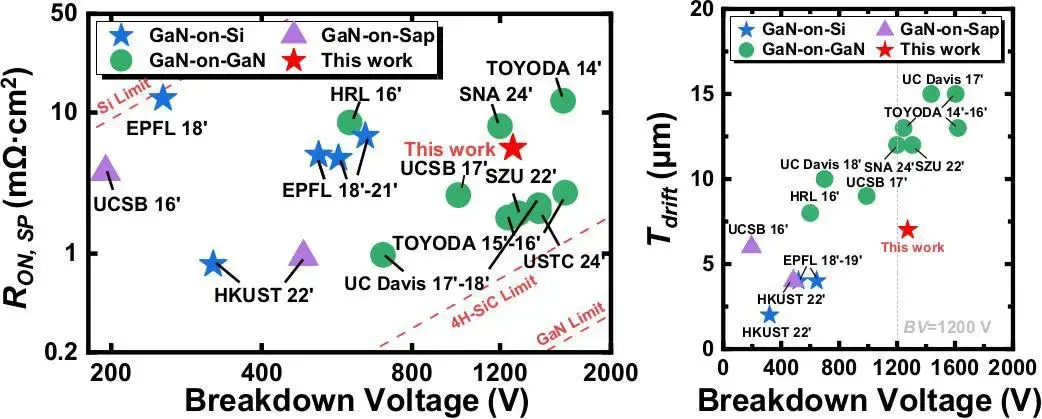
图4:制备的FIT-MOS与硅、蓝宝石(Sap)和GaN衬底上已报道的GaN垂直沟槽MOSFET(a) Ron,sp与BV 对比,以及 (b) 漂移层厚度 (Tdrift)与BV 对比。
研究人员还比较了FIT-MOS器件与先前报道的垂直 GaN 晶体管的Ron,sp、BV和漂移层厚度,得到的Baliga 优值为 291 MW/cm2,实现与更昂贵的GaN衬底上制备的器件接近的性能。同时,耐压超过1200 V垂直型GaN-on-GaN 晶体管往往需要超过 10 μm的漂移层,而垂直型GaN-on-Si FIT-MOS 得益于高效的氟离子注入终端,使用更薄的漂移层(7 μm)就实现了超过1200 V的击穿电压。
测试结果显示,FIT-MOS 呈现增强模式工作特性,阈值电压(VTH)为 3.3 V,开关电流比约为 10⁷,导通电流密度达 8 kA/cm²,比导通电阻(Ron,sp)为 5.6 mΩ·cm2。它的击穿电压(BV)达到了 1277 V,而对照的 MET-MOS 只有 567 V。不过研究团队也指出,因为 FIT 结构有额外的垂直泄漏路径,FIT-MOS 在低漏源电压(VDS)下的关态电流密度比 MET-MOS 大。
研究团队展示了1200 V全垂直Si基GaN沟槽MOSFET,并采用了氟离子注入终端结构。其采用了FIT高阻结构替代了传统的台面刻蚀终端结构,有效隔离了器件,消除了终端区域的电场聚集问题,从而将BV从MET-MOS的567 V提高了FIT-MOS的1277 V。此外,FIT-MOS的Vth为3.3 V,ION/OFF比达到了107,Ron,sp为5.6 mΩ·cm2,漏极电流密度为8 kA/cm2,这些结果使得垂直Si基GaN晶体管在kV级电力电子应用中奠定了基础。
本文报道了1200 V全垂直Si基GaN沟槽MOSFET的氟离子注入终端(FIT)结构,FIT结构取代了通常使用的台面刻蚀终端,有效地隔离了分立的FIT-MOS,消除了MET-MOS中的电场聚集现象,结果表明,该器件的击穿电压为1277 V。氟离子注入终端技术为垂直GaN沟道MOSFET在kV级电力系统中的应用提供了广阔的前景。
来源:《semiconductor today》等
审核编辑 黄宇
-
MOSFET
+关注
关注
151文章
10741浏览量
234827 -
华为
+关注
关注
218文章
36163浏览量
262637
发布评论请先 登录
氧化镓器件新突破!光导开关击穿电压突破10000V
森国科发布SOD123封装1200V/1A碳化硅二极管

山东大学开源鸿蒙技术俱乐部成立仪式暨系统软件技术论坛圆满举办

1200V CoolSiC™ MOSFET评估平台:设计与应用全解析
GaN(氮化镓)与硅基功放芯片的优劣势解析及常见型号
山东大学与济南市科技局领导莅临深兰科技调研考察
2025开放原子校源行山东大学站圆满落幕
【AI大讲堂】中星联华走进高校系列-山东大学站

华为星河AI高品质校园网络解决方案助力山东大学开学典礼顺利举行
山东大学与华为达成联合创新合作意向
建设中国RISC-V人才生态高地 ——算能与山东大学携手推动产教融合 打造人才培养新范式

派恩杰第三代1200V SiC MOSFET产品优势
新品 | 针对车载充电和电动汽车应用的EasyPACK™ CoolSiC™ 1200V和硅基模块

瞻芯电子第3代1200V 35mΩ SiC MOSFET量产交付应用




 华为联合山东大学突破:1200V全垂直硅基氮化镓MOSFET
华为联合山东大学突破:1200V全垂直硅基氮化镓MOSFET




评论