为了推动AI等创新应用落地,使其惠及更广大的用户,需要指数级增长的算力。为此,半导体行业正在不断拓展芯片制造的边界,探索提高性能、降低功耗的创新路径。
在这样的背景下,传统上仅用于散热和保护设备的封装技术正在从幕后走向台前,成为行业热门趋势。与传统的封装技术不同,先进封装技术可以在单个设备内集成不同厂商、不同制程、不同大小、不同功能的芯片,从而为打造功能更强大、能效比更高的系统级芯片(SoC),带来了全新的可能性。

英特尔一直致力于将处理器、加速器和存储器等各种各样的芯片堆叠起来,组合到更大规模的封装中,帮助客户让产品性能“更上一层楼”。在2025 IEEE电子器件技术大会(ECTC)上,英特尔分享了其封装技术的最新进展,这一大会由IEEE(电气电子工程师学会)电子封装协会主办,聚焦于封装、器件和微电子系统的科研、技术与教育,是封装领域的国际顶会。
具体而言,英特尔在封装领域的三大关键技术路径包括:提高封装的良率,确保供电稳定可靠,以及通过有效的热管理技术实现散热。
EMIB-T:稳定供电

英特尔的EMIB(嵌入式多芯片互连桥接)技术已经投入生产,突破了光罩尺寸的限制,实现了多芯片之间的高速互联。此外,通过硅通孔(TSV)技术,EMIB-T 优化了供电效率,并为集成高速HBM4,以及基于UCIe标准的芯粒提供了简便的解决方案。
热压键合:提高良率
随着封装尺寸越来越大,集成多芯片的复杂程度也在同步提升。英特尔计划通过探索高精度、大光罩热压键合(TCB)的先进工艺来提高良率和可靠性。

分解式散热器:高效散热
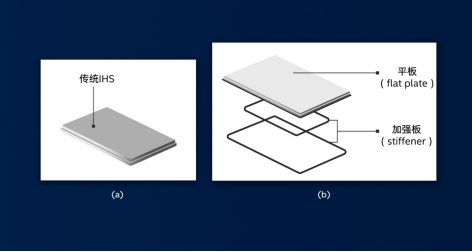
随着封装变得越来越复杂,尺寸也越来愈大,热设计功耗(TDP)也在不断增加。为应对散热层面的挑战,英特尔正在研发全新的分解式散热器技术,以及新一代热界面材料。这些创新可以更有效地将热量从热源传递到散热器的各个部分,进而提升整体的散热效率。
审核编辑 黄宇
-
英特尔
+关注
关注
61文章
10316浏览量
181051 -
封装
+关注
关注
128文章
9320浏览量
149028 -
AI
+关注
关注
91文章
40969浏览量
302533
发布评论请先 登录
英特尔开发者年度盛会智潮涌动,推动AI创新走向产业纵深
忆联亮相2025英特尔技术创新与产业生态大会
智锐通科技亮相“英特尔技术创新与产业生态大会”,展示AI医疗内窥解决方案

吉方工控亮相2025英特尔技术创新与产业生态大会
渝见科技未来:2025英特尔技术创新与产业生态大会擘画产业新蓝图

创芯赋能智能生态!汇顶科技亮相2025英特尔技术创新与产业生态大会

聚“芯”向新 生态共赢|芯海科技亮相“2025英特尔技术创新与产业生态大会”

陈立武中文首秀!英特尔18A芯片规模量产,CES上新迎接AI新机遇

向新而生,同“芯”向上!2025英特尔技术创新与产业生态大会在重庆举行




 英特尔推进技术创新,以规模更大的封装满足AI应用需求
英特尔推进技术创新,以规模更大的封装满足AI应用需求






评论