文章来源:半导体与物理
原文作者:jjfly686
本文介绍了芯片中金属互连线的各个层级的不同设计。
在半导体芯片中,数十亿晶体管需要通过金属互连线(Interconnect)连接成复杂电路。随着制程进入纳米级,互连线的层次化设计成为平衡性能、功耗与集成度的关键。芯片中的互连线按长度、功能及材料分为多个层级,从全局电源网络到晶体管间的纳米级连接,每一层都有独特的设计考量。
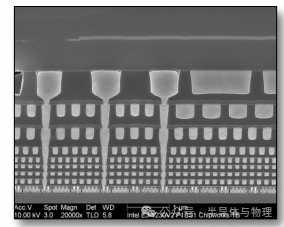
全局互连(Global Wires)
层级范围:通常为最高层金属(如M8、M9),最多2层。
长度:5-10mm,覆盖整个芯片区域。
材料:采用掺氟硅酸盐玻璃(FSG,k≈3.5)或传统氧化物(SiO₂,k≈3.9)作为绝缘介质,铜(Cu)为导体。
设计优势:高层金属厚度可达1-3μm,电流承载能力是低层金属的2-3倍,适合大电流传输。
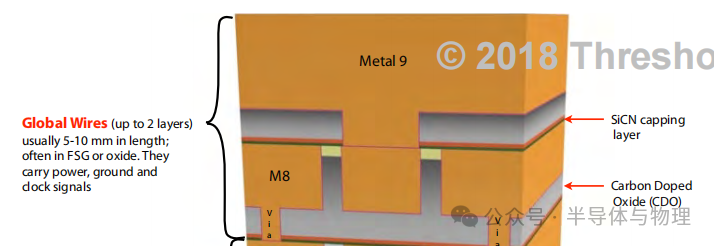
半全局互连(Semi-Global Wires)
层级范围:中间层金属(如M4-M7),最多4层。
长度:0.5-5mm,连接不同功能模块(如CPU核心与缓存)。
材料:绝缘介质为碳掺杂硅氧化物(CDO,k≈2.8-3.2),铜互连搭配氮化钽(TaN)阻挡层。
性能优化:CDO的碳掺杂降低介电常数,减少信号串扰,同时保持机械强度。
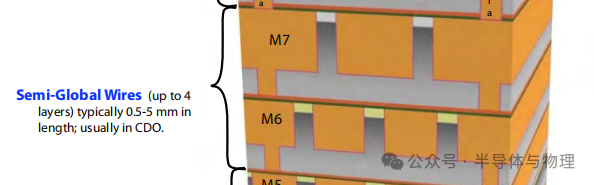
中间互连(Intermediate Wires)
层级范围:低层金属(如M2-M3),最多5层。
长度:<100μm,实现模块内局部连接。
材料:同样使用CDO介质,铜互连需更薄的阻挡层(1-2nm TaN)。
工艺挑战:深宽比>5:1的通孔需原子层沉积(ALD)铜籽晶层,避免电镀空洞。
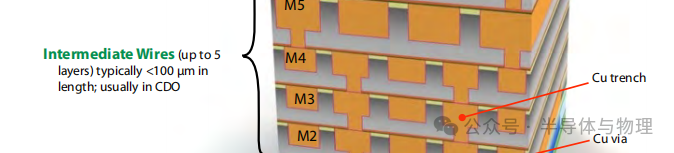
局部互连(M1 & Contacts)
层级范围:最底层金属(M1),直接连接晶体管源/漏极。
长度:<50μm,纳米级线宽(10-20nm)。
材料:CDO介质,钴(Co)或钌(Ru)逐步替代铜,减少电阻飙升问题。
关键技术:选择性外延填充接触孔,结合化学机械抛光(CMP)确保平坦化。

-
芯片
+关注
关注
463文章
54422浏览量
469246 -
半导体
+关注
关注
339文章
31236浏览量
266495 -
晶体管
+关注
关注
78文章
10439浏览量
148588
原文标题:半导体芯片中的互连层次
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
芯片,集成电路,半导体含义
芯片,半导体,集成电路,傻傻分不清楚?
半导体芯片内部结构详解
半导体元件与芯片的区别有哪些
半导体元件与芯片的区别
半导体封装革新之路:互连工艺的升级与变革




 半导体芯片中的互连层次
半导体芯片中的互连层次

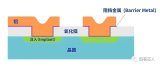




评论