电子发烧友网报道(文/李宁远)近日,英特尔发表声明展示“业界首款”用于下一代先进封装的玻璃基板,与现今使用的有机基板相比,玻璃基板具有卓越的机械、物理和光学特性,在单一封装中可连接更多晶体管,提高延展性并能够组装更大的小芯片复合体。
英特尔指出,玻璃基板凭借优秀的平面度有效改善光刻的聚焦深度,提升封装的良品率,降低加工成本。此外,玻璃基板还具有利于层对层互连覆盖的物理结构稳定性,进一步提升封装的晶体管密度上限,降低封装功耗。
下一代封装技术,玻璃基板优势明显
随着半导体制程工艺提升越来越困难,先进封装技术的重要性则愈发凸显,成为延续摩尔定律的关键。在封装领域,大家听到的更多的是先进封装技术,其实封装基板一直是封装细分领域的重要组成部分。
封装基板为芯片提供保护和支撑,既是芯片向外界散热的主要途径,也是实现芯片与外界之间进行电流和信号传输的重要载体。
根据封装基板的材料、结构和功能特点常见的封装基板有很多分类,其中有机封装基板是半导体行业常用的一种基板。有机封装基板是一种采用有机材料作为基板的封装方式。有机基板具有较低的成本、较好的加工性能和较轻的重量这些优势,在消费类电子产品的芯片封装中很常见。
近日英特尔展示用于下一代先进封装的玻璃基板时表示,到本世纪末,有机材料基板会迎来技术瓶颈,有机材料基板无法进一步提高晶体管密度的同时,还面临着容易收缩形变的问题。例如数据中心的系统级封装(SiP)具有数十个小片,功耗可能高达数千瓦,有机材料基板作为互连材料已经开始乏力。
可以说芯片基板作为芯片的重要组成部分,对芯片性能和稳定性有着重要影响,在芯片集成度不断升级的需求下,有机材料基板逐渐不能满足封装需求。
本次展示的玻璃基板被英特尔誉为“重大突破”,能够解决有机材质基板用于芯片封装产生的翘曲问题,突破有机材质基板受限的性能天花板,让半导体封装晶体管数量极限最大化,同时还具有更省电、散热更好的优势。
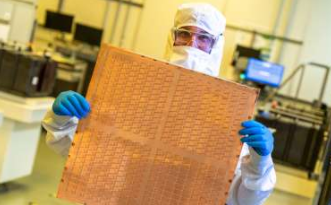
根据英特尔的说法,这并不意味着用玻璃取代整个基板,而是用玻璃取代有机封装中的有机材料。
玻璃这种无机非金属材料,其高硬度、高熔点、热导性能良好的热性是成为理想的芯片基板材料的基础。同时,玻璃基板具有较好的表面平整度和尺寸稳定性,玻璃基板的热膨胀系数与硅相近,可以有效地减小热应力带来的影响。而且,在光透过性上,玻璃基板的表现更出色。
根据公布的信息,该玻璃基板可以承受更高的温度,将pattern distortion减少了50%,确保了制造过程的精密和准确。并具有极低的平面度,可改善光刻的聚焦深度,并具有极其紧密的层间互连覆盖所需的尺寸稳定性。英特尔的目标是在2030年前将单一封装芯片中的晶体管数量上限提高至1万亿个,玻璃基板在内的先进封装技术将会此目标提供不少助力。
同时英特尔表示,使用玻璃材料基板能够提高芯片的供电效率,互连密度相比有机材料可以提高10倍,将带宽近翻倍提升至448G。
受益于互连密度的提高,数据密集型应用的高密度、高性能芯片无疑将率先从这项技术中受益。英特尔也预计玻璃基板正式面世后最初将用于需要较大尺寸封装的应用,如涉及数据中心和人工智能方向。
助力芯片微缩化,算力增长催生玻璃基板需求
在算力需求迅猛增长的如今,算力已经是无法替代的先进生产力,是人工智能、大数据、物联网等先进技术落地应用的基础支撑。下一代先进封装的玻璃基板凭借单一封装纳入更多的晶体管,将实现更强大的算力,持续推进摩尔定律极限。
先进芯片的竞争,不论是先进制程还是先进封装,都有一个共同点,即在单一封装纳入更多的晶体管进一步微缩化,这也是实现更强大算力的前提。
在先进制程领域,台积电和三星都在为2nm制程节点冲刺,英特尔的Intel 20A、Intel 18A制程节点也在按计划推进中,预计在2025年先进制程迎来龙头间阶段性的白热化对决。为了解决芯片进一步微缩的难题,业界也在不断探索着新的芯片供电网络方案。
在半导体先进制程领域,工艺在向更小的制程节点突破,封装领域的竞争也正在向细分领域蔓延。英特尔在业内率先推出用于下一代先进封装的玻璃基板,如果进展顺利,将继续推动摩尔定律以数据为中心的应用的算力需求,为未来的算力时代提供助力。
随着先进技术对更强大计算需求的增加,半导体行业进入在封装中使用多个“Chiplet”通过内部互联的技术封装在一起。信号传输速度、功率传输、设计规则和封装基板稳定性等任一项改进都对先进芯片来说至关重要。
玻璃基板优越的机械、物理和光学性能允许在一个封装内连接更多的晶体管,传输信号的速度也会更快。芯片架构师将能够在一个封装里封装更多的Chiplet,同时实现性能、密度、灵活性的提升并降低功耗。对于半导体行业来说,芯片微缩进程里玻璃基板或许是下一代封装里必不可少的一环。
除了英特尔,此前韩国SK集团的芯片封装子公司Absolics宣布进入玻璃基板赛道,目标是今年建成将成为半导体封装玻璃基板量产工厂,首先专注于小量生产,并计划自2024年第二季正式投入量产。
日本DNP也表示已开发出专注于新一代半导体封装的玻璃基板,量产目标时间定在2027年。Absolics和DNP的玻璃基板技术都源自美国GT PRC,不过二者目前研发的针对玻璃基板的应用有所不同。
写在最后
虽然玻璃基板技术距离量产,距离引领半导体行业进入下一个封装时代还需要不少时间突破材料制备上的困难,同时成本和良率也很难在短时间内和经过长期验证的有机基板竞争。但这一进展的公布无疑是一个开始,封装革命的开始,它让业内看到了玻璃基板已经可以提供比当前有机基板更好的信号性能和更密集的布线,是下一代封装里重要一环。
随着半导体行业的快速发展,尤其是算力需求的攀升,芯片制造领域的竞争越来越激烈,设计、制造、封测每个环节都可能成为芯片行业的胜负手。先进封装领域,竞争已经在每一个细分领域打响。
英特尔指出,玻璃基板凭借优秀的平面度有效改善光刻的聚焦深度,提升封装的良品率,降低加工成本。此外,玻璃基板还具有利于层对层互连覆盖的物理结构稳定性,进一步提升封装的晶体管密度上限,降低封装功耗。
下一代封装技术,玻璃基板优势明显
随着半导体制程工艺提升越来越困难,先进封装技术的重要性则愈发凸显,成为延续摩尔定律的关键。在封装领域,大家听到的更多的是先进封装技术,其实封装基板一直是封装细分领域的重要组成部分。
封装基板为芯片提供保护和支撑,既是芯片向外界散热的主要途径,也是实现芯片与外界之间进行电流和信号传输的重要载体。
根据封装基板的材料、结构和功能特点常见的封装基板有很多分类,其中有机封装基板是半导体行业常用的一种基板。有机封装基板是一种采用有机材料作为基板的封装方式。有机基板具有较低的成本、较好的加工性能和较轻的重量这些优势,在消费类电子产品的芯片封装中很常见。
近日英特尔展示用于下一代先进封装的玻璃基板时表示,到本世纪末,有机材料基板会迎来技术瓶颈,有机材料基板无法进一步提高晶体管密度的同时,还面临着容易收缩形变的问题。例如数据中心的系统级封装(SiP)具有数十个小片,功耗可能高达数千瓦,有机材料基板作为互连材料已经开始乏力。
可以说芯片基板作为芯片的重要组成部分,对芯片性能和稳定性有着重要影响,在芯片集成度不断升级的需求下,有机材料基板逐渐不能满足封装需求。
本次展示的玻璃基板被英特尔誉为“重大突破”,能够解决有机材质基板用于芯片封装产生的翘曲问题,突破有机材质基板受限的性能天花板,让半导体封装晶体管数量极限最大化,同时还具有更省电、散热更好的优势。
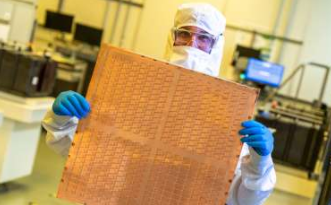
英特尔玻璃基板实物(图源:英特尔)
根据英特尔的说法,这并不意味着用玻璃取代整个基板,而是用玻璃取代有机封装中的有机材料。
玻璃这种无机非金属材料,其高硬度、高熔点、热导性能良好的热性是成为理想的芯片基板材料的基础。同时,玻璃基板具有较好的表面平整度和尺寸稳定性,玻璃基板的热膨胀系数与硅相近,可以有效地减小热应力带来的影响。而且,在光透过性上,玻璃基板的表现更出色。
根据公布的信息,该玻璃基板可以承受更高的温度,将pattern distortion减少了50%,确保了制造过程的精密和准确。并具有极低的平面度,可改善光刻的聚焦深度,并具有极其紧密的层间互连覆盖所需的尺寸稳定性。英特尔的目标是在2030年前将单一封装芯片中的晶体管数量上限提高至1万亿个,玻璃基板在内的先进封装技术将会此目标提供不少助力。
同时英特尔表示,使用玻璃材料基板能够提高芯片的供电效率,互连密度相比有机材料可以提高10倍,将带宽近翻倍提升至448G。
受益于互连密度的提高,数据密集型应用的高密度、高性能芯片无疑将率先从这项技术中受益。英特尔也预计玻璃基板正式面世后最初将用于需要较大尺寸封装的应用,如涉及数据中心和人工智能方向。
助力芯片微缩化,算力增长催生玻璃基板需求
在算力需求迅猛增长的如今,算力已经是无法替代的先进生产力,是人工智能、大数据、物联网等先进技术落地应用的基础支撑。下一代先进封装的玻璃基板凭借单一封装纳入更多的晶体管,将实现更强大的算力,持续推进摩尔定律极限。
先进芯片的竞争,不论是先进制程还是先进封装,都有一个共同点,即在单一封装纳入更多的晶体管进一步微缩化,这也是实现更强大算力的前提。
在先进制程领域,台积电和三星都在为2nm制程节点冲刺,英特尔的Intel 20A、Intel 18A制程节点也在按计划推进中,预计在2025年先进制程迎来龙头间阶段性的白热化对决。为了解决芯片进一步微缩的难题,业界也在不断探索着新的芯片供电网络方案。
在半导体先进制程领域,工艺在向更小的制程节点突破,封装领域的竞争也正在向细分领域蔓延。英特尔在业内率先推出用于下一代先进封装的玻璃基板,如果进展顺利,将继续推动摩尔定律以数据为中心的应用的算力需求,为未来的算力时代提供助力。
随着先进技术对更强大计算需求的增加,半导体行业进入在封装中使用多个“Chiplet”通过内部互联的技术封装在一起。信号传输速度、功率传输、设计规则和封装基板稳定性等任一项改进都对先进芯片来说至关重要。
玻璃基板优越的机械、物理和光学性能允许在一个封装内连接更多的晶体管,传输信号的速度也会更快。芯片架构师将能够在一个封装里封装更多的Chiplet,同时实现性能、密度、灵活性的提升并降低功耗。对于半导体行业来说,芯片微缩进程里玻璃基板或许是下一代封装里必不可少的一环。
除了英特尔,此前韩国SK集团的芯片封装子公司Absolics宣布进入玻璃基板赛道,目标是今年建成将成为半导体封装玻璃基板量产工厂,首先专注于小量生产,并计划自2024年第二季正式投入量产。
日本DNP也表示已开发出专注于新一代半导体封装的玻璃基板,量产目标时间定在2027年。Absolics和DNP的玻璃基板技术都源自美国GT PRC,不过二者目前研发的针对玻璃基板的应用有所不同。
写在最后
虽然玻璃基板技术距离量产,距离引领半导体行业进入下一个封装时代还需要不少时间突破材料制备上的困难,同时成本和良率也很难在短时间内和经过长期验证的有机基板竞争。但这一进展的公布无疑是一个开始,封装革命的开始,它让业内看到了玻璃基板已经可以提供比当前有机基板更好的信号性能和更密集的布线,是下一代封装里重要一环。
随着半导体行业的快速发展,尤其是算力需求的攀升,芯片制造领域的竞争越来越激烈,设计、制造、封测每个环节都可能成为芯片行业的胜负手。先进封装领域,竞争已经在每一个细分领域打响。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片设计
+关注
关注
15文章
1171浏览量
56775 -
玻璃基板
+关注
关注
1文章
105浏览量
11097 -
基板
+关注
关注
2文章
324浏览量
24082 -
先进封装
+关注
关注
2文章
561浏览量
1057
发布评论请先 登录
相关推荐
热点推荐
苹果抢跑!自研AI服务器芯片选定玻璃基板,先进封装迎来终极方案?
电子发烧友网报道(文/梁浩斌)苹果AI芯片,瞄准了玻璃基板。近日供应链消息称,三星电机已经向苹果公司提供了半导体玻璃基板的样品,预计苹果将在其自研AI服务器芯片

键合玻璃载板:半导体先进封装的核心支撑材料
(UV)、加热或机械方式解键合移除。 需要注意区别玻璃载板与玻璃基板,玻璃载板属于临时支撑工具,可重复使用3-4次,而
五家大厂盯上,英特尔EMIB成了?
电子发烧友网综合报道 最近,英特尔EMIB封装火了,在苹果、高通、博通的招聘信息中,都指出正在招募熟悉EMIB封装的工程师。近期还有消息称,由于台积电CoWoS 先进
TGV产业发展:玻璃通孔技术如何突破力学瓶颈?
在后摩尔时代,芯片算力提升的突破口已从单纯依赖制程工艺转向先进封装技术。当硅基芯片逼近物理极限,2.5D/3D堆叠技术通过Chiplet(芯粒)拆分与异构集成,成为突破光罩限制的核心路径。而在
意法半导体推进下一代芯片制造技术 在法国图尔工厂新建一条PLP封装试点生产线
意法半导体(简称ST)公布了其位于法国图尔的试点生产线开发下一代面板级包装(PLP)技术的最新进展。该生产线预计将于2026年第三季度投入运营。
英特尔代工:明确重点广合作,服务客户铸信任
英特尔代工大会召开,宣布制程技术路线图、先进封装里程碑和生态系统合作。 今天,2025英特尔代工大会(Intel Foundry Direct Connect)开幕,
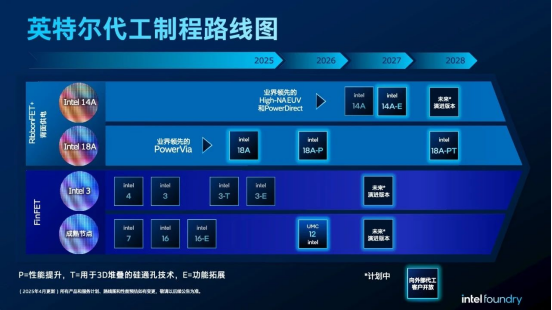
英特尔与面壁智能宣布建立战略合作伙伴关系,共同研发端侧原生智能座舱,定义下一代车载AI
今日,英特尔与面壁智能签署合作备忘录。双方宣布达成战略级合作伙伴关系,旨在打造端侧原生智能座舱,定义下一代车载AI。目前,双方已合作推出“英特尔&面壁智能车载大模型GUI智能体”,将端侧AI大模型引入汽车座舱,让用户不再受限于网




 英特尔公布玻璃芯研发进展,玻璃基板或引领下一代先进封装
英特尔公布玻璃芯研发进展,玻璃基板或引领下一代先进封装











评论