文章来源:学习那些事
原文作者:赵先生
本文主要介绍粘片工艺。
粘片工艺介绍
粘片作为芯片与管壳间实现连接和固定的关键工序,达成了封装对于芯片的固定功能,以及芯片背面电连接功能。在行业里,这一工序常被叫做粘片。由于其核心作用是固定芯片,因而也被称作固晶工艺或贴片工艺,英文表述为“Die Bonding”或“Die Attach”。
在日常生活中,“粘”通常意味着借助胶水实现两个物体的连接,这属于物理连接过程。所以,用粘片来描述芯片的导热胶粘接工艺,既生动又恰当。与之不同,另一种借助合金料片,将芯片焊接到管壳、基板或载体上的工艺,被称作芯片烧结、合金烧结或合金粘片。这一过程涉及多种金属间的复杂反应。
芯片与外壳或基板的贴装方法,主要有导热胶粘接和合金料烧结(此处不探讨倒装焊)。导热胶对被粘接的芯片和外壳要求相对宽松,只要确保原材料洁净,导热胶就能顺利固化并完成粘接。而烧结则需要用到合金焊料,焊料的可焊性、熔点、机械强度以及热膨胀系数等,都会对焊接质量和可靠性造成影响。这些是材料生产厂家需要考虑和优化的内容。封装厂的任务是挑选合适的成熟焊料片,并应用于器件生产。每种焊料片因成分配比和自身性质固定,所需的焊接条件也相对固定。封装厂无需开展过多研究,只需按照对应的烧结曲线,完成焊料与芯片的焊接。由此可见,粘片工艺对后期技术研发的依赖程度较低。
然而,国内外仍有大量研究聚焦于粘片工艺。这主要是因为设备波动、物料变质、原材料缺陷以及背面金属化层质量问题等,都会干扰粘接和焊接的正常进行,必须通过研究分析找出问题。早期,原材料氧化、人员手工贴片手法差异、设备真空度限制以及保护气氛施加方式等问题,极大地影响了粘片工艺的稳定性,导致为获得良好焊接效果所需的粘片工艺参数存在较大不确定性。此外,粘片在封装工序中处于靠前位置,后续工序会对粘片的可靠性产生影响。因此,在设计封装工艺方案时,需要全面考虑包括粘片在内的各工序之间的匹配关系,比如温度梯度和应力叠加等,避免后续工艺对粘片质量造成影响。同时,粘片也会对其他工序产生影响。例如,粘片过程中的偏移,是器件小型化进程中需要解决的难题,导热胶的胶晕会影响键合丝与管壳的键合强度。
无论如何,粘片工序都是集成电路封装工艺中最为基础且关键的环节之一。值得注意的是,后续筛选考核中的热冲击、温度循环、机械冲击、扫频振动、恒定加速度等试验,都是在检验粘片的可靠性,这充分说明了该工艺可靠性的重要性 。
粘片工艺的选型
导热胶粘接和合金烧结这两种粘片技术,各有优劣。
导热胶粘接:该工艺适用性广泛,能用于绝大多数芯片与器件的粘接。然而,导热胶热膨胀系数偏高,与陶瓷、金属以及硅芯片在热性能匹配上,不及焊料,容易引发热失配问题。此外,导热胶等胶粘剂会吸附气体,并在使用过程中缓慢分解释放有害气体,对器件内部造成损害。
合金烧结:此工艺可靠性极佳,具备较高的焊接强度,以及出色的电导率和热导率。对于高可靠性要求的器件,通常采用合金焊料烧结粘片,使其能适应大温区变化、高应力冲击等严苛的服役环境。不过,部分合金料在烧结过程中,可能出现颗粒飞溅现象。
另外,不同类型的导热胶,固化温度和耐受环境温度有所不同。一旦超出耐受温度,导热胶粘接就容易失效。而经过合金烧结的器件,若再次处于超过固化温度的环境中,焊接材料会重新熔化,可能导致芯片脱落,还会引发氧化、产生更多焊接空洞等问题。
因此,在选择粘片工艺时,需依据产品性能指标要求,选择适配的工艺。
粘片质量标准——剪切强度。
剪切应力试验是评估粘片质量的常用方法。芯片经粘接或烧结后所具备的强度,即芯片粘结强度。可依照GJB 548B - 2005中方法2019.2“芯片剪切强度”规定的流程开展试验。芯片粘结强度与芯片面积密切相关,该方法给出了粘结强度是否合格的判断标准,具体如图1所示。
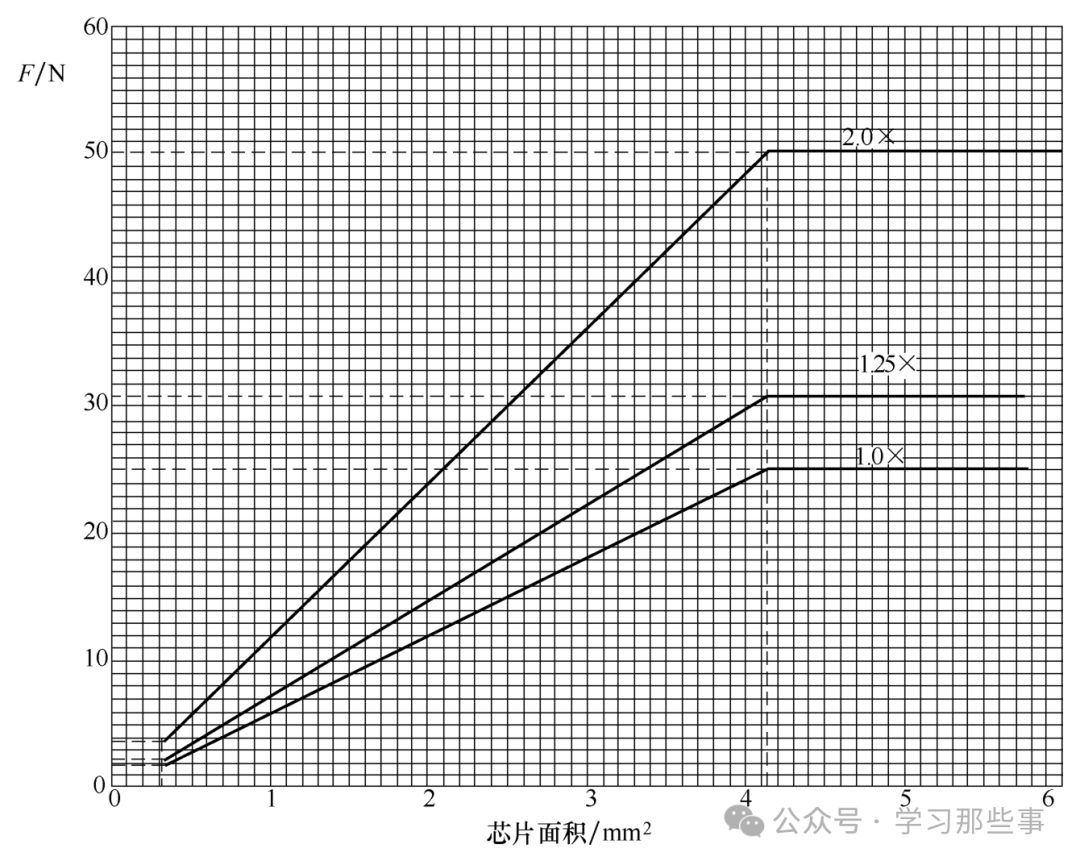
图1:芯片剪切强度标准
当芯片粘结面积大于4.13mm²,需至少承受25N的力,或其相应倍数的力。
当芯片粘结面积介于0.32mm²(含)至3.14mm²之间时,芯片承受的最小剪切强度,可参照图1所示标准确定。
当芯片粘结面积小于0.32mm²,最小剪切强度应为1倍时6N/mm²,或2倍时12N/mm² 。
粘片质量指标——空洞率
在高可靠性集成电路产品生产中,常采用烧结粘片,并对芯片焊接空洞率作出严格要求。出现以下任意一种情况,即判定粘片空洞率不合格:
接触区空洞面积超过整个接触面积的二分之一。
单个空洞横跨半导体芯片的整个长度或宽度范围,且超过整个预定接触面积的10% 。
导热胶粘片
粘接原理:芯片粘片工艺,核心在于利用胶粘剂在芯片与管壳、基板等承载物之间搭建起互连层。通过升温,促使胶粘剂内部发生复杂的化学变化,历经液相阶段,逐步凝胶化,最终转变为固相。借助这一过程,不但能达成稳固的机械连接,让芯片与载体紧密结合,还能赋予连接层优良的电学和热学性能。在当前环保要求愈发严格的背景下,导热胶和AuSn焊料凭借自身优势,成为替代传统SnPb合金料的首选材料。在集成电路封装行业,环氧树脂凭借出色的综合性能,成为应用最为普遍的胶粘剂。环氧树脂本质上是高分子聚合物,分子式为(C₁₁H₁₂O₃)ₙ,指分子内含有两个或更多环氧基团的一类聚合物。它由环氧氯丙烷与双酚A或者多元醇,经过缩聚反应制备而成。由于环氧基具有较高的化学活性,能够与多种含活泼氢的化合物发生开环反应,通过固化交联,构建起网状结构,因此环氧树脂归属于热固性树脂。其中,双酚A型环氧树脂产量最大、种类最丰富,并且随着技术的不断进步,新的改性产品不断问世,产品质量也在持续提升。未经填料改性的环氧树脂,导热性能差,且不具备导电特性。向环氧树脂中添加Al₂O₃、AlN等陶瓷填料后,能够显著提高其热导率。按照导电性能的差异,胶粘剂可分为导电胶和绝缘胶。在环氧树脂中掺入银粉,制成的导电胶可实现导电连接功能。对于背面设置有电极的芯片,导电胶可实现芯片背面电极与基板盘之间的电气连通。在实际生产中,导电胶还常用于电阻、电感、电容等阻容元件的粘接。绝缘胶则主要用于芯片背面无需导通的场景。大多数芯片粘片时,会选用不导电胶。这类胶粘剂除了能满足导热需求外,还可以提升绝缘性能。在这里,将用于集成电路芯片粘片的胶粘剂,统一称作导热胶。胺类化合物是环氧树脂常用的固化剂,一般以粉末形式均匀分散在环氧树脂体系中。在常温条件下,固化剂与环氧基团之间的反应非常缓慢。当温度升高到一定程度,固化剂吸收足够的能量开始溶解,并与环氧树脂分子上的环氧基团发生化学反应,使得分子链之间不断交联。在反应过程中,环氧基团转化为醇盐结构。当温度进一步升高,醇盐基团会与其他环氧基团继续反应,在相邻聚合物链之间形成新的醚键,逐步构建起高度交联的三维网状结构。随着分子链的不断增长,胶粘剂的黏度逐渐增大,从最初的线性聚合物交联成为网状结构,最终固化为热固性聚合物 。
导电胶的固化
按照固化方式的差异,导电胶可划分为热固化和光固化两大类型。其中,热固化依据固化温度的不同,又可细分为室温固化、中温固化(150℃左右)和高温固化(150 - 300℃)。
室温固化耗时较长,通常需要数小时甚至数天,在工业生产中应用较少。高温固化速度较快,但在电子工业领域,过高的温度可能对器件性能造成影响,因此一般尽量避免使用。中温固化一般只需数分钟到一小时,在实际生产中应用最为广泛。光固化导电胶的固化,主要依赖紫外线照射引发树脂基体发生固化反应。这种固化方式速度快,且树脂基体在避光条件下可长期保存,目前已成为研究的热点方向。
玻璃化转变温度Tg
玻璃态与橡胶态
环氧树脂导热胶隶属有机聚合物范畴,玻璃化转变温度,即非晶态高聚物(包含晶态聚合物的非晶区域)在玻璃态和橡胶态之间相互转变的特定温度。以玻璃化转变温度Tg作为分界线,聚合物在不同温度环境下,会呈现出玻璃态和橡胶态两种特性迥异的状态。玻璃态本质上是一种无定形的固体形态。在此状态下,原子在结构上既不存在长程有序排列,也不具备平移对称性。可以将其理解为一种保留了液体结构特征的固体。而橡胶态指的是,聚合物内链段能够自由运动,但整个分子链不会产生相对位移的状态。处于橡胶态时,只需施加较小的外力,聚合物就能产生较大的形变,并且当外力移除后,形变能够迅速恢复。在部分学术研究资料中,也将玻璃态和橡胶态表述为玻璃态和高弹态。大多数高分子聚合物常态下处于玻璃态。玻璃化转变温度,是聚合物大分子链摆脱束缚、实现自由运动所需达到的最低温度。值得注意的是,该温度并非一个精确的固定值,而是分布在一定的温度区间内。当聚合物所处温度高于Tg时,材料展现出显著的高弹性;当温度低于Tg时,材料则表现出脆性。因此,Tg对于工业生产和材料性能调控而言,是一个至关重要的参数。
Tg与材料性质
玻璃化转变温度并非某一个确切的温度点,而是一个温度范围。尽管学界针对玻璃化转变现象提出了众多理论,但到目前为止,还没有任何一种理论能够对这一复杂现象做出全面、完善的解释。目前,测定Tg的方法主要分为四类,分别通过监测材料的体积变化、热力学性质变化、力学性质变化以及电磁效应来实现。当聚合物发生玻璃化转变时,其多项物理性质会发生剧烈变化。以比体积、比热容、膨胀系数、导热系数为例,这些参数在玻璃化转变过程中都会出现不连续的变化。以H35导电胶为例,当温度低于其玻璃化转变温度时,热膨胀系数为31×10⁻⁶in/(in·℃);而当温度高于玻璃化转变温度后,热膨胀系数大幅上升至97×10⁻⁶in/(in·℃)。从分子结构的角度分析,Tg转变实质上是高聚物无定形部分从冻结状态向解冻状态过渡的一种松弛现象。与传统的相转变不同,玻璃化转变过程中并不伴随相变热的产生。当温度低于Tg时,高聚物处于玻璃态,此时分子链和链段都被“冻结”,无法自由移动,仅有构成分子的原子(或原子团)在其平衡位置附近做微小振动。当温度达到Tg时,虽然分子链整体仍无法移动,但链段开始获得足够的能量,能够进行相对运动,材料因而呈现出高弹性质。当温度进一步升高,整个分子链都开始运动,材料逐渐转变为具有粘性流动特性的熔融体或液体。玻璃化转变温度是表征聚合物特性的重要参数之一。一般来说,聚合物的玻璃化转变温度越低,其分子链的柔性就越大;反之,玻璃化转变温度越高,分子链的刚性就越强。此外,在玻璃化转变温度附近,聚合物胶粘剂的导电性等关键性能,也可能发生显著变化 。
-
芯片
+关注
关注
463文章
54680浏览量
471199 -
集成电路
+关注
关注
5469文章
12758浏览量
376305 -
封装
+关注
关注
128文章
9395浏览量
149231 -
工艺
+关注
关注
4文章
728浏览量
30431
原文标题:粘片工艺概述
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录

运算放大器选型指南中文版
压电致动器与粘滑原理仿真
机器视觉光学系统的介绍和选型指南详细概述

胶水粘接工艺及UL94-V0密封粘接胶水

精通芯片粘接工艺:提升半导体封装可靠性




 粘片工艺介绍及选型指南
粘片工艺介绍及选型指南




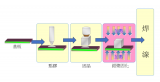



评论