半导体碳化硅(SiC)功率器件作为一种宽禁带器件,以其耐高压、高温、导通电阻低、开关速度快等优异特性,在电力电子领域展现出了巨大的应用潜力。然而,要充分发挥SiC器件的这些优势性能,封装技术起着至关重要的作用。传统的封装技术难以匹配SiC器件的快速开关特性和高温工作环境,因此,SiC功率器件的封装面临着诸多挑战。本文将详细解析SiC功率器件封装中的三个关键技术:低杂散电感封装技术、高温封装技术以及多功能集成封装技术。
一、低杂散电感封装技术
SiC器件的开关速度极快,开关过程中的dv/dt和di/dt均极高。虽然这显著降低了器件的开关损耗,但传统封装中较大的杂散电感参数却带来了新的问题。在极高的di/dt下,较大的杂散电感会产生更大的电压过冲以及振荡,进而引起器件电压应力、损耗的增加以及电磁干扰问题。因此,降低封装中的杂散电感参数是SiC器件封装技术的重要研究方向。
1.1 传统封装结构的局限性
传统的SiC器件封装方式大多沿用了硅器件的封装技术,如通过焊锡将芯片背部焊接在基板上,再通过金属键合线引出正面电极,最后进行塑封或者灌胶。这种封装方式技术成熟、成本低廉,且可兼容和替代原有Si基器件。然而,其较大的杂散电感参数却成为了制约SiC器件性能发挥的瓶颈。
传统封装中杂散电感的大小与开关换流回路的面积相关。其中,金属键合连接方式、元件引脚和多个芯片的平面布局是造成传统封装换流回路面积较大的关键影响因素。金属键合线不仅增加了换流回路的面积,还引入了额外的寄生电感。此外,多个芯片的平面布局也限制了电流回路的优化空间,使得杂散电感参数难以进一步降低。
1.2 低杂散电感封装技术的创新
针对传统封装结构的局限性,国内外学者们研究开发了一系列新的封装结构,用于减小杂散参数,特别是降低杂散电感。以下是一些典型的低杂散电感封装技术:
- 单管翻转贴片封装:阿肯色大学团队借鉴了BGA(球栅阵列)的封装技术,提出了一种单管的翻转贴片封装技术。该技术通过一个金属连接件将芯片背部电极翻转到和正面电极相同平面位置,然后在相应电极位置上植上焊锡球,从而消除了金属键合线和引脚端子。这种封装方式显著减小了电流回路面积,进而降低了杂散电感参数。与传统的TO-247封装相比,单管翻转贴片封装的体积减小了14倍,导通电阻减小了24%。
- DBC+PCB混合封装:传统模块封装使用的敷铜陶瓷板(Direct Bonded Copper,DBC)限定了芯片只能在二维平面上布局,导致电流回路面积大、杂散电感参数大。CPES、华中科技大学等团队将DBC工艺和PCB(印刷电路板)板相结合,利用金属键合线将芯片上表面的电极连接到PCB板上,从而控制换流回路在PCB层间流动。这种混合封装方式大大减小了电流回路面积,进而降低了杂散电感参数。实验结果表明,该混合封装可将杂散电感控制在5nH以下,体积相比于传统模块下降40%。
- 柔性PCB板结合烧结银工艺的封装:Semikron公司利用SKiN封装技术制作了1200V/400A的SiC模块。该技术采用柔性PCB板取代键合线实现芯片的上下表面电气连接,从而显著减小了电流回路面积和杂散电感参数。模块内部回路寄生电感仅有1.5nH,开关速度大于50kV/μs,损耗相比于传统模块可降低50%。
- 芯片正面平面互连封装:除了采用柔性PCB板取代金属键合线外,还可使用平面互连的连接方式来实现芯片正面的连接。例如,SiliconPower公司采用端子直连(Direct Lead Bonding,DLB)的焊接方法实现芯片之间的互连。类似的技术还有IR的Cu-Clip IGBT、Siemens的SiPLIT技术等。平面互连的方式不仅可以减小电流回路面积,进而减小杂散电感、电阻,还拥有更出色的温度循环特性以及可靠性。
- 双面散热封装技术:双面散热封装工艺由于可以双面散热、体积小,较多用于电动汽车内部IGBT的封装应用。该技术通过在上下表面均采用DBC板进行焊接,实现上下表面同时散热。得益于上下DBC的对称布线与合理的芯片布局,双面散热封装可将回路寄生电感参数降到3nH以下,模块热阻相比于传统封装下降38%。
二、高温封装技术
SiC器件的工作温度可达到300℃以上,而现有适用于硅器件的传统封装材料及结构一般工作在150℃以下。在更高温度时,传统封装材料的可靠性急剧下降,甚至无法正常运行。因此,高温封装技术成为了SiC器件封装技术中的另一个重要研究方向。
2.1 高温封装材料的选择
为了实现SiC器件的高温封装,必须选择具有高热导率、低热膨胀系数和良好机械性能的材料。例如,氮化铝(AlN)陶瓷基板就是一种理想的封装材料。AlN陶瓷基板具有高热导率(可达320W/mK)、低热膨胀系数(与SiC芯片的热膨胀系数相近)和良好的机械性能,能够满足SiC器件高温封装的要求。
此外,氮化硅(Si3N4)陶瓷基板也逐渐受到关注。Si3N4陶瓷基板具有更低的热膨胀系数和更高的可靠性,虽然其热导率略低于AlN陶瓷基板,但在某些高温应用场景下仍具有显著优势。
2.2 高温封装工艺的创新
除了选择合适的封装材料外,高温封装工艺的创新也是提高SiC器件封装可靠性的关键。以下是一些典型的高温封装工艺:
- 活性金属钎焊(AMB)技术:AMB技术是一种利用活性金属(如Ti、Zr等)与陶瓷基板表面形成化学键合的高温封装技术。该技术具有高强度、高可靠性和良好的热导率等优点,能够满足SiC器件高温封装的要求。
- 纳米银烧结技术:纳米银烧结技术是一种利用纳米银颗粒在高温下熔化并形成致密烧结层的高温封装技术。该技术具有低温烧结高温使用、良好的高温工作特性等优点,且烧结层的热导率可以达到150-300W/(K·m),模块温度循环的可靠性提高5倍以上。此外,纳米银烧结技术还可以实现零空洞连接,进一步提高封装的可靠性。
- 铜夹片、铜条带、铜箔母排等平面互连技术:为了解决引线键合的寄生电感、热应力等一系列问题,部分企业已经引入了铜夹片、铜条带、铜箔母排等平面互连技术。这些技术通过消除焊线,使得SiC芯片通过焊接或烧结直接互连到铜导体上,实现了两条平行的冷却路径。热量可以从芯片的上下两侧消散和传递,从而提高了封装的散热性能。
三、多功能集成封装技术
随着电子系统的集成度和复杂度的不断提高,对功率器件封装的多功能集成要求也越来越高。SiC功率器件封装不仅需要实现功率和信号的高效、高可靠连接,还需要集成保护、监测、控制等多种功能。因此,多功能集成封装技术成为了SiC器件封装技术中的另一个重要研究方向。
3.1 多功能集成封装技术的优势
多功能集成封装技术具有以下几个显著优势:
- 提高系统集成度:通过将保护、监测、控制等多种功能集成到功率器件封装中,可以大大提高系统的集成度,减少外部元件的数量和连接线的长度,从而降低系统的成本和复杂度。
- 提高系统可靠性:集成封装技术可以实现功率器件与其他元件之间的紧密连接和协同工作,从而提高系统的整体可靠性。例如,将温度传感器集成到功率器件封装中,可以实时监测器件的工作温度,防止过热损坏。
- 提高系统性能:集成封装技术可以优化功率器件与其他元件之间的信号传输和能量转换路径,从而提高系统的整体性能。例如,将栅极驱动器电路集成到功率器件封装中,可以缩短栅极信号的传输路径,提高器件的开关速度。
3.2 多功能集成封装技术的实现方式
多功能集成封装技术可以通过以下几种方式实现:
- 三维封装技术:三维封装技术通过将多个芯片或元件垂直堆叠在一起,实现高度集成化的封装。例如,将SiC功率器件与栅极驱动器电路、温度传感器等元件垂直堆叠在一起,形成一个紧凑的三维封装模块。这种封装方式可以大大提高系统的集成度和性能。
- 嵌入式芯片技术:嵌入式芯片技术通过将芯片直接嵌入到PCB板或陶瓷基板中,实现芯片与基板之间的紧密连接和协同工作。例如,利用PCOC(片上电源)技术将SiC MOSFET芯片嵌入PCB内部,实现较低的电感路径和共模电容。这种封装方式可以减小电流回路面积和杂散电感参数,提高器件的开关速度和可靠性。
- 智能封装技术:智能封装技术通过在封装中集成传感器、微控制器等智能元件,实现功率器件的实时监测、控制和保护。例如,在SiC功率器件封装中集成温度传感器和微控制器,可以实时监测器件的工作温度并根据温度变化调整工作参数或触发保护机制。这种封装方式可以提高系统的智能化水平和可靠性。
四、总结与展望
SiC功率器件的封装技术是实现其优异性能的关键。低杂散电感封装技术、高温封装技术以及多功能集成封装技术是当前SiC功率器件封装技术的三大研究热点。这些技术通过优化封装结构、材料和工艺,
-
半导体封装
+关注
关注
4文章
331浏览量
15280 -
芯片封装
+关注
关注
14文章
627浏览量
32443 -
sic器件
+关注
关注
1文章
64浏览量
16058 -
器件封装
+关注
关注
0文章
12浏览量
5600
发布评论请先 登录
SiC功率器件SiC-MOSFET的特点
SiC功率器件概述
SiC-MOSFET器件结构和特征
归纳碳化硅功率器件封装的关键技术
SiC MOSFET的器件演变与技术优势
映众GTX1660Ti黑金至尊版上手 足以满足用户畅玩主流单机游戏的需求
碳化硅功率器件:革命性的封装技术揭秘
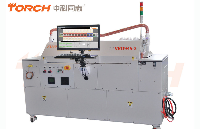
车规级功率模块封装的现状,SiC MOSFET对器件封装的技术需求
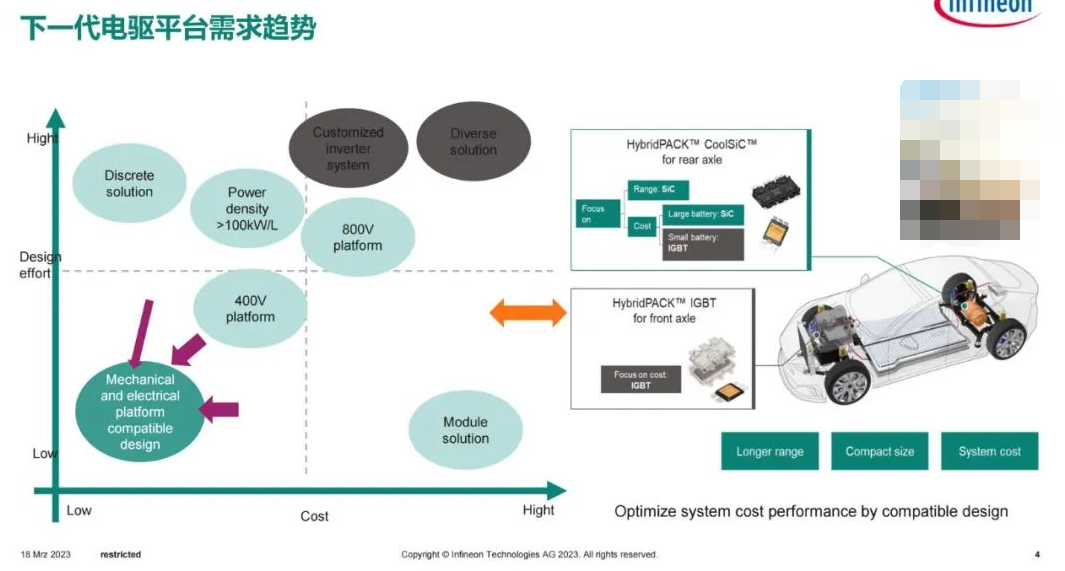



 SiC器件封装技术大揭秘:三大“绝技”让你惊叹不已!
SiC器件封装技术大揭秘:三大“绝技”让你惊叹不已!






评论