制作氧化局限面射型雷射与蚀刻空气柱状结构一样都需要先将磊晶片进行蚀刻,以便暴露出侧向蚀刻表面(etched sidewall)提供增益波导或折射率波导效果,同时靠近活性层的高铝含量砷化铝镓层也才能与高温水蒸气进行氧化反应。制作砷化镓以及其他材料光电元件时定义元件形貌或个别元件之间的电性隔绝的蚀刻制程称为mesa etching’mesa在西班牙语中指桌子,或者像桌子一样的平顶高原,四周有河水侵蚀或因地质活动陷落造成的陡峭悬崖,通常出现在早期移民以西班牙裔为主的美国西南地区例如大峡谷等知名景点,下图5-10即为美国犹他州峡谷地国家公园的mesa景观。

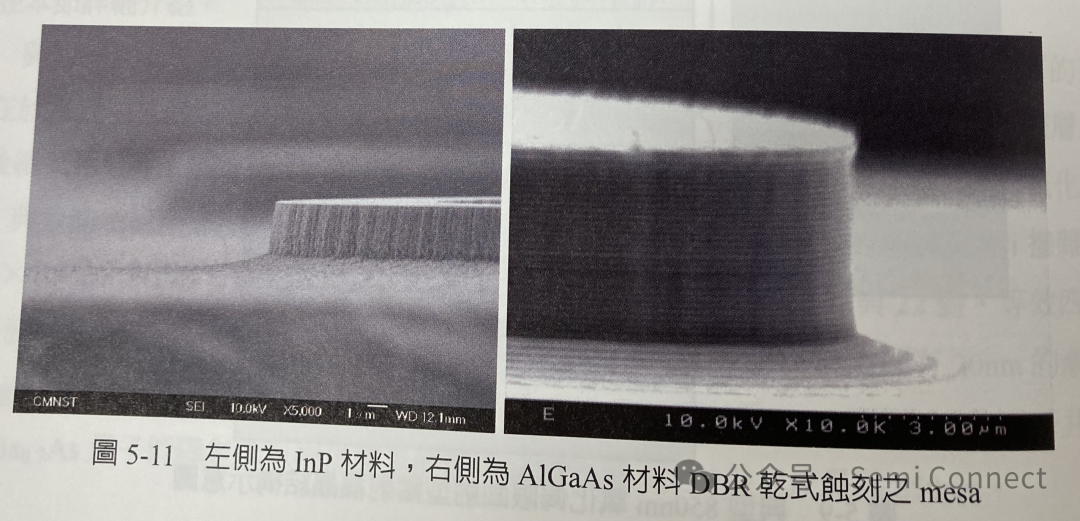
进行mesa etching通常有两种选择,早期选用酸性溶液进行化学湿式蚀刻(chemicalwet etching),通常用来蚀刻砷化镓相关材料的蚀刻液为硫酸或磷酸混合双氧水及水稀释后的溶液,磊晶层表面会有光阻定义不易被酸性溶液侵蚀的SiO2作为蚀刻保护层,在浸泡蚀刻溶液特定时间后,未受保护的区域就会被溶液蚀刻掉,留下未受蚀刻的区域供后续制作元件所需。采用化学湿式蚀刻通常会遭遇到一个严重的问题,由于化学反应速率与构成磊晶层的材料在不同晶格方向有显著差异,因此经常在与磊晶面平行方向造成非等向性蚀刻(anisotropic etching),让原本设计为圆形或者方形的图案在蚀刻后变成接近圆角方形。同时在垂直磊晶面方向因为等向性蚀刻而造成底切(undercut)现象,让蚀刻侧壁呈现大幅度的倾斜,且剩余未被蚀刻的尺寸小于原先设计,这两个现象都会造成蚀刻结果与光罩设计的元件图案不一致的结果,造成后续制程例如金属化对准的问题。

由于湿式蚀刻之蚀刻选择比与垂直方向非等向性较差,因此通常无法达到蚀刻侧壁垂直的制程需求,如图5-13所示,从蚀刻后所拍摄的扫瞄式电子显微镜(SEM)照片可以观察到,蚀刻后的mesa边缘呈现平缓的坡度,而非原本所期望的垂直蚀刻侧面,这个结果对于后续氧化制程后要观察氧化深度造成相当大的困扰,同时要蒸镀金属上电极也可能造成短路现象,甚至在后续光阻曝光显影步骤就会出现问题,因此有必要改采蚀刻选择性与非等向性较优异的干式蚀刻法。

后来面射型雷射蚀刻制程较常采用的技术转变为干式蚀刻,通常采用活性离子蚀刻(Reactive Ion Etching, RIE)[20]或感应耦合电浆活性离子蚀刻(Inductively Coupled Plasma-Reactive Ion Etching, ICP-RIE)。典型的RIE蚀刻设备示意图如下图5-14所示。

RIE蚀刻设备腔体中一般压力约为数毫托耳(mTorr)至数百毫托耳,借由射频电源提供能量将蚀刻反应气体游离呈电浆状态,这些电浆具有高度化学活性可以和被蚀刻的牛导体、金属或介电质材料产生化学反应并形成气态生成物最后被真空帮浦移除,一般放置样品的载台会另外施加偏压形成电场引导电浆态反应物朝向被蚀刻样品加速,因此这些电奖粒子通常也会具有动能并因而撞击被蚀刻物表面,形成非等向性物理性蚀刻,与化学性蚀刻相辅相成,一般均能获得比传统化学溶液湿式蚀刻更加垂直的蚀刻侧面,同时底切现象也可以显著改善。利用感应耦合线圈可以进一步提高电浆密度,而且通常ICP-RIE反应腔体压力较传统RIE更低,因此粒子的平均自由径(mean free path)较长,有利于带电粒子(通常是电子)被加速到较高能量撞击气体分子产生电浆的机率,因此采用ICP-RIE进行蚀刻通常可以获得更快的蚀刻速率和蚀刻选择比,典型的ICP-RIE蚀刻设备示意图如下图5-15所示。

由于进行蚀刻后通常会接着进行高温选择性氧化制程,元件表面需要有保护层以免表面氧化造成后续金属电极制作问题,因此通常会在蚀刻制程进行前镀上SiO2或SiNx作为蚀刻阻挡层同时也可以在氧化制程中保护元件表面。一般会利用电浆辅助化学气相沉积(plasma enhanced chemical vapor deposition, PECVD)成长较致密的SiNx以做为蚀刻与后续湿式氧化的表面保护层,典型的镀膜参数包含温度控制在300°C,反应腔体压力500mTorr,微波功率20W,氮气流量600 scem(standard cubic centimeter per minute,温度273K一大气压下每分钟流量1立方公分),氨气流量15 sccm,矽甲烷SiN4(5%)/ N2流量挫制在400 scom。所需的SiNx厚度取决于RIE或ICP-RIE设备与使用之蚀刻反应气体对于做为蚀刻光罩的SiNx与砷化镓/砷化铝镓DBR之间的蚀刻选择比,蚀刻选择比愈高表示SiNx不需要太厚就可以承受下方砷化镓/砷化铝镓DBR被蚀刻到活性层深度的时间:相反的,蚀刻选择比愈低,则SiNx的厚度就必须愈厚,才能够应付长时间的蚀刻而不至于尚未达到所需蚀刻深度时上方的蚀刻阻挡层已经消耗殆尽。因此要蚀刻顶部发光(top emission)氧化局限面射型雷射结构时,以850nm发光波长为例,通常需要蚀刻超过4微米深度才能到达活性层,如果所使用的RIE设备对于SiNx和AIGaAS/GaAs材料蚀刻选择比为1:4,那么用来作为蚀刻阻挡层的SiNx厚度至少要1微米,考量到还需剩下足够厚度的SiNx作为选择性氧化制程的表面保护层,实际需要镀上的SiNx至少应该要1.3微米。若要制作长波长1.3微米的面射型雷射,由于每一层的DBR厚度随着发光波长等比例增加,因此蚀刻深度至少6微米,要直接一次蚀刻6微米到活性层,则需大约2微米厚度的SiNx做为蚀刻阻挡层。这时候具有较高蚀刻速率与蚀刻选择比的ICP-RIE必要性就突显出来了。
成长完成SiNx蚀刻保护层后,就进行标准黄光制程以定义蚀刻图案,在光阻硬烤后利用活性离子蚀刻设备先蚀刻SiNx,将光罩图案转移到SiNx蚀刻保护层上。典型的SiNx蚀刻条件为氩气(Ar)流量5sccm,SF620sccm,氦气(He)流量5sccm,压力50 mTorr,微波功率75W,自偏压(self-bias)106.7伏特;蚀刻0.8微米SiNx约需时6分30秒,蚀刻2微米SiNx约需时16分钟,蚀刻速率控制在每分钟0.125微米/分左右,同时利用蚀刻终点监测(end-point detector)监测蚀刻深度,以确保后续欲蚀刻之砷化镓材料表面己确实暴露出来。
待SiNx保护层完成蚀刻后,以丙酮加热去除残余光阻,随即以活性离子蚀刻设备进行砷化镓/砷化铝镓分布布拉格反射器之蚀刻制程。典型的AIGaAs/GaAs蚀刻参数为氢气流量80sccm,氯气(Cl2)流量2 sccm,氦气流量15 sccm,压力10 mTorr,微波功率100W,自偏压120 Volt,蚀刻1.3微米氧化局限面射型雷射时,为确保紧邻活性层的高铝含量氧化层确实暴露出来,蚀刻深度至少需达到6微米,蚀刻时间约为11分钟;若要制作850nm氧化局限面射型雷射时,蚀刻深度约为4微米,因此蚀刻时间约仅需7分30秒。
利用传统活性离子蚀刻所形成之蚀刻结果如下图5-16所示:
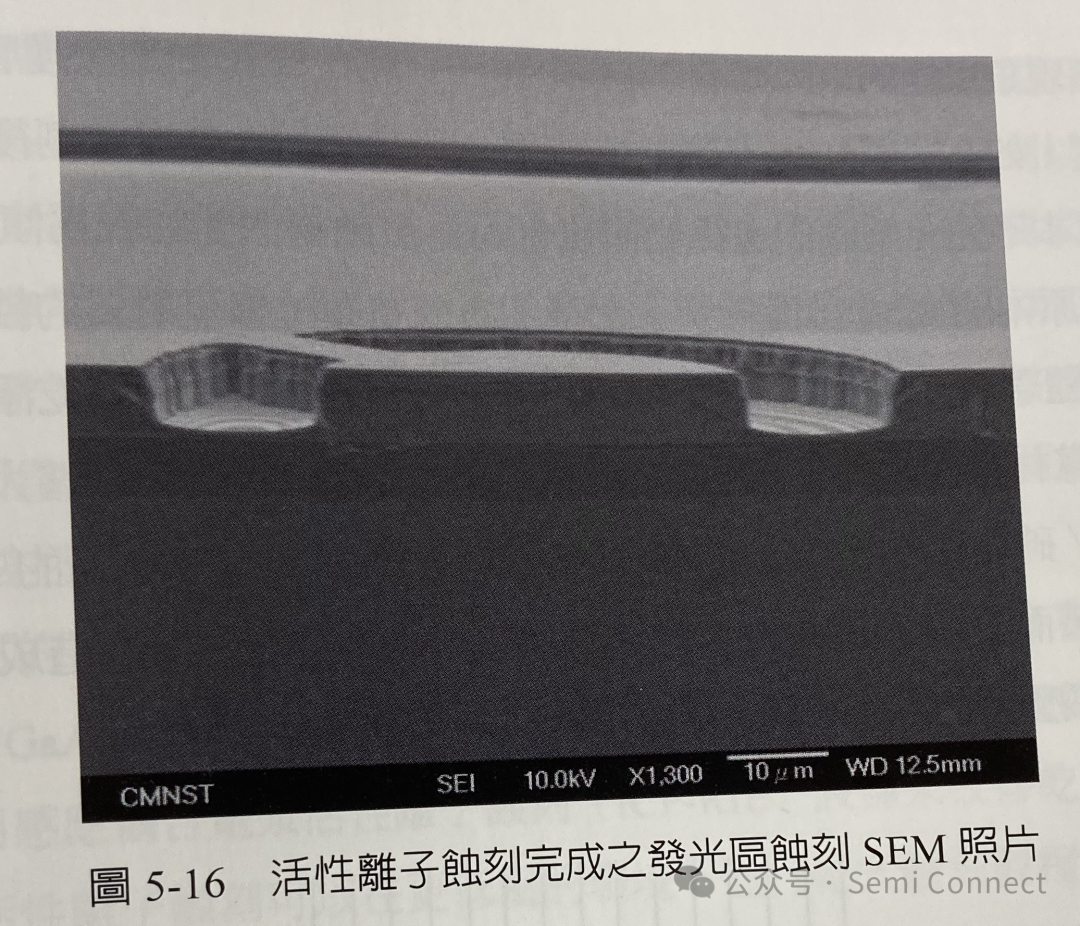
在蚀刻完整结构的氧化局限面射型雷射时,由于蚀刻深度相对较深,所需的蚀刻时间也因此延长,早期实验发现SiNx蚀刻保护层在蚀刻时侧壁(sidewall)若不垂直,则容易造成砷化镓/砷化铝镓分布布拉格反射器之蚀刻侧壁形成两段式转折,可能会对后续选择性氧化制程及元件寿命造成不良影响,两段式的蚀刻侧面如下图5-17所示:

研判造成该现象可能的原因如图5-18所示,一开始SiNx蚀刻保护层侧面稍微呈现不垂直的倾斜角度,如下图5-18(a)所示,在经过一段时间活性离子蚀刻后,SiNx厚度也会逐渐变薄,而原本不完全垂直的边缘侧面也会因为被蚀刻而变的较为倾斜,如图5-18(b)所示。虚线表示原本的SiNx剖面形状,此时下方分布布拉格反射器的蚀刻侧面还能维持垂直状态:但是随着SiNx边缘愈来愈薄,渐渐的图案周围也被蚀刻干净无法再对下方的砷化镓/砷化铝镓材料提供保护,因此被蚀刻区域的面积就随之稍微扩大,而活性离子在向下蚀刻砷化镓/砷化铝镓材料时也同时继续蚀刻SiNx保护层,渐渐的DBR就形成了两段式的蚀刻侧面,而上方一段由于主要是因为SiNx图案边缘减薄所造成,因此也会较为倾斜,不像下方那么垂直,这一点也可以由图5-17中观察到。
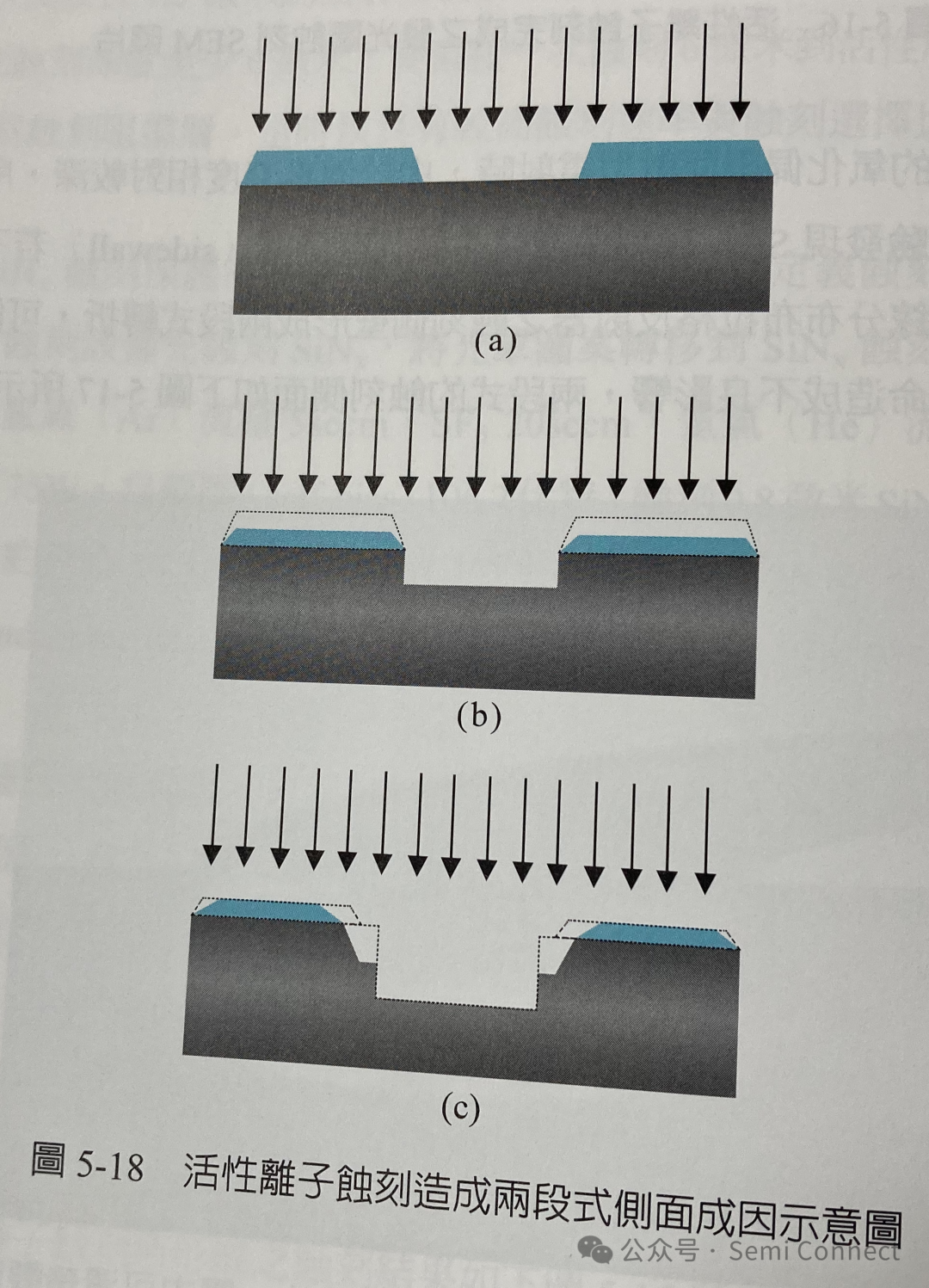
为避免形成两段式蚀刻侧面,可行的解决方法有两种,其一为干式活性离子蚀刻之后再辅以磷酸一双氧水或硫酸一双氧水之蚀刻溶液稍微浸泡进行湿式蚀刻以去除不平整的蚀刻侧面,第二个方法为严格控制SiNx蚀刻保护层的蚀刻双程,务必要求一开始蚀刻保护层的蚀刻侧面就非常垂直平整,如此即可避免因边绿减薄效应而造成两段式蚀刻侧壁的不良结果,也因此虽然氢氟酸或其稀释溶液Buffered oxide etch(BOE)普遍被用来蚀刻SiO2或SiNx,但是因为湿式蚀刻溶液造成等向性蚀刻的undercut会造成图案边缘不垂直,所以不适合用在面射型雷射蚀刻保护层上。
若是所使用的RIE蚀刻设备受限于可选用的蚀刻气体及制程参数无法进一步改善SiNx对AIGaAs/GaAs材料的蚀刻选择比及蚀刻速率,另一个选择为改采SiO2作为蚀刻保护层,同时改用感应耦合电浆活性离子蚀刻(ICP-RIE)设备来改善干式蚀刻制程。利用感应耦合电浆活性离子蚀刻可以在更低压的环境下进行干式蚀刻制程,粒子的平均自由径(mean free path)较长,有利于带电粒子(通常是电子)被加速到较高能量撞击气体分子产生电浆的机率,因而获得较快的蚀刻速率,并且可以维持较佳的蚀刻选择比。如此一来作为蚀刻保护层的介电质材料(SiO2)就无需成长较厚的厚度,通常采用ICP-RIE进行面射型雷射蚀刻制程仅需0.4微米厚度的SiO2即足够抵挡ICP-RIE进行面射型雷射分布布拉格反射器蚀刻至5微米以上深度,同时蚀刻时间也大幅缩短为两分钟以内。此外为了确保SiO2的蚀刻侧壁维持垂直平整,避免上述因边缘减薄效应而造成两段式蚀刻侧壁的不良结果,原本利用BOE化学湿式蚀刻的制程最好也改用ICP-RIE进行干式蚀刻。RIE触刻SiO2条件为压力100mTorr,RF功率为100W,蚀刻气体为CF4及O2,流量分别为40 sccm与5 sccm。加入氧气有助于清除反应残余物,避免沉积在蚀刻表面造成不平坦的蚀刻结果。蚀刻完成后去除光阻之SiO2保护层经由SEM观察结果如下图5-19所示。
在完成良好的SiO2蚀刻保护层制程后,就可以继续进行下方分布布拉格反射器之蚀刻。传统采用活性离子蚀刻设备若缺少BCl3蚀刻气体,懂采用氯气Cl2的话对于DBR的主要成分材料砷化镓/砷化铝镓与蚀刻保护层SiNx的蚀刻选择比较差。若采用ICP-RIE搭配蚀刻效果较佳之BCl3或SiCl4作为主要化学性蚀刻气体,将可获得较佳之蚀刻选择比。典型的ICP-RIE蚀刻GaAS/AIGaAs制程参数为压力3mTorr,氮气(N2)流量5sccm,氢气(Ar)流量10sccm,BCl3流量25sccm。在一开始尝试ICP-RIE制程条件时,分别将感应耦合电浆功率(ICP power)固定在700W,调整射频(RF)功率分别为60W、90W、120W和150W,并利用原子力显微镜3D-AFM观察蚀刻表面平坦度,发现在射频功率为150W时具有最平整的蚀刻结果,如下图5-21所示:
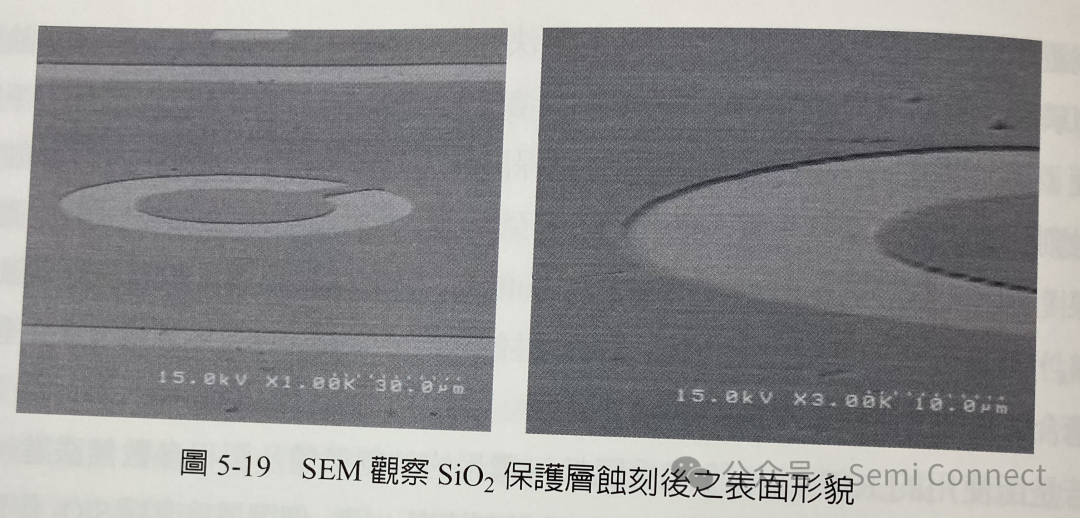
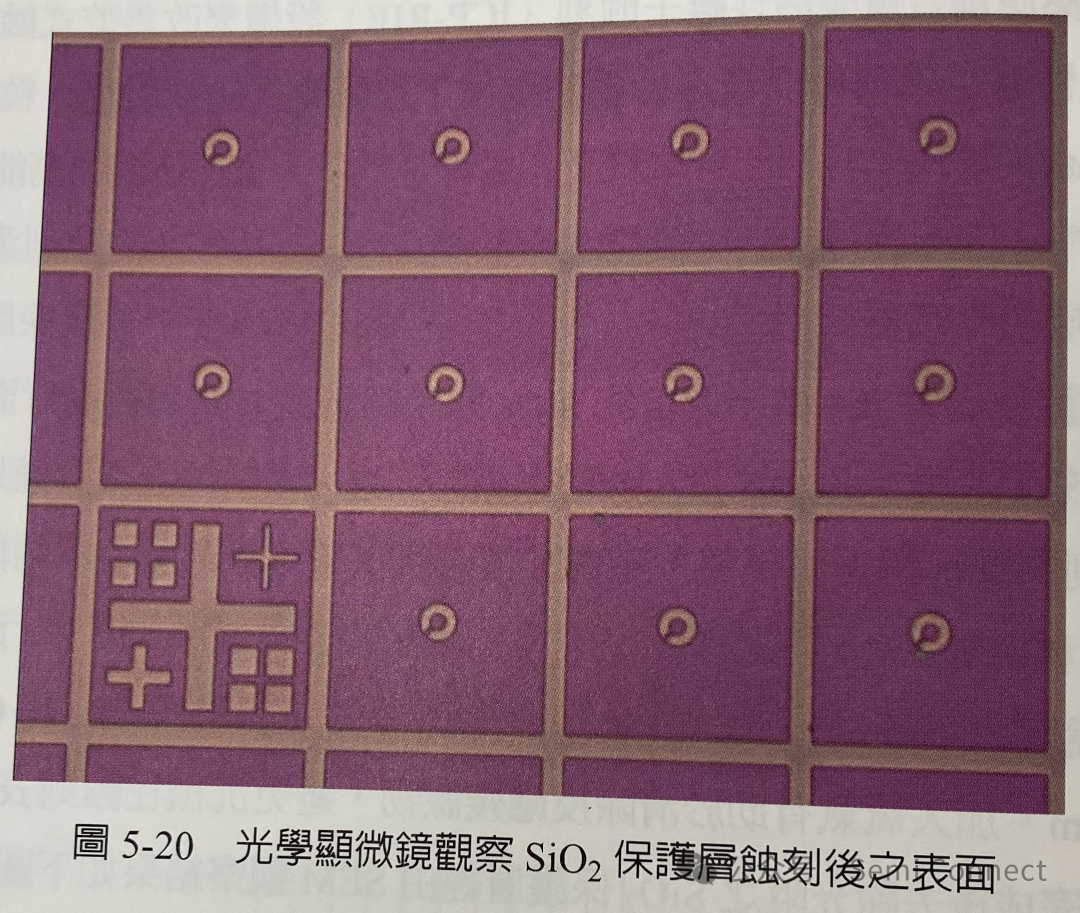
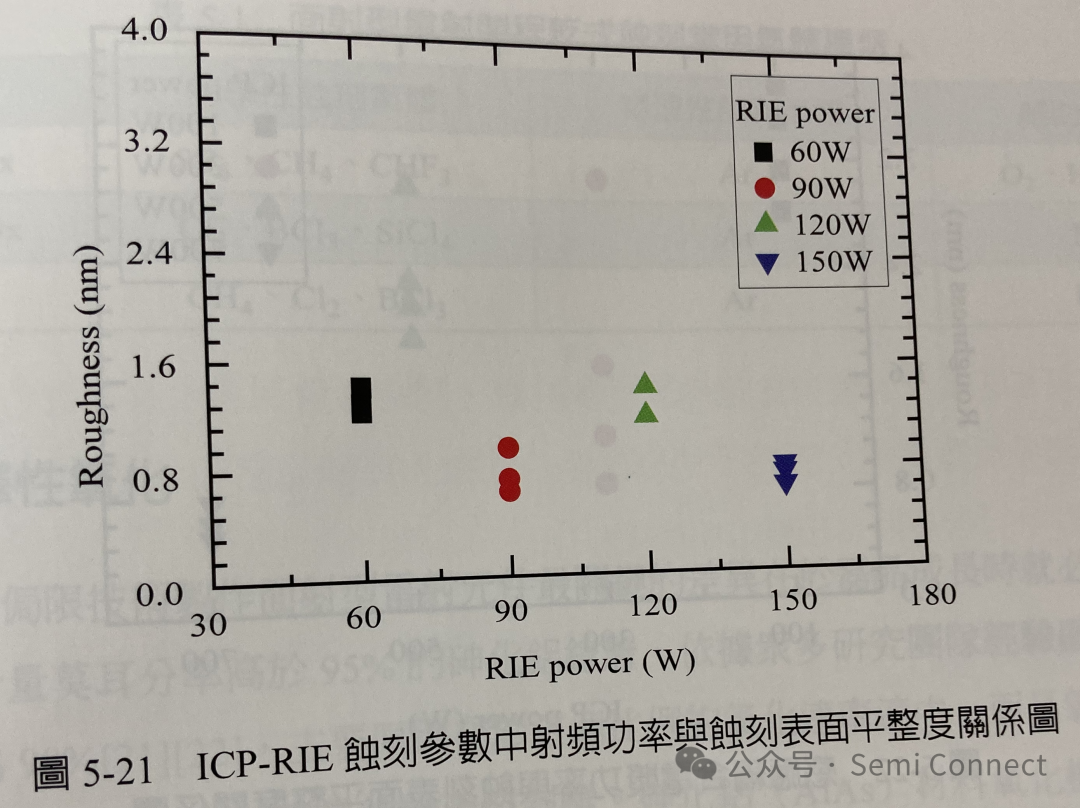
随后将RF功率固定为150W,改变感应耦合电浆功率从100W到700W之间进行调整,并将蚀刻后样品经由原子力显微镜观察蚀刻表面平整度,由结果可以发现,感应耦合电浆功率在700w时,蚀刻样品具有最平坦之表面,如下图5-22所示。新式ICP-RIE在压力1帕(Pa)下可以获得较干整蚀刻表面,搭配不同的气体流量参数包括氯气(Cl2)2 sccm,氩气(Ar)10sccm,以及四氯化矽(SiCl4)4sccm,基板承载盘温度控制在110°C,ICP功率设定为200W,RIE功率为10w,同样可以获得优异的DBR蚀刻结果。上述的蚀刻制程中所探用的ICP-RIE感应耦合电浆功率及射频功率之条件,配合腔体压力及反应气体、流量等参数,均视所采用的制程设备与样品尺寸而异,若要进行量产蚀刻制程时需考虑负载效应(loading effect)补偿因为待蚀刻物面积增加导致相同反应气体流量不足以达到小尺寸样品测试时相同的蚀刻速率与深度。
采用SiO2作为蚀刻保护层,并利用感应耦合电浆活性离子蚀刻法,搭配具高选择比SiCl4或BCl3蚀刻气体及制程参数,蚀刻后之面射型雷射元件SEM照片如图5-23所示,获得平整垂直的蚀刻侧壁有利后续选择性氧化结果的观察。

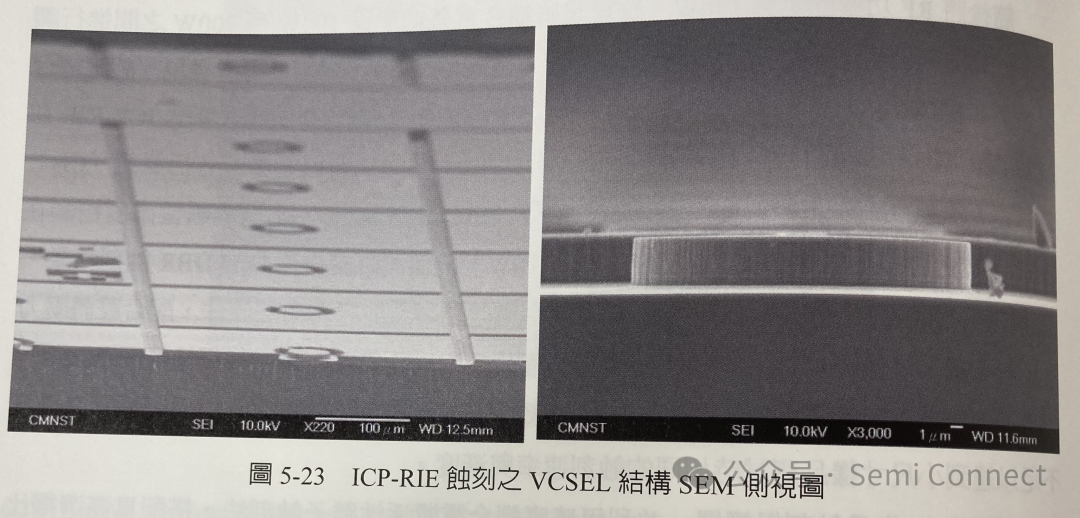
下表5-1列出面射型雷射制程中常见材料干式蚀刻常用的气体,但是实际应用时并不仅限于这些气体,通常蚀刻矽相关材料会使用含氟的气体,蚀刻含铝材料会使用氯气及其化合物,其他常使用的惰性气体如氩气Ar大多借助其物理性蚀刻能力,而氮气、氧气、氢气、氦气多作为蚀刻辅助气体,有的可以提供蚀刻侧壁保护,有的可以帮助蚀刻反应生成物尽快被移除(例如氧气),而氦气通常被用来冷却承载盘面的蚀刻样品。

-
雷射
+关注
关注
0文章
25浏览量
10390 -
SiO2
+关注
关注
0文章
24浏览量
8822
原文标题:蚀刻
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
RK 平台 Vendor Storage 开发指南:基础知识、流程与实用技巧

最易读懂的理工科基础丛书——图解电机基础知识入门
DC-DC基础知识 + 硬件电路

功率器件热设计基础知识
射频前端设计中的功率等级基础知识






 蚀刻基础知识
蚀刻基础知识
















评论