刻蚀是半导体制造中最常用的工艺之一, 上海伯东日本 Atonarp Aston 质谱仪适用于等离子体刻蚀过程及终点监测 (干法刻蚀终点检测), 通过持续监控腔室工艺化学气体, 确保半导体晶圆生产的高产量和最大吞吐量.
Aston 质谱仪干法刻蚀终点检测整体解决方案
连续蚀刻工艺金属, 如铝 Al, 钨 W, 铜 Cu, 钛 Ti 和氮化钛 TiN 会形成非挥发性金属卤化物副产物, 例如六氯化钨 WCl6 重新沉积在蚀刻的侧壁上, 因颗粒污染或沉积材料导致电气短路, 从而导致产量降低.
上海伯东 Aston 质谱仪提供包括腔室和过程, 例如指纹识别, 腔室清洁, 过程监控, 包括有腐蚀性气体存在时, 颗粒沉积和气体污染物凝结.
Aston 质谱分析仪与腔室连接
 Aston 质谱分析仪
Aston 质谱分析仪
Aston 质谱分析仪等离子刻蚀腔体监测
 Aston 质谱分析仪
Aston 质谱分析仪
Aston 质谱分析仪CVD清洗终点优化
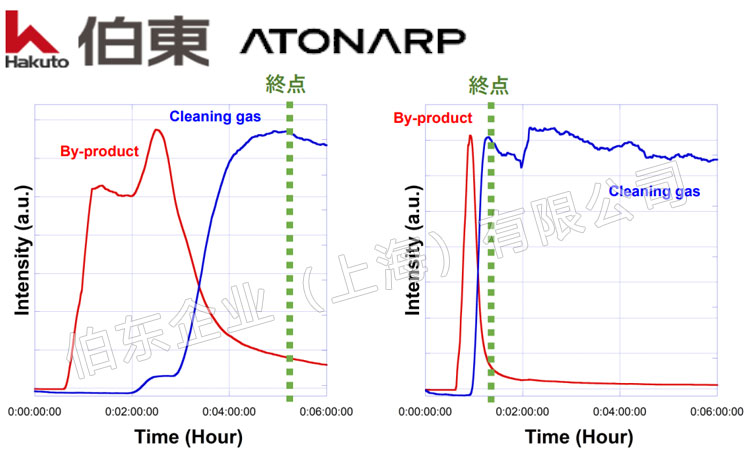 ASton 质谱分析仪
ASton 质谱分析仪
Aston 质谱分析仪小开口区域刻蚀
 Aston 质谱分析仪
Aston 质谱分析仪
Aston 质谱仪干法刻蚀终点检测优势
高性能, 嵌入式和可靠的原位计量分子气体计量
完整的腔室解决方案, 在不同工艺步骤中对前体, 反应物和副产物进行时时监测
批量生产过程的控制
高灵敏度, Aston™ 质谱仪的 OA% 灵敏度显示为 <0.25%, 其检测限比 OES (LOD 约 2.5%)高出一个数量级.
Aston 质谱仪技术参数
质量分辨率 | 0.8 u |
质量稳定性 | 0.1 u |
灵敏度(FC / SEM) | 5x10-6 / 5x10-4 A/Torr |
检测极限 | 10 ppb |
最大工作压力 | 1X10-3 torr |
每单位停留时间 | 40 ms |
每单位扫描更新率 | 37 ms |
发射电流 | 0.4 mA |
发射电流精度 | 0.05% |
启动时间 | 5 mins |
离子电流稳定性 | < ±1% |
浓度的准确性 | < 1% |
浓度稳定性 | ±0.5% |
电力消耗 | 350W |
重量 | 13.7 Kg |
尺寸 | 400 x 297 x 341 mm |
为了确保一致和优化的接触蚀刻, 需要高灵敏度的原位分子诊断来提供蚀刻副产物的实时测量和量化, 并能够检测到明确定义的终点. 随着接触开口面积 OA% 的减少, 诸如光学发射光谱 OES 等传统计量解决方案缺乏准确检测蚀刻终点的灵敏度(低信噪比 SNR 比). 上海伯东 Aston™ 质谱仪的 OA% 灵敏度显示为 <0.25%, 其检测限比 OES (LOD 约 2.5%)高出一个数量级. 此外, Aston™ 质谱仪内部产生的基于等离子体的电离源允许它在存在腐蚀性蚀刻气体的情况下工作, 无论处理室中是否存在等离子体源.
若您需要进一步的了解Atonarp Aston™在线质谱仪详细信息或讨论,
请联络上海伯东: 叶女士分机107
现部分品牌诚招合作代理商, 有意向者欢迎联络上海伯东 叶女士
上海伯东版权所有, 翻拷必究!
-
半导体
+关注
关注
336文章
29977浏览量
257987 -
分析仪
+关注
关注
0文章
1727浏览量
54242 -
监测
+关注
关注
2文章
4242浏览量
46772 -
质谱分析
+关注
关注
0文章
11浏览量
5785
发布评论请先 登录
高端芯片制造装备的“中国方案”:等离子体相似定律与尺度网络突破

安泰高压放大器在等离子体发生装置研究中的应用

上海光机所在多等离子体通道中实现可控Betatron辐射
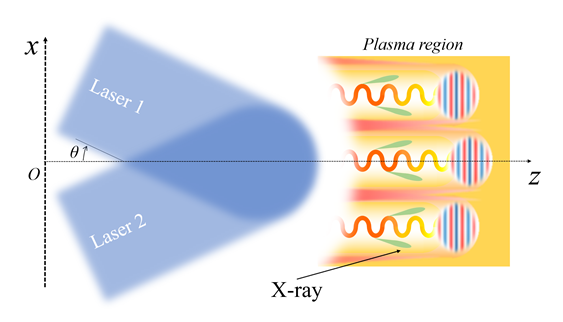
半导体刻蚀工艺技术-icp介绍
通快霍廷格电子携前沿等离子体电源解决方案亮相SEMICON China 2025

等离子体光谱仪(ICP-OES):原理与多领域应用剖析
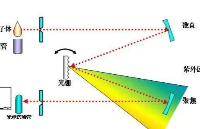
等离子体蚀刻工艺对集成电路可靠性的影响

OptiFDTD应用:纳米盘型谐振腔等离子体波导滤波器
等离子的基本属性_等离子体如何发生
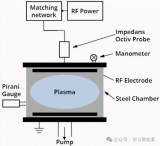





 Aston 质谱仪等离子体刻蚀过程及终点监测
Aston 质谱仪等离子体刻蚀过程及终点监测














评论