在半导体技术的浩瀚星空中,三星电子与SK海力士正携手点亮一颗璀璨的新星——高带宽存储器(HBM)晶圆工艺技术的重大革新。据韩媒最新报道,这两家行业巨头已正式迈入下一代HBM的技术探索之旅,其核心在于引入一种旨在防止晶圆翘曲的新技术,这一变革预示着HBM制造领域的新篇章。
技术革新:激光解键合技术的崛起
在半导体制造的精密工艺中,晶圆解键合是一项至关重要的环节,它关乎到最终产品的质量与性能。传统上,这一过程依赖于机械方式,即使用刀片将主晶圆与载体晶圆分离。然而,随着HBM层数的不断增加,如12层乃至16层的堆叠设计,晶圆变得越来越薄,传统机械解键合方法逐渐显露出其局限性。当晶圆厚度降至30微米以下时,机械剥离不仅效率低下,更存在损坏晶圆的风险,从而增加了后续蚀刻、抛光、布线等工艺步骤的复杂性和成本。
正是在这一背景下,三星电子与SK海力士携手合作伙伴,共同探索激光解键合技术的新路径。激光解键合,顾名思义,是利用激光的高能量密度特性,以非接触的方式精确地将晶圆从载体上分离,从而避免了机械剥离可能带来的损伤。这一技术的引入,不仅解决了超薄晶圆剥离的难题,更为HBM的进一步小型化、高性能化提供了有力支撑。
供应链变革:新材料与新设备的涌现
技术革新往往伴随着供应链的重塑。随着激光解键合技术的逐步应用,相关的材料和设备供应链也将发生深刻变化。传统的机械解键合设备市场,主要由日本东京电子和德国SÜSS MicroTec等少数几家企业主导,而激光解键合技术的兴起,则有望吸引更多新玩家加入,形成更为激烈的竞争格局。
同时,针对激光解键合的特殊需求,晶圆解键合粘合剂也需进行相应升级。美国3M、日本信越化学、日产化学等业界领先企业,正积极研发适应激光解键合工艺的新型粘合材料,以确保晶圆在剥离过程中的稳定性和安全性。
展望未来:HBM4与更广阔的应用前景
作为下一代HBM的标志性产品,HBM4在堆叠DRAM存储器的底部采用了基于系统半导体的“基础芯片”,这一设计对工艺精度和晶圆厚度提出了更高要求。因此,激光解键合技术被视为HBM4制造过程中的理想选择。随着技术的不断成熟和供应链的逐步完善,HBM4有望在AI服务器、高性能计算等领域得到广泛应用,进一步推动相关产业的快速发展。
综上所述,三星电子与SK海力士在HBM晶圆工艺技术上的这一重大革新,不仅展现了企业在技术创新方面的卓越实力,更为整个半导体行业带来了新的发展机遇和挑战。随着激光解键合技术的深入研究和广泛应用,我们有理由相信,未来的HBM将更加小型化、高性能化,为人类社会带来更加丰富的科技体验。
-
半导体
+关注
关注
339文章
31224浏览量
266463 -
SK海力士
+关注
关注
0文章
1011浏览量
41900 -
三星
+关注
关注
1文章
1781浏览量
34442
发布评论请先 登录
SK海力士投资19万亿韩元在韩国建设先进封装厂
KV缓存黑科技!SK海力士“H³存储架构”,HBM和HBF技术加持!
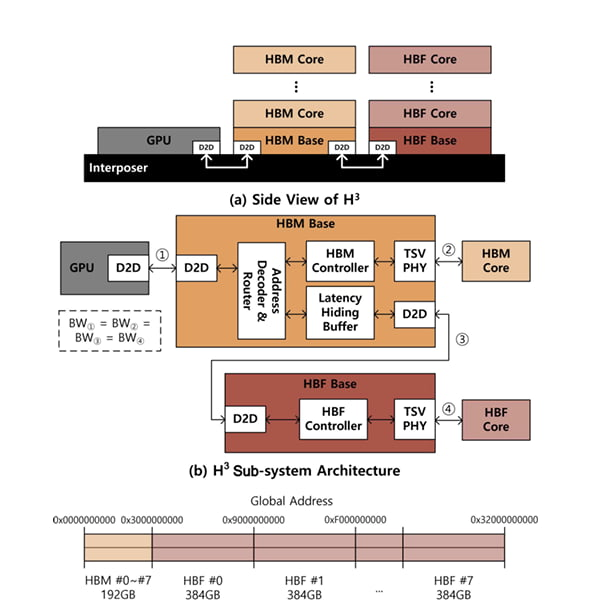
台积电未来10年产能至少翻倍!AI存储需求旺,SK海力士和三星业绩飘红

SK海力士发布未来存储路线图
SK海力士ZUFS 4.1闪存,手机端AI运行时间缩短47%!
美撤销三家在华半导体企业授权 包括英特尔 SK海力士 三星
突破堆叠瓶颈:三星电子拟于16层HBM导入混合键合技术




 三星、SK海力士探索激光解键合技术
三星、SK海力士探索激光解键合技术






评论