underfill是什么工艺?
Underfill是一种底部填充工艺,其名称是由英文“Under”和“Fill”两个词组合而来,原意是“填充不足”或“未充满”,但在电子行业中,它已逐步演变成一个名词,指代一种特定的工艺。
Underfill工艺主要应用于电子产品的封装过程,尤其是在芯片级封装(CSP)和球栅阵列(BGA)等领域。通过利用毛细作用原理,Underfill工艺迅速将底填剂浸透到BGA和CSP底部,然后加热固化,以完全覆盖元件底部区域,将CSP元件整个本体与板面紧密粘接在一起。这样做的主要目的是降低热或机械应力对焊点的影响,从而增强连接的强度和稳定性,提高封装的可靠性和耐久性。
在实际操作中,Underfill工艺的步骤包括烘烤、预热、点胶、固化和检验。其中,点胶是关键的步骤,需要使用高精度的点胶系统来确保填充剂能够准确地填充到芯片与基板之间的空隙中,同时避免溢胶到其他零部件上。
Underfill胶产品介绍:
 Underfill胶产品介绍
Underfill胶产品介绍总之,Underfill工艺在电子制造中扮演着重要的角色,对于保护元器件、增强其粘性、避免因脱落引发故障等方面都具有显著的效果。如需了解更多与Underfill工艺相关的信息,建议查阅电子封装技术领域的专业书籍或咨询汉思新材料。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
电子产品
+关注
关注
6文章
1308浏览量
61207 -
芯片封装
+关注
关注
14文章
623浏览量
32397
发布评论请先 登录
相关推荐
热点推荐
芯片底部填充工艺流程有哪些?
芯片底部填充工艺流程有哪些?底部填充工艺(Underfill)是一种在电子封装过程中广泛使用的技术,主要用于增强倒装芯片(FlipChip)、球栅阵列(BGA)、芯片级封装(CSP)等高级封装技术中

关于Molded underfill
你好目前正在研究Molded underfill的研究生老师叫我把实验结果作压力与面积图试图与波以耳的PV图趋势相似实验数据:60(KPa) 9.847331287(cm2)70(KPa
发表于 11-02 23:05
【先进封装】Underfill的基本特性
底部填充胶在使用过程中,主要的问题是空洞,出现空洞的原因与其封装设计、点胶工艺、固化参数等相关。而要分析空洞就需要对Underfill的特性有个基本的认识。今天就分别就空洞的特征和Underfill的基本特性做一个介绍。
发表于 05-18 10:26
•1631次阅读

9.7.12 底填料Underfill∈《集成电路产业全书》
Underfill撰稿人:中国科学院深圳技术研究院朱朋莉http://www.siat.ac.cn审稿人:中国科学院上海微系统与信息技术研究院罗乐http://www.sim.ac.cn9.7封装

汉思新材料芯片封装胶underfill底部填充胶点胶工艺基本操作流程
汉思新材料芯片封装胶underfill底部填充胶点胶工艺基本操作流程一、烘烤烘烤,主要是为了确保主板的干燥。实施底部填充胶之前,如果主板不干燥,容易在容易在填充后有小气泡产生,在最后的固化环节,气泡

underfill底部填充工艺用胶解决方案
underfill底部填充工艺用胶解决方案由汉思新材料提供随着手机、电脑等便携式电子产品的发展趋向薄型化、小型化、高性能化,IC封装也趋向小型化、高聚集化方向发展。而底部封装点胶工艺可以解决精密

车载多媒体显示屏主板BGA器件点胶underfill底部填充胶应用
显示屏主板BGA器件点胶underfill底部填充胶应用由汉思新材料提供客户产品为:车载多媒体显示屏主板用胶部位:车载多媒体显示屏主板有多个BGA器件需要点胶BGA芯片尺寸:如图所示需要
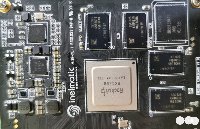
汉思HS700系列underfill胶水芯片底部填充胶
汉思HS700系列underfill胶水芯片底部填充胶是专为手机、数码相机以及手提电脑等数码产品而研发生产的,用于这些数码产品内部芯片的底部填充。那么为什么这些产品需要用到underfill底部填充

芯片封装胶underfill底部填充胶点胶工艺基本操作流程
的脱落。在烘烤工艺中,参数制定的依据PCBA重量的变化,具体可以咨询汉思新材料。二、预热对主板进行预热,可以提高Underfill底部填充胶的流动性。要注意的是——

underfill胶水的作用是什么?
underfill胶水的作用是什么?Underfill胶水,也称为底部填充胶,在电子半导体封装技术工艺中扮演着至关重要的角色。其作用主要体现在以下几个方面:加固与保护加固芯片连接:Underf
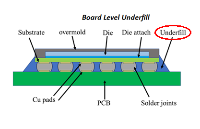
先进封装Underfill工艺中的四种常用的填充胶CUF,NUF,WLUF和MUF介绍
今天我们再详细看看Underfill工艺中所用到的四种填充胶:CUF,NUF,WLUF和MUF。 倒装芯片的底部填充工艺一般分为三种:毛细填充(流动型)、无流动填充和模压填充,如下图所示, 目前看来

在芯片封装保护中,围坝填充胶工艺具体是如何应用的
围坝填充胶(Dam&Fill,也称Dam-and-Fill或围堰填充)工艺是芯片封装中一种常见的底部填充(Underfill)或局部保护技术,主要用于对芯片、焊点或敏感区域提供机械支撑

汉思新材料:人形机器人底部填充胶(Underfill)应用指南
人形机器人底部填充胶(Underfill)应用指南人形机器人结构复杂、运动剧烈,其早期故障中超过60%与焊点失效相关,而底部填充胶(Underfill)应用不当是主要原因之一。通过在关键芯片底部填充




 underfill是什么工艺?
underfill是什么工艺?


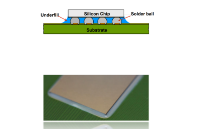



评论