本文介绍了SU-8光刻胶的起源、曝光过程、材料特性和加工方法。
SU-8光刻胶具有良好的光学特性(透明),优异的生物相容性,因此被广泛的应用在MEMS领域,例如光波导、微透镜、光学阵列等光学器件,微流控芯片、微电机阵列、高通量分析生物医学器件,微型机械臂、微型传感器等微机械系统。可能有很多小伙伴都很好奇SU-8到底是什么,它凭什么可以做这么多事情,本文将带你详细了解。
一、起源
SU-8是由IBM公司开发的并拥有该项专利(美国专利号4882245)。原配方组成成分有EPON SU-8树脂(来源于 ShellChemicals)、丁内酯(GBL)溶剂和作为光敏剂的三芳基锍盐(重量比5%-10%)。由于该每个单体有8个活性基环,故起名为SU-8,也正因为其高功能度提高了加工的灵敏度。随后SU-8推出了一些其他溶剂配方,包括甲基异丁基酮(MIBK)和丙二醇醚醋酸酯(PGMEA)等。1996年,MicroChem公司(Newton,NA)为商业化的SU-8提供了生产线NANOTMXPSU-8,即随后出现的SU-8 2000和SU-8 3000生产线。这些新配方解决了原配方中遇到的一些涂覆和粘附的问题。例如,根据MicroChem,SU-8 2000是用环戊酮(CHO)溶剂制定的,提供了良好的涂层和粘附性能。

图 SU-8分子结构 二、曝光过程
在紫外光照射下,三芳基碘盐光敏剂被激活,释放活性碘离子。这些活性碘离子与SU-8光刻胶中的丙烯酸酯单体反应,引发单体之间的交联反应,导致SU-8光刻胶在曝光区域形成凝胶化的图案。
三、材料特性
SU-8是一种负性、抗近紫外线和热固性的聚合物。其高固体含量(重量比72%-85%)使得通过单次旋涂结构厚度即可达几百微米,经多次旋涂甚至可达几毫米。在365nm的近紫外光谱中,吸光度约为46%,可用于制备侧壁基本无倾斜的结构。此外,由于其树脂芳香族的性质及高度交联,SU-8具有出色的热和化学稳定性、高机械强度,可用于平坦化的化学机械抛光。
四、加工方法
1、光刻:制备掩膜版、旋涂光刻胶,采用常规365nm的波长曝光。可通过添加抗反射涂层到衬底上减少不必要的反射,以实现更准确的特征尺寸控制,同样地,SU-8也可以通过结合紫外线光刻技术和立体光刻技术,实现SU-8三维结构的制造。
2、去除:可采用热NMP、硫酸/过氧化氢或专门的去除剂(如NANOTM Remover PG)等去除。
3、释放:通过薄牺牲层(如铝、钛、铜)控制SU-8的释放。
4、键合:SU-8可用作粘合剂,将个别样品、芯片和圆片键合在一起,也可与环氧树脂、PMMA、BCB光刻胶等实现键合。
5、转移:将释放下来的 SU-8微结构进行转印。
6、刻蚀掩膜:具有出色的耐化学性,耐氢氟酸和等离子体刻蚀。
审核编辑:黄飞
-
光刻胶
+关注
关注
10文章
358浏览量
31930
原文标题:什么是SU-8光刻胶?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
Futurrex高端光刻胶
光刻胶残留要怎么解决?
Microchem SU-8光刻胶 2000系列
光刻胶在集成电路制造中的应用
光刻胶黏度如何测量?光刻胶需要稀释吗?
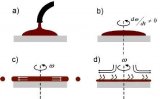
光刻胶的一般特性介绍
如何成功进行微流控SU-8光刻胶的紫外曝光?
如何成功的旋涂微流控SU-8光刻胶?
SU-8光刻胶的光学特性研究:190-1680nm波段的光谱椭偏分析




 SU-8光刻胶起源、曝光、特性
SU-8光刻胶起源、曝光、特性






评论