近日,浙江微钛先进封测研发基地项目开工。
据悉,项目建设地点位于经济开发区辉埠片区,总投资15亿元。项目总用地面积110亩,总建筑面积约10.5万平方米,建设内容主要包括新建厂房及办公楼等,购置数控机床、卧式加工中心、立式加工中心等设备。建设单位为浙江微钛集成电路有限公司,建设工期为2024—2026年,计划2024年3月开工。
项目投用后,可形成年封装/测试3.96亿颗FCCSP10x10芯片、0.198亿FCBGA33x33芯片及1.342亿WBBGA芯片的生产能力,年销售收入38亿元,年可贡献税收约为3.5亿元以上。本文来源:衢州发布
FCCSP封装 是什么?
FC-CSP 是芯片级尺寸封装(CSP)形式中的一种。根据J-STD-012 标准的定义口,CSP 是指封装体尺寸不超过裸芯片 1.2倍的一种封装形式,它通过凸块与基板倒装焊方式实现芯片与基板的电气互连,且芯片面朝下,芯片焊区与基板焊区直接互连。相比于 WB 和TAB 键合方法,FC-CSP 中的半导体芯片与基板的间距更小,信号损失减小,I/O密度高,更适合大规模集成电路 (LSI)、超大规模集成电路(VLSI)和专用集成电路(ASIC)芯片使用。FC-CSP 的基本封装结构如图所示。

作为一种先进的封装技术,FC-CSP 主要具有如下技术特点。
(1)封装尺寸较小:FC-CSP 的封装面积不到 QPP (0.5mm 节距)的1/10,只有BCA 封装的 1/3~1/10;特别是运用铜杜凸块封装,可以进一步滅小凸块间距,从而减小封装面积。
(2)引脚数(I0)更多:在相同尺寸的芯片封装中,相对于传统的打线封装,FC-CSP 可容纳更多的引脚数。
(3) 电性能更优:由于芯片与封装外壳布线之间的互连线更短,寄生参数更小,信号干扰较小,且信号传输延迟时问短,因此具有更小的电阻率,以区更快的信号传输速度。
(4) 实现多种不同功能芯片及器件的一体式封装。以单芯片 (Single Die) FC-CSP 产品为例,FC-CSP 封装工艺流程如图所示。

FC-CSP 的关键技术如下所述、
(1)FC-CSP 对于封装的厚度有较高的要求,因此在圆片减薄时,需要严格控制好最终的厚度(在目标值士151μm 以内)。另外,还要控制好工艺参数避免在切割时发生产品芯片破片及裂纹如图等问题

(2)由于采用回流焊连接芯片凸块及基板的线路,所以需要防止回流过程中的断路,以及过小间距时的短路问题。特别是当芯片与基板的面积比较大时,由于芯片与基板材料的热收缩比有所不同,可能造成高温回流焊时的翘曲不致,从而产生一定的应力,导致凸块与基板连接处发生断裂。
(3)必须严格控制回流焊的降温速率,避免凸块与基板结合处及圆片内低K材料的断裂。通常,降温到 150摄氏度以下时,应控制降温速率在4摄氏度/s以内,如图所示。
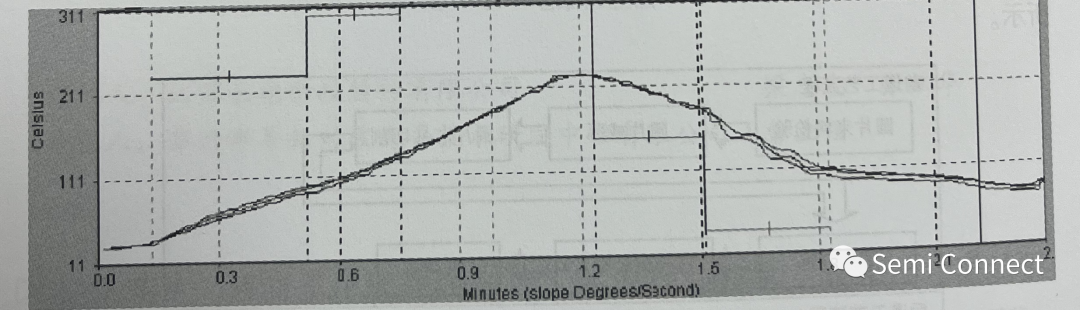
(4)当凸块与基板上的线路较窄时,必须严格控制凸块的锡量及倒装对位的精度,防止凸块与邻近的基板线路相连而造成短路。
(5)倒装贴片后,必须用塑封体并加以固化来保护内部的芯片,同时也起到阻隔外界信号干扰的作用。必须严格控制塑封过程中的固化时间及温度,避免塑封体与芯片分离,以及塑封后产品翘曲问题等的发生。
结合工艺和目前各 IC 制造厂 商的研发情况来看,FC-CSP 的主要结构类型有单芯片 (Single Die) FC-CSP、多芯片平置 ( Muli-Chip Side byside) FC-CSP(见图1)和叠层芯片混联 (Stacked-Die Hybid) FC-CSP(见图2)。叠层封装是指在一个芯腔或基片上将多个芯片堆看起来,芯片与芯片或封装之问实现连接。叠层封装主要应用在手机处理器中,以此来降低功耗、缩小尺寸,提高封装的集成度和性能。

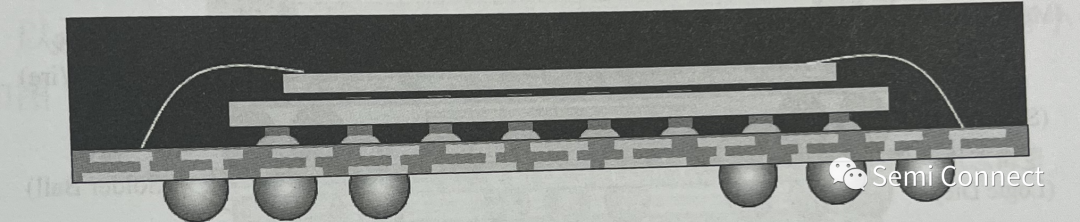
随着 FC-CSP 技术的迅速推广,其应用也越来越广泛,主要应用领域如下
所述
(1)消费类电子产品:手机、便携式摄像机、数码电子产品、DVD、无线产品等。
(2)计算机类:稳压器、高速存储器、智能卡、外设等。
(3)通信类:数宇传呼机、移动电话、CPS 等。
(4)因其具有高引脚数、小型化、微型化、薄型化、多功能等特性,使得FC-CSP 在网络通信、数宇信号处理、混合信号和射频信号、专用集成电路、微控制器等领域有着更广泛的应用。
审核编辑:刘清
-
集成电路
+关注
关注
5464文章
12686浏览量
375742 -
CSP封装
+关注
关注
0文章
24浏览量
11860 -
信号传输
+关注
关注
4文章
501浏览量
21159 -
ASIC芯片
+关注
关注
2文章
96浏览量
24908
原文标题:总投资15亿!年产3.96亿颗!浙江再添先进封测项目
文章出处:【微信号:today_semicon,微信公众号:今日半导体】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
封测巨头全球“圈地”,先进封装正成为AI时代的战略制高点
上扬软件再添InP激光器制造MES新案例

一文看懂 | 中国华北、华东地区SiC功率器件厂商2026年最新动态【上】
中软国际在金融科技出海征程再添关键里程碑
水晶光电在ESG与AI领域再添殊荣
中国电力行业首颗遥感卫星成功发射-维度网
纳芯微NSSine系列实时控制MCU/DSP再添新成员

广电计量与浙江大学先进技术研究院达成战略合作
苹果豪掷1000亿美元,美国封测产业链初成
半导体先进封测年度大会:长电科技解读AI时代封装趋势,江苏拓能半导体科技有限公司技术成果受关注
42.5亿,重庆半导体大动作,8个集成电路领域头部企业集中签约,包含2个传感器项目




 年产3.96亿颗!浙江再添先进封测项目
年产3.96亿颗!浙江再添先进封测项目





评论