ChatGPT等应用作为生活中不可或缺的工具,需要海量数据才能维持正常运转。截至2023年6月,ChatGPT的训练数据集达3,000亿个字词,日访问量达6,000万次,每天有超过1,000万次的查询,而这只是一个开始。人工智能(AI)和高性能计算(HPC)等技术正在蓬勃发展,这些应用需要的带宽和算力只会越来越大。所以如果要打造一个真正的智能世界,需要的系统规模和复杂程度真的很难想象。
随着摩尔定律的放缓,Multi-Die系统架构将为GenAI、自动驾驶、超大规模数据中心等多领域的创新发展提供可能。根据功耗、性能、面积(PPA)要求,更具体地说是功耗、性能、外形尺寸和成本要求,目前的设计尚处于从2D到3D(某些应用中甚至延伸到3.5D)的中间地带。
未来的智能产品必定依赖于Multi-Die系统设计,但如何才能在2024年实现大规模普及呢?以下是我们关于2024年Multi-Die系统设计的四个重要预测。
Multi-Die系统的采用要分多阶段进行
数据密集型应用将是2.5D和3DIC设计等Multi-Die系统封装的主要驱动力。考虑到数据中心的数据量和复杂性,我们预计数据中心在可预见的未来将成为Multi-Die系统“最热情的用户”。移动通讯等其他领域正处于利用Multi-Die系统设计的过渡期,这一阶段内的采用过程往往选择更加灵活,需要视需求选用不同的堆叠技术和工艺节点。
汽车等行业通常要从众多供应商处采购元件,因此可能会采取基于小芯片的方法,继续使用2.5D封装。这种方法能够确保电子控制单元(ECU)部件随时可用,并可以轻松地组装到中介层等基板上。对于汽车中使用的芯片来说,混搭与匹配是十分常见的现象,更高程度的标准化也可能会为这种做法带来裨益。
在复杂性中寻找共性
垂直整合,仍是开发者们在2024年想要采用Multi-Die系统所需要克服的难关之一。HPC数据中心有足够的资金和办法来处理堆叠相关的问题,但其他行业并不一定具备这一条件。如果不做垂直整合,也不依赖生态系统,那么对Multi-Die系统能够平稳运行的需求的数量也会急剧上升,这也是阻碍Multi-Die系统被采用的一大难点。
3D堆叠所面临的主要挑战包括热分析、配电规划、散热系统和制造要求。尽管3D堆叠较为复杂,但它代表着未来的方向,而生态系统也必须不断发展以提供相应的支持。随着堆叠变得日益普遍,已经成为2.5D首选接口的UCIe将在未来一年及以后得到相应发展。复杂性可通过两个关键要素进一步简化:通用的语言和明确的规则。2.5D或3D设计的组件目前都使用统一的通用术语,这样与多个合作伙伴一起构建系统则更加便捷。
具备一套规则及标准的规则描述方法对于Multi-Die系统创新的成功至关重要。正如高速公路上的车辆必须遵守交通标志的指示一样,无论是何种形式的芯片,都将持续受到规则的约束。标准化测试和参考流程等让包含制造在内的堆叠过程更加简单明了。
3DIC设计的突破,自动化是关键
当前芯片架构仍以2.5D为主,Multi-Die系统设计依赖手动,成功与否则取决于开发者技能与技术规格匹配程度。这可能意味着在进行组合之前,需要手动渲染5个、6个甚至20个单独的部件。从这个意义上说,真正的、具有完整架构自动化并经过优化的3D设计还没有变成现实。
向自动化3D实施技术的转变是当前迫切需要迈出的一步,有助于加快设计流程,增加稳健性,并确保高性能元件最终不会只停留在构想阶段。这种转变将会持续到2024年,并将涵盖从架构设计和实施到分析和验证的方方面面。
人工智能可以加速优化设计空间。没有AI,实验范围就会受到限制,工艺中的裸片越多,规划流程和实现最佳配置就会越困难。
Multi-Die系统并非不受限制
尽管Multi-Die系统设计取得了显著进步,但仍存在很多限制。我们预计高带宽内存(HBM)在2024年仍将作为外部存储器。根据对带宽和散热的要求,该器件在布局上可能会进一步靠近芯片,但其片外属性不太可能改变。
单就堆叠而言,其实并不存在上限,但在当前环境下,三到四层通常已是极限(也有少数例外)。这不仅是由于供电方面的限制,还出于制造和可靠性方面的考虑。与摩天大楼一样,高度太高可能会导致结构问题。高堆叠需要更繁琐的制造步骤并面临更多的风险,要想有把握地实现这个目标还需要时间。可以肯定的是,业界正在朝着这个方向努力。而要实现这一目标,就需要全面拥抱端到端自动化。
结语
2024年,我们将进一步探索Multi-Die系统的无尽潜力,引领终端应用迈向新的里程碑。但前方道路并非坦途。跨越Multi-Die系统设计的复杂性,需要我们整个半导体生态系统的共同努力与协作,携手向前,开创万物智能的未来。
审核编辑:刘清
-
存储器
+关注
关注
39文章
7756浏览量
172189 -
人工智能
+关注
关注
1820文章
50324浏览量
266929 -
自动驾驶
+关注
关注
794文章
14988浏览量
181504 -
HBM
+关注
关注
2文章
433浏览量
15882 -
ChatGPT
+关注
关注
31文章
1600浏览量
10393
原文标题:万物智能不打烊!2024 年关于Multi-Die系统的四大猜想
文章出处:【微信号:Synopsys_CN,微信公众号:新思科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
USB RFID读写器的四个常见应用
新思科技携手Socionext实现3DIC芯片成功流片

PCBA生产过程的四个主要环节?
MULTI-BEAM Plus电源连接器有何特点?-赫联电子
软件定义的硬件辅助验证如何助力AI芯片开发

合科泰MOSFET选型的四个核心步骤
新思科技助力UCIe 3.0快速落地
新思科技以AI驱动EDA加速Multi-Die创新
新思科技斩获2025年台积公司开放创新平台年度合作伙伴大奖
新思科技UCIe IP解决方案实现片上网络互连
新思科技网页端虚拟原型工具的工作流程
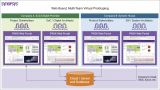
用于 GSM/ GPRS (824-915 MHz) (1710-1910 MHz) 的 Tx-Rx 四频前端模块,带四个线性 TRx 开关端口 skyworksinc

用于 GSM/GPRS (824-915 MHz) (1710-1910 MHz) 的 Tx-Rx 四频前端模块,带四个线性 TRx 开关端口 skyworksinc

用于四频 GSM / GPRS / EDGE 的 Tx-Rx FEM,具有四个线性 TRx 开关端口和双频 TD-SCDMA skyworksinc

PLC产品故障问题测试的四个部分




 关于2024年Multi-Die系统设计的四个重要预测
关于2024年Multi-Die系统设计的四个重要预测




评论