硅通孔技术(TSV,Through Silicon Via)是通过在芯片和芯片之间、晶圆和晶圆之间制作垂直导通,实现芯片之间互连的技术,是2.5D/3D 封装的关键工艺之一。通过垂直互连减小互连长度、信号延迟,降低电容、电感,实现芯片间低功耗、高速通讯,增加带宽和实现小型化。
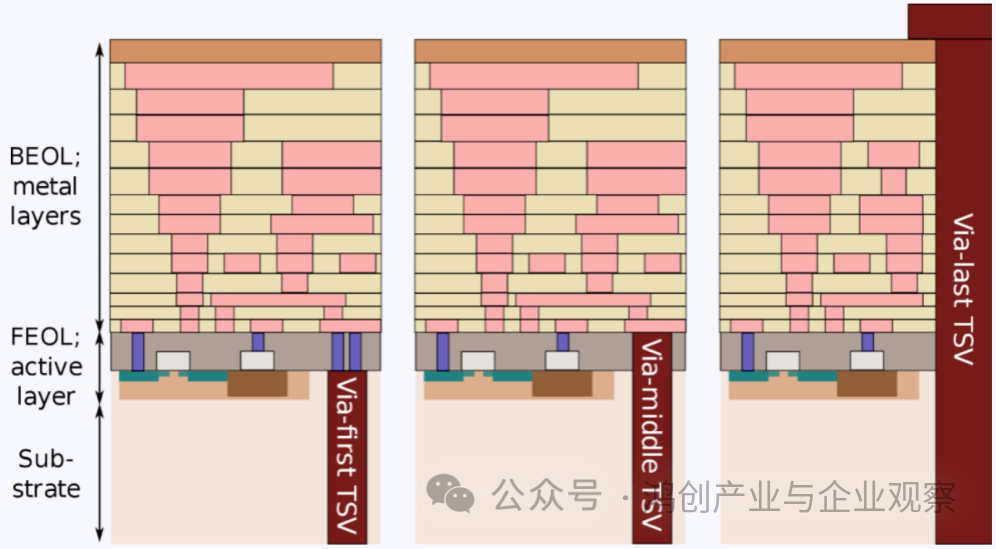
依据TSV 通孔生成的阶段 TSV 工艺可以分为:1)Via-First;2)Via-Middle;3)Via-Last。
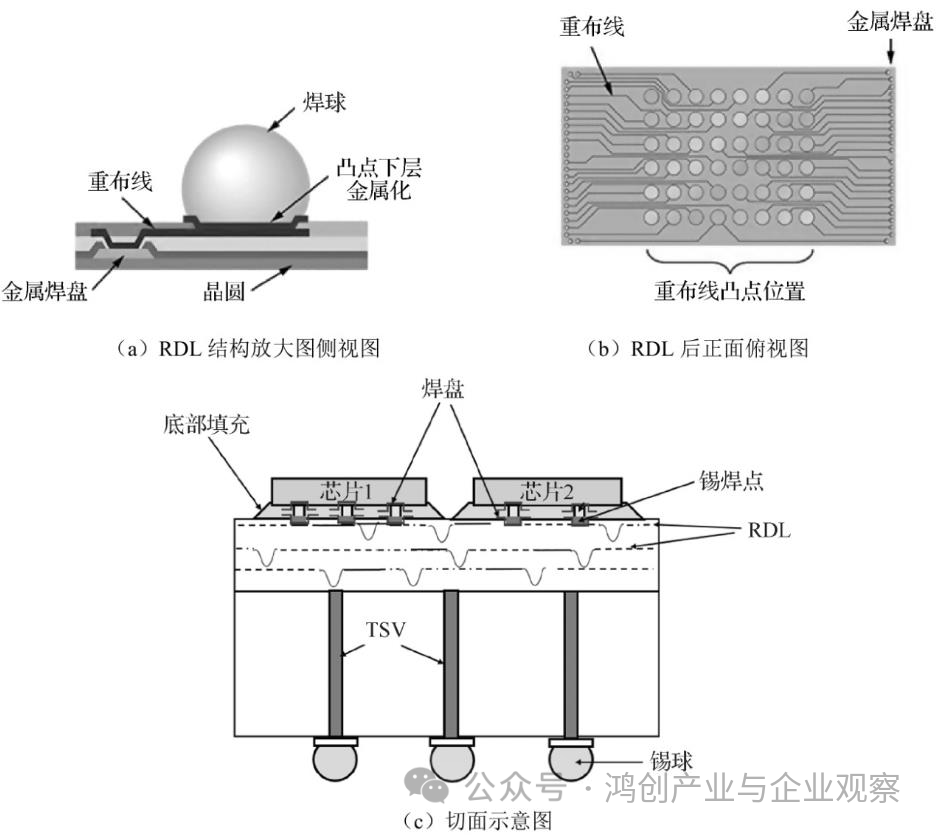
TSV 工艺包括深硅刻蚀形成微孔,再进行绝缘层、阻挡层、种子层的沉积,深孔填充,退火,CMP 减薄,Pad 的制备叠加等工艺技术。
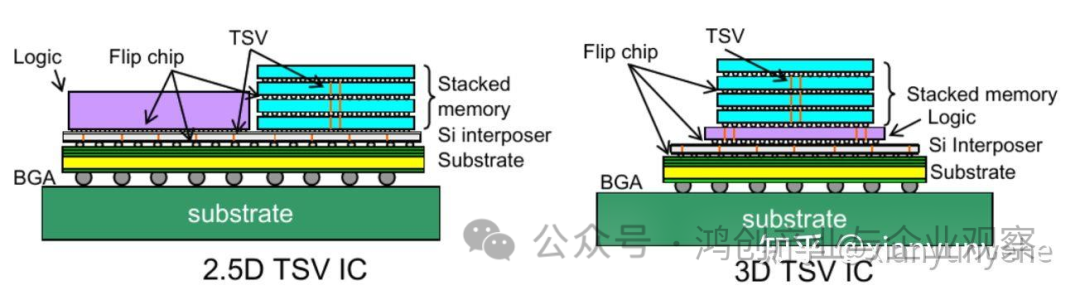
1)孔成型:孔成型的方式有激光打孔、干法刻蚀、湿法刻蚀等。基于深硅刻蚀(Deep Reactive Ion Etching,DRIE)的 Bosch工艺是目前应用最广泛工艺。反应离子刻蚀(Reactive Ion Etching,RIE)工艺是采用物理轰击和化学反应双重作用的刻蚀,Bosch 工艺通过刻蚀和保护交替进行来提高 TSV 的各向异性,保证 TSV 通孔垂直度。
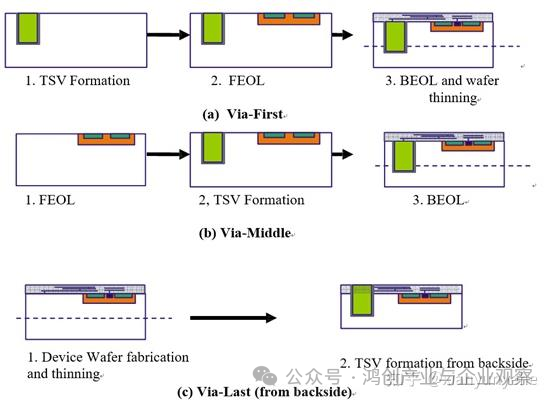
2)沉积绝缘层:TSV 孔内绝缘层用于实现硅村底与孔内传输通道的绝缘,防止 TSV通孔之间漏电和串扰。TSV 孔壁绝缘介质材料选用无机介质材料,包括PECVD、SACVD、ALD 和热氧化法。
3)沉积阻挡层/种子层:在2.5D TSV 中介层工艺中,一般使用铜作为 TSV 通孔内部金属互联材料。在电镀铜填充 TSV 通孔前,需在 TSV 孔内制备电镀阻挡/种子层,一般选用 Ti、Ta、TiN、TaN 等材料。TSV 电镀种子层起着与电镀电极电连接并实现 TSV 孔填充的作用。
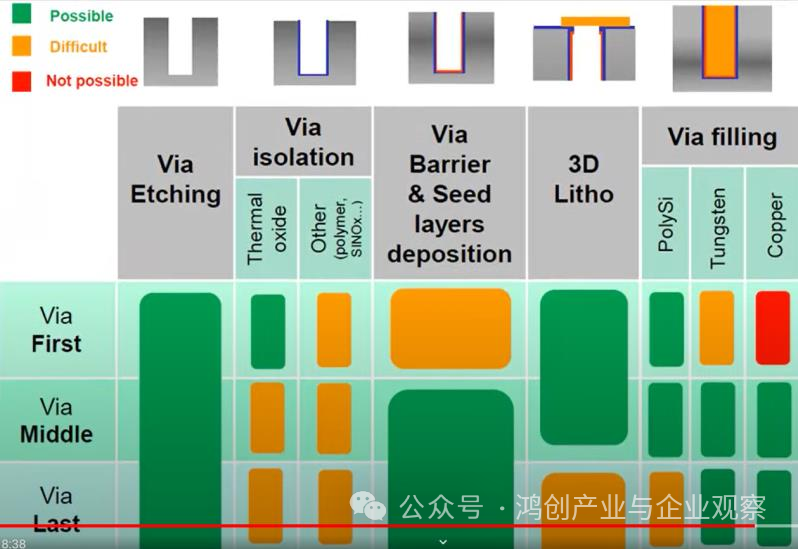
4)电镀填充工艺:TSV 深孔的填充技术是 3D 集成的关键技术,直接关系到后续器件的电学性能和可靠性。可以填充的材料包括铜、钨、多晶硅等。
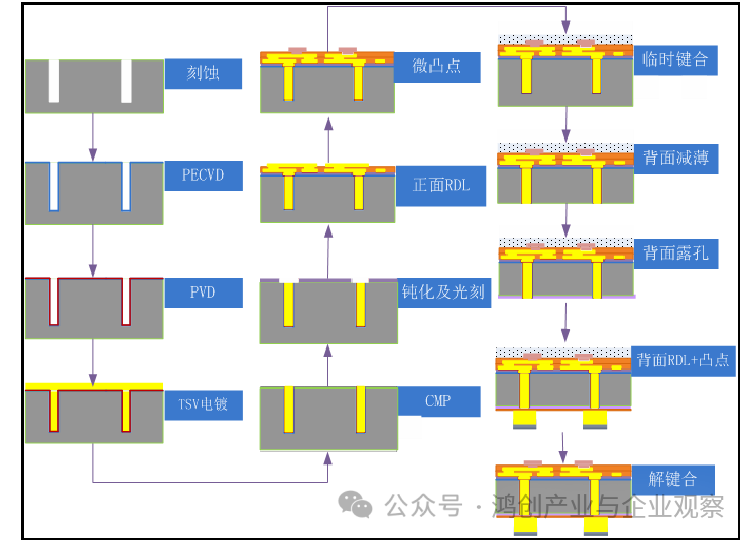
5)CMP(化学机械抛光)工艺和背面露头工艺:CMP 技术用于去除硅表面的二氧化硅介质层、阻挡层和种子层。TSV 背面露头技术也是 2.5DTSV 转接基板的关键工艺,包括晶圆减薄、干/湿法刻蚀工艺。
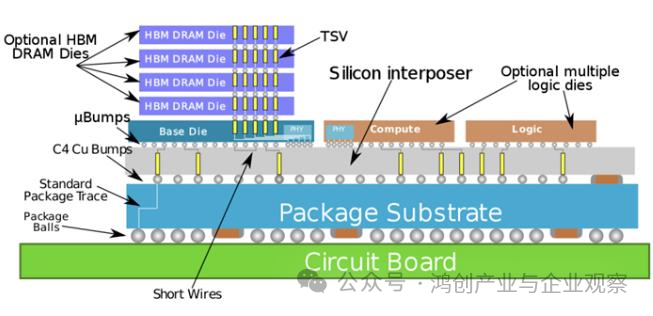
6)晶圆减薄:晶圆表面平坦化后,还需要进行晶圆背面的减薄使 TSV 露出,传统的晶圆减薄技术包括机械磨削、CMP 和湿法腐蚀等。目前业界主流的解决方案是将晶圆的磨削、抛光、保护膜去除和划片膜粘贴等工序集合在一台设备内。
审核编辑:汤梓红
-
芯片
+关注
关注
463文章
54440浏览量
469413 -
晶圆
+关注
关注
53文章
5450浏览量
132762 -
TSV
+关注
关注
4文章
139浏览量
82774 -
硅通孔
+关注
关注
2文章
31浏览量
12150
原文标题:【研究笔记】硅通孔技术(TSV)
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
一文看懂TSV技术
TSV硅通孔填充材料
3D IC集成与硅通孔TSV互连

中微推出用于3D芯片及封装的硅通孔刻蚀设备Primo TSV200E(TM)
基于CAN-WAS的硅通孔TSV测试
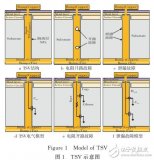



 一文详解硅通孔技术(TSV)
一文详解硅通孔技术(TSV)











评论