Joongang.co.kr 20日表示,sk海力士开始招募将hbm4以3d堆栈方式直接集成到芯片上的逻辑半导体(cpu、gpu)设计师。
据悉,sk海力士正在与包括英伟达在内的多家半导体公司讨论hbm4综合设计方法。
外电认为,如果nvidia和sk hynix共同设计集成芯片,sk hynix的hbm4芯片很有可能通过半导体芯片的晶片结合技术,堆积在logic芯片上。为了实现存储芯片与逻辑芯片的合作,共同设计是不可避免的。
如果sk海力士取得成功,不仅将改变逻辑和存储半导体连接的方式,还将改变制造方式等业界运营方式。
hbm spot目前位于cpu或gpu旁边的中间层,使用1024位接口连接逻辑芯片。sk hynix制定了将hbm4直接堆积在logic芯片上,完全消除中介层的目标。
在某些方面,这种方式类似于amd的3d v-cache堆栈,它将l3 sram缓存封装在cpu芯片上,但hbm提供更多容量和更便宜的性能。
由于hbm4需要2048位接口,所以hbm4中继层非常复杂且昂贵。如果能把内存和逻辑芯片堆在一起,从经济效益上看是可能的,但也提出了散热的问题。
像nvidia h100这样的现代逻辑芯片包含非常大的hbm3内存,在提供巨大的vram带宽的同时还能产生数百瓦的热量。因此,逻辑和内存包的放热需要一个非常复杂的方法,这个方法甚至需要考虑液体冷却和/或浸水的放热。
韩国科学技术院电气电子工学系教授Kim Jung-ho表示:“如果2~3代以后发热问题得到解决,hbm和gpu将在没有中介层的情况下统一运行。”
业界有关负责人预测说:“在今后10年内,半导体游戏的规则可能会发生变化,因此存储器和逻辑半导体的差距可能会微乎其微。”
-
cpu
+关注
关注
68文章
11332浏览量
225939 -
Logic
+关注
关注
1文章
97浏览量
48220 -
逻辑芯片
+关注
关注
1文章
167浏览量
32270
发布评论请先 登录
192GB,SK海力士开始为英伟达Vera Rubin量产SOCAMM2
SK海力士投资19万亿韩元在韩国建设先进封装厂
SK海力士携AI存储器产品亮相NVIDIA GTC 2026

消息称英伟达HBM4订单两家七三分,独缺这一家
SK海力士HBS存储技术,基于垂直导线扇出VFO封装工艺




 英伟达联手SK海力士,尝试将HBM内存3D堆叠到GPU核心上
英伟达联手SK海力士,尝试将HBM内存3D堆叠到GPU核心上


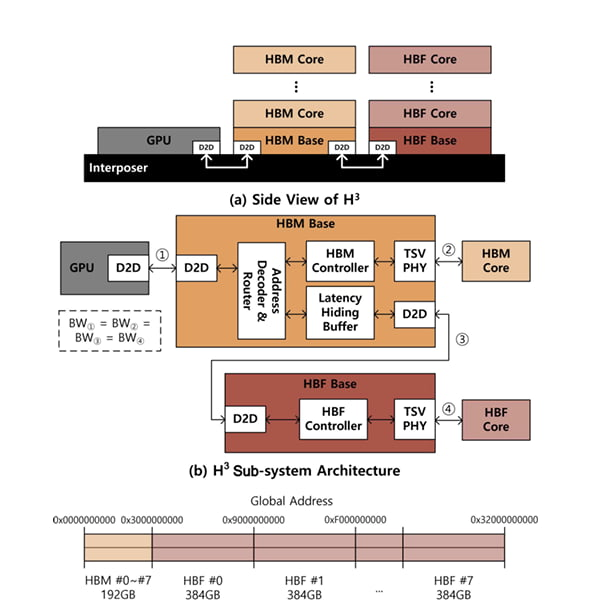



评论