芯片键合,作为切割工艺的后道工序,是将芯片固定到基板(substrate)上的一道工艺。引线键合(wire bonding)则作为芯片键合的下道工序,是确保电信号传输的一个过程。wire bonding是最常见一种键合方式。

Gold Bonding Wire: 半导体键合金线/金丝
用于半导体封装工艺中的芯片键合。
Wire Bond/金线键合:指在对芯片和基板间的胶粘剂处理以使其有更好的粘结性能后,用高纯金线把芯片的接口和基板的接口键合。
成分为金(纯度为99.999%),掺杂银、钯、镁、铁、铜、硅等元素。
掺杂不同的元素可以改变金线的硬度、刚性、延展度、电导率等参数。
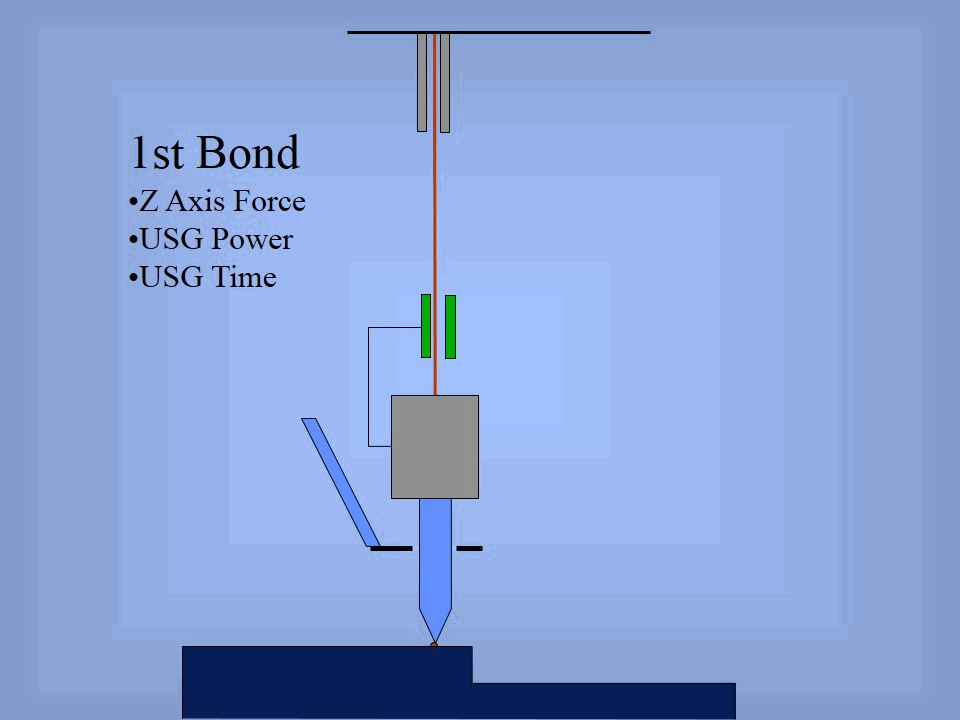
一、 目的:建立基本的 wire bonding 标准,制定生产过程中产品合格/不合格的判断标准。
二、 范围:本标准只适用于金线球焊工艺。
三、 基本焊接条件:热压超声波焊接用于金线键合,所需的温度、压力、超声波功率及时间视不同机型、不同材料有很大不同,具体根据机型、材料特性科学设定。
四、 品质判断标准:
1) 球形标准,如下图所示:
① 球的直径:以2.5φ-3.5φ为标准 ,低于2.5φ为球小,大于3.5φ为球大。
② 球的厚度:以0.5φ-1.5φ为标准,低于0.5φ为球扁,大于1.5φ为球厚。
③ 球畸形:焊线偏离焊球中心超过1/2φ为球畸形。
注:以上φ为金线直径,以下类同。
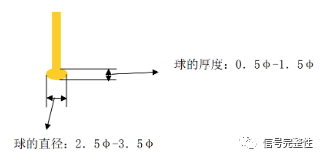
线形标准:
① 线形不良:线摆动以≤3φ、S 形≤2φ为标准,超过此标准为线形不良。线形摆动如下图所示
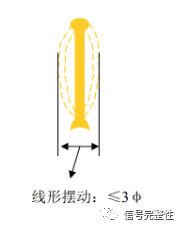
② 线受损:以≤1/4φ为标准,超过1/4φ为线受损不可接受。
③ 弧形标准:晶粒边距金线垂直距离至少1.5φ,少于1.5φ为线低;晶粒面距线形最高不超过 200um,如下图所示。
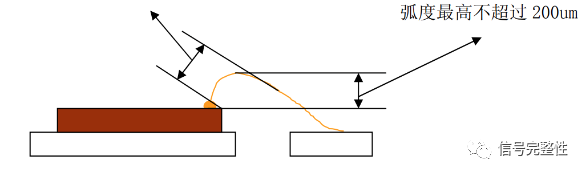
④ 跪线:如下图所示,圆圈处所指的金线贴在焊接表面上为跪线,不可接受。标准线形为圆圈处所指的金线与焊接表面应有一定角度。
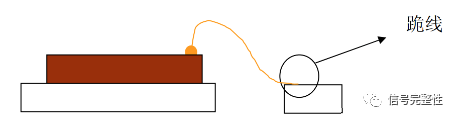
3)焊口标准:
① 焊口:长为0.8φ—1.5φ,宽为1.5φ—2.5φ,且瓷咀印必须完整,超出此规格范围为不可接受,如下图所示:
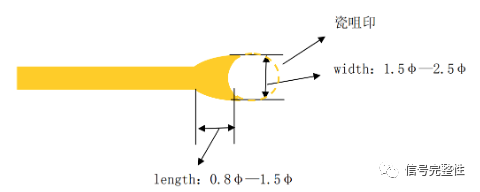
② 线尾:线尾长度必须≤1φ,大于1φ时为线尾长,不可接受。跪线 length:0.8φ—1.5φ width:1.5φ—2.5φ 瓷咀印
③ 虚焊、脱焊:焊球与Die面接触,焊口与Frame 表面接触,拉力测试为0时为虚焊;焊球或焊口中有一个不与焊接表面接触时为脱焊。如下图所示
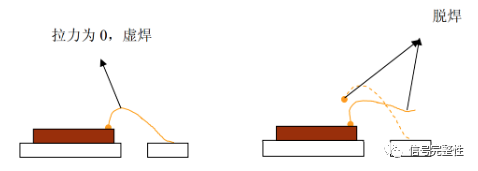
4) 位置标准:
① 走位:球走位:焊球须在IC pad位置内或恰好压在 Pad 边上,超出pad位置为球走位。焊口走位:焊点须在PCB金手指内,焊口离金手指边至少 1φ。超出金手指 为焊口走位。

② 漏线:应焊线的位置没有焊线。
③ 焊错位:金线没有焊在指定 Pad 上而是焊在别的 Pad 上。
5) 拉力及推球标准:
① 拉力测试方法:拉力测试时以靠近焊球金线弧形最高处为基准,如下图所示:
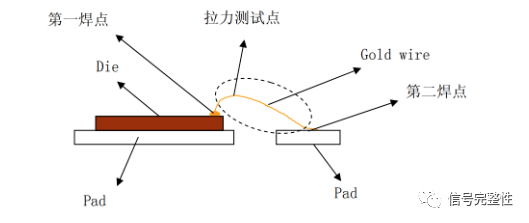
金线拉力管制,如下表:

备注:23、23J 为同一直径的金线,对 SOT-54、SOT-23 产品 Wire bonding 时有两个引线方向,方向不同金线的管制拉力不同,用J来区分,其余类同。
③ 推球不良:推球时使用推球机做推力实验,推球力至少16g以上,金线在pad上残留量≥60%,不满足此规格为推球不良。
审核编辑:汤梓红
-
芯片
+关注
关注
463文章
54437浏览量
469399 -
半导体
+关注
关注
339文章
31245浏览量
266589 -
封装工艺
+关注
关注
3文章
69浏览量
8307 -
引线键合
+关注
关注
2文章
38浏览量
8630
原文标题:芯片金线生产工艺标准
文章出处:【微信号:半导体封装工程师之家,微信公众号:半导体封装工程师之家】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
介绍芯片键合(die bonding)工艺
什么是倒装芯片 倒装芯片技术的优点 倒装芯片封装工艺流程

招聘半导体封装工程师
铝带键合点根部损伤研究:提升半导体封装质量
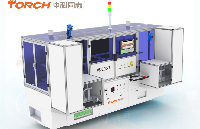



 用于半导体封装工艺中的芯片键合解析
用于半导体封装工艺中的芯片键合解析


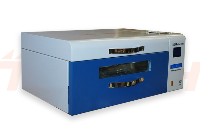






评论