英特尔近期宣布推出一种新型处理器技术,使用玻璃基板替代传统的有机基板,有望彻底改变处理器和芯片的制造方式。相较于有机基板,玻璃基板具备更高的互连密度、更高效的输入/输出、更快速的信号传输、更低的功耗,并且可以实现类似硅的热膨胀,有助于制造更大的封装。
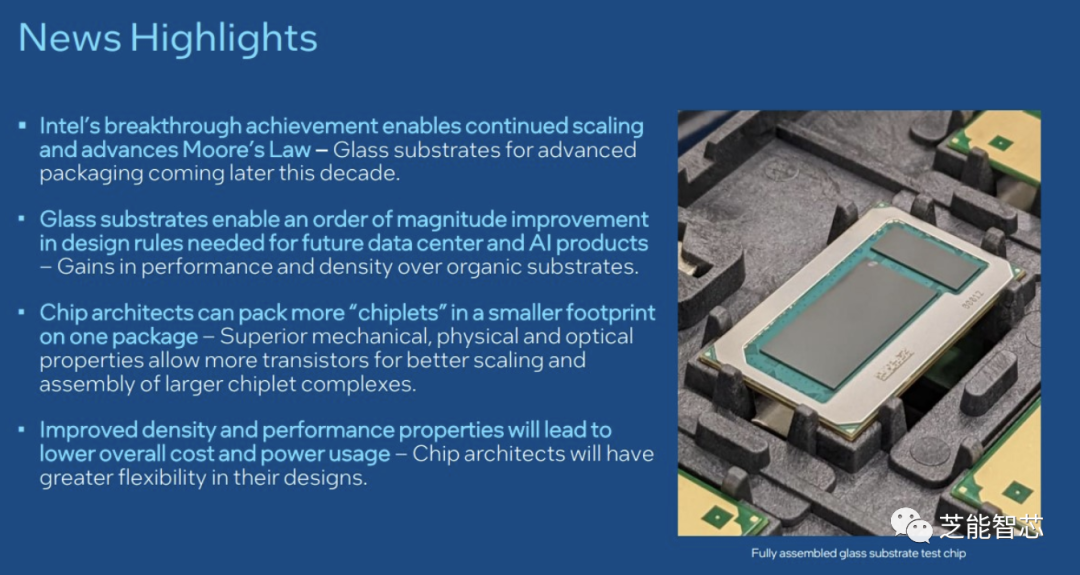
英特尔还计划引入玻璃通孔技术(TGV),将类似于硅通孔的技术应用于玻璃基板,还推出了Foveros Direct,这是一种具有直接铜对铜键合功能的高级封装技术。计划为可插拔共封装光学器件设计一种基于玻璃的耦合技术。这些创新将使处理器和芯片在性能、功耗和功能方面取得巨大进展,为未来计算技术的发展铺平了道路。
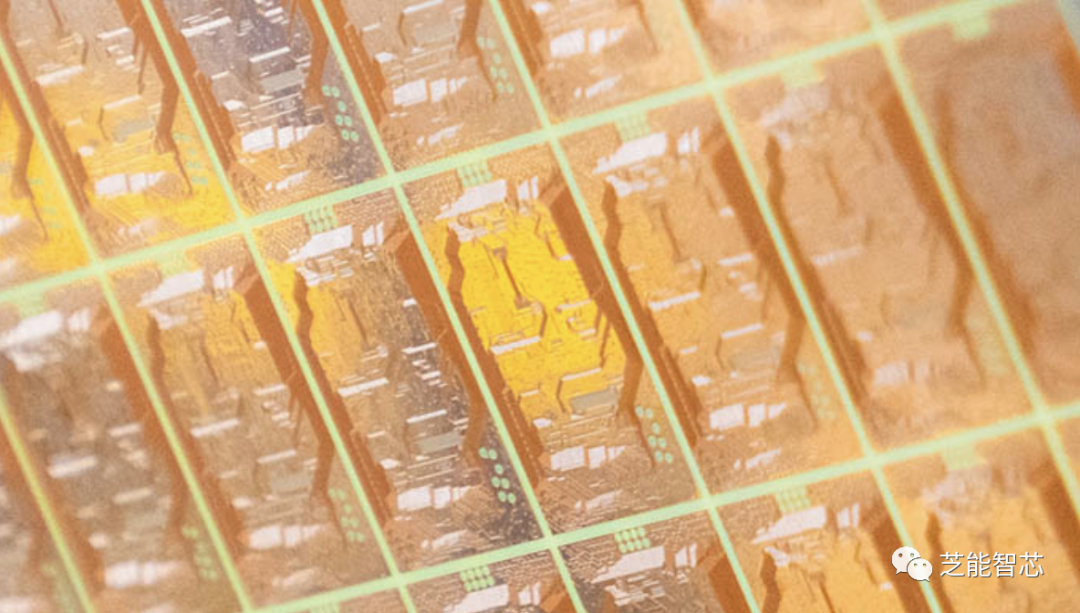
玻璃基板封装技术:处理器制造的差异化:英特尔最近宣布了一项令人振奋的技术突破,将引入一种创新的处理器技术,采用玻璃基板替代传统的有机基板

高密度互连与光学互连的实现
玻璃基板技术将带来更高的互连密度和集成光学互连的能力,为处理器的性能提升提供了新的可能性。相较于传统有机基板,玻璃基板不仅功耗更低,而且信号传输速度更快,为计算设备的高效运行提供了关键支持。
先进封装选项
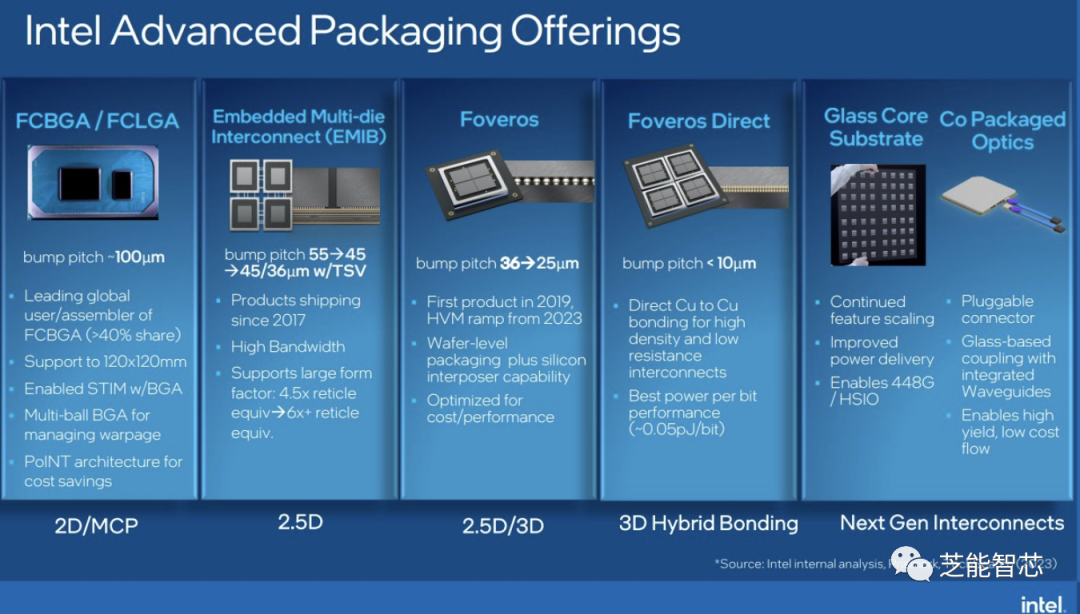
英特尔的新技术不仅仅停留在玻璃基板的层面,还引入了Foveros Direct,这是一种具有直接铜对铜键合功能的高级封装技术,计划为可插拔共封装光学器件设计一种基于玻璃的耦合技术,已在英特尔创新 2022 上展示,为处理器的未来功能拓展奠定了基础。

相较于有机基板,玻璃基板的制造具备更高的灵活性,可以调整为具有类似于硅的热膨胀特性,这有助于制造更大封装的处理器。英特尔预测,相较于有机基板,玻璃基板可以获得10倍甚至更多的通孔密度,实现更低的能耗和更高速度的信号传输(高达448G)。
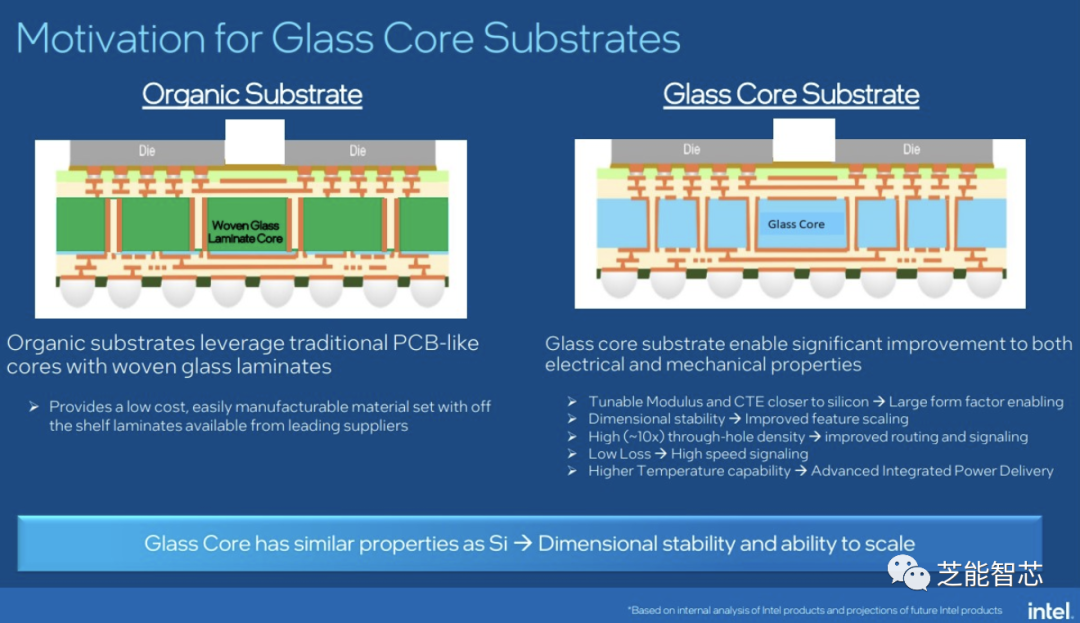
玻璃通孔技术的应用
硅通孔技术(TSV)现在正被成功应用于玻璃基板上,与以往相比,新一代处理器将在更小的体积内实现更多的组件,从而提高了设备的紧凑性和性能。
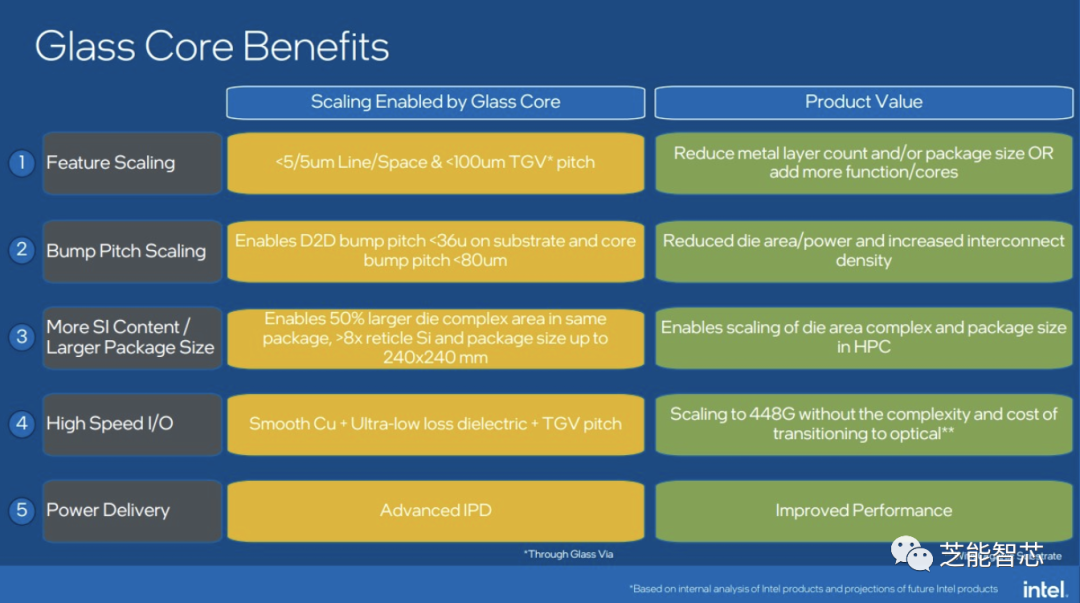
展望未来
英特尔明确表示,这项突破性的技术披露为未来的计算设备和人工智能提供了崭新的可能性。
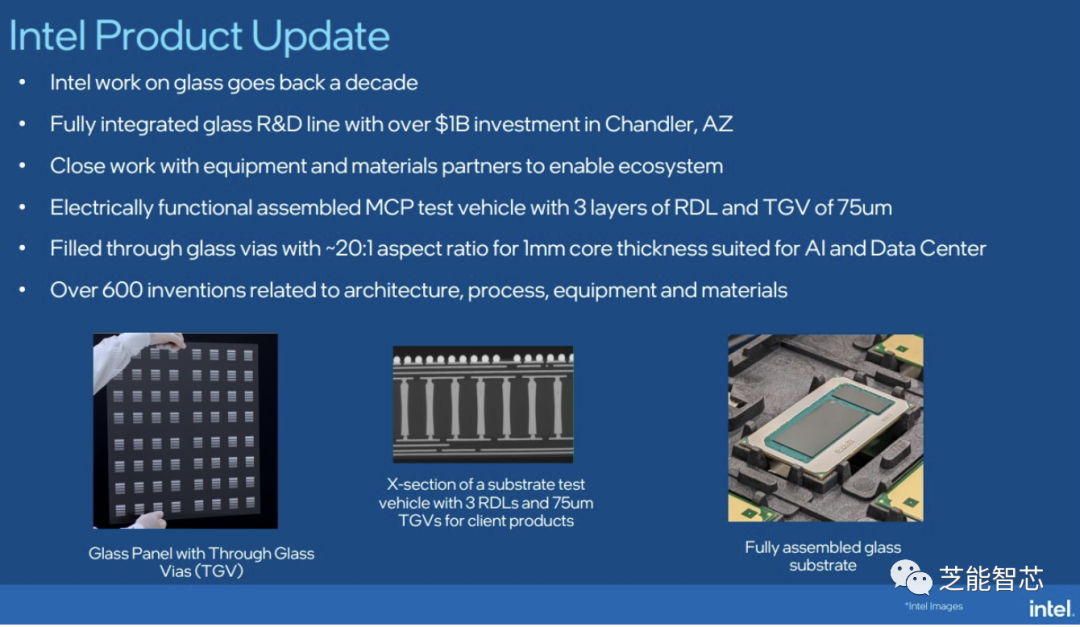
-
英特尔
+关注
关注
61文章
10320浏览量
181067 -
封装
+关注
关注
128文章
9329浏览量
149039 -
玻璃基板
+关注
关注
1文章
105浏览量
11099
原文标题:下一代英特尔玻璃基板封装转型概述
文章出处:【微信号:QCDZSJ,微信公众号:汽车电子设计】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
超越台积电?英特尔首个18A工艺芯片迈向大规模量产

燧弘华创携手英特尔共建联合实验室
18A工艺首发!英特尔推出下一代PC处理器,77%游戏性能暴涨+180TOPS算力

五家大厂盯上,英特尔EMIB成了?
英特尔举办行业解决方案大会,共同打造机器人“芯”动脉

适用于下一代 GGE 和 HSPA 手机的多模/多频段 PAM skyworksinc

英特尔宣布工程技术领导层重要任命,加速CEO陈立武转型布局
分析师:英特尔转型之路,机遇与挑战并存

英特尔先进封装,新突破
直击Computex 2025:英特尔重磅发布新一代GPU,图形和AI性能跃升3.4倍

直击Computex2025:英特尔重磅发布新一代GPU,图形和AI性能跃升3.4倍

英特尔代工:明确重点广合作,服务客户铸信任
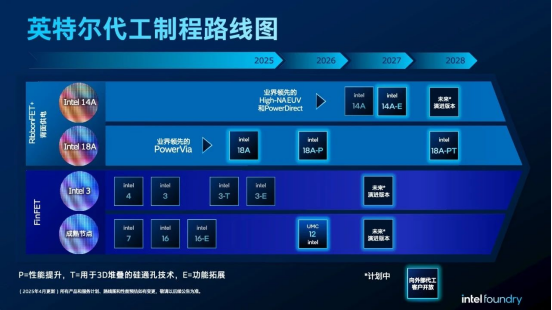



 下一代英特尔玻璃基板封装转型概述
下一代英特尔玻璃基板封装转型概述







评论