随着BGA、CSP封装器件向密间距、微型化的方向发展,无铅制程的广泛应用给电子装联工艺带来了新的挑战。球窝(Pillow-head Effect)缺陷是BGA、CSP类器件回流焊接中特有的一种缺陷形态。如图所示,焊料球和焊锡之间没有完全熔合,而是像枕头一样放在一个窝里或一个堆上。这种缺陷经常发生在BGA、CSP器件的回流焊接中,在无铅制程中更为突出。
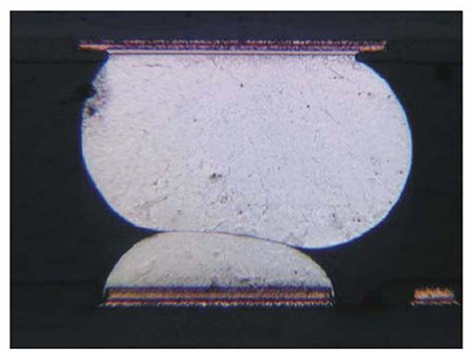
图1.球窝现象
球窝缺陷不易被检测出来,因为焊料球和焊锡之间往往有部分连接。所以电路可能能够通过功能测试、光学检查和ICT测试。但是,由于焊料之间没有真正熔混,焊点不牢固,可能会在后续的工艺或使用过程中导致失效。例如,在焊接工艺之后,存在球窝缺陷的PCBA可能会在后续的组装工艺、运输过程中因为热胀冷缩或者在现场经受长时间的电流负荷而失效。因此,球窝缺陷的危害性是极大的。
球窝产生的机理
1.锡膏或焊料球的可焊性不良。
2.锡膏印刷和贴片精度影响。如果锡膏印刷不均匀或不准确,或者贴片位置偏移,会导致焊料球和焊锡之间的接触不良,从而形成球窝。
3.BGA焊球的共面性不好。如果BGA封装器件的焊球高度不一致,会导致部分焊点受力不均匀,从而造成翘曲或断裂。
4.芯片翘曲或芯片温度不均匀,存在温差。如果芯片在回流焊接过程中受热不均匀,或者在回流焊接前后发生翘曲,都会导致芯片与PCB基材之间的热膨胀系数不匹配,从而产生应力和变形。这会使得部分焊点失去接触或分离,形成球窝。
抑制球窝现象的措施
1.优化回流温度曲线,保证锡膏能够完全液化并与焊料球充分熔合。
2.选用合适的锡膏:采用抗热坍塌能力强,去CuO(Cu2O)、SnO(SnO2)效果良好的锡膏。
3.改善热风回流的均热能力,最好采用“热风+红外”复合加热方式,能有效改善封装体上温度的均匀性。
4.加强对回流炉排气系统的监控,确保排气管道顺畅有效。
福英达锡膏
深圳市福英达公司自主研发和生产的SiP系统级封装锡膏Fitech siperiorTM 1550/1565,粒径T8、T9,最小印刷/点胶点φ=70/50μm,可稳定用于μBGA预置。在实际应用中体现出优异的印刷性、脱模转印性、形状和稳定保持性及足量且均匀的印刷量。长时间印刷后无锡珠、桥连缺陷。
审核编辑 黄宇
-
封装
+关注
关注
128文章
9330浏览量
149044 -
BGA
+关注
关注
5文章
586浏览量
51951 -
CSP
+关注
关注
0文章
129浏览量
29544
发布评论请先 登录
Texas Instruments BGA托盘变更PCN解读
BGA 焊得再漂亮也没用!90% 的虚焊空洞,肉眼根本看不见

一文掌握BGA封装技术:从基础到可靠性测试,推拉力测试机如何保障品质?

GT-BGA-2003高性能BGA插座
罗彻斯特电子为客户提供厂内BGA封装元器件重新植球服务

BGA芯片阵列封装植球技巧,助力电子完美连接

钓鱼打窝船总掉链?仁懋 TOLL 封装 “芯” 方案

GT-BGA-2000高速BGA测试插座
半导体封装质量把关:红墨水试验技术要点与常见问题解答




 解读BGA、CSP封装中的球窝缺陷
解读BGA、CSP封装中的球窝缺陷



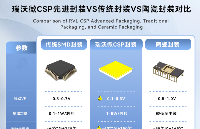





评论