BGA植球是实现芯片与基板互连的关键工艺,助焊剂的应用直接决定焊球定位精度、焊接可靠性与焊点质量,其工序适配性、性能要求均与其他封装焊接存在显著差异。
一、BGA 植球中助焊剂的核心应用工序
助焊剂仅在焊球放置前的涂覆工序集中使用,是植球工艺的“桥梁”。
助焊剂在BGA植球中的工序大概为:焊盘预处理(清洗除氧化)后、焊球放置前,通过针转移、钢网印刷或喷雾方式,在BGA焊盘表面均匀涂覆一层助焊剂。
核心作用包括:
1、粘结固定——利用助焊剂常温下的粘性,将预成型焊球精准吸附在对应焊盘上,避免运输至回流炉过程中移位。
2、活化润湿——回流时助焊剂清除焊盘(如Ni/Au、CuOSP)与焊球表面氧化层,降低焊料表面张力,促进焊球与焊盘冶金结合。
3、防氧化保护——挥发产生的气体隔绝空气,避免焊接过程中焊球二次氧化。
二、BGA植球对助焊剂的专属要求
基于植球工艺“定位精准、细间距适配、低缺陷” 的核心需求,助焊剂需满足以下6点关键要求:
1、粘度适配。常温粘度需控制在5000-15000cP(25℃),既要保证焊球吸附后30分钟内无移位,又要避免粘度过高导致焊球无法与焊盘充分贴合。细间距 BGA(≤0.5mm)需选用更高粘度(10000-15000cP),防止回流时焊球漂移桥连。
2、活性适中。选用中等活性(RMA级),有机酸含量3%-5%——既能有效清除轻度氧化层(如NiO、SnO₂),又不会腐蚀焊盘镀层(尤其Au/Ni 镀层),避免焊后出现黑盘现象。
3、残留特性。免清洗配方,残留量≤0.3mg/cm²,且残留膜需具备高绝缘性(绝缘电阻≥10¹²Ω)、无腐蚀性,避免细间距焊点间漏电或长期使用后氧化失效。
4、温度窗口匹配。活性温度区间需覆盖焊料熔点(如SAC305焊球对应180-245℃),回流时助焊剂挥发速率与焊球熔化节奏同步,无爆沸现象(防止产生焊点空洞)。
5、铺展控制:铺展率≤120%,避免助焊剂过度流动导致相邻焊球粘连(桥连),尤其适配0.3mm以下超细间距植球。
6、环保合规:无卤素(Cl⁻+Br⁻<0.1%)、无铅,符合RoHS 2.0、AEC-Q101标准,适配消费电子、汽车电子等场景。
三、与其他封装焊接助焊剂的核心差异
BGA植球助焊剂的设计逻辑聚焦“定位 + 润湿”双重需求,与SMT回流焊、功率器件钎焊、WLCSP Bump制作的助焊剂差异显著。其差异如下表格:
封装类型 | 核心差异点 | 助焊剂关键特性对比 |
BGA植球 | 侧重焊球定位与防漂移 | 高粘度、中等活性、低铺展率、低残留 |
SMT回流焊 (锡膏) | 侧重印刷适配与润湿 | 低粘度(2000-8000cP)、活性可调、触变性强(预混于锡膏) |
功率器件钎焊 (SiC/晶闸管) | 侧重高温稳定性 | 高温活性(200-300℃)、高绝缘性、低挥发物 |
WLCSP Bump制作 | 侧重细间距印刷精度 | 超细粉适配(7/8 号粉)、高触变性、极低空洞率 |
具体差异解析:
SMT助焊剂多预混于锡膏,粘度更低以适配钢网印刷,触变性强(防坍塌)。而 BGA 植球助焊剂需独立涂覆,粘度更高以实现焊球固定,铺展率更严格(防桥连)。
功率器件钎焊温度高(250℃以上),助焊剂需具备高温活性与低挥发特性。BGA植球回流温度较低(245℃以下),更侧重粘度控制与定位精度,无需耐受极端高温。
WLCSP Bump间距更小(≤50μm),助焊剂需适配超细焊粉印刷,侧重空洞抑制。BGA植球间距较大(≥0.3mm),核心痛点是焊球漂移与桥连,对粘度和铺展率的要求更突出。
简言之,BGA植球助焊剂的核心竞争力在于“粘性与活性的平衡、铺展与残留的控制”,这是区别于其他封装焊接助焊剂的关键,也是保障植球良率的核心。
-
smt
+关注
关注
45文章
3153浏览量
75214 -
BGA
+关注
关注
5文章
582浏览量
50991 -
功率器件
+关注
关注
43文章
2065浏览量
94657 -
助焊剂
+关注
关注
3文章
148浏览量
12156
发布评论请先 登录
BGA植球
BGA植球 焊接 返修
专注多年BGA植球,返修,焊接,
专业BGA植球,BGA返修,BGA焊接。
无铅焊接对助焊剂的要求-购线网
请问BGA芯片用大瑞锡球植锡为什么总失败呢?
倒装晶片的组装的助焊剂工艺
倒装晶片装配对助焊剂应用单元的要求
bga植球方法
SMT贴片加工助焊剂的作用要求
倒装晶片装配对助焊剂应用单元的要求
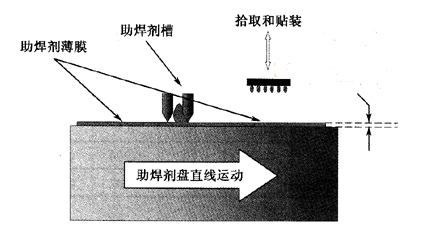





 BGA植球中助焊剂的应用工序及核心要求
BGA植球中助焊剂的应用工序及核心要求













评论