有过深硅刻蚀的朋友经常会遇到这种情况:在一片晶圆上不同尺寸的孔或槽刻蚀速率是不同的。这个就是负载效应所导致的,且是负载效应的一种表现形式。负载效应,可能导致刻蚀速率和均匀性受到影响,那么负载效应是怎么产生的?有什么危害?又是如何抑制负载效应呢?
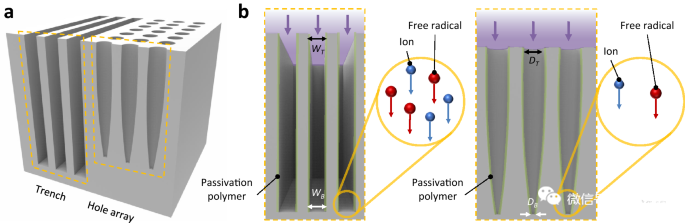
什么是负载效应?
负载效应(Load Effect),指当刻蚀面积的大小或形状发生变化时,刻蚀速率也随之改变的现象,即刻蚀速率取决于被刻蚀表面材料的量的现象。负载效应可以分为三种:宏观负载效益,微观负载效益,与深宽比相关的负载效应。
1.宏观负载效应
Macro-loading Effect,指在反应物恒定供应的情况下,刻蚀速率随着晶圆被刻蚀的表面积增大而降低。因为,晶圆的开口率越大,需要的反应物越多,蚀刻速率越低。举个例子,当一片晶圆的需要刻蚀的表面积占晶圆总表面积的2%时,速率可能为10um/min;当需要刻蚀的面积占晶圆总面积50%时,速率可能为1um/min。
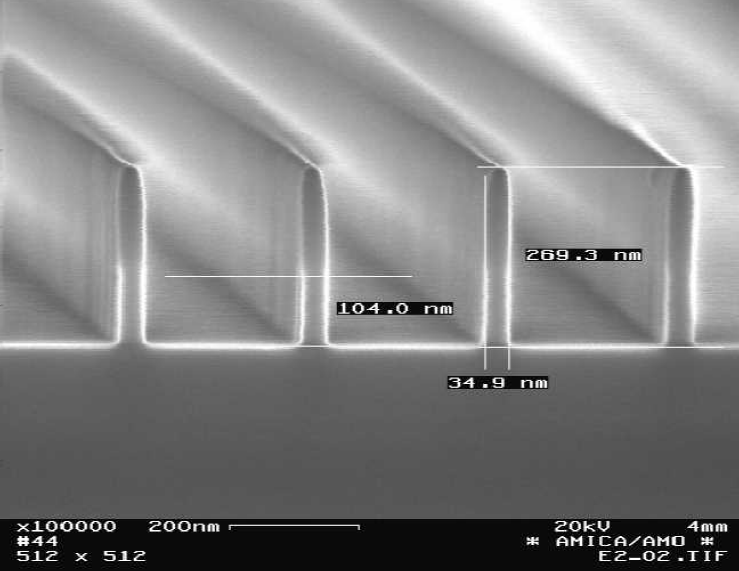
2.微观负载效应
Micro-loading Effect,指当晶圆同时包含稀疏和密集的待刻蚀图形时,密集区域的刻蚀速率比稀疏区域的刻蚀速率低。这是因为在密集区域消耗的反应物更多,反应物不能及时到达密集刻蚀区域所导致的。

3.与深宽比相关的负载效应
ARDE,指在高深宽比的结构刻蚀中,如深孔或深槽。较小尺寸的孔或槽刻蚀速率小于较大尺寸的孔或槽。这是因为刻蚀气体难以进入深部,而同时反应产物难以逸出,导致底部的刻蚀速率降低。

负载效应带来的问题
1.刻蚀的均匀性降低
负载效应导致晶圆上的不同区域具有不同的刻蚀深度。这可能导致晶圆上的某些区域过度刻蚀,而其他区域则未达到所需的刻蚀深度。这样可能会影响到后续的制程。
2.刻蚀效果差
负载效应可能导致刻蚀剖面的形状不规则,所刻蚀的尺寸与设计尺寸存在较大差距等问题。
3.成本增加
为了解决负载效应带来的问题,可能需要对不同尺寸结构进行多次光刻,干刻或换用更高级的设备等,导致项目的成本增加。
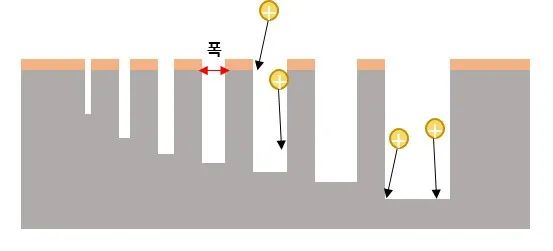
如何抑制负载效应?
1.优化刻蚀参数
通过调整刻蚀的参数,如功率、气体流量、气体压力和温度,可以达到更均匀的刻蚀效果。例如调节刻蚀机台的压力,在低压下,刻蚀物质的平均自由程更长。这使得它们可以更容易地进入深的、狭窄的特征中,从而提高这些结构的的刻蚀速率。
2.优化掩模设计
通过增加被刻蚀结构间的距离,减少高深宽比,减少大面积的图案等来减少负载效应。
3.脉冲刻蚀
使用脉冲模式进行刻蚀,其中刻蚀和沉积过程交替进行,有助于减轻负载效应。
审核编辑:刘清
-
晶圆
+关注
关注
52文章
4527浏览量
126446 -
刻蚀机
+关注
关注
0文章
45浏览量
4057
原文标题:干法刻蚀的负载效应是什么?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
干法刻蚀常用设备的原理及结构

释放MEMS机械结构的干法刻蚀技术
【转帖】干法刻蚀的优点和过程
请教碳化硅刻蚀工艺
释放MEMS机械结构的干法刻蚀技术
两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀
GaN材料干法刻蚀工艺在器件工艺中有着广泛的应用

干法刻蚀之铝刻蚀的介绍,它的原理是怎样的





 干法刻蚀的负载效应是怎么产生的?有什么危害?如何抑制呢?
干法刻蚀的负载效应是怎么产生的?有什么危害?如何抑制呢?

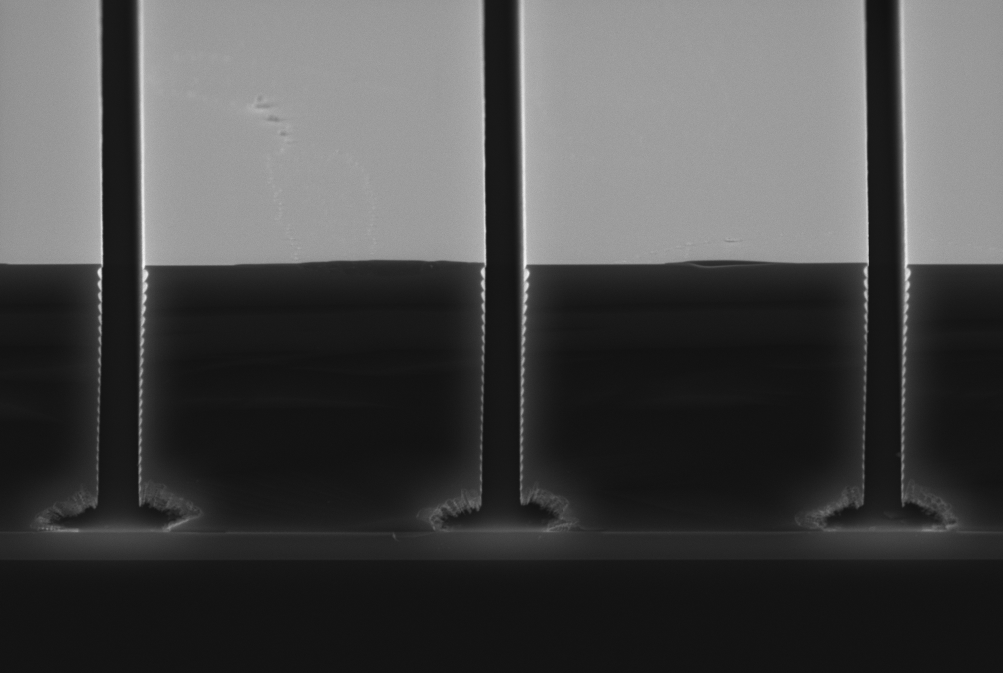
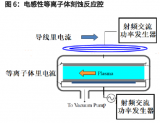










评论