引言
薄膜和多层中的应力会降低性能,甚至导致技术应用中的故障,通过诸如破裂、弯曲或分层的机制。然而,在某些情况下,应力是理想的,因为它可以用来提高涂层的特定性能,例如导电性,热稳定性,机械强度或磁性。由于这个原因,评估和控制薄膜和涂层的应力状态具有技术重要性。
实验与讨论
英思特用磁控溅射装置在基底压强为5×10-7pa的超高真空室内生长了铜和钨薄膜。选择在a-SiNx上生长薄膜而不直接在Si上生长薄膜有两个动机:一方面,a-SiNx缓冲层作为扩散阻挡层来防止原子从薄膜扩散到衬底中(Cu特别容易与Si反应),从而阻止像CuxSi或WxSi这样的化合物的形成;另一方面,无定形氮化硅的存在阻止了膜从母衬底继承晶体结构,这将影响膜生长期间的应力演变。通过这种方式,沉积层独立于晶体取向形成它们自己的织构母基板的位置。
如图1,我们利用W和Cu金属膜应力演化的知识,制备了Cu/W纳米多层膜。它们由10个重复的Cu/W双层单元构成,每个Cu和W层的厚度为10nm。
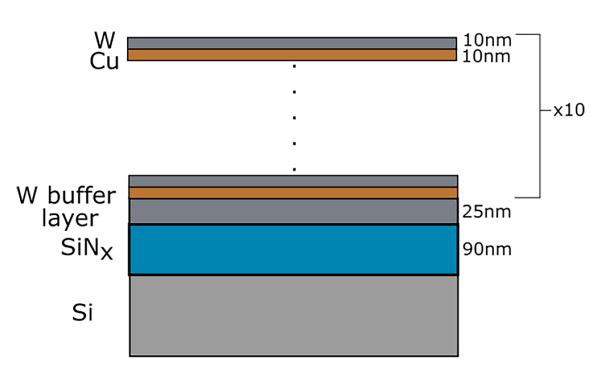
图1:Cu/W纳米多层和衬底的几何形状
衬底与用于单层Cu和W膜的相同,即200微米厚的Si(100)(平方11cm2)晶片,具有90 nm的a-SiNx阻挡层和25 nm的W缓冲层,10nm厚的Cu层和10nm厚的W层在0.533 Pa的Ar压力和80 W的功率下进行交替沉积。我们选择这些特定条件是因为它们将压缩Cu与拉伸W相结合,以试图实现几乎无应力的NML。根据图2显示,通过简单地考虑块体Cu{111}和W{110}之间的面内晶格失配,我们预计Cu总是处于高拉伸应力下。
对于Cu/Ag多层膜我们研究发现其中新的晶粒在下面的多晶层上成核,与先前沉积的晶粒在一起,产生拉伸应力。因此,W在a-SiNx和多晶Cu上的不同应力演化表明“叠加原理”在纳米多层膜中不成立。换句话说,对于单一金属膜,生长应力对沉积参数的依赖性不能直接用于调整相应多层结构中的应力演变。
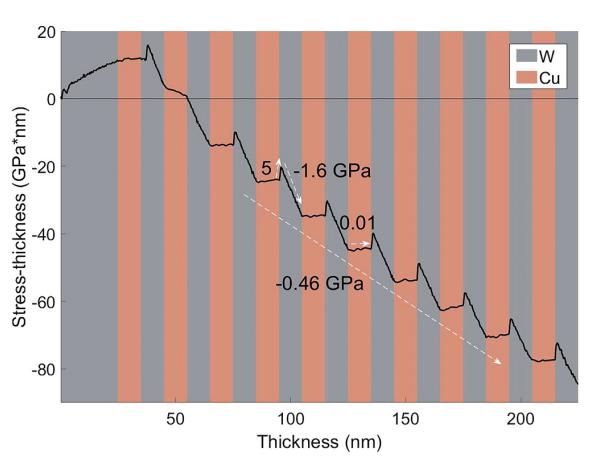
图2:应力-厚度曲线
英思特通过观察在沉积铜层期间获得的应力-厚度数据, 发现在先前沉积的钨层上沉积铜不会影响整个衬底曲率,增厚的Cu层不能使下面的W/Cu叠层变形,而是简单地容纳在其上。然而,生长期间恒定的衬底曲率并不意味着零增量应力。
结论
英思特研究了DC磁控溅射法生长的钨和铜薄膜中,氩气压强和外加功率对应力演化的影响。由此可见,低Ar压力和高功率有利于压缩固有应力的发展,因为更高能的吸附原子到达生长膜的表面,触发原子扩散进入晶界和/或原子喷丸。
对于较低能量的吸附原子,如在高Ar压力和低施加功率下所有利的,这些应力产生机制被抑制,并且所得薄膜形成拉伸应力状态。对于在与其单膜变体相似的条件下生长的Cu/W多层膜,应力演变由连续沉积的W层中的本征应力控制。较软的铜层中的应力简单地适应下面较硬的钨层的应力状态,导致大的界面应力贡献。
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洁设备,RCA清洗机,KOH腐殖清洗机等设备的设计、生产和维护。
审核编辑 黄宇
-
薄膜
+关注
关注
1文章
375浏览量
46263 -
晶圆
+关注
关注
53文章
5451浏览量
132767
发布评论请先 登录
外延应力如何提升芯片性能

深度解析薄膜应力与晶圆曲率法

磁控溅射工艺时间对金属及氧化物靶材溅射速率的影响:基于台阶仪的薄膜厚度表征

磁控溅射SiO₂薄膜工艺优化:台阶仪在膜厚与粗糙度表征中的应用

集成电路制造中薄膜生长设备的类型和作用

集成电路制造中薄膜生长工艺的发展历程和分类

一文详解磁控溅射技术

四探针法测量Ti-Al-C薄膜的电阻率

钨管激光熔覆修复技术的核心原理及优势
椭偏仪在半导体的应用|不同厚度m-AlN与GaN薄膜的结构与光学性质

金属淀积工艺的核心类型与技术原理
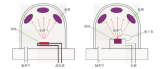
AKEMOND应力应变测试仪选型
详解原子层沉积薄膜制备技术




 溅射生长的铜和钨薄膜的应力调整
溅射生长的铜和钨薄膜的应力调整


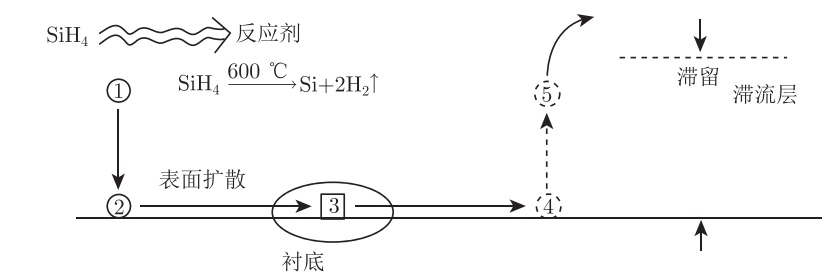



评论