研究背景
由于GaN和AlGaN材料中拥有较强的极化效应,AlGaN/GaN异质结无需进行调制掺杂就能在界面处形成高浓度的二维电子气(2DEG),在此基础上发展而来的高电子迁移率晶体管(HEMT)是GaN材料最重要的器件之一,在功率器件和射频器件领域拥有广泛的应用前景。HEMT器件通常是在硅(Si)、蓝宝石(Al2O3)、碳化硅(SiC)等异质衬底上通过金属有机气象外延(MOCVD)进行外延制备。由于异质衬底材料和GaN之间纯在较大的晶格失配和热失配,外延层中往往存在大量的缺陷,使得HEMT器件中存在较强电流崩塌效应,影响器件的性能发挥。
近年来,随着大尺寸、高质量自支撑GaN衬底的成功制备,研究人员开始在自支撑GaN衬底上进行外延制备HEMT。得益于没有晶格失配和热失配,在自支撑GaN衬底上外延的HEMT结构中缺陷密度远小于异质衬底上的外延样品。包括开尔文显微镜、拉曼光谱、电致发光(EL)在内的很多方法常被用来表征HEMT器件中电场和电流崩塌之间的关系,所有方法中电致发光能够简单且非破坏性的反映出区域内最高场强。
研究进展
最近,来自日本名古屋理工学院的研究团队利用电致发光的表征方法,证明GaN衬底上的HEMT器件相对于异质衬底上的HEMT器件在高电场下拥有更好的性能[1]。
器件结构如图1所示,除了SiC衬底需要生长成核层之外,两个器件结构完全一致。通过XRD确定势垒层厚度为17.5nm,Al组分为0.22。源漏欧姆接触电极为Mo/Al/Mo/Au,栅极金属为Ni/Au,栅源距离、栅极长度、栅漏距离分别为1.0μm、0.8μm、6.0μm。
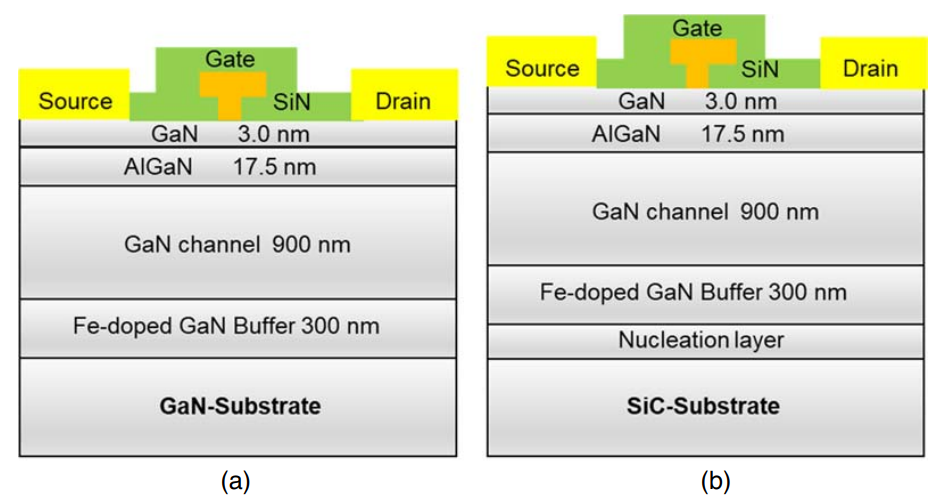
图1.(a)GaN衬底和(b)SiC衬底上器件界面图
通过图2可以看出GaN衬底器件的饱和输出电流密度更大,且电流崩塌更小。为了更直观的对比,取输出电压为6V时,脉冲电流和直流电流比值作为电流崩塌因子,SiC衬底器件为26%,GaN衬底器件仅为8%。
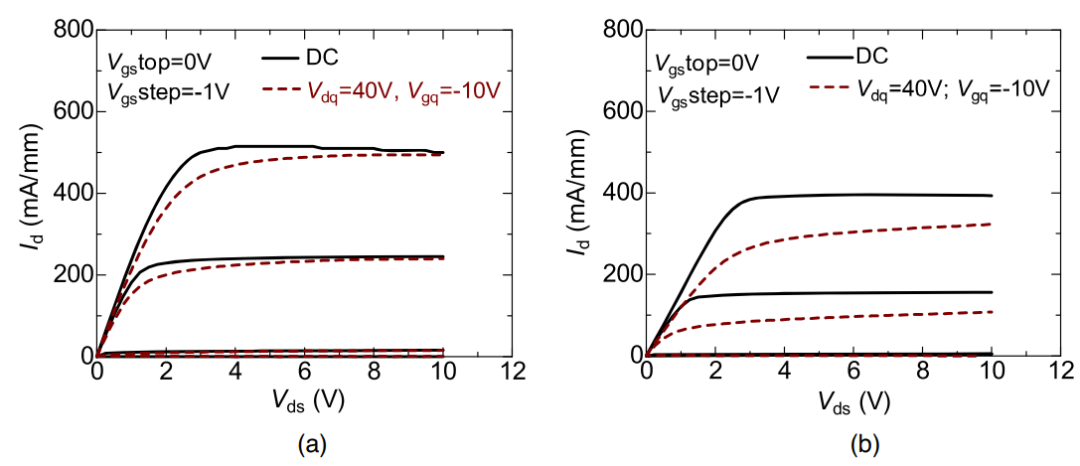
图2 直流和脉冲输出曲线:(a)GaN衬底和(b)SiC衬底
EL测试可以对比衬底对HEMT器件中最高场强区域的影响,图3为两组器件的EL图,测试漏极电压从40V增加到100V,漏极电流为35mA mm-1。图3(a)-3(c)为GaN衬底器件,从3(a)中可以看出在栅极附近有条状发光区,随着漏极电压增大,发光区域只是轻微向漏极偏移。这一现象表明,即使是在100V的高漏极偏压下,高场强区域依旧保持在栅极附近。图3(d)-3(f)为SiC衬底器件,可以看到器件中条状发光区域随着漏极偏压的增大向漏极发生了明显的偏移。
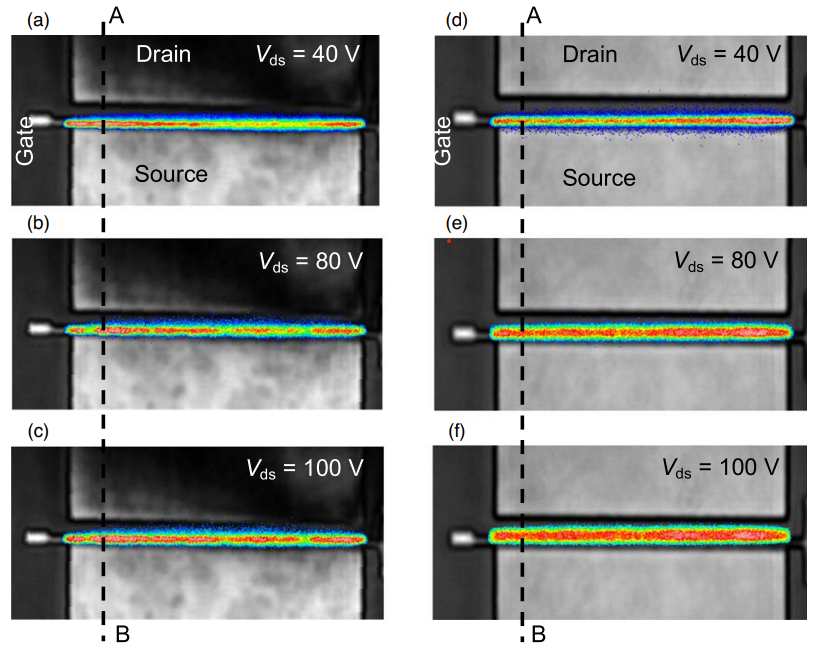
图3 (a)-(c)GaN衬底器件EL图谱 (d)-(f)SiC衬底器件EL图谱
为了定量讨论EL发光的偏移,沿着图3中虚线AB进行扫描,如数据图4所示。当偏压从40V增加到100V时,GaN衬底器件和SiC衬底器件的EL峰分别向漏极便宜了0.5μm和1.7μm。图5展示了EL峰位和偏压之间的关系,可以观察到,GaN衬底器件的偏移起始电压为60V大于SiC器件,且偏移距离的斜率也较小。
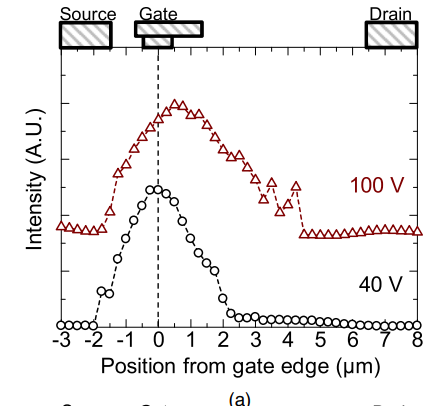
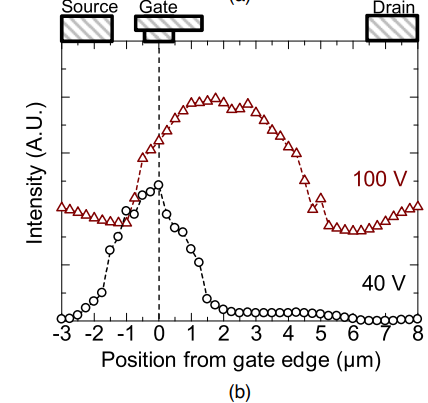
图4 EL线扫:(a)GaN衬底器件,(b)SiC衬底
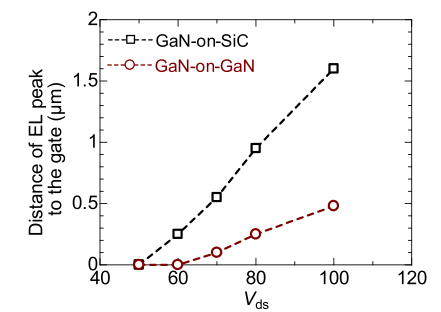
图5EL峰位偏移距离与漏极偏压之间关系
由于是通过异质外延进行制备,SiC衬底器件中存在较多的缺陷。在高漏极偏压下这些缺陷捕获电子形成空间电荷,使得器件高场强区发生偏移,也造成了严重的电流崩塌效应。相对的,通过同质外延制备的GaN衬底器件,拥有更好的外延层晶体质量。更少的缺陷使得更少的电子在高偏压下被捕获,高场强区扩展更小,器件的电流崩塌效应也更小。
该工作通过电致发光(EL)的表征方法,证明使用GaN衬底可以有效的减轻HEMT器件器件中的电流奔踏效应。随着器件功率密度的不断增大,GaN衬底将会是HEMT器件性能增长的重要保证。
文章来源:夏松渊江苏第三代半导体研究院
审核编辑:汤梓红
-
晶体管
+关注
关注
78文章
10482浏览量
149032 -
GaN
+关注
关注
21文章
2396浏览量
85031 -
HEMT
+关注
关注
2文章
81浏览量
14569
原文标题:GaN单晶衬底显著改善HEMT器件电流崩塌效应
文章出处:【微信号:芯长征科技,微信公众号:芯长征科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
同是功率器件,为什么SiC主要是MOSFET,GaN却是HEMT
GaN HEMT在电机设计中有以下优点
不同衬底风格的GaN之间有什么区别?
GaN HEMT可靠性测试:为什么业界无法就一种测试标准达成共识
《炬丰科技-半导体工艺》GaN 基板的表面处理
基于GaN HEMT的半桥LLC优化设计和损耗分析
《涨知识啦19》之HEMT 的电流崩塌效应的讲解
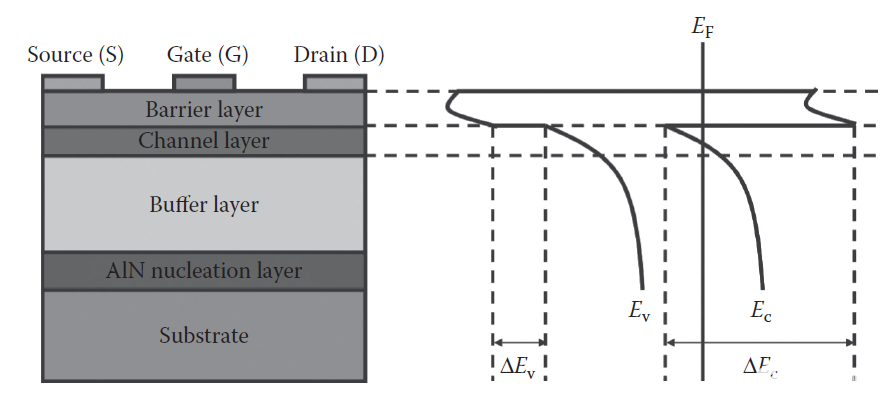
新开发了一种GaN衬底减薄技术——激光减薄技术
分析毫米波GaN器件热电效应
AlN/AIGaN/GaN MIS-HEMT器件制作
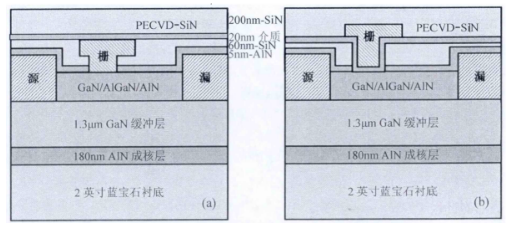
GaN HEMT为什么不能做成低压器件
GaN HEMT有哪些优缺点
浮思特 | 在工程衬底上的GaN功率器件实现更高的电压路径
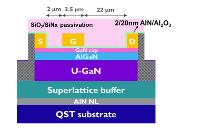
增强AlN/GaN HEMT
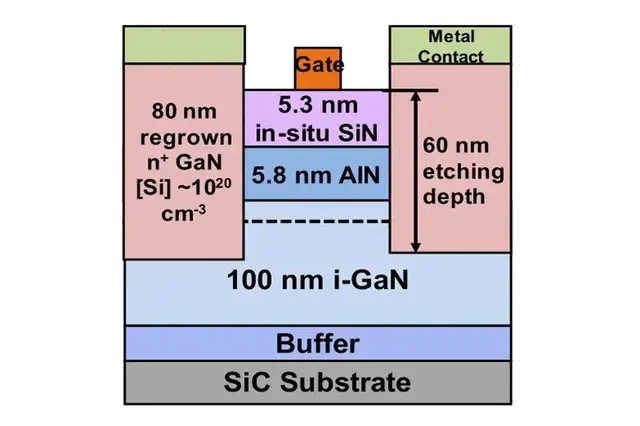



 GaN单晶衬底显著改善HEMT器件电流崩塌效应
GaN单晶衬底显著改善HEMT器件电流崩塌效应





评论