横向氮化镓高电子迁移率晶体管(HEMT)在中低功率转换应用领域正呈现强劲增长态势。将这一材料体系扩展至更高电压等级需要器件设计和衬底技术的创新。本文总结了台湾研究团队在工程衬底上开发1500V击穿电压(BV)GaN HEMT器件的研究成果。
Qromis衬底技术(QST®)
硅基氮化镓(GaN-on-Si)是目前商用功率HEMT器件的首选技术,其主流最高工作电压范围目前为650V及以下。当尝试将该技术扩展到更高电压范围时,会面临诸多挑战:GaN与Si之间显著的热膨胀系数(CTE)差异会导致高缺陷密度、晶圆翘曲和薄膜开裂,进而影响器件可靠性和良率,且晶圆直径越大问题越严重。
业界已提出碳化硅基氮化镓(GaN-on-SiC)和蓝宝石基氮化镓(GaN-on-sapphire)等替代方案。虽然GaN-on-SiC已商业应用于射频和微波领域,但SiC的高成本使其难以在消费级和工业级功率器件市场实现商业化。高性价比蓝宝石衬底上虽已实现高压HEMT演示,但其较低的热导率在高功率应用中存在局限。而理想的原生GaN-on-GaN技术则受限于大尺寸GaN衬底的匮乏。
Qromis开发的GaN-on-QST®平台提供了一种无应力、可扩展的解决方案。QST®衬底采用类似绝缘体上硅(SOI)的结构设计:以多晶氮化铝陶瓷为核心,外覆经过特殊设计的复合层及晶体硅(111)氧化层(BOX),该结构能有效促进GaN/AlGaN外延生长。
该衬底符合SEMI标准且兼容CMOS工艺线。其核心优势在于热膨胀系数与GaN在宽温域内(包括高温外延生长及后续冷却过程)完美匹配,这使得器件既能通过增加外延层厚度提升耐压,又可实现大尺寸晶圆制造。正如硅基CMOS技术发展中代工模式对Fabless设计公司的关键作用,晶圆代工同样推动着GaN技术的普及。世界先进(VIS)已成为首家提供200mm QST®衬底650V增强型GaN HEMT代工服务的厂商。此外,Qromis已将衬底技术授权给信越化学,任何拥有产线的GaN企业均可采购。
1500V耐压GaN-on-QST®器件
本研究在QST®衬底的氮化铝成核层上方采用了超晶格(SL)缓冲层结构(图1)。与传统硅衬底相比,QST®衬底允许使用更薄且质量更优的缓冲层,从而提升器件热电性能。
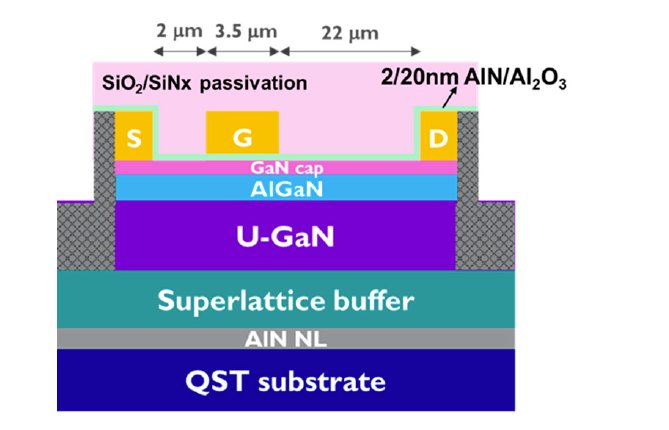 图1
图1实验采用2μm厚的标准AlN/GaN超晶格层。超晶格上方的高阻碳掺杂GaN层(GaN:C)作为缓冲层组成部分,其厚度在1-3μm间调整以研究对击穿电压的影响。
制备的耗尽型(d-mode)MIS-HEMT器件阈值电压为-12.7V。图2对比了器件关态特性与传统硅基GaN器件的差异,可得出以下结论:
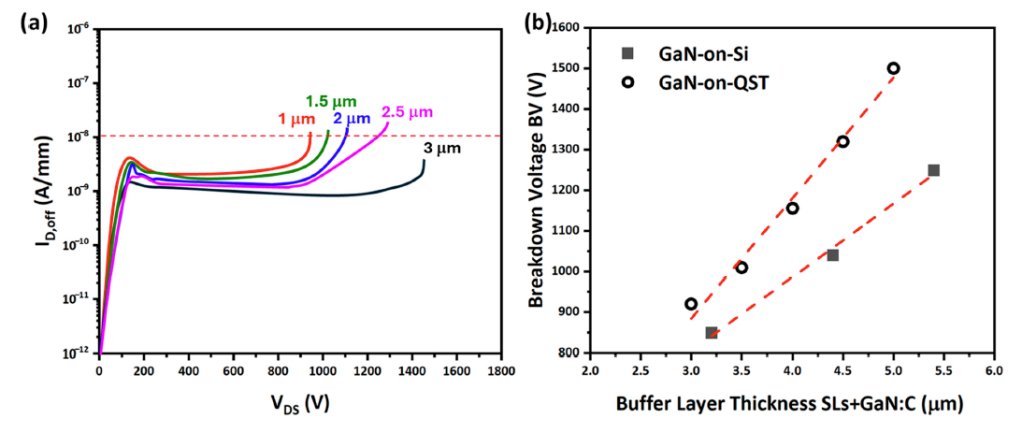 图2
图2• GaN:C层增厚可提升击穿电压,3μm样品实现1500V耐压(总缓冲层厚度5μm=SL+GaN:C)
• 相同耐压下QST®衬底缓冲层可减薄1μm以上(以1200V为例)
• QST®衬底能增强GaN:C层效能,同等厚度下尤其在高压段可获得更高耐压
为深入分析机理,研究者进行了TCAD仿真。已知陷阱辅助热场发射(TA-TFE)会在关态高电场(特别是高负栅压)下引发HEMT源漏泄漏:栅极下方横向能带抬升导致电子-空穴对产生——空穴通过缓冲层位错陷阱形成,电子则从漏极抽取。当缓冲层空穴生成率较低时,高场下源漏泄漏增量较小;但当空穴浓度因复合增强达到碳掺杂浓度时,碳掺杂抑制泄漏的效果将失效。实验数据校准后的TCAD TA-TFE模型仿真结果见图3-4。
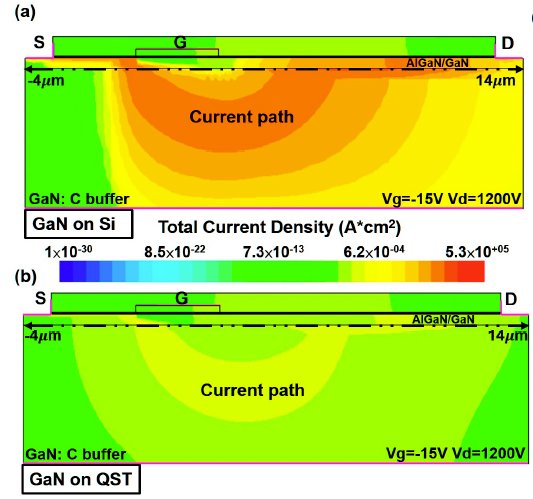 图3
图3图4显示QST®器件的泄漏电流随漏压增加几乎无变化。研究者认为这是由于QST®衬底位错密度更低、GaN晶体质量更优,使碳掺杂缓冲层效能提升,从而降低陷阱密度和泄漏电流。
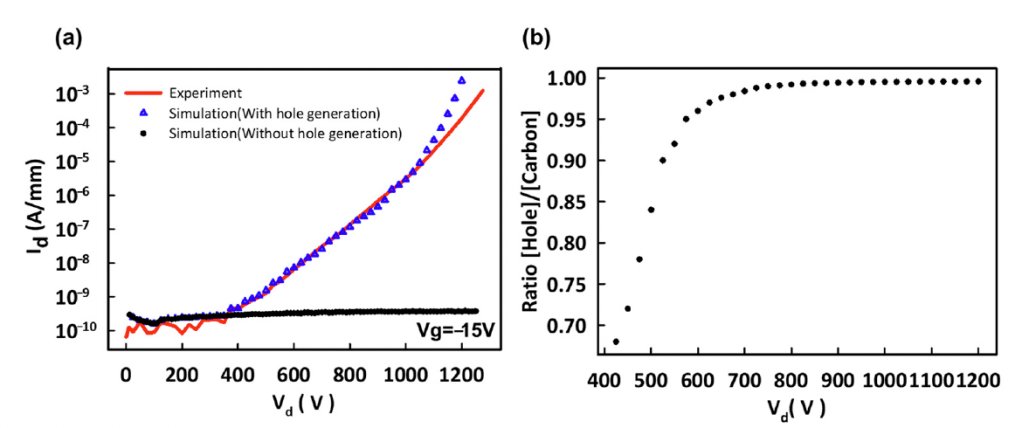 图4
图45K低温光致发光(PL)光谱分析验证了仿真与电性能结果:QST®样品在360nm GaN特征峰表现出更窄更强的信号,表明其更优的结晶质量;而硅基GaN在可见光波段的强峰可能源于衬底材料的高密度深能级陷阱。
QST®衬底将持续升级:计划2025年推出的第二代产品将采用SiC替代Si作为籽晶层以降低外延晶格失配,涵盖6/8英寸晶圆规格;后续还将采用GaN籽晶层实现终极晶格匹配。信越化学近期宣布开发的300mm专用衬底更彰显QST®技术对大尺寸GaN制造的支撑能力。
-
晶体管
+关注
关注
78文章
10453浏览量
148818 -
功率器件
+关注
关注
43文章
2261浏览量
95596 -
GaN
+关注
关注
21文章
2390浏览量
84810
发布评论请先 登录
基于德州仪器GaN产品实现更高功率密度
GaN器件在Class D上的应用优势
首个在6英寸蓝宝石衬底上的1700V GaN HEMTs器件发布




 浮思特 | 在工程衬底上的GaN功率器件实现更高的电压路径
浮思特 | 在工程衬底上的GaN功率器件实现更高的电压路径


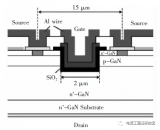
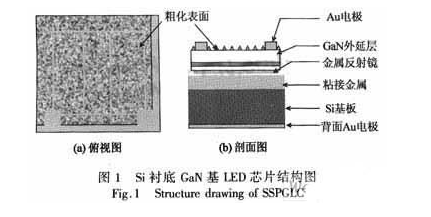
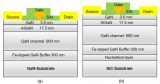






评论