声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
半导体
+关注
关注
339文章
31222浏览量
266416 -
封装
+关注
关注
128文章
9329浏览量
149039 -
封装技术
+关注
关注
12文章
605浏览量
69360 -
微电子
+关注
关注
18文章
415浏览量
42964
原文标题:【半导光电】微电子封装用主流键合铜丝半导体封装技术
文章出处:【微信号:今日光电,微信公众号:今日光电】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
热点推荐
半导体晶片键合的对准方法
以及实际上能够接合任何种类的晶片材料。粘合晶片键合不需要特殊的晶片表面处理或平面化步骤。晶片表面的结构和颗粒可以被容忍,并通过粘合材料得到一定程度的补偿。也可以用选择性粘合晶片键
发表于 04-26 14:07
•4714次阅读

《炬丰科技-半导体工艺》用于半导体封装基板的化学镀 Ni-P/Pd/Au
,半导体芯片和封装基板是通过金线键合连接的。印刷电路板和封装基板通过焊球连接。为了满足这些连接所需的可靠性,
发表于 07-09 10:29
芯片封装中铜丝键合技术
铜线具有优良的机械、电、热性能,用其代替金线可以缩小焊接间距、提高芯片频率和可靠性。介绍了引线键合工艺的概念、基本形式和工艺参数;针对铜丝易氧化的特性指出,焊接时
发表于 12-27 17:11
•64次下载

键合铜丝的研究及应用现状
共读好书 周岩 刘劲松 王松伟 彭庶瑶 彭晓飞 (沈阳理工大学 中国科学院金属研究所师昌绪先进材料创新中心江西蓝微电子科技有限公司) 摘要: 目前,键合铜丝因其价格低廉、具有优良的材料




 微电子封装用主流键合铜丝半导体封装技术
微电子封装用主流键合铜丝半导体封装技术









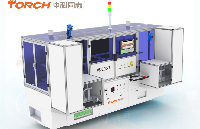





评论