静电释放导致的失效主要表现为
即时失效与延时失效两种模式。
即时失效
即时失效又称突发失效,指的是元器件受到静电放电损伤后,突然完全或部分丧失其规定的功能。一般较容易通过功能检测发现。
延时失效
延时失效又称潜在失效,指静电放电能量较低,或放电回路有限流电阻,仅造成轻微损伤,器件电参数可能仍然合格或略有变化。
一般不容易通过功能检测发现,而且失效后很难通过技术手段确认。
典型案例
#案例1
失效图示

试验复现
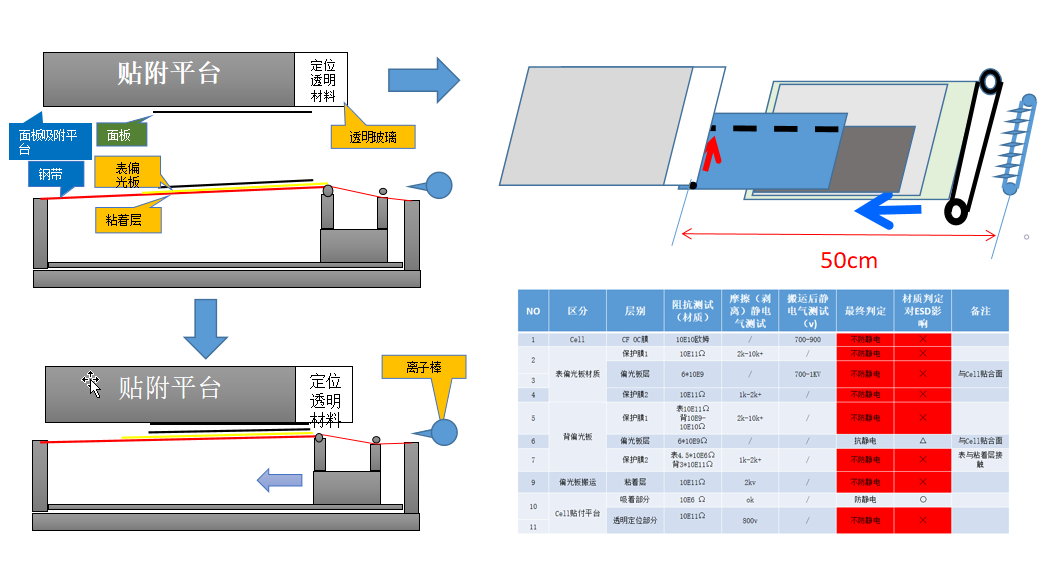
结论
不良发生位置集中于CF表偏贴合端子部的左边,距离离子棒约50cm。因距离过大,离子棒对此位置的除静电能力有弱化。
#案例2
失效图示
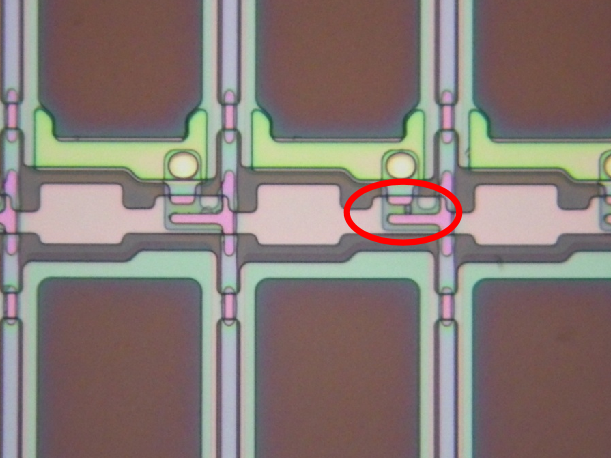
试验复现
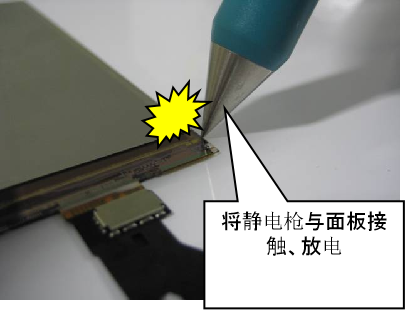
结论
经过静电耐圧试验发现,样品1在两种破坏类型中,情况分别为:
1.机器模型:使用2-3kV ESD痕迹发生;
2.人体模型:使用3-4kV ESD痕迹发生;
样品2在两种破坏类型中,情况分别为:
1.机器模型:使用12-14kV ESD痕迹发生;
2.人体模型:使用24-28kV ESD痕迹发生。
案例分享
EOS
过电压,过电流,
过功率,过电烧毁
失效表现
EOS的碳化面积较大,一般过功率烧毁会出现原始损伤点且由这点有向四周辐射的裂纹,且多发于器件引脚位置。
典型案例
失效图示
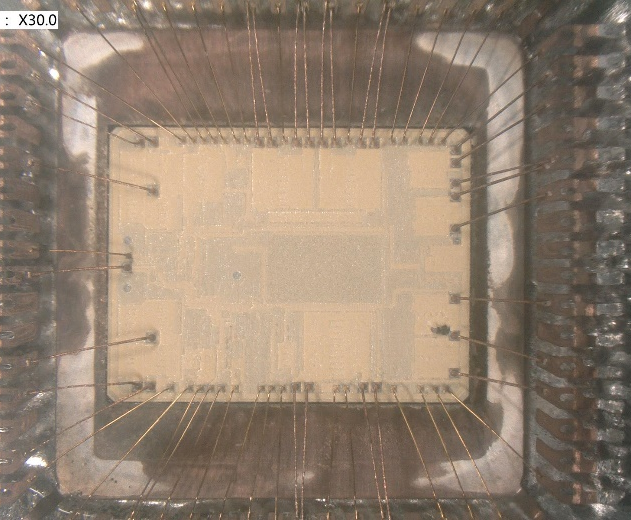
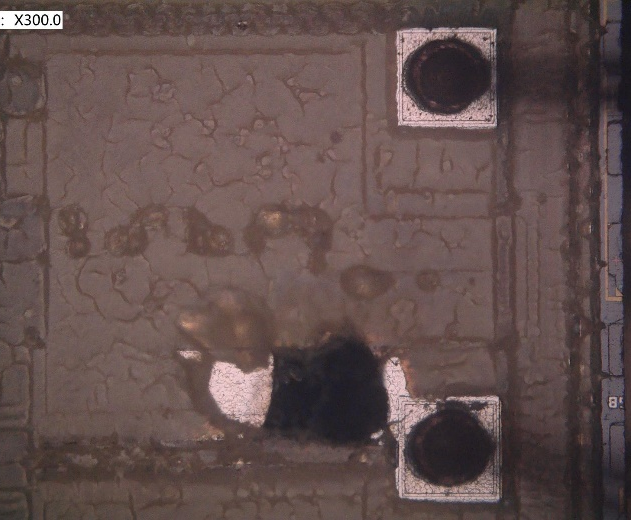

说明: 空洞异常处有因局部受热造成的表面树脂碳化现象,周边树脂出现裂纹。
试验复现
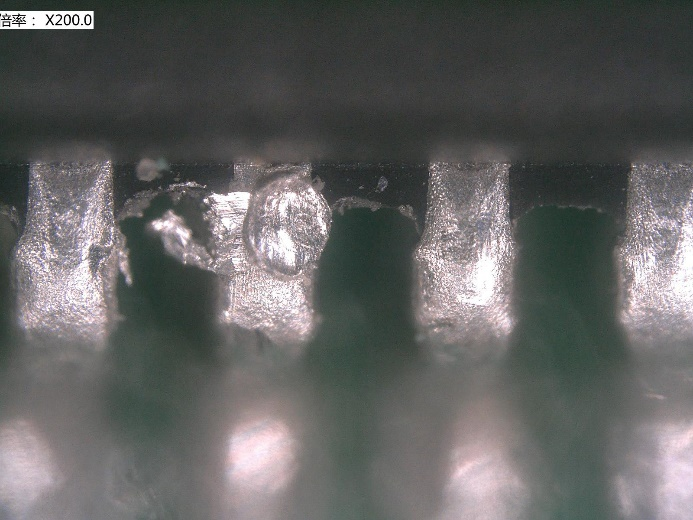


验证方法:使用正常样品在两个引脚上分别接入12V电源正负极进行复现试验。
结论
接上12.0V电源瞬间,两电极之间有被烧坏的声音,电流瞬间升高,电压下降。两引脚之间阻抗测试显示为OL,说明二者之间经过反接12V电压被大电流瞬间击穿断开。
#案例2
TVS管失效分析
失效图示
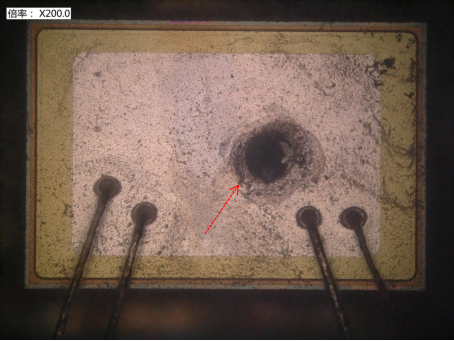
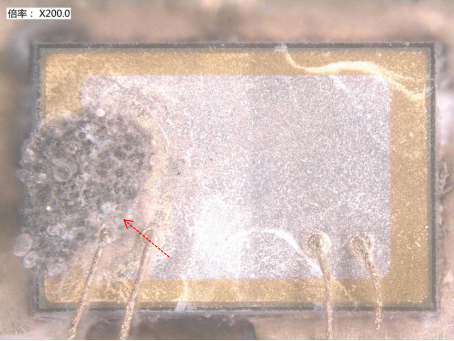
说明:样品开封发现样品晶圆位置均发现有烧伤痕迹,击穿位置树脂高温碳化,为过流过压导致。
试验复现
TVS管击穿FA分析图


左右滑动查看图集
击穿验证之后进行开封检测,发现复现样品晶圆位置均发现有烧伤痕迹,与异常品失效发生类似。
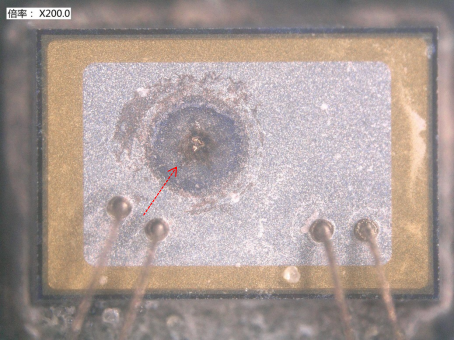
结论
晶圆表面发现有过流过压击穿的痕迹,即树脂高温碳化;
DC直流电源加压到18V,TVS管被击穿短路,复现品晶圆位置失效与异常品类似。
9V样品取下滤波电容,使其输出不稳定,TVS被击穿,短路失效。
据此判断,TVS管为过压导致失效,样品输出不稳定时有击穿TVS管的可能。
审核编辑:刘清
-
ESD
+关注
关注
50文章
2375浏览量
178830 -
电子元器件
+关注
关注
134文章
3812浏览量
112980 -
EOS
+关注
关注
0文章
132浏览量
22074 -
MCU芯片
+关注
关注
3文章
258浏览量
12538
原文标题:ESD与EOS失效案例分享
文章出处:【微信号:actSMTC,微信公众号:actSMTC】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
ESD测试的详细解释
抗EOS设计详解及实际"栗子"
ESD和EOS失效模式介绍

风华贴片电感的失效模式有哪些?如何预防?
浅谈常见芯片失效原因
连接器会失效情况分析?
ESD与EOS资料整理
TWS蓝牙耳机ESD EOS整体解决方案

显示视频接口的ESD保护方案应用——VGA接口保护方案
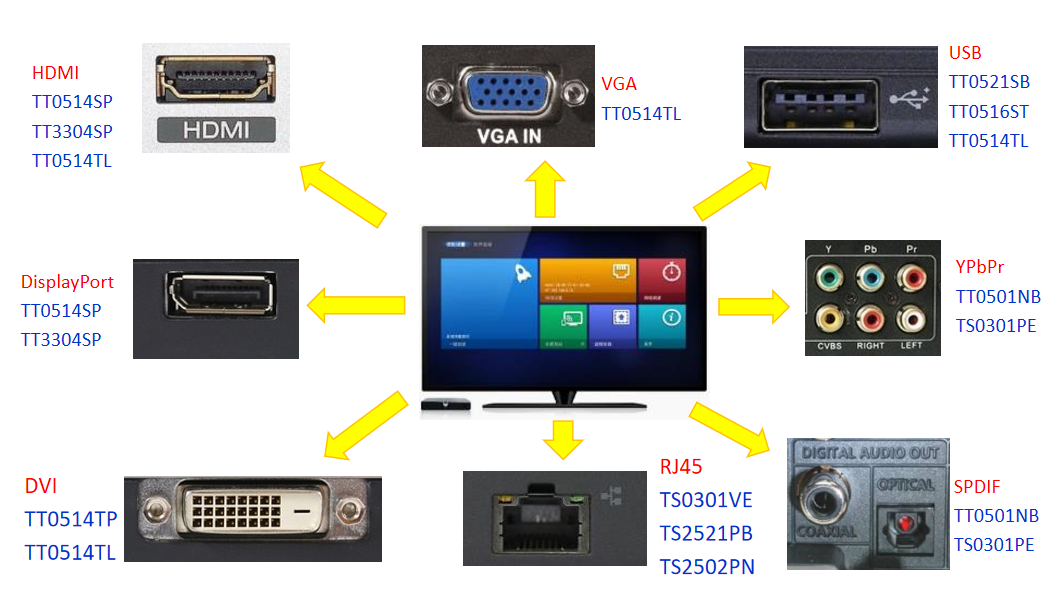
显示视频接口的ESD保护方案应用——YPbPr接口保护方案






 ESD与EOS在实际情况中的失效表现
ESD与EOS在实际情况中的失效表现

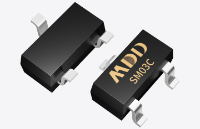
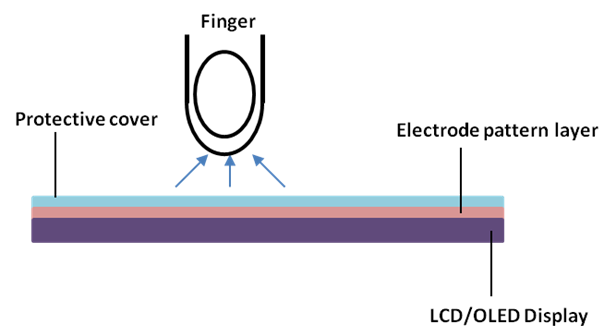
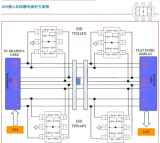
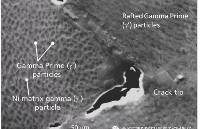











评论