从下图中可以看出结合使用XeF2气流和氯离子轰击的刻蚀速率最高,明显高于这两种工艺单独使用时的刻蚀速率总和。原因在于氯离子轰击会打断表面硅原子的化学键形成悬浮键。
表面上带有悬浮键的硅原子比没有断裂的硅原子更易于和氟自由基形成四氟化硅。由于离子轰击以垂直方向为主,因此垂直方向的刻蚀速率比水平方向高,所以RIE具有非等向性刻蚀轮廓。
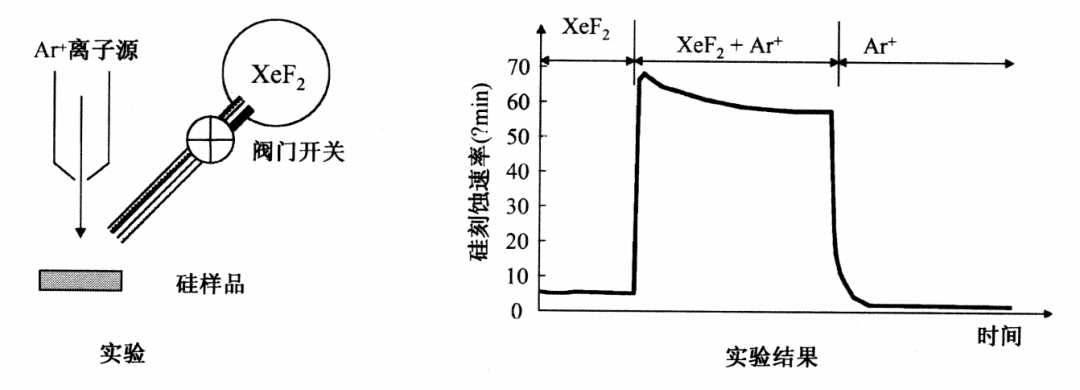
先进的半导体制造中,几乎所有的图形化刻蚀都是RIE过程。RIE的刻蚀速率和刻蚀选择性可以控制,刻蚀轮廓是非等向性且可控的,下表给出了这三种刻蚀工艺的比较。

刻蚀工艺原理
等离子体刻蚀中,首先将刻蚀气体注入真空反应室。当压力稳定后再利用射频产生辉光放电等离子体。部分刻蚀剂受高速电子撞击后将分解产生自由基,接着自由基扩散到边界层下的晶圆表面并被表面吸附。
在离子轰击作用下,自由基很快和表面的原子或分子发生反应而形成气态的副产品。从晶圆表面脱附而岀的易挥发性副产品扩散穿过边界层进入对流气流中,并从反应室中排出。整个等离子体刻蚀过程如下图所示。

等离子体刻蚀由于具有等离子体的离子轰击,所以能达到非等向性的刻蚀轮廓,非等向性原理有两种:损伤机制和阻绝机制,这两者都和离子轰击有关。
对于损伤机制,有力的离子轰击将打断晶圆表面上原子之间的化学键,带有悬浮键的原子就会受到刻蚀自由基的作用。这些原子容易和刻蚀剂的自由基产生化学键而形成挥发性的副产品,并从表面移除掉。由于离子轰击的方向垂直于晶圆表面,因此垂直方向的刻蚀速率远高于水平方向,所以等离子体刻蚀能形成非等向性的刻蚀轮廓。釆用损伤机理刻蚀是一种接近于物理刻蚀的RIE工艺。下图显示了非等向性刻蚀的损伤机理。
电介质刻蚀包括二氧化硅、氮化硅和低左介质层刻蚀,是倾向于物理刻蚀的RIE技术。使用损伤机制的刻蚀如果要增强非等向性轮廓就必须增加离子轰击。低压和高射频采用重离子轰击,能够得到接近理想的垂直刻蚀轮廓。然而此举会使等离子体造成器件的损坏,尤其对于多晶硅栅刻蚀,因此一般常选择另一种离子轰击较少的非等向性刻蚀机制。
当发展单晶硅刻蚀时,在进行硅刻蚀之前,没有将二氧化硅硬遮蔽层图形化的光刻胶去除(一般要求硅刻蚀之前先去光刻胶以避免污染),接着刻蚀的结果导致了另一种非等向性刻蚀机制,这就是阻挡机制。在等离子体刻蚀工艺中,离子轰击会溅镀一些光刻胶进入空洞中。当光刻胶沉积在侧壁时就阻挡侧壁方向的刻蚀,沉积在底层的光刻胶会逐渐被等离子体的离子轰击移除,所以使底部的晶圆表面暴露在刻蚀剂中,因此这种刻蚀过程以垂直方向为主(见下图)。
这种刻蚀很长时间被用来发展各种非等向性刻蚀技术,如非等向性刻蚀中所产生的化学沉积物将会保护侧壁,并且阻挡水平方向的刻蚀。使用阻挡机制的刻蚀所需的离子轰击比使用损伤机制少,从而可以达到非等向刻蚀的目的。单晶硅刻蚀、多晶硅刻蚀和金属刻蚀一般都釆用这种机制,它们属于接近化学刻蚀的RIE过程。对于侧壁的沉积物则需要通过干法/湿法清洗,或者二者并用的清洗方式来处理。
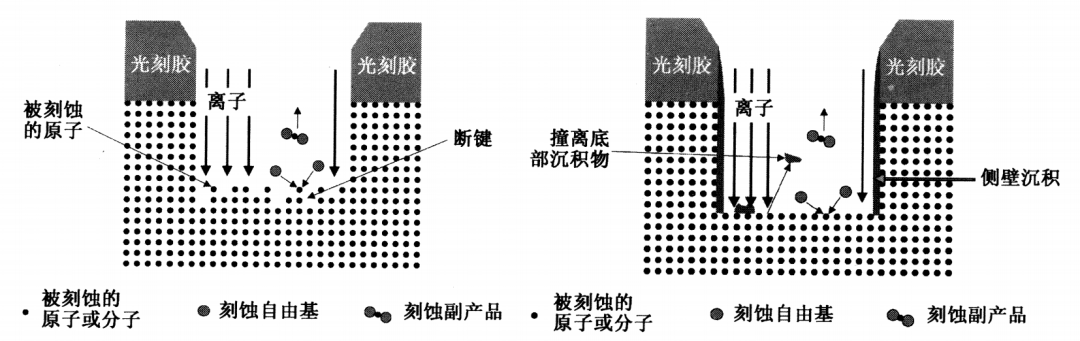
审核编辑:刘清
-
半导体
+关注
关注
339文章
31236浏览量
266502 -
晶圆
+关注
关注
53文章
5449浏览量
132757 -
光刻胶
+关注
关注
10文章
357浏览量
31857
原文标题:半导体行业(一百五十七)之刻蚀工艺(八)
文章出处:【微信号:FindRF,微信公众号:FindRF】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
comsol电化学燃烧电池,等离子体,光电年会
TDK|低温等离子体技术的应用
等离子体应用
中微等离子体刻蚀设备Primo AD-RIE(TM)运抵中芯国际
中微推出电感耦合等离子体刻蚀设备用于批量生产存储芯片和逻辑芯片前道工序
中微半导体自主研制的5纳米等离子体刻蚀机获台积电验证
中微发布了第一代电感耦合等离子体刻蚀设备
低温等离子体技术的应用




 半导体制造中的等离子体刻蚀过程
半导体制造中的等离子体刻蚀过程








评论