最近有人问我光刻胶曝光的原理和正负光刻胶的主要组分是什么,我也只是知道是这么一回事,但是里面包含许多专有名词还是挺拗口的,反正我是不想去记它。
今天刚好找了一下以前的笔记,大家可以复习一下,写材料的时候也能从copy一下。
首先,是光刻的工序
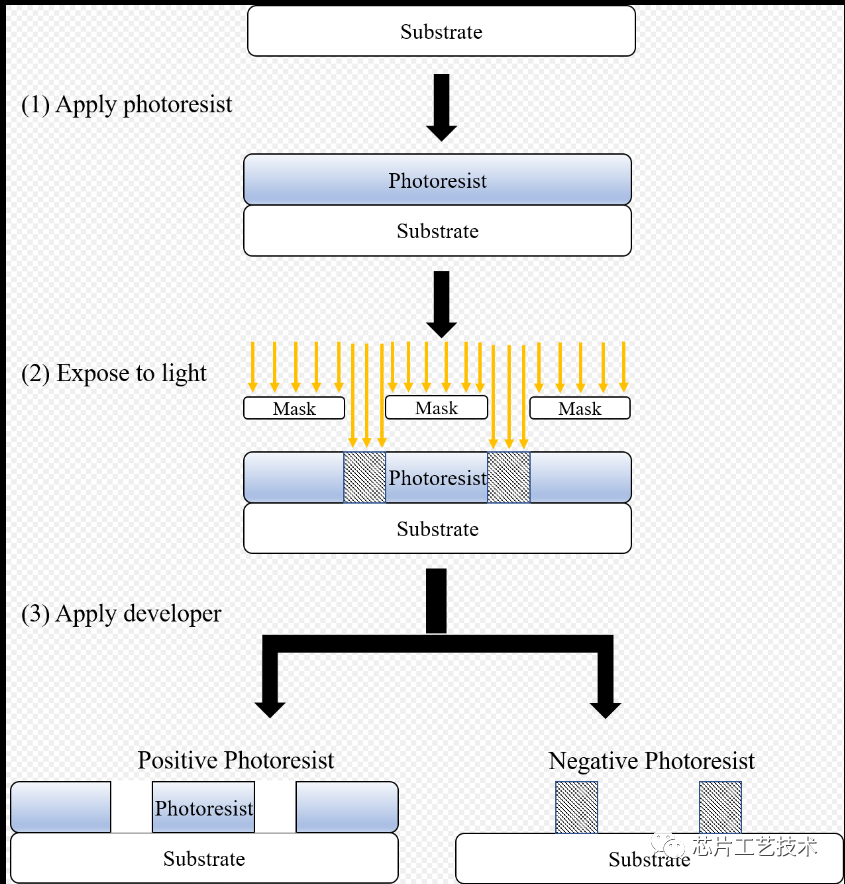
光刻胶分两种,一种正光刻胶、一种负光刻胶,出来的效果图如上。
①正性光致抗蚀剂:受光照部分发生降解反应而能为显影液所溶解。留下的非曝光部分的图形与掩模版一致。正性抗蚀剂具有分辨率高、对驻波效应不敏感、曝光容限大、针孔密度低和无毒性等优点,适合于高集成度器件的生产。②负性光致抗蚀剂:受光照部分产生交链反应而成为不溶物,非曝光部分被显影液溶解,获得的图形与掩模版图形互补。负性抗蚀剂的附着力强、灵敏度高、显影条件要求不严,适于低集成度的器件的生产。
光刻胶的组成:树脂(resin/polymer),光刻胶中不同材料的粘合剂,给与光刻胶的机械与化学性质(如粘附性、胶膜厚度、热稳定性等);感光剂,感光剂对光能发生光化学反应;溶剂(Solvent),保持光刻胶的液体状态,使之具有良好的流动性;添加剂(Additive),用以改变光刻胶的某些特性,如改善光刻胶发生反射而添加染色剂等。
例如台湾的一款正胶成分如下

负性光刻胶。树脂是聚异戊二烯,一种天然的橡胶;溶剂是二甲苯;感光剂是一种经过曝光后释放出氮气的光敏剂,产生的自由基在橡胶分子间形成交联。从而变得不溶于显影液。负性光刻胶在曝光区由溶剂引起泡涨;曝光时光刻胶容易与氮气反应而抑制交联。
例如一款负胶的主要成分:

正性光刻胶。树脂是一种叫做线性酚醛树脂的酚醛甲醛,提供光刻胶的粘附性、化学抗蚀性,当没有溶解抑制剂存在时,线性酚醛树脂会溶解在显影液中;感光剂是光敏化合物(PAC,Photo Active Compound),最常见的是重氮萘醌(DNQ),在曝光前,DNQ 是一种强烈的溶解抑制剂,降低树脂的溶解速度。在紫外曝光后,DNQ 在光刻胶中化学分解,成为溶解度增强剂,大幅提高显影液中的溶解度因子至 100 或者更高。这种曝光反应会在 DNQ 中产生羧酸,它在显影液中溶解度很高。正性光刻胶具有很好的对比度,所以生成的图形具有良好的分辨率。

光刻胶原料中,虽树脂质量占比不高,但其控制光刻胶主要成本。ArF树脂以丙二醇甲醚醋酸酯为主, 质量占比仅 5%-10%,但成本占光刻胶原材料总成本的 97% 以上。



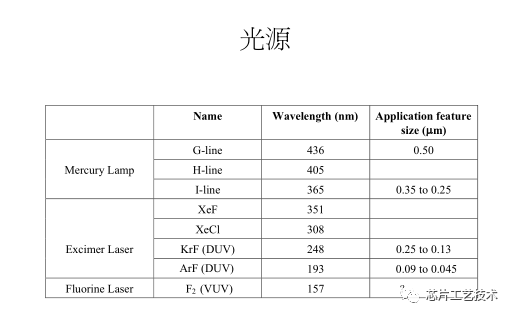
半导体工艺中右一种lift-off工艺,很多人也做过
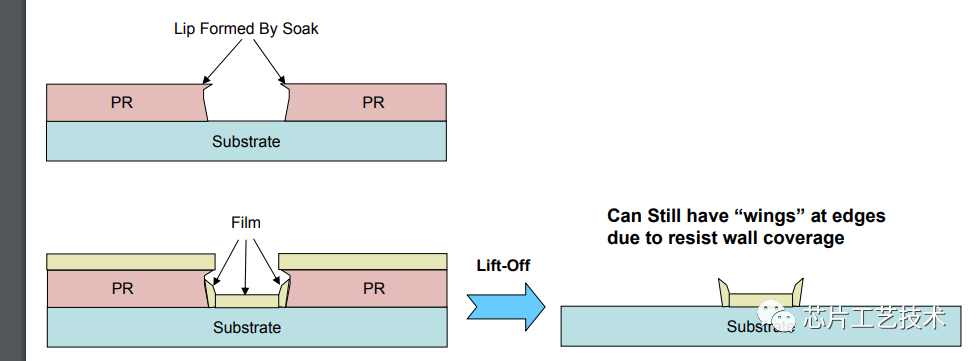
这种就是一种异常情况,会出现毛刺黑丝等异常。
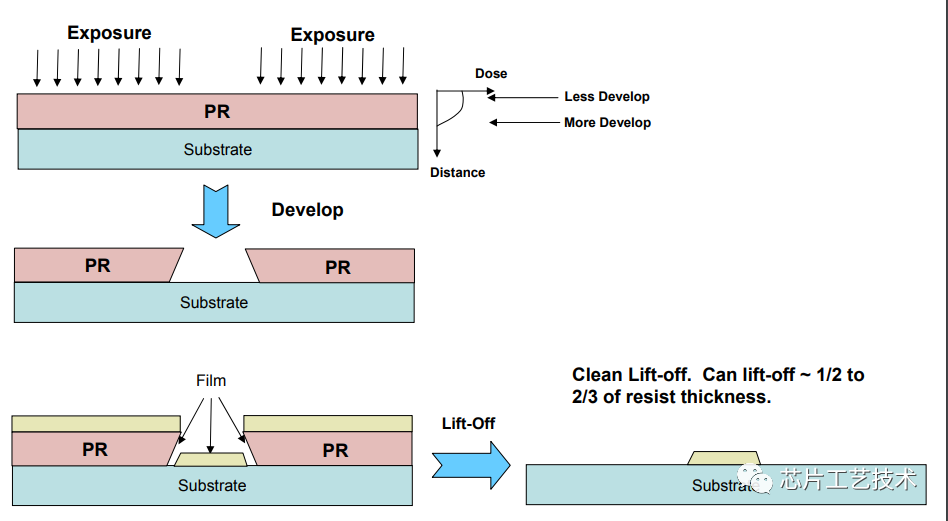
审核编辑:郭婷
-
半导体
+关注
关注
339文章
31203浏览量
266366 -
光刻胶
+关注
关注
10文章
356浏览量
31855
原文标题:【半导光电】光刻胶的成分和光刻原理
文章出处:【微信号:今日光电,微信公众号:今日光电】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
Futurrex高端光刻胶
光刻胶残留要怎么解决?
Microchem SU-8光刻胶 2000系列
光刻胶
光刻胶在集成电路制造中的应用
光刻胶板块的大涨吸引了产业注意 ,国产光刻胶再遇发展良机?
光刻胶黏度如何测量?光刻胶需要稀释吗?
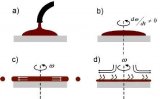
光刻胶分类与市场结构

光刻胶的保存和老化失效
光刻胶剥离工艺




 光刻胶的原理和正负光刻胶的主要组分是什么
光刻胶的原理和正负光刻胶的主要组分是什么






评论