包括汽车、工业、数据中心和能源行业在内的多种电子应用对大功率设备的需求正在增加。如今,功率器件必须满足高效率、高功率密度、低功耗和出色的热管理等严格要求。为了成功应对这些挑战,在芯片制造过程中需要更高纵横比结构的跨晶圆均匀性。通过使用非常精确和均匀的深硅蚀刻工艺,可以在不影响所需外形尺寸的情况下实现这些先进的器件结构。
芯片制造商正面临着对特殊器件不断增长的需求,包括功率器件、微机电系统、模拟和混合信号半导体、射频 IC 解决方案、光电器件和CMOS 图像传感器,能够支持广泛的消费和工业应用,如电动汽车、物联网、5G等。
Lam Research 推出 Syndion GP
半导体行业创新晶圆制造设备和服务的全球供应商 Lam Research Corporation 最近宣布推出 Syndion GP,这是一种新产品,允许芯片制造商使用深硅蚀刻技术开发下一代功率器件和电源管理 IC。
“在 Lam Research,我们有自己的工程和工艺开发来支持这些专业技术,”战略营销高级总监 Michelle Bourke 和战略营销董事总经理 David Haynes 说,他们都是 Lam Research 客户支持业务集团的一部分。“我们今天关注的是基于硅的功率器件和电源管理 IC。”
Lam Research 是等离子蚀刻和沉积工具以及用于制造半导体(包括先进的功率半导体器件)的单晶片清洁解决方案的制造商。据 Lam Research 称,这些天来,宽带隙半导体受到了很多关注,例如氮化镓和碳化硅,该公司也涉足这些领域。然而,迄今为止,硅基功率器件是当今市场上最大的一部分,并且在传统 MOSFET、超级结 MOSFET、IGBT 和模拟 IC 等功率器件上仍有许多先进的发展。
今天,大多数 FET 已从平面结构迁移到沟槽栅极,从性能的角度来看,其结构和制造至关重要。同时,有从 200 毫米晶圆制造转向 300 毫米晶圆制造的趋势,从而降低了总体成本并利用了领先的先进设备。图 1 显示了使用 Syndion GP 处理的晶圆。
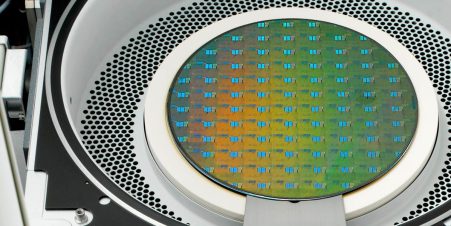
图 1:Lam Research 设备上的晶圆(来源:Lam Research)
“我们推出了 Syndion GP 来应对这些关键挑战,”Bourke 和 Haynes 说。“这款新产品将使我们的客户能够进行 200 毫米或 300 毫米晶圆制造,从而使他们能够顺利过渡到更高的产能以及改进的技术能力。”
大多数先进的基于硅的设备需要更高的功率密度和改进的开关性能,而不会影响外形尺寸。这一要求可以通过转向更高纵横比的沟槽来解决,这需要精确和均匀的深硅蚀刻工艺来创建沟槽。这些深沟槽是非常密集的平行线阵列,由亚微米垂直侧壁隔开。如图 2 所示,深沟槽的纵横比可以达到 60:1(甚至更高),因此需要出色的蚀刻均匀性和轮廓。只是给你一个概念,哈利法塔(世界上最高的建筑之一)的纵横比约为 9:1,仅为深硅沟槽纵横比的六分之一。

图 2:深沟的几何形状对性能至关重要。(来源:林研究)
这些结构的蚀刻控制非常重要。在前几代 IGBT 中,器件制造过程中蚀刻过程中涉及的硅面积相对较低——仅为晶圆尺寸的 10% 到 15%。在这些能够处理更高功率密度的先进结构中,蚀刻硅的面积可能是晶圆表面的 50% 甚至 60%,这给芯片制造商带来了技术挑战。
“随着从 200 到 300 毫米晶圆的这种迁移,在更大的晶圆上实现所需的均匀性变得更加困难:您不仅需要达到 300 毫米,而且还需要您的设备良率非常好,这就是我们能够通过开发特定解决方案(例如 Syndion GP)来解决这些应用程序所提供的,”Bourke 和 Haynes 说。
Syndion GP 汇集了 Lam Research 技术的许多要素。它可以通过控制深硅蚀刻工艺或 DRIE 工艺的自由基和离子的分布来实现对整个晶片的等离子体的非常好的控制。
由于历史上大部分硅基器件都是在 200 毫米晶圆上制造的,因此如今的产能有限,因为大多数 200 毫米晶圆厂已满。
“200 毫米设备的短缺是我们的客户转向 300 毫米设备的原因之一,从而为产能提供了更多选择,”Bourke 和 Haynes 说。“我们想要一种足够灵活的工具来处理 200 和 300 毫米晶圆,并且能够处理传统的 MOSFET、IGBT、超级结 MOSFET 和智能电源应用,所有这些都只需要一个腔室技术。”
Lam Research 的发言人表示,硅基器件将在很长一段时间内与宽带隙材料(SiC 和 GaN)共存。仍然有很多关于硅的先进研究来提高 IGBT 或超级结 MOSFET 的性能,使它们能够在更高的电压和更高的频率下工作。如果转向 300 毫米将推动制造能力的经济性和可用性,则需要改进过程控制。
“这正是我们在推出新产品时一直关注的重点,”Bourke 和 Haynes 说。“我们认为,将这些更先进和大批量的制造工具用于制造硅基功率器件将有助于在未来很长一段时间内延长这些技术的寿命。”
审核编辑 黄昊宇
-
半导体
+关注
关注
339文章
31294浏览量
266869 -
功率器件
+关注
关注
43文章
2227浏览量
95525 -
蚀刻
+关注
关注
10文章
431浏览量
16691
发布评论请先 登录
onsemi FFSH10120A-F085碳化硅肖特基二极管:下一代功率半导体的佼佼者
安森美FFSH20120A - F085碳化硅肖特基二极管:下一代功率半导体的佼佼者
安森美FFSH30120ADN - F155碳化硅肖特基二极管:下一代功率半导体的佼佼者
onsemi FFSH2065B - F155碳化硅肖特基二极管:下一代功率半导体的卓越之选
Kapsch TrafficCom借助TomTom Traffic打造下一代智能出行产品
DirectScan 技术解析:下一代半导体电子束检测的创新路径与应用

安森美携手格罗方德开发下一代氮化镓功率器件
安森美SiC器件赋能下一代AI数据中心变革
Telechips与Arm合作开发下一代IVI芯片Dolphin7
用于下一代 GGE 和 HSPA 手机的多模式/多频段功率放大器模块 skyworksinc

适用于下一代 GGE 和 HSPA 手机的多模/多频段 PAM skyworksinc




 深硅蚀刻技术使下一代功率器件成为可能
深硅蚀刻技术使下一代功率器件成为可能





评论