IGBT模块是新一代的功率半导体电子元件模块,诞生于20世纪80年代,并在90年代进行新一轮的改革升级,通过新技术的发展,现在的IGBT模块已经成为集通态压降低、开关速度快、高电压低损耗、大电流热稳定性好等等众多特点于一身,而这些技术特点正式IGBT模块取代旧式双极管成为电路制造中的重要电子器件的主要原因。
近些年,电动汽车的蓬勃发展带动了功率模块封装技术的更新迭代。目前电动汽车主逆变器功率半导体技术,代表着中等功率模块技术的先进水平,高可靠性、高功率密度并且要求成本竞争力是其首先需要满足的要求。
01 功率器件模块封装结构演进趋势
IGBT作为重要的电力电子的核心器件,其可靠性是决定整个装置安全运行的最重要因素。由于IGBT采取了叠层封装技术,该技术不但提高了封装密度,同时也缩短了芯片之间导线的互连长度,从而提高了器件的运行速率。传统Si基功率模块封装存在寄生参数过高,散热效率差的问题,这主要是由于传统封装采用了引线键合和单边散热技术,针对这两大问题,SiC功率模块封装在结构上采用了无引线互连(wireless interconnection)和双面散热(double-side cooling)技术,同时选用了导热系数更好的衬底材料,并尝试在模块结构中集成去耦电容、温度/电流传感器以及驱动电路等,研发出了多种不同的模块封装技术。
01 直接导线键合结构(DLB)
直接导线键合结构最大的特点就是利用焊料,将铜导线与芯片表面直接连接在一起,相对引线键合技术,该技术使用的铜导线可有效降低寄生电感,同时由于铜导线与芯片表面互连面积大,还可以提高互连可靠性。三菱公司利用该结构开发的IGBT模块,相比引线键合模块内部电感降低至57%,内部引线电阻减小一半。
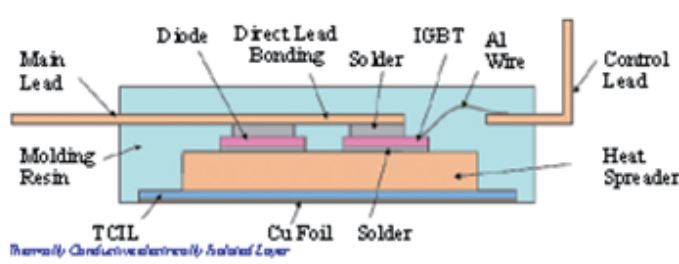
DLB结构
02 SKiN结构
SKiN模块结构也是一种无引线键合的结构,它采用了双层柔软的印刷线路板同时用于连接MOSFET和用作电流通路。
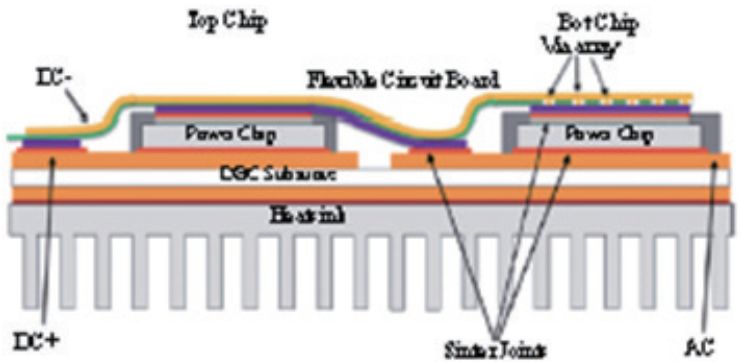
SKiN结构
03 2.5D和3D模块封装结构
为进一步降低寄生效应,使用多层衬底的2.5D和3D模块封装结构被开发出来用于功率芯片之间或者功率芯片与驱动电路之间的互连。在2.5D结构中,不同的功率芯片被焊接在同一块衬底上,而芯片间的互连通过增加的一层转接板中的金属连线实现,转接板与功率芯片靠得很近,需要使用耐高温的材料,低温共烧陶瓷(LTCC)转接板常被用于该结构,下图为一种2.5D模块封装结构。
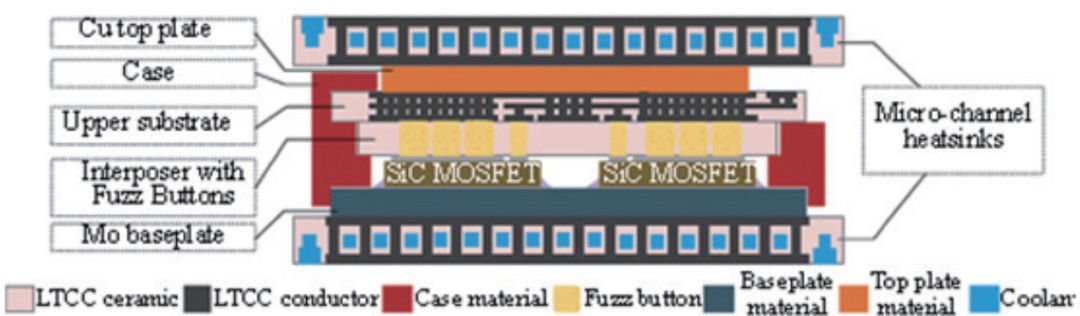
2.5D模块封装结构
而在3D模块封装结构中,两块功率芯片或者功率芯片和驱动电路通过金属通孔或凸块实现垂直互连,下图是一种利用紧压工艺(Press-Pack)实现的3D模块封装,这种紧压工艺采用直接接触的方式而不是引线键合或者焊接方式实现金属和芯片间的互连,该结构包含3层导电导热的平板,平板间放置功率芯片,平板的尺寸由互连的芯片尺寸以及芯片表面需要互连的版图结构确定,整个结构的厚度一般小于5mm。

采用紧压工艺的3D模块封装结构
下图是另一种3D模块封装结构,该结构通过低温共烧陶瓷工艺,实现了功率芯片和驱动电路的垂直互连,该结构还可以方便地将被动元件集成在低温共烧陶瓷衬底上。
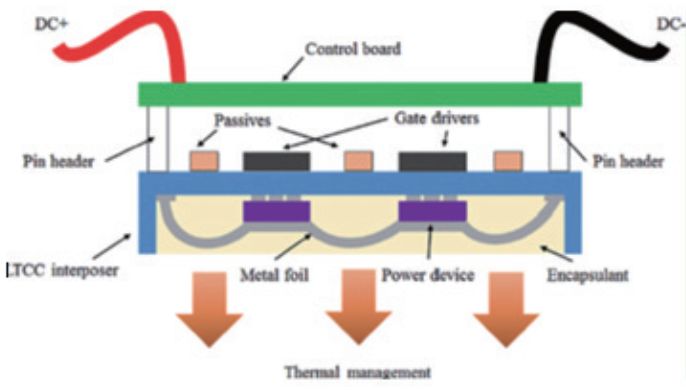
3D模块封装结构
02 IGBT模块封装流程简介
1、丝网印刷:将锡膏按设定图形印刷于散热底板和DBC铜板表面,为自动贴片做好前期准备 印刷效果;
2、自动贴片:将IGBT芯片与FRED芯片贴装于DBC印刷锡膏表面;
3、真空回流焊接:将完成贴片的DBC半成品置于真空炉内,进行回流焊接;
4、超声波清洗:通过清洗剂对焊接完成后的DBC半成品进行清洗,以保证IGBT芯片表面洁净度满足键合打线要求;
5、X-RAY缺陷检测:通过X光检测筛选出空洞大小符合标准的半成品,防止不良品流入下一道工序;
6、自动键合:通过键合打线,将各个IGBT芯片或DBC间连结起来,形成完整的电路结构;
7、激光打标:对模块壳体表面进行激光打标,标明产品型号、日期等信息;
8、壳体塑封:对壳体进行点胶并加装底板,起到粘合底板的作用;
9、功率端子键合
10、壳体灌胶与固化:对壳体内部进行加注A、B胶并抽真空,高温固化 ,达到绝缘保护作用;
11、封装、端子成形:对产品进行加装顶盖并对端子进行折弯成形;
12、功能测试:对成形后产品进行高低温冲击检验、老化检验后,测试IGBT静态参数、动态参数以符合出厂标准 IGBT 模块成品。
功率半导体模块封装是其加工过程中一个非常关键的环节,它关系到功率半导体器件是否能形成更高的功率密度,能否适用于更高的温度、拥有更高的可用性、可靠性,更好地适应恶劣环境。功率半导体器件的封装技术特点为:设计紧凑可靠、输出功率大。其中的关键是使硅片与散热器之间的热阻达到最小,同样使模块输人输出接线端子之间的接触阻抗最低。
审核编辑 :李倩
-
封装技术
+关注
关注
12文章
605浏览量
69396 -
功率器件
+关注
关注
43文章
2268浏览量
95635
原文标题:揭秘:IGBT模块封装与流程
文章出处:【微信号:today_semicon,微信公众号:今日半导体】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
感应加热电源的拓扑架构演进与SiC功率模块及驱动系统的价值分析报告

电镀电源拓扑架构演进与SiC功率模块及驱动技术的深度价值分析报告

固态变压器SST技术演进中的飞跨电容三电平架构趋势与SiC碳化硅模块应用
浮思特 | SiC功率器件在直流充电桩PFC模块中的应用趋势与实践

倾佳电子大功率工业风机变频器的技术发展趋势及碳化硅(SiC)模块的演进价值分析




 功率器件模块封装结构演进趋势
功率器件模块封装结构演进趋势










评论