光刻胶在做完后续成形工艺之后,PR就不需要了,而且还要去除的很干净,减少多后续工艺的影响。
去除光刻胶的方法主要有干法和湿法,湿法是主流,但是对于一些ICP或者离子注入工艺后发生“硬化”的光刻胶,湿法就会出现去胶不干净的情况。
因此就有了干法刻蚀去除光刻胶的技术,从20世纪70年代末开始,干法工艺采用灰化Ashing来去除光刻胶。

灰化,简单的理解就是用氧气把光刻胶燃烧掉,光刻胶的基本成分是碳氢有机物,在射频或微波作用下,氧气电离成氧原子并与光刻胶发生化学反应,生成一氧化碳,二氧化碳和水等,再通过泵被真空抽走,完成光刻胶的去除。
在干法去除机中,等离子体由微波,射频和UV臭氧源共同作用产生。
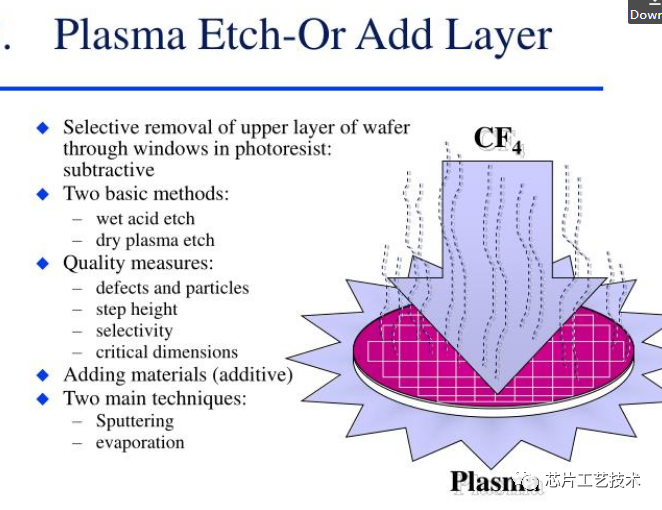
也有用CF4的。
工艺条件也和设备不同有关,一般处理10min~20分钟,根据产品特性而定,
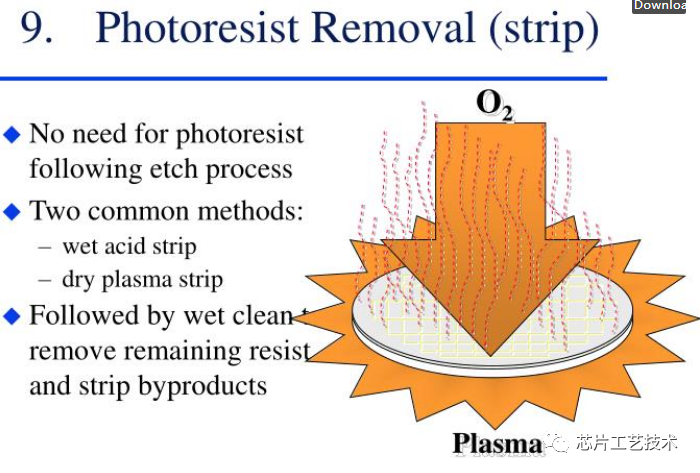
有时候也先用干法刻蚀去胶再用湿法去胶清洗。
但是有时候还是不能去除干净,就只能用笨方法擦了,大家有什么好方法也可以互相交流。
审核编辑 :李倩
-
光刻胶
+关注
关注
10文章
348浏览量
31543 -
刻蚀
+关注
关注
2文章
217浏览量
13679
原文标题:如何去除光刻胶
文章出处:【微信号:dingg6602,微信公众号:芯片工艺技术】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
光刻胶剥离工艺

国产光刻胶突围,日企垄断终松动
针对晶圆上芯片工艺的光刻胶剥离方法及白光干涉仪在光刻图形的测量

金属低刻蚀的光刻胶剥离液及其应用及白光干涉仪在光刻图形的测量

减少光刻胶剥离工艺对器件性能影响的方法及白光干涉仪在光刻图形的测量

【「芯片通识课:一本书读懂芯片技术」阅读体验】芯片怎样制造
干法刻蚀的概念、碳硅反应离子刻蚀以及ICP的应用

光刻胶成为半导体产业的关键材料
干法刻蚀时侧壁为什么会弯曲
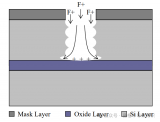





 干法刻蚀去除光刻胶的技术
干法刻蚀去除光刻胶的技术
















评论