摘要
随着越来越高的VLSIs集成度成为商业实践,对高质量晶片的需求越来越大。对于表面上几乎没有金属杂质、颗粒和有机物的高度洁净的晶片来说,尤其如此。为了生产高清洁度的晶片,有必要通过对表面杂质行为的实验和理论分析来建立晶片表面清洁技术。本文解释了金属和颗粒杂质在硅片表面的粘附机理,并提出了一些清洗方法。
介绍
LSI(大规模集成电路)集成密度的增加对硅片质量提出了更高的要求。更高质量的晶片意味着晶体精度、成形质量和表面质量的优异质量。必须考虑有关芯片尺寸增加和制造成本增加的问题。近年来已经讨论了300毫米晶片的实际应用。300毫米晶圆需要极高的表面清洁度(参见图1)。有机杂质以及传统杂质(如金属和颗粒)的质量标准已经开始制定。这些杂质产生于晶片制造设备、化学品、人体、洁净室材料、无尘服装和反应产物,并且经常沉积在晶片表面”。
它们导致互连故障和晶体缺陷,然后退化设备性能。为此,硅晶片的表面清洁度不断提高。
为了满足这些要求,重要的是从理论上分析发生在硅片表面上的现象,并根据理论分析的结果进行工艺设计。本报告特别讨论了金属和颗粒在晶片表面的粘附机理,并介绍了基于我们理论研究的新的清洗方法。
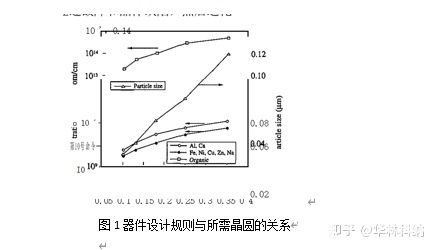
金属在硅片表面的吸附机理
由于硅晶片表面上的铁会导致晶体缺陷并降低器件性能,因此应该尽可能多地去除铁。Henley等人指出,对于8 nm厚的栅极氧化物,需要10'0 cm '的铁污染水平。像铁一样,其他金属(例如,镍、铬、铜、锌和钠)会降低器件性能(或者改变晶体管阈值,诱发晶体缺陷以降低pn结泄漏和栅极氧化物完整性,或者加速氧化)。他们一定是以满足不断缩小的设备尺寸。为了去除这些金属或控制它们在清洗溶液中的吸附,有必要了解它们在清洗溶液中的行为。
清洗溶液中的金属吸附有两种主要机制。一种是化学吸收,如金属在碱性溶液中吸附到天然氧化物(SiO)上。另一种是酸性溶液中裸露硅的电化学吸附。为了理解这些机制,我们进行了离子平衡分析和电化学分析。
2.1离子平衡分析
NH,OH+HCO+HCO混合物(APM)也称为“标准清洗溶液1 (SC-1 )”,是一种代表性的碱性清洗溶液,具有极其优异的颗粒去除能力,因此被广泛使用。然而,如果清洗溶液中存在金属离子,它们会吸附在晶片表面”。尤其是,当铁以少于十亿分之几(ppb)的痕量存在时,会降低电性能如复合寿命、I。当它是从前一道工序中遗留下来的,或者当使用低纯度的化学品时,就会产生严重的问题。
SC-1清洗液中的金属吸附通常用金属氧化物生成焓或络合离子模型来解释,但很少进行定量讨论。根据化学平衡理论对这一问题进行了分析”。
在SC-1清洗液中,通过过氧化氢形成自然氧化物(SiO2)和通过碱蚀刻SiO2同时进行。由于这个原因,整个晶片的厚度慢慢地减小减少,但一定厚度的SiO,存在于晶圆片表面,与时间无关。在这种情况下,如果蚀刻速率足够慢,并且金属吸附和解吸反应足够快,则在一氧化硅和溶液之间保持一定的金属离子吸附平衡。实际上,由于SC-1清洗溶液对二氧化硅的蚀刻速率是每分钟几个单层,而金属的吸附量在晶片浸没后一秒钟内达到恒定值,所以可以认为这种平衡是成立的。给定温度下溶液中金属离子浓度与吸附量的关系称为“吸附等温线”。图2显示了299氢氧化铵、31%过氧化氢和去离子水的1:1:5混合物在80℃温度下的吸附等温线。

结论
上面已经讨论了金属吸附和颗粒粘附机理。对这些粘附行为的分析有助于技术的发展,通过不断增加VLSIs的集成密度来实现更高的清洁度。20世纪70年代提出的RCA清洗工艺支持了目前的半导体工业。300毫米晶圆的出现将改变用于提高晶圆表面清洁度的清洁方法。为了适应这种变化,有必要在原子水平上分析和控制硅片表面发生的反应。这种努力将导致技术突破的发现和半导体工业的进一步发展。
审核编辑 黄昊宇
-
硅晶片
+关注
关注
0文章
74浏览量
15645 -
清洗作业
+关注
关注
0文章
2浏览量
5979
发布评论请先 登录
硅晶片清洗方式的详细说明
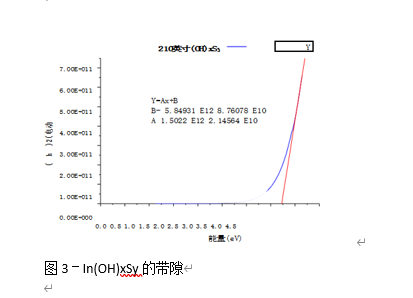
关于硅晶片研磨之后的清洗工艺介绍
半导体工艺—晶片清洗工艺评估
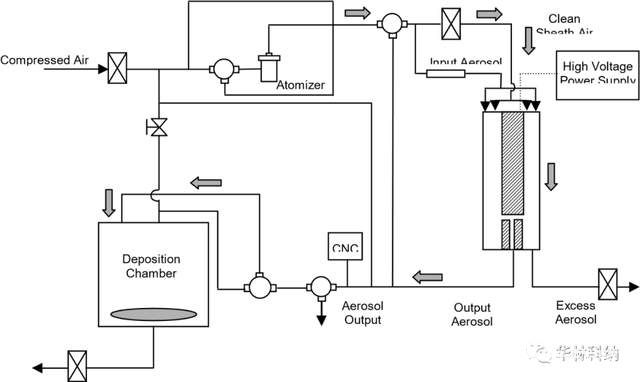
晶片清洗及其对后续纹理过程的影响

新型全化学晶片清洗技术详解
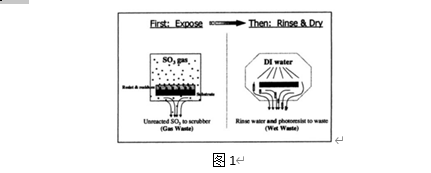
半导体制造过程中的硅晶片清洗工艺
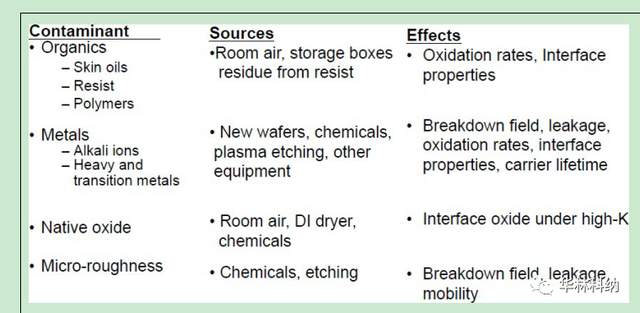
湿式化学清洗过程对硅晶片表面微粒度的影响

使用脉动流清洗毯式和图案化晶片的工艺研究

不同的湿法晶片清洗技术方法




 硅晶片的清洗技术
硅晶片的清洗技术

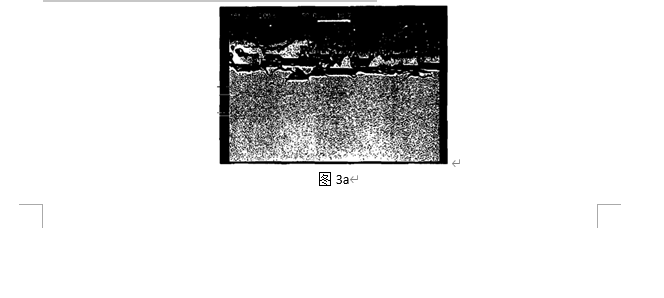
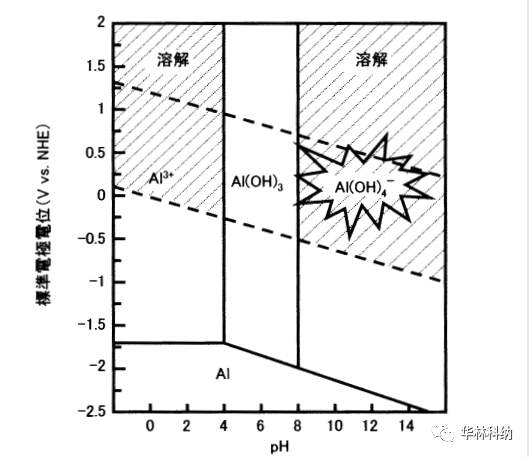
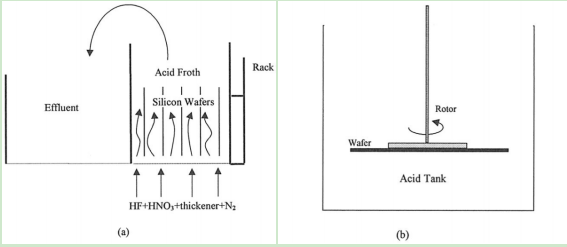





评论