引言
介绍了一种蚀刻后残留物清洗配方,该配方基于平衡氢氟酸的腐蚀性及其众所周知的残留物去除特性。在最初由基于高k电介质的残留物提供的清洁挑战所激发的一系列研究中,开发了一种配方平台,其成功地清洁了由氧化钽和类似材料的等离子体图案化产生的残留物,同时保持了金属和电介质的兼容性。这进一步表明,这种溶液的基本优点可以扩展到其它更传统的蚀刻后残留物的清洗,而不牺牲相容性,如通过对覆盖膜的测量和通过SEM数据所证明的。
关键词:蚀刻后残留物、选择性清洗、高K、HfOx、ZrOx、TaOx、铝、TaN、互连、Cap MIM、选择性非晶氧化物去除
介绍
自从用于半导体互连的等离子体图案化出现以来,用于等离子体蚀刻后残留物(PER)的清除的配方类型已经有了显著的发展。在等离子蚀刻变得突出之前,半导体工业中的湿法化学工艺主要局限于光刻胶剥离、湿法蚀刻和标准清洗。等离子体产生的残留物的出现(主要)是基于铝、钨和氧化硅的图案化,因此有必要创造新类别的清洁材料,其中一些来自溶剂和蚀刻剂,另一些基于全新的反应化学,例如基于羟胺的清洁化学,以及其他高度工程化的配方混合物。
类似地,受产品性能需求的驱动,半导体行业在其产品中采用了越来越多的材料。因此,在半导体制造过程中需要清洗的PER的种类随着时间的推移而增加,但在过去的一二十年中增长最快。没有改变的是对PER清洗化学物质的一系列要求,简单来说就是在经常出现敏感的金属和电介质材料的情况下去除不需要的残留物。这种去除需要在适中的温度下快速完成,使用易于冲洗、干燥和化学处理的无害成分,并且成本合理。
材料和工艺需求的激增可能导致各种各样的清洗化学物质,其中不同种类的化学物质被高度调整用于高度特定的工艺,例如Al线清洗、通孔清洗、铜镶嵌蚀刻后清洗、Ti蚀刻剂/清洗组合、需要与“稀有”金属如Co或Ru相容的清洗等。并且在某种程度上已经观察到这种清洁产品的扩散。
尤其具有挑战性的是在钽、锆和铪等高k材料的等离子体蚀刻过程中产生的PER的清洁[3]。这些挑战在早期对金属氧化物和硅酸盐进行构图以用作氧化硅的替代栅极电介质的工作中被观察到,并且随着这些类型的材料在MIM(金属-绝缘体-金属)中使用的增加而持续至今去耦和其他电容器和其他电路元件[4]。众所周知,这些物质具有很强的弹性,很难清除,当清洗过程中出现其他物质,尤其是铝等金属时,这一挑战就变得更加严峻。
因此,与难熔金属氧化物相关的清洁挑战是在更具化学反应性的金属和潜在的精密介电材料存在下去除PER并且更雄心勃勃地扩展能够应对这一挑战的化学制剂,以成功地实现其它清洁需求,例如上述那些。
解决这些挑战的最新工作证明了技术水平的显著提高,并通过精确控制氢氟酸水溶液与水和极性非质子溶剂的结合,建立了用于难熔金属基残留物的高选择性湿法化学清洗产品。因此,稀释的氢氟酸(DHF)经常被用作这些清洗过程中的活性成分

这项工作说明了这样做的可能性,通过仔细控制I)溶液pH;ii)水含量和iii)当与弱酸和弱碱配制时,明智地选择存在的旁观者抗衡离子,以提供常见的活性物质(主要是水合氢离子、H3O+和氟化物F-)。
最佳pH值和反离子效应的确定。

进一步的研究和化学筛选证实了一些强酸具有很强的能力,能够将pH值漂移到非常酸性的区域,从而提高高k基PER的蚀刻速率,同时提高整体铝兼容性(图1和图2)。此外,还观察到,根据酸的抗衡离子的性质、性质和大小,可以在金属相容性和选择性方面达到额外的性能。
低水环境中的蚀刻速率和清洗性能。针对不同的密度和掺杂剂量,描述并监测了含氢氟酸(HF)的低水含量溶液对HfO2和SiO2的蚀刻速率行为;例如,在文献[6]中报道,在7/1 DHF中,在35C下,TEOS的速度为12nm/min,溅射氧化物的速度为25-70nm/min[7]。为了进行比较,BOE 10% HF中的HfO2被蚀刻约3-5纳米/分钟,而铝被蚀刻超过100纳米/分钟,新的配方和成分微调允许保持HfO2的蚀刻速率,同时阻止DHF混合物中的Al侵蚀(表II:Al ER < 1.5纳米/分钟)。
为了扩大这种配方组合的应用空间,在25°c时,在现在商业上称为TechniClean IK 73的溶液中,为Ti和TiO2(图3)以及其他常见材料(表1)生成了类似的数据。
Ti和TiO2数据非常有趣,说明了IK 73提供的选择性以及可用于清洗Al/Ti基残留物的工艺窗口的确定。红线示出了覆盖层Ti的去除,并且表明在60秒多一点的时间内没有发生钝化型Ti的去除。相比之下,沉积态TiO2的去除几乎立即开始,因此在这种情况下(其中Ti和TiO2的厚度分别为x和y ),存在可用的工艺窗口(由垂直的蓝色虚线示出),在该窗口期间,在Ti钝化的侵蚀之前完全去除TiO2。虽然这些数据是关于橡皮布表面的,但是它们表明,结合表II中的值,这种方法对于通常被认为比涉及高k材料的清洗应用更敏感的清洗应用的适用性
审核编辑:符乾江
-
半导体
+关注
关注
336文章
30034浏览量
258697 -
蚀刻
+关注
关注
10文章
428浏览量
16468
发布评论请先 登录
设备身份唯一标识和基于数字证书的身份认证两种方案,在应用场景上有何侧重,分别适用于哪些类型的物联网设备?
SkyOne® Ultra 2.0 前端模块,适用于 WCDMA / LTE 频段 1、2、3、4、34、39 skyworksinc

工业级硅片超声波清洗机适用于什么场景
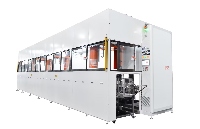
自动聚焦拉曼光谱技术在拉曼化学成像的应用

适用于 WLAN 和蓝牙®应用的 2.4 GHz 高效前端 skyworksinc


2.4 GHz 低功耗、扁平前端模块,带端口,适用于蓝牙®物联网应用 skyworksinc

电路板故障暗藏 “隐形杀手”:助焊剂残留该如何破解?

深入探讨 PCB 制造技术:化学蚀刻
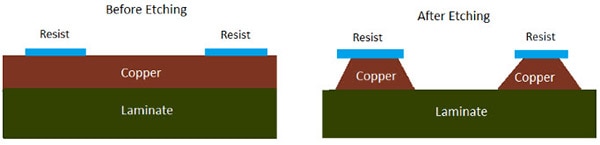
PCB线路板离子污染度的检测技术与报告规范






 适用于清洁蚀刻后残留物的定制化学成分(1)
适用于清洁蚀刻后残留物的定制化学成分(1)













评论