摘要
湿清洗后,用原子分辨扫描隧道显微镜对氢端Si表面进行观察。当将Si晶片浸入稀释的含高频溶液中时,通过堆积小梯田和台阶来构建表面。当用超纯水冲洗样品时,可以清楚地观察到一些特征,如露台内的锯齿状链、阶梯边缘的一行和露台上孤立的锯齿状链,并确定它们的原子排列。然而,过度的冲洗产生了纳米高度的脊状结构,这可以用水中氢氧化物离子的各向异性蚀刻来解释。
介绍
硅晶片是半导体器件的一种有前途的衬底,因为用自由基氧化法制备的硅的空穴迁移率已经达到硅的2.4倍。人们对采用硅衬底制造超大规模集成电路器件重新产生了兴趣。为了实现比现在更高性能的互补金属氧化物半导体电路,有必要平坦化栅极绝缘体和硅衬底之间的界面,因为界面粗糙度决定了金属氧化物半导体晶体管的载流子迁移率。为此,在形成栅极绝缘体之前,需要湿法清洗过程来用氢原子终止硅表面,并在原子尺度上将其平坦化。已经进行了许多尝试来研究各种湿法清洗工艺对原子尺度上的硅或硅的表面结构的影响。这项研究的目的是阐明原子氢封端的硅表面浸入稀含氟化氢溶液后的结构,即对硅片进行初步清洗,然后用超纯水冲洗。提出了一种获得原子级平坦氢封端硅表面的方法。
实验
在本研究中,所有样品都是n型硅,其电阻率为10伏厘米。在形成牺牲氧化物后,将每个样品浸入H2SO 4 97wt %的溶液中。 H2O230wt%重量=4:1(按体积计)10分钟,然后用超纯水冲洗10分钟。然后将每个样品浸入50wt %的氢氟烷烃溶液中。H2O2 s30%重量。H2O=1:1:98(按体积计)持续3分钟,以去除牺牲的氧化物并用氢原子终止表面(样品A)。因此,在湿法清洗过程中避免了硅表面的有机碳残留和金属污染。表面的疏水性或傅里叶变换红外光谱测量证实每个样品表面都是氢封端的。在湿法清洗过程的15分钟内,硅样品被引入超高真空(UHV)室。
图1显示了浸入含氟化氢的稀溶液后表面的典型扫描隧道显微镜图像(样品甲)。

结果和讨论
水中的氢氧离子会腐蚀硅表面。5–7图中的表面原子很可能处于高反应性位置。优先在用超纯水冲洗的短时间内被去除,以形成图1所示的表面结构。表面的放大图像(样品B)如图所示。其中扫描面积为7.037.0 nm2.形成阶梯和台阶的原子图像清晰可见。图2中的主要特征。
图5显示了在稀释的含HF溶液中清洗并随后用超纯水冲洗60分钟后Si样品的典型STM图像(样品c)。RPV和Rrms分别为1.65 nm和0.22 nm。沿着图110中的f 110g方向所获得的带有台阶和台阶的表面。图5与图1非常相似。2.然而,沿着f 110g方向的纳米高度的脊状结构,如图1中的箭头D所示。5、经常被观察。据报道,各向异性蚀刻在超纯水中进行,以显示硅或硅晶片上的面。很可能在60分钟的冲洗过程中,在硅表面上发生各向异性蚀刻以形成微相,这导致如图1中箭头D所示的脊状结构的形成。


结论
总之,氢封端的硅表面在浸入含氟化氢溶液中,然后用超纯水冲洗后,用扫描隧道显微镜在原子尺度上观察到。当硅晶片浸入含氢氟化合物溶液中时,其表面由沿不同方向排列的小平台和台阶构成。结果表明,用超纯水适度冲洗可形成均匀的硅表面,其微观粗糙度得到改善。即形成大的阶地,大部分台阶边缘沿f 110g方向延伸。另一方面,由于超纯水各向异性刻蚀出现微形貌,过度的清洗会使具有纳米高度脊状结构的硅表面粗糙化。这些结果表明,在用含氢溶液清洗后,硅晶片的清洗持续时间应得到控制,以获得原子级平坦的氢封端表面。
审核编辑:汤梓红
-
半导体
+关注
关注
339文章
31559浏览量
267975 -
晶体管
+关注
关注
78文章
10482浏览量
149025 -
蚀刻
+关注
关注
10文章
432浏览量
16723
发布评论请先 登录
湿法清洗和干法清洗,哪种工艺更适合先进制程的硅片

集成电路制造中常用湿法清洗和腐蚀工艺介绍

晶圆刻蚀清洗过滤:原子级洁净的半导体工艺核心
革新半导体清洗工艺:RCA湿法设备助力高良率芯片制造
衬底清洗全攻略:从湿法到干法,解锁半导体制造的“洁净密码”

湿法清洗尾片效应是什么原理
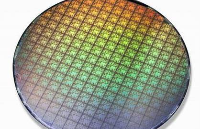
如何选择合适的湿法清洗设备

湿法刻蚀是各向异性的原因

晶圆清洗工艺有哪些类型




 湿法清洗后氢封端表面的原子级分析
湿法清洗后氢封端表面的原子级分析



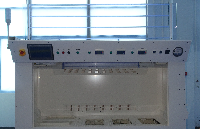




评论