报道,功率器件及第三代半导体是当前的半导体产业技术追逐的热点,也是国内半导体产业中最有希望能够赶超世界先进技术的领域之一。
当前,众多国产功率半导体厂商已经在材料、设计、制造、封测等各个环节成功突围,逐渐形成自主可控的完整产业链。然而,在产业最上游的高端封装设备领域,却仍以国外企业为主导,因此,加速推动功率半导体高端封装设备国产化进程已经刻不容缓。
功率半导体时代到来, Clip Bond封装大有可为
相对数字集成电路而言,功率半导体并不是单纯追求线宽的缩小,且生命周期长,市场空间大,可应用于几乎所有的电子制造业,包括工业控制、通信、消费电子、新能源、汽车、轨道交通、智能电网等。
可以预见的是,随着智能驾驶、智能制造、新基建等需求的爆发,未来5年全球功率半导体市场规模将保持增长。根据Omdia数据显示,预计2021年全球功率半导体市场规模将增长至441亿美元,到2024年将突破500亿美元。其中,2021年中国功率半导体市场规模将达到159亿美元,到2024年有望达到190亿美元。
作为全球最大的功率半导体消费国,经过多年自主研发和引进吸收外来技术,国内功率半导体领域的工艺能力不断突破,已经在功率二极管、三极管、晶闸管、中低压MOSFET、电源管理IC等领域具备一定竞争力。
同时,为了提高分立器件的成品率和可靠性,分立器件封测企业正在为新产品研发更先进的封装工艺及封装技术。
在大电流、高电压等应用场景需求催生下,以Clip Bond为代表的新型分立器件封装工艺迅速崛起,其具备提高电流承载能力、提升器件板级可靠性、有效降低器件热阻、提高封装效率等优势,已成为华润微等国内主流功率器件厂商掌握的主要封装工艺技术,并在工业控制、新能源汽车等领域广泛得到应用。
此外,5G网络、物联网等新兴领域的发展,也对功率半导体封装技术提出了新的要求,小型化、功能系统化、模块化封装成为了当前功率半导体封装技术发展的主要方向。
显然,为提高功率密度和优化电源转化,功率半导体封装工艺需在器件和模块两个层面实现技术突破,进而提高产品的性能和使用寿命。
顺势而为,推出完整Clip Bond工艺封装设备产品线
值得注意的是,作为新型的功率半导体封装工艺,Clip Bond和模块化封装虽然应用前景广阔,包括华润微、士兰微、华为、比亚迪、中车时代等国内主流功率器件厂商都在进行大规模的扩产,但由于下游市场需求激增,上游设备供应商的产能出现明显不足的情况。
集微网从国内杰出封装设备供应商普莱信处了解到,在全球疫情的干扰下,进口设备的交期已经拉长半年,甚至一年,封测厂根本没法拿到足够的设备。
对于半导体产业来说,市场变化非常快,谁也不能预料后续的市场情况。因此,能否快速拿到设备、扩产产能,进而抢占更多市场份额,对功率半导体厂商来说至关重要。
据了解,针对需要使用铜跳线工艺(Clip Bonding)的高功率半导体封装产线,客户需要购买Die Bonder(固晶机)、Clip Bonder以及真空炉设备,其中Die Bonder是整线设备的核心产品,技术难度较大,长期以来该市场都被ASMPT、Besi等厂商垄断,具备Clip Bonding工艺整线产品的厂商更是少之又少,整体市场基本被ASMPT垄断,且设备价格较高。
在此情况下,国内功率半导体市场亟需国产封装设备,让设备依赖进口的情况得到彻底改善。普莱信基于自身的Die Bonder设备优势和客户需求,开发了Clip Bonder设备和真空炉,成为市场上少数能提供车规级Clip Bond整线产品的封装设备。
“公司拥有成熟的Die Bonder设备,在8英寸设备方面,公司与进口设备精度和速度能保持一致,在12英寸设备方面,公司能做到精度与进口设备保持一致的情况下,工作效率高出30%。在Clip Bonder这一产品上,普莱信仍然保持高精和高速的特点,相对国际厂家,普莱信的Clip Bond产品线采用多点胶头,在保证和国际厂家相同精度的条件下,有更快的速度,相对国内厂家,普莱信能提供更高的精度,打破国产Clip Bond产品只能做低端分离器件的技术尴尬”普莱信市场经理李道东表示,公司设备交期为3-4个月,能为客户争取更多时间,确保扩产进度的高效推进。
写在最后
当前,国内半导体封装设备已经在部分要求不高的领域逐步完成国产替代,但在Clip Bond、第三代半导体模块化封装等新型功率半导体封装工艺方面,整体市场仍被进口设备占据。
伴随着半导体产业链向国内市场的转移,华润微、士兰微、华为、比亚迪、中车时代等都在进行大规模的扩产,为国内封装设备行业发展带来巨大的发展机遇。
资料显示,每年中国大陆对Clip Bond整线设备产品的市场规模约为10亿元,模块化封装设备产品更是达20亿元左右,这一数据还在持续增长。自成立以来,普莱信就立足于中高端市场,在此时推出性价比高,且交期稳定的Clip Bond整线产品,并积极布局第三代半导体模块化封装设备产品线,有望推动封装设备国产化率大幅提升,也能助力国内功率半导体厂商加速向先进封装领域升级。
审核编辑:汤梓红
-
集成电路
+关注
关注
5464文章
12695浏览量
375782 -
半导体
+关注
关注
339文章
31279浏览量
266689 -
封装
+关注
关注
128文章
9339浏览量
149058
发布评论请先 登录
芯驰科技全面展示三大产品线的最新成果
合科泰详解Clip封装如何重塑功率器件性能边界
沐曦股份正式推出曦索X系列全新GPU品牌与产品线
森国科发布两款创新TOLL+Cu-Clip封装SiC MOSFET产品

森国科创新推出PDFN8*8结合Cu-Clip封装碳化硅二极管

三星电子扩充2026年Micro RGB电视产品线
TE推出压阻式力传感器产品介绍-赫联电子
高速线设备和包带工艺介绍

Chiplet封装设计中的信号与电源完整性挑战

德承发表全新MAGNET产品线,为机器视觉打造高效能DIN-Rail嵌入式工控机

KAGA FEI扩展低功耗蓝牙模块产品线
普莱信成立TCB实验室,提供CoWoS、HBM、CPO、oDSP等从打样到量产的支持

MUN12AD03-SEC的封装设计对散热有何影响?
乐鑫科技产品线概览及 ESP32-C5 量产后的市场影响




 普莱信推出完整Clip Bond工艺封装设备产品线
普莱信推出完整Clip Bond工艺封装设备产品线

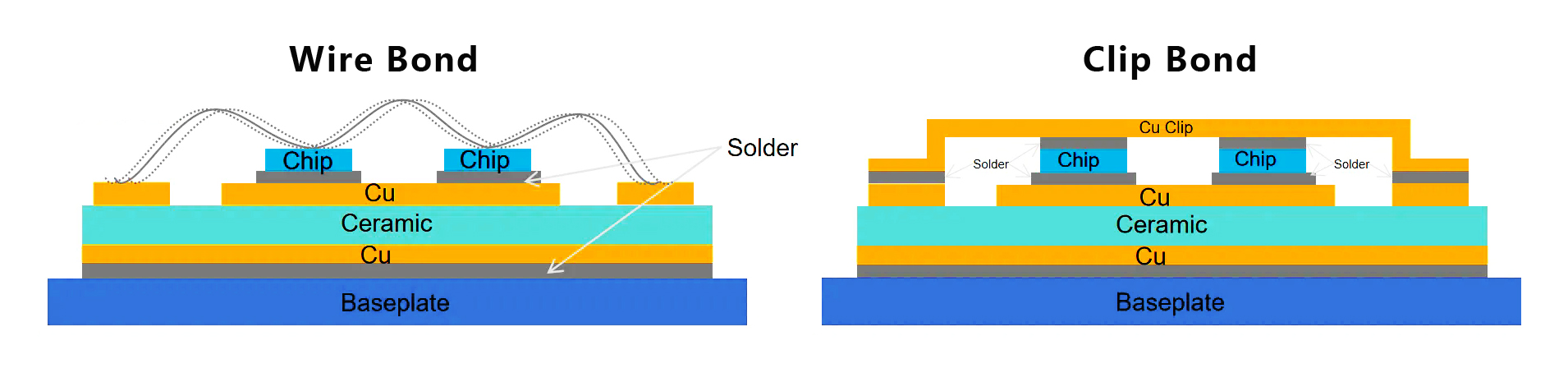



评论