通过逐步的说明,本系列说明并向您展示了确保在当今最先进的节点中确保布局保真度所需的自对准模式创建的复杂性。第1部分介绍了SADP和SAQP。在本期的最后一部分中,我们将向您介绍自对准光刻蚀刻光刻的基本知识(SALELE)。
销售
在“销售”过程中,不添加任何虚拟金属,并且仅在紧密的尖端到尖端间距位置处需要块。图1显示了SALELE的分解过程。输入目标(1a)分解为LE1_target和LE2_target(1b)。与SADP / SAQP流程一样,所有目标形状都必须具有对称的光栅,并与轨道完美对齐。但是,SALELE流程不会将目标行转换为SADP / SAQP之类的轨道。取而代之的是,仅将LE1_target形状或LE2_target形状上的目标线之间的紧密的尖端间距转换为形状,此处命名为LE1_Litho_Bias和LE2_Litho_Bias(形状的尺寸略微增大,以考虑光刻工艺的偏差)(1c)。为了消除添加虚拟金属(及其所产生的电容)的需要,目标形状之间的较大间隙被简单地保留了下来。
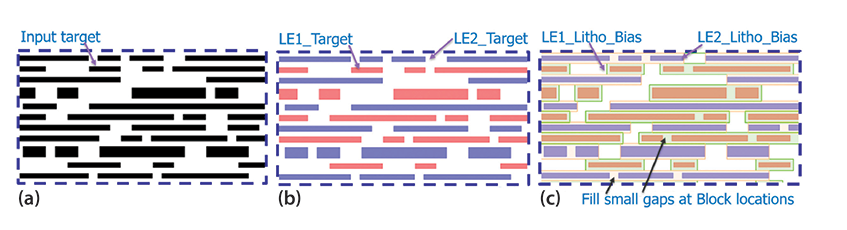
图1SALELE分解过程:(a)输入目标,(b)将输入目标分解为LE1_target和LE2_target,(c)通过填充紧密的尖端到尖端位置的间隙将LE1_target和LE2_target转换为最终的掩模形状(这些间隙将稍后被阻止遮罩阻止)。
在下一步中,将块形状添加到尖端到尖端的紧密位置,以在目标形状之间创建所需的隔离。SALELE进程使用两个SAB掩码,一个用于LE1_Target,另一个用于LE2_Target,每个掩码都使用前面所述的相同SAB进程。SALELE过程有两个间隙宽度约束。第一个是紧密的笔尖到笔尖的空间,它由块形状定义-该间隙宽度由可以打印的最小块宽度定义。第二个约束是在不添加任何块形状的位置处的最小间隙宽度,这由金属目标印刷过程的点对点光刻分辨率限制来定义,就像单个EUV掩模一样。
SALELE + SAB过程需要打印四个遮罩:两个目标遮罩(LE1和LE2)和两个块遮罩(LE1_block遮罩和LE2_block遮罩)。出于我们的目的,假定块掩膜为EUV暗场掩膜。
让我们仔细看一下SALELE制造过程的细节。由于复杂性,我们将分阶段完成所有步骤(图2-5)。
2a。打印(1c)中所示的LE1_Litho_Bias目标。使用PTD工艺,将图案转移到硬掩模上。执行额外的蚀刻工艺以创建沟槽的所需宽度,减小沟槽之间的空间并平滑线边缘粗糙度。
2b。将图案转移到基础层。现在创建的图案比2a中的图案更宽,彼此之间的空间更小,从而为将在其内部形成的间隔物腾出空间。使用ALD,进行保形沉积以构建第一侧壁。
2c。自上而下蚀刻到LE_1沟槽内边缘的电介质侧壁。
2d。沉积另一个硬掩模并涂覆光致抗蚀剂。
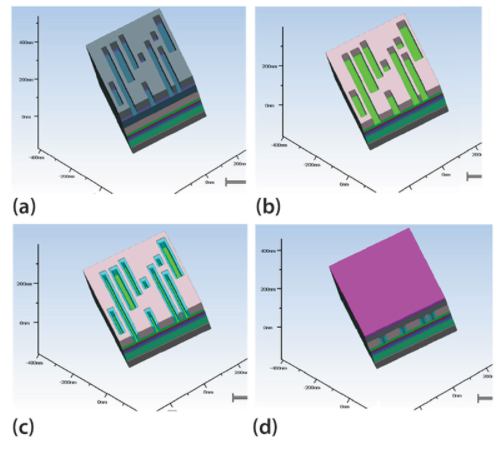
图2SALELE的制造过程:(a)LE1沟槽的硬掩模开口,(b)额外的蚀刻以扩大LE1沟槽,(c)侧壁沉积,(d)第二硬掩模和光刻胶涂层。使用SEMulator3D生成的图像[10]
3a。在光刻胶上打印第一块掩模图案,然后将其转移到第二个硬掩模上。为了去除光致抗蚀剂,去除未被侧壁或阻挡掩模覆盖的沟槽内的材料,并去除阻挡掩模形状的硬掩模。
3b。现在我们仅在防区遮罩位置具有底层(绿色材料)。
3c。分别沉积第三硬掩模和光刻胶。
3d。在光刻胶上打印第二块掩模并将其转移到其硬掩模上。
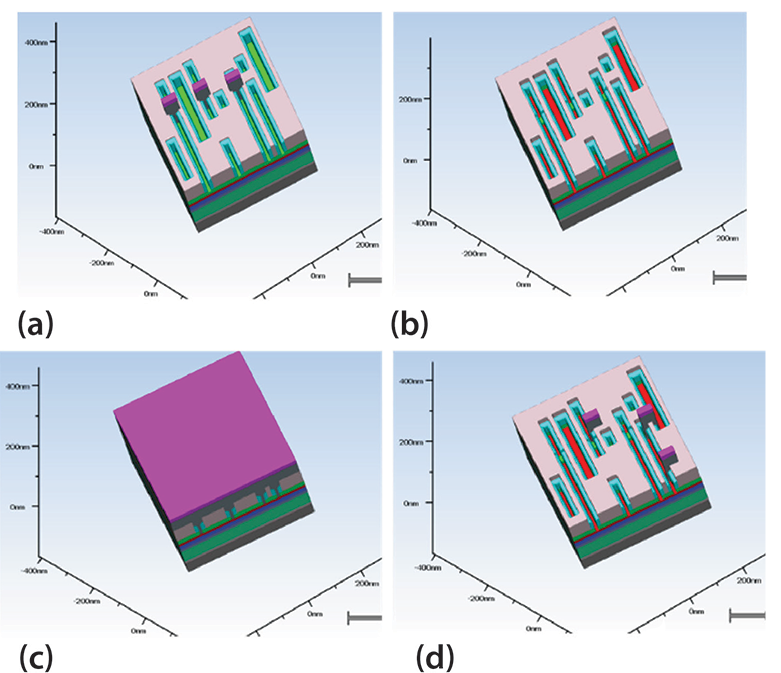
图3SALELE的制造过程:(a)打印第一块掩模并转移到其硬掩模,(b)将块掩模的形状转移到底层材料,(c)分别进行硬掩模和光刻胶沉积,(d)打印第二块掩模和转移到其硬掩膜。使用SEMulator3D生成的图像[10]
4a。刻蚀沟槽内的底层(红色材料),除第一个阻隔掩模位置以外的所有位置都将其去除,除第二个阻隔掩模位置以外的所有位置均去除第三个硬掩模。
4b。去除光刻胶和硬掩模以露出第二块掩模图案。
4c。分别沉积硬掩模和光刻胶。
4d。要打印图1c中所示的LE2_Litho_Bias目标,请使用PTD工艺将图案转移到光刻胶和其他硬掩模上。
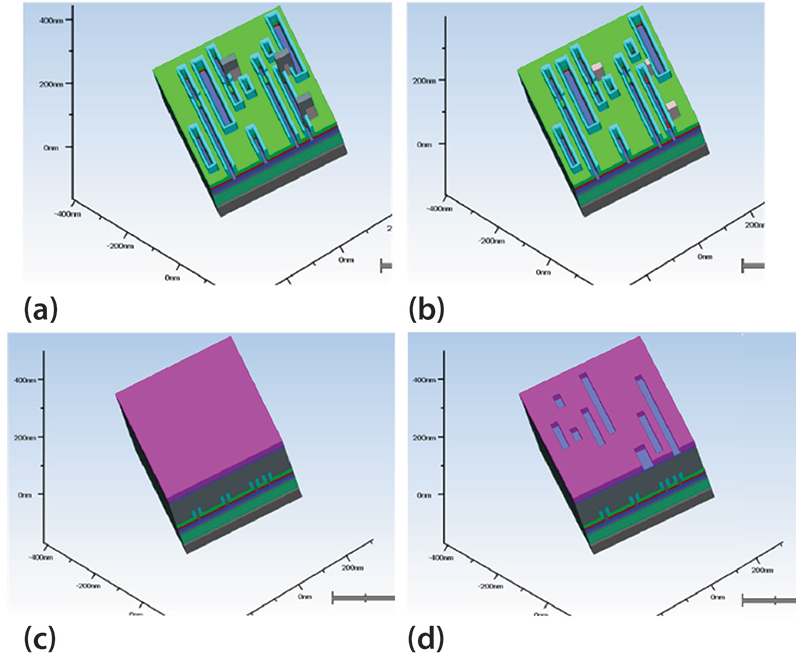
图4SALELE的制造过程:(a)刻蚀沟槽内的底层,(b)去除硬掩模后的第二块掩模图案,(c)分别沉积硬掩模和光刻胶,(d)将LE2转移到光刻胶上。使用SEMulator3D生成的图像[10]
5a。现在,我们有了LE_2沟槽,第二块遮罩已位于沟槽内部。
5b。去除硬掩模后的图案。
5c。去除LE_2沟槽位置的底层(红色材料)和第二块掩模硬掩模。
5天除去侧壁和硬掩膜。现在我们有了金属目标形状的最终沟槽(最终图案)。未被底层覆盖的所有物体都将填充金属。
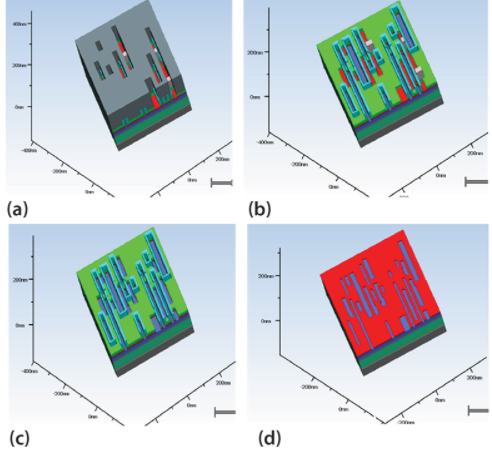
图5SALELE的制造过程:(a)将LE2转移到硬掩模上,(b)进行硬掩模图案化后的图案,(c)去除LE_2沟槽位置处的底层和硬掩模,(d)最终沟槽。使用SEMulator3D生成的图像[10]
如图6所示,第二金属靶(LE2_Target)与LE1侧壁(6a)自对准。只要这些侧壁是不同的材料并且具有足够的蚀刻灵敏度,LE2蚀刻工艺就不会影响侧壁或使侧壁之间的空间变大,如(6b)所示。另外,LE2_Litho_Bias目标可以比所需的最终目标大一点,从而降低了金属电阻。
第二目标图案是由侧壁和LE2掩模共同定义的,这意味着即使LE2和LE1之间的对齐误差很小,LE2和LE1之间的间距也由侧壁的宽度定义,该宽度通过工艺定义是恒定的。如果LE2模式没有任何相邻的LE1形状,则它可以比LE2目标宽,因为它是由LE2_Litho_Bias和LE1侧壁定义的。结果,最终的LE2模式可能具有不一致的宽度(6b)。
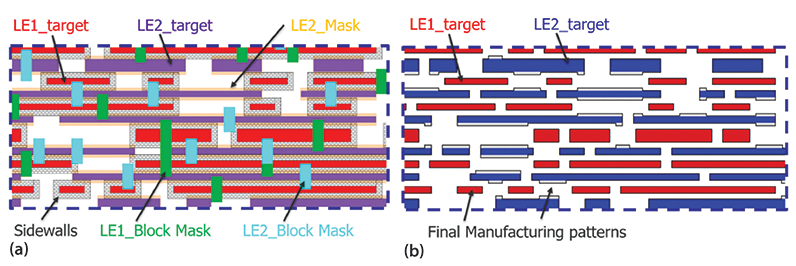
图6SALELE自动对齐过程:(a)将LE2与LE1对齐,(b)最终制造的形状。
自对准的多图案工艺已成为最先进的工艺节点的必要条件。通过避免与DP / TP / QP LEn工艺和EUV单掩模光刻相关的未对准问题,它们提高了图案保真度(并提高了产量)。当前使用三种形式的自调整流程-SADP,SAQP和SALELE。尽管SADP和SAQP仅依赖于目标遮罩和切割/遮罩遮罩,但SALELE流程结合了自对准多图案和LELE流程的各个方面。
IMEC和Mentor在此次合作中提供的独特观点和经验为开发可用于生产的SALELE工艺做出了贡献,该工艺比SADP / SAQP工艺具有一些有希望的优势,例如消除了伪金属(及其附加电容) )。通过了解每个过程的细节,代工厂和设计公司的工程师将能够更好地选择,实施和制造具有这些过程的设计,而不会影响成品率或性能。
Jae Uk Lee是计算光刻领域的高级研发工程师,包括源掩模优化/光学接近度校正以及IMEC的可制造性设计。
Ryoung-han Kim博士是IMEC物理设计/设计自动化,OPC / RET和测试现场/卷带式磁带的主管。
David Abercrombie是西门子公司Mentor的高级物理验证方法的程序经理。
Rehab Kotb Ali是西门子Mentor的高级产品工程师,致力于先进的物理验证技术。
Ahmed Hamed-Fatehy是西门子公司Mentor的RET产品的首席产品工程师。
编辑:hfy
-
PTD
+关注
关注
0文章
2浏览量
7777 -
光刻胶
+关注
关注
10文章
357浏览量
31855
发布评论请先 登录
双色调显影-------光学光刻和极紫外光刻


3D 共聚焦显微镜 | 芯片制造光刻工艺的表征应用

改善光刻图形线宽变化的方法及白光干涉仪在光刻图形的测量

改善光刻图形垂直度的方法及白光干涉仪在光刻图形的测量

金属低蚀刻率光刻胶剥离液组合物应用及白光干涉仪在光刻图形的测量

ASML杯光刻「芯 」势力知识挑战赛正式启动

MEMS制造领域中光刻Overlay的概念
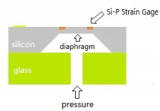
为什么光刻要用黄光?
金属低刻蚀的光刻胶剥离液及其应用及白光干涉仪在光刻图形的测量




 一文解析对准光刻蚀刻光刻的基本知识(SALELE)
一文解析对准光刻蚀刻光刻的基本知识(SALELE)







评论