近日,华进半导体封装先进技术研发中心有限公司副总经理秦舒表示,摩尔定律的延伸受到物理极限、巨额资金投入等多重压力,迫切需要新的技术延续工艺进步,通过先进封装集成技术,实现高密度集成、体积微型化和更低的成本,使得“后摩尔定律”得以继续。
而采用以TSV为核心的高密度三维集成技术(3D IC)是未来封装领域的主导技术,3D IC与CMOS技术和特色工艺一起,构成后摩尔时代集成电路发展的三大支撑技术。
封装要贴近技术发展的需求,封装要贴近市场的需求和应用的需求,而面向物联网、人工智能、5G、毫米波、光电子领域的特色制造技术和定制化封装工艺,是实现中国集成电路特色引领的战略选择。过去我们谈封装,大家看的比较多是我有几条腿引出来,现在都是定制化了,不是给你几条腿,现在多一点的是128条腿,甚至可以做到几千个脚、几千个引线,这就是定制化设置,根据需求设置,这就是封装贴近技术发展的需求。
现在应用很多,也相应的要求封装多元化。比如人工智能、高性能计算,要求封装的类型是3D SRAM的ASIC,还有终端可扩展计算系统。比如数据中心,需要的封装是包含HBM、ASIC和3D SRAM的大尺寸2.5D封装,包含L3缓存分区的分离芯片的3D ASIC,包含多个光纤阵列的硅光子MCM。比如汽车电子,需求是驾驶辅助系统(ADAS)雷达设备的扇出封装,电动汽车和混合动力汽车中使用的MCU、电源管理系统的WB和IGBT封装模组。比如5G射频、毫米波,对于封装的要求是包含多款异质芯片的多芯片模组(例如LNA、PA、Switch和滤波器等),包含TSV Last工艺的3D集成以及集成天线和被动元器件需求。
TSV先进封装市场预测。预计2022年TSV高端产品晶圆出片量为60多万片;尽管数量有限,但由于晶片价值高,仍能产生高收入。而高带宽存储器(HBM)正在成为大带宽应用的标准。智能手机中成像传感器的数量不断增加,计算需求不断增长,促使3D SOC市场扩增。预计未来五年,12寸等效晶圆的出货数量将以20%的CAGR增加,从2016年的1.3M增加到2022年的4M。TSV在低端产品中的渗透率将保持稳定,其主要增长来源是智能手机前端模块中的射频滤波器不断增加,以支持5G移动通信协议中使用的不同频带。
2.5D Interposer市场前景。TSV Interposer是一种昂贵而复杂的封装工艺技术,成本是影响2.5D市场应用的关键因素,需要进一步降低封装或模块的总体成本。2016年到2022年,3D硅通孔和2.5D市场复合年增长率达20%;截至2022年,预计投产400万片晶圆。其市场增长驱动力主要来自高端图形应用、高性能计算、网络和数据中心对3D存储器应用的需求增长,以及指纹识别传感器、环境光传感器、射频滤波器和LED等新应用的快速发展;由于TSV Less 低成本技术的发展,2021年TSV Interposer市场的增速放缓,部分TSV Less技术将逐步替代TSV Interposer以实现2.5D;但部分市场预测,TSV Less技术的开发和商业化将会延迟;同时,为满足高性能计算市场,对TSV Interposer的需求持续增长。TSV Interposer将继续主导2.5D市场,像TSMC&UMC这样的参与者将扩大产能以满足市场需求。总体来看,TSV Interposer 仍具有强劲的市场优势。
总结来看,目前约75%左右的异质异构集成是通过有机基板进行集成封装,这其中大部分是SiP。余下的约25%是采用其他基板实现异质异构集成,这其中包含了硅转接板、fanout RDL以及陶瓷基板等。随着集成电路制造工艺节点的不断提高,成本却出现了拐点,无论从芯片设计、制造的难度,还是成本,多功能系统的实现越来越需要SiP和异质异构集成。随着人工智能和5G的发展,系统追求更高的算力、带宽,芯片的尺寸和布线密度也都在不断提高,使得2.5D封装的需求开始增加。2.5D系统集成封装涉及的技术和资源包含前道晶圆工艺、中道封装工艺和后道组装工艺,是很复杂的集成工艺,目前掌握全套技术的公司较少。
-
半导体
+关注
关注
339文章
31279浏览量
266768 -
摩尔定律
+关注
关注
4文章
640浏览量
81162
发布评论请先 登录
长电科技邀您相约SEMICON CHINA 2026
【「AI芯片:科技探索与AGI愿景」阅读体验】+工艺创新将继续维持着摩尔神话
AI狂飙, FPGA会掉队吗? (上)

后摩尔时代破局者:物元半导体领航中国3D集成制造产业

Chiplet与3D封装技术:后摩尔时代的芯片革命与屹立芯创的良率保障

晶心科技:摩尔定律放缓,RISC-V在高性能计算的重要性突显

电力电子中的“摩尔定律”(1)




 摩尔时代集成电路发展的三大支撑技术使得后摩尔定律得以继续
摩尔时代集成电路发展的三大支撑技术使得后摩尔定律得以继续





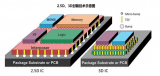

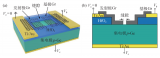



评论