⑴常规双面板工艺流程和技术。
①开料---钻孔---孔化与全板电镀---图形转移(成膜、曝光、显影)---蚀刻与退膜---阻焊膜与字符---HAL或OSP等---外形加工---检验---成品
②开料---钻孔---孔化---图形转移---电镀---退膜与蚀刻---退抗蚀膜(Sn,或Sn/pb)---镀插头---阻焊膜与字符---HAL或OSP等---外形加工---检验---成品
⑵常规多层板工艺流程与技术。
开料---内层制作---氧化处理---层压---钻孔---孔化电镀(可分全板和图形电镀)---外层制作---表面涂覆---外形加工---检验---成品
(注1):内层制作是指开料后的在制板---图形转移(成膜、曝光、显影)---蚀刻与退膜---检验等的过程。
(注2):外层制作是指经孔化电镀的在制板---图形转移(成膜、曝光、显影)---蚀刻与退膜等过程。
(注3):表面涂(镀)覆是指外层制作后---阻焊膜与字符---涂(镀)层(如HAL、OSP、化学Ni/Au、化学Ag、化学Sn等等)。
⑶埋/盲孔多层板工艺流程与技术。
一般采用顺序层压方法。即:
开料---形成芯板(相当于常规的双面板或多层板)---层压---以下流程同常规多层板。
(注1):形成芯板是指按常规方法造成的双面板或多层板后,按结构要求组成埋/盲孔多层板。如果芯板的孔的厚径比大时,则应进行堵孔处理,才能保证其可靠性。
⑷积层多层板工艺流程与技术。
芯板制作---层压RCC---激光钻孔---孔化电镀---图形转移---蚀刻与退膜---层压RCC---反复进行形成a+n+b结构的集成印制板(HDI/BUM板)。
(注1):此处的芯板是指各种各样的板,如常规的双面、多层板,埋/盲孔多层板等等。但这些芯板必须经过堵孔和表面磨平处理,才能进行积层制作。
(注2):积层(HDI/BUM)多层板结构可用下式表示。
a+n+b
a—为一边积层的层数,n—为芯板,b—为另一边积层的层数。
⑸集成元件多层板工艺流程与技术。
-
pcb
+关注
关注
4425文章
24034浏览量
427318 -
华强pcb线路板打样
+关注
关注
5文章
14629浏览量
44766
发布评论请先 登录
激光焊接机在焊接冷凝管的工艺流程

激光焊接机在焊接罐体的工艺流程

等离子清洗机的工艺流程是什么样的呢?
激光焊接机在焊接仪表外壳的工艺流程
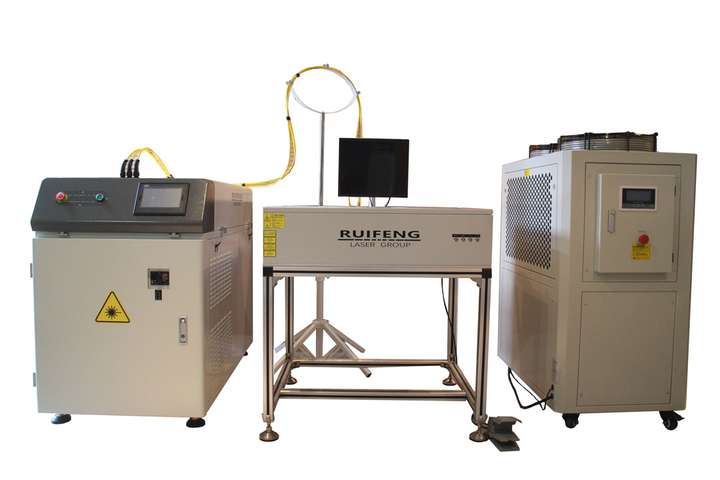
激光焊接机在焊接锯片的工艺流程

PCB沉金工艺流程简介「检测环节」

激光焊接机在焊接压力腔组件的工艺流程
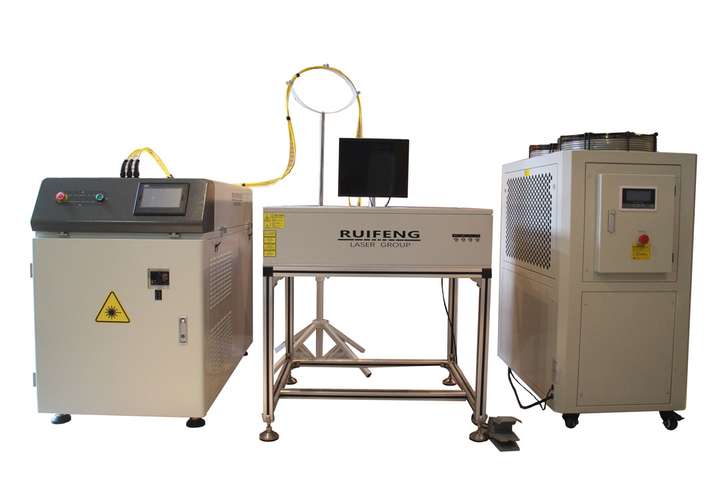
激光焊接机在焊接储液器的工艺流程

激光焊接机在焊接电加热管的工艺流程

浅谈回流焊接技术的工艺流程
晶圆蚀刻扩散工艺流程




 PCB制板工艺流程是怎样的
PCB制板工艺流程是怎样的

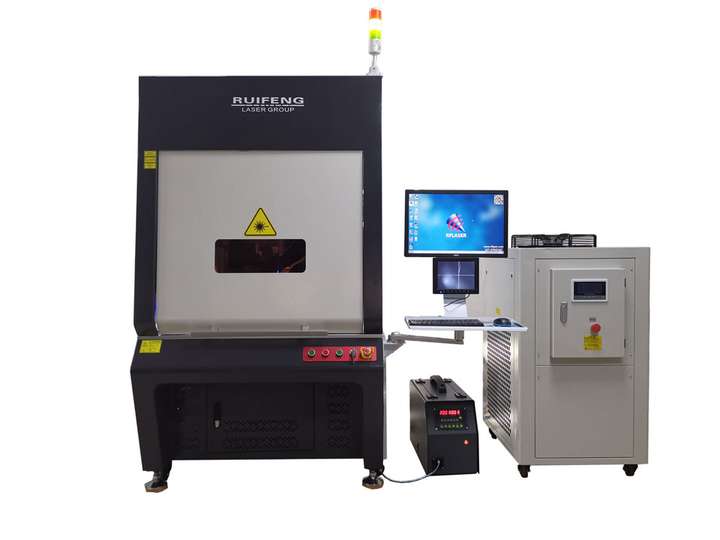






评论