随着上游芯片产能不断扩产,封装行业已经步入微利时代,许多企业为了抢夺客户大打价格牌,激烈的价格竞争和无序的业内生态链促使行业开始需求新的封装工艺。而具有提升发光效率以及提高散热能力等优势的倒装LED芯片技术的革新与应用正是当今封装企业专注研发的重点。
2014-05-17 10:12:16 2286
2286 倒装芯片工艺是指通过在芯片的I/0 焊盘上直接沉积,或者通过 RDL 布线后沉积凸块(包括锡铅球、无铅锡球、铜桂凸点及金凸点等),然后将芯片翻转,进行加热,使熔融的焊料与基板或框架相结合,将芯片的 I/0 扇出成所需求的封装过程。倒装芯片封装产品示意图如图所示。
2023-04-28 09:51:34 3701
3701 
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
2023-07-21 10:08:08 3128
3128 
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
2023-08-01 11:48:08 1174
1174 
在半导体制造领域,芯片装配(Chip Mounting)是一个至关重要的环节。特别是在LED产业中,正装芯片和倒装芯片的选择会直接影响产品的性能、稳定性和成本。本文将详细对比正装芯片与倒装芯片的各方面区别,帮助您更准确地选择适合您需求的产品。
2023-09-04 09:33:05 2719
2719 
底部填充工艺就是将环氧树脂胶水点涂在倒装晶片边缘,通过“毛细管效应”,胶水被吸往元件的对侧完成底 部充填过程,然后在加热的情况下胶水固化。为了加快胶水填充的速度,往往还需要对基板进行预热。利用
2018-09-06 16:40:41
倒装晶片元件损坏的原因是什么?
2021-04-25 06:27:25
要处理细小焊球间距的倒装晶片的影像,需要百万像素的数码相机。较高像素的数码相机有较高的放大倍率, 但像素越高,视像区域(FOV)越小,这意味着大的元件可能需要多次影像。照相机的光源一般为
2018-11-27 10:53:33
过程中分解进入焊点。 了解造成各种缺陷的根本原因,有利于我们采取得当的措施来解决及预防各种可能出现的缺陷。表1列出 的是在倒装晶片组装工艺中常见的缺陷及原因分析,并针对各缺陷提出了改善措施,以方便工程技术人员在 工艺过程中快速有效地找出问题的根本原因,帮助采取正确的解决或预防方法。表1常见缺陷及原因分析
2018-09-06 16:40:06
什么元件被称为倒装晶片(FC)?一般来说,这类元件具备以下特点。 ①基材是硅; ②电气面及焊凸在元件下表面; ③球间距一股为0.1~0.3 mm,球径为0.06~0,.15 mm,外形尺寸
2018-11-22 11:01:58
基板技术是倒装晶片工艺需要应对的最大挑战。因为尺寸很小(小的元件,小的球径,小的球间距,小的贴装 目标),基板的变动可能对制程良率有很大影响: ·密间距贴装良率极易受限于阻焊膜和焊盘的尺寸公差
2018-11-27 10:47:46
。然后再通过第二条生产线处理部分组装的模 块,该生产线由倒装芯片贴片机和回流焊炉组成。底部填充工艺在专用底部填充生产线中完成,或与倒装芯片生 产线结合完成。如图1所示。图1 倒装晶片装配的混合工艺流程
2018-11-23 16:00:22
及老 化测试。 由于倒装晶片焊点在元件的下面,直接检查非常困难,利用X射线检查仪能够观察到一些焊接缺陷: 可以观察到焊接过程中倒装晶片具有非常好的“自对中性”,在氮气焊接环境中尤其突出。如图1和图2
2018-11-23 15:59:22
助焊剂工艺在倒装晶片装配工艺中非常重要。助焊剂不仅要在焊接过程中提供其化学性能以驱除氧化物和油污 ,润湿焊接面,提高可焊性,同时需要起到黏接剂的作用。在元件贴装过程中和回流焊接之前黏住元件,使其
2018-11-23 15:44:25
在回流焊接炉中,倒装晶片和其他元件要被焊接在基板上。在此过程中,如果加热的温度太高,或者时间太长 ,助焊剂便会在润湿整个焊接面之前挥发或分解完,造成润湿不良或其他焊接缺陷。另外,在复杂的混合装配
2018-11-23 15:41:18
由于倒装晶片韩球及球问距非常小,相对于BGA的装配,其需要更高的贴装精度。同时也需要关注从晶片被吸 取到贴装完成这一过程。在以下过程中,元件都有可能被损坏: ·拾取元件; ·影像处理
2018-11-22 11:02:17
有些倒装晶片应用在柔性电路板或薄型电路板上,这时候对基板的平整支撑非常关键。解决方案往往会用到载 板和真空吸附系统,以形成一个平整的支撑及精确的定位系统,满足以下要求: ①基板Z方向的精确支撑
2018-11-23 15:45:30
倒装晶片(Flip Chip)贴装属于先进半导体组装(Advanced Semiconductor Assembly),常见的应用有无线天线、蓝牙、硬盘磁头、元件封装、智能传感器和一些医用高精密
2018-11-27 10:45:28
WLP的命名上还存在分歧。CSP晶片级技术非常独特,封装内部并没有采用键合方式。封装芯片的命名也存在分歧。常用名称有:倒装芯片(STMicroelectronics和Dalias
2018-08-27 15:45:31
、高密度便携式电子设备的制造所必须的一项技术。在低成本应用中,倒装芯片的成功是因为它可达到相对于传统表面贴装元件包装更大的成本效益。例如,一款新的寻呼机利用了倒装芯片技术将微控制器装配于PCB,因为倒装
2019-05-28 08:01:45
1.倒装芯片焊接的概念 倒装芯片焊接(Flip-chipBonding)技术是一种新兴的微电子封装技术,它将工作面(有源区面)上制有凸点电极的芯片朝下,与基板布线层直接键合。 2.倒装芯片
2020-07-06 17:53:32
本文作者:深圳大元倒装COB显示屏是真正的芯片级封装,摆脱了物理空间尺寸的限制,使点间距有了更进一步下钻的能力。倒装COB显示屏厂家--深圳大元倒装COB显示屏与LED小间距相比:1、倒装cob
2020-05-28 17:33:22
以来迅速发展的新型微电子封装技术,包括焊球阵列封装(BGA)、芯片尺寸封装(CSP)、圆片级封装(WLP)、三维封装(3D)和系统封装(SIP)等项技术。介绍它们的发展状况和技术特点。同时,叙述了微电子
2023-12-11 01:02:56
鲜 飞(烽火通信科技股份有限公司,湖北 武汉 430074)摘 要:微电子技术的飞速发展也同时推动了新型芯片封装技术的研究和开发。本文主要介绍了几种芯片封装技术的特点,并对未来的发展趋势及方向进行了
2018-11-23 16:59:52
降低印刷线路板的复杂度和成本。这种设计大大缩小了封装尺寸,并扩大了PCB基板面上每平方英尺的性能。 EI可使用其系统级封装技术,将PCB基板面积较原始PCB减少多达27倍。具体操作办法是:以裸芯片
2018-08-27 15:24:28
提供封装,组装及测试的可靠支持。以往的一级封闭技术都是将芯片的有源区面朝上,背对基板和贴后键合,如引线健合和载带自动健全(TAB)。FC则将芯片有源区面对基板,通过芯片上呈阵列排列的焊料凸点实现芯片
2018-09-11 15:20:04
MEMS器件有时也采用晶圆级封装,并用保护帽把MEMS密封起来,实现与外部环境的隔离或在下次封装前对MEMS器件提供移动保护。这项技术常常用于惯性芯片的封装,如陀螺仪和加速度计。这样的封装步骤是在MEMS
2010-12-29 15:44:12
金鉴检测在大量LED失效案例总结的基础上,发现用硅胶封装、银胶粘结的垂直倒装芯片易出现漏电现象。这是因为,硅胶具有吸水透气的物理特性,易使导电银胶受潮,水分子侵入后在含银导体表面电解形成氢离子
2015-06-12 11:44:02
金鉴检测在大量LED失效案例总结的基础上,发现用硅胶封装、银胶粘结的垂直倒装芯片易出现漏电现象。这是因为,硅胶具有吸水透气的物理特性,易使导电银胶受潮,水分子侵入后在含银导体表面电解形成氢离子
2015-06-19 15:28:29
`晶圆级封装(WLP)就是在其上已经有某些电路微结构(好比古董)的晶片(好比座垫)与另一块经腐蚀带有空腔的晶片(好比玻璃罩)用化学键结合在一起。在这些电路微结构体的上面就形成了一个带有密闭空腔的保护
2011-12-01 13:58:36
在封装技术卜的反映。提出了目前和可预见的将来引线键合作为半导体封装内部连接的主流方式与高性能俪成本的倒装芯片长期共存,共同和硅片键合应用在SiP、MCM、3D等新型封装当中的预测。1 半导体封装外部
2018-11-23 17:03:35
论述了微电子封装技术的发展历程 发展现状及发展趋势 主要介绍了微电子封装技术中的芯片级互联技术与微电子装联技术 芯片级互联技术包括引线键合技术 载带自动焊技术 倒装芯片技术 倒装芯片技术是目前
2013-12-24 16:55:06
尊敬的先生/女士,我想找出所有VIRTEX-6的半导体安装技术,是倒装芯片安装技术的芯片吗?谢谢问候,缺口
2020-06-15 16:30:12
晶圆级封装技术源自于倒装芯片。晶圆级封装的开发主要是由集成器件制造厂家(IBM)率先启动。1964年,美国IBM公司在其M360计算器中最先采用了FCOB焊料凸点倒装芯片器件。
2020-03-06 09:02:23
晶圆级芯片封装技术是对整片晶圆进行封装测试后再切割得到单个成品芯片的技术,封装后的芯片尺寸与裸片一致。
2019-09-18 09:02:14
晶圆级CSP的装配对贴装压力控制、贴装精度及稳定性、照相机和影像处理技术、吸嘴的选择、助焊剂应 用单元和供料器,以及板支撑及定位系统的要求类似倒装晶片对设备的要求。WLCSP贴装工艺的控制可以参
2018-09-06 16:32:18
先进封装发展背景晶圆级三维封装技术发展
2020-12-28 07:15:50
封装技术(倒装芯片接合和柔性载板)正好适用于这个应用。倒装芯片接合技术已经发展30多年了。此一技术的优点是体积小、接线密度高,而且因为引脚短而电性得以改善4。倒装芯片接合技术的另一个优势,是能够将多个
2018-09-11 16:05:39
随着集成电路设计师将更复杂的功能嵌入更狭小的空间,异构集成包括器件的3D堆叠已成为混合与连接各种功能技术的一种更为实用且经济的方式。作为异构集成平台之一,高密度扇出型晶圆级封装技术正获得越来越多
2020-07-07 11:04:42
金鉴检测在大量LED失效案例总结的基础上,发现用硅胶封装、银胶粘结的垂直倒装芯片易出现漏电现象。这是因为,硅胶具有吸水透气的物理特性,易使导电银胶受潮,水分子侵入后在含银导体表面电解形成氢离子
2015-05-13 11:23:43
的性能发展,纵观近几年的电子封装产业,其发展趋势如下:●电子封装技术继续朝着超高密度的方向发展,出现了三维封装、多芯片封装(MCP)和系统级封装(SIP)等超高密度的封装形式。 ●电子封装技术继续
2018-08-23 12:47:17
在消费类产品小型化和更轻、更薄发展趋势的推动下,厂商开发了更小的封装类型。实际上,封装已经成为新设计中选择还是放弃某一器件的关键因素。本文首先定义了“倒装芯片
2009-04-27 10:53:55 49
49 介绍了微机电(MEMS)封装技术,包括晶片级封装、单芯片封装和多芯片封装、模块式封装与倒装焊3种很有前景的封装技术。指出了MEMS封装的几个可靠性问题,最后,对MEMS封装的发展趋势
2009-12-29 23:58:16 42
42 随着新型基底材料的出现,倒装芯片技术面临着新的挑战,工程师们必须解决裸片
2006-04-16 21:05:16 2035
2035 摘要:晶片级封装(WLP)允许集成电路(IC)面向下安装在印刷电路板(PCB)上,芯片的焊盘通过单独的焊点与PCB连接。本文讨论了晶片级封装技术及其优势,描述了Maxim WLP的PCB布局和安装流
2009-04-21 11:36:53 1566
1566 摘要:在消费类产品小型化和更轻、更薄发展趋势的推动下,厂商开发了更小的封装类型。实际上,封装已经成为新设计中选择还是放弃某一器件的关键因素。本文首先定义了“倒
2009-05-09 09:07:44 1373
1373 国际整流器公司的晶片级封装(Wafer Level Package)器件将最近的芯片设计与最新的封装技术结合使具有最可能小的体积。首先使用WLP 技术的产品是HEXFET 功率MOSFET 器件的FlipFET 系列,FlipFET
2011-05-19 18:18:46 0
0 倒装芯片的成功实现与使用包含诸多设计、工艺、设备与材料因素。只有对每一个因素都加以认真考虑和对待才能够促进工艺和技术的不断完善和进步,才能满足应用领域对倒装芯片技
2011-07-05 11:56:17 1673
1673 随着倒装芯片封装在成本和性能上的不断改进, 倒装芯片 技术正在逐步取代引线键合的位置。倒装芯片的基本概念就是拿来一颗芯片,在连接点位置放上导电的凸点,将该面翻转,有
2011-10-19 11:42:55 4889
4889 倒装芯片互连技术有诸多优点,但是由于其成本高,不能够用于大批量生产中,所以其应用受到限制。而本文推荐使用的有机材料的方法能够解决上述的问题。晶圆植球工艺的诞对于降
2011-12-22 14:35:52 86
86 器件的小型化高密度封装形式越来越多,如多模块封装(MCM)、系统封装(SiP)、倒装芯片(FC,Flip-Chip)等应用得越来越多。这些技术的出现更加模糊了一级封装与二级装配之间的界
2012-01-09 16:07:47 46
46 芯片级封装介绍本应用笔记提供指引使用与PCB安装设备相关的芯片级封装。包括系统的PCB布局信息制造业工程师和制造工艺工艺工程师。 包概述 倒装芯片CSP的包概述半导体封装提供的芯片级封装代表最小
2017-03-31 10:57:32 45
45 超级CSP——让倒装芯片获得最大可靠性一种晶圆片级封装
2017-09-14 11:31:37 22
22 芯片图解 为了避免正装芯片中因电极挤占发光面积从而影响发光效率,芯片研发人员设计了倒装结构,即把正装芯片倒置,使发光层激发出的光直接从电极的另一面发出(衬底最终被剥去,芯片材料是透明的),同时,针对倒装设计出方便LED封装厂焊线的结构
2017-09-29 17:18:43 72
72 过来,故称其为倒装晶片。 倒装芯片的实质是在传统工艺的基础上,将芯片的发光区与电极区不设计在同一个平面这时则由电极区面朝向灯杯底部进行贴装,可以省掉焊线这一工序,但是对固晶这段工艺的精度要求较高,一般很难达到较高的良率。 倒装晶片
2017-10-24 10:12:25 8
8 于1月开始进入量产。这是克服现有倒装芯片 LED 封装的品质极限,并能够扩大其应用范围的创新性产品。 LG Innotek 利用最尖端半导体技术,开发了巨大提升产品可靠性的高品质倒装芯片 LED 封装。以此实现了中功率及高功率下的高光效、高光速高级照明的产品化。
2018-02-12 18:24:00 2904
2904 
由于倒装芯片的出光效率高、散热条件好、单位面积的出光功率大、可靠性高、批量化制造成本低和能够承受大电流驱动等一系列优点,使得倒装LED照明技术具有很高的性价比。
2019-08-30 11:02:34 3429
3429 倒装芯片(Flip chip)是一种无引脚结构,一般含有电路单元。 设计用于通过适当数量的位于其面上的锡球(导电性粘合剂所覆盖),在电气上和机械上连接于电路。
2019-10-22 14:21:06 11727
11727 、高密度便携式电子设备的制造所必须的一项技术。在低成本应用中,倒装芯片的成功是因为它可达到相对于传统表面贴装元件包装更大的成本效益。例如,一款新的寻呼机利用了倒装芯片技术将微控制器装配于PCB,因为倒装芯片使用较少的电路板空间,比传统的
2020-10-13 10:43:00 0
0 倒装芯片FC、晶圆级CSP、晶圆级封装WLP主要应用在新一代手机、DVD、PDA、模块等。 一、倒装芯片FC 倒装芯片定义为可能不进行再分布的晶圆。通常,锡球小于150um,球间距小于350um
2020-09-28 14:31:30 5721
5721 倒装晶片自60年代诞生后,这个技术已逐渐替换常规的打线接合,逐渐成为封装潮流,为高端器件及高密度封装领域中经常采用的封装形式。倒装晶片主要应用在无线局域网络天线、系统封装、多芯片模块、图像传感器
2021-03-25 10:37:18 2837
2837 LED芯片也被称为LED发光芯片,是LED灯的核心组件,其主要材料为单晶硅,也就是将单晶硅经过切割而成的晶片附在一个支架上并封装起来。其中晶片由两部分组成,一部分是P型半导体,在它里面空穴占主导地位
2021-11-17 16:29:28 22216
22216 倒装芯片 CSP 封装
2022-11-14 21:07:58 19
19 替代引线键合最常用、先进的互连技术是倒装芯片技术称为C4,即可控塌陷芯片连接(Controlled Collapse Chip Connection)或FC(Flip Chip,倒装芯片)。这项技术
2023-01-12 17:48:05 3978
3978 Flip-Chip BGA (FC-BGA)是指将芯片利用倒装(FC)技术焊接在线路基板上,并制成倒装芯片 BGA 封装形式。
2023-04-28 15:09:13 4514
4514 
FC-CSP 是芯片级尺寸封装(CSP)形式中的一种。根据J-STD-012 标准的定义口,CSP 是指封装体尺寸不超过裸芯片 1.2倍的一种封装形式,它通过凸块与基板倒装焊方式实现芯片与基板的电气
2023-05-04 16:19:13 2513
2513 
正在开发新的凸点结构以在倒装芯片封装中实现更高的互连密度,但它们复杂、昂贵且越来越难以制造。
2023-05-22 09:46:51 578
578 
汉思新材料研发生产半导体(Flipchip)倒装芯片封装用底部填充材料为了解决一些与更薄的倒装芯片封装相关的问题,汉思化学研发了一种底部填充材料,作用在于通过控制芯片和基板的翘曲来降低封装产品的应力
2023-03-01 05:00:00 536
536 
本文要点将引线键合连接到半导体的过程可以根据力、超声波能量和温度的应用进行分类。倒装芯片技术使用称为凸块的小金属球进行连接。在倒装芯片QFN封装中,倒装芯片互连集成在QFN主体中。基于倒装芯片QFN
2023-03-31 10:31:57 1313
1313 
灯COB灯等。NU520倒装LED恒流驱动器芯片片来自数能Numen研发的倒装COB恒流灯带无焊线封装工艺,恒流裸片(NU520)直接与PCB板一体化,整个流程更简洁化,封装层无焊线空间,封装层更轻薄,降低热阻,提升光品质.产品性能更稳定节能舒适等优势。1:LED倒装芯片最佳伴侣2:倒装一
2023-06-20 16:17:03 0
0 底部填充胶被填充在芯片与基板之间的间隙,来降低芯片与基板热膨胀系数不匹配产生的应力,提高封装的稳定性。
2023-07-31 10:53:43 387
387 
先进的倒装芯片封装技术由于具有较高的单位面积内 I/O 数量、短的信号路径、高的散热性、良好的电学和热力学性能,在电子封装中被广泛关注。
2023-08-01 10:08:25 260
260 
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
2023-08-18 09:55:04 1632
1632 
华为技术有限公司日前公开了一项名为“具有改进的热性能的倒装芯片封装”专利,申请公布号为CN116601748A。
2023-08-18 11:14:43 1037
1037 从国家知识产权局官网获悉,华为技术有限公司日前公开了一项名为“具有改进的热性能的倒装芯片封装”专利,申请公布号为CN116601748A。
2023-08-18 15:19:06 528
528 
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
2023-08-21 11:05:14 524
524 
倒装芯片技术是通过芯片上的凸点直接将元器件朝下互连到基板、载体或者电路板上。引线键合的连接方式是将芯片的正面朝上,通过引线(通常是金线)将芯片与线路板连接。
2023-08-22 10:08:28 2166
2166 
有些倒装晶片应用在柔性电路板或薄型电路板上,这时候对基板的平整支撑非常关键。解决方案往往会用到载 板和真空吸附系统,以形成一个平整的支撑及的定位系统,满足以下要求:
2023-09-21 15:26:17 126
126 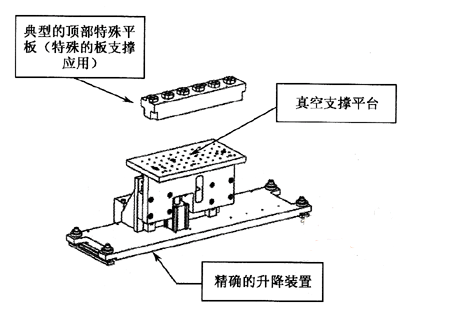
要满足批量高速高良率的生产,供料技术也相当关键。倒装晶片的包装方式主要有2×2和4×4 in JEDEC盘, 20O mm或300 mm晶圆盘(Wafer),还有卷带料盘(Reel)。对应的供料
2023-09-21 15:31:54 216
216 
相对于其他的IC元件,如BGA和CSP等,倒装晶片装配工艺有其特殊性,该工艺引入了助焊剂工艺和底部填充工 艺。因为助焊剂残留物(对可靠性的影响)及桥连的危险,将倒装芯片贴装于锡膏上不是一种可采用的装配方法 。
2023-09-22 15:13:10 352
352 
倒装晶片(Flip Chip)贴装属于先进半导体组装(Advanced Semiconductor Assembly),常见的应用有无线天线、蓝牙、硬盘磁头、元件封装、智能传感器和一些医用高精密设备等。
2023-09-26 15:47:45 335
335 
简单介绍倒装芯片封装工艺过程中选择锡膏的基本知识
2023-09-27 08:59:00 320
320 
Flip chip又称倒装片,是在I/O pad上沉积锡铅球,然后将芯片翻转佳热利用熔融的锡铅球与陶瓷机板相结合此技术替换常规打线接合,逐渐成为未来的封装主流,当前主要应用于高时脉的CPU、GPU(GraphicProcessor Unit)及Chipset 等产品为主。
2023-10-08 15:01:37 232
232 了晶圆级封装(WLP)技术的发展。接下来讨论了使用晶圆级封装器件的实际方面。讨论的主题包括:确定给定器件的倒装芯片/UCSP封装的可用性;通过其标记识别倒装芯片/UCSP;圆片级封装件的可靠性;寻找适用的可靠性信息。
2023-10-16 15:02:47 420
420 电阻器是电子电路中常见的被动元件,用于限制电流、调整电压和执行其他电阻性功能。在电阻器的制造中,有两种常见的类型:厚膜晶片电阻和薄膜晶片电阻。这两种类型的电阻器在结构、性能和应用方面都有一些显著的区别。本文将介绍厚膜晶片电阻和薄膜晶片电阻的区别,以帮助读者更好地理解它们的特性和用途。
2023-10-23 09:00:17 840
840 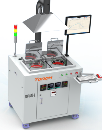
介绍倒装芯片封装选择什么样的锡膏?
2023-10-31 13:16:13 308
308 
详细介绍了FC技术,bumping技术,underfill技术和substrate技术,以及倒装封装芯片的热设计,机械应力等可靠性设计。
2023-11-01 15:25:51 3
3 半导体技术的进步大大提高了芯片晶体管数量和功能, 这一集成规模在几年前是无法想象的。
2023-12-11 18:15:23 486
486 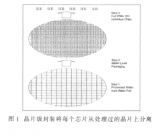
欢迎了解 1 引言 半导体技术的进步大大提高了芯片晶体管数量和功能, 这一集成规模在几年前是无法想象的。因此, 如果没有 IC 封装技术快速的发展, 不可能实现便携式电子产品的设计。在消费类
2023-12-14 17:03:21 201
201 
共读好书 敖国军 张国华 蒋长顺 张嘉欣 (无锡中微高科电子有限公司) 摘要: 倒装焊是今后高集成度半导体的主要发展方向之一。倒装焊器件封装结构主要由外壳、芯片、引脚(焊球、焊柱、针)、盖板(气密性
2024-02-21 16:48:10 132
132 
倒装芯片技术,也被称为FC封装技术,是一种先进的集成电路封装技术。在传统封装技术中,芯片被封装在底部,并通过金线连接到封装基板上。而倒装芯片技术则将芯片直接翻转并安装在封装基板上,然后使用微小的焊点
2024-02-19 12:29:08 480
480 
Flip Chip封装工艺,也称为芯片倒装封装技术,是一种将集成电路芯片倒装在载板或基板上的封装方式。Flip Chip的英文名称直译为“翻转芯片”,其思想源自于50年代的热电偶焊接技术,而真正
2024-02-20 14:48:01 241
241 不断增加封装中的输入/输出(I/O)数量,封装解决方案正从传统的线键封装向倒装芯片互连迁移,以满足这些要求。对于具有多种功能和异构移动应用的复杂和高度集成的系统而言,倒装芯片封装(FCCSP)被认为一种有效的解决方案。
2024-03-04 10:06:21 176
176 
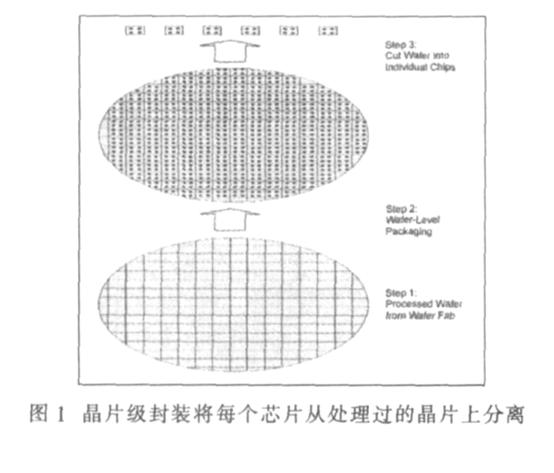
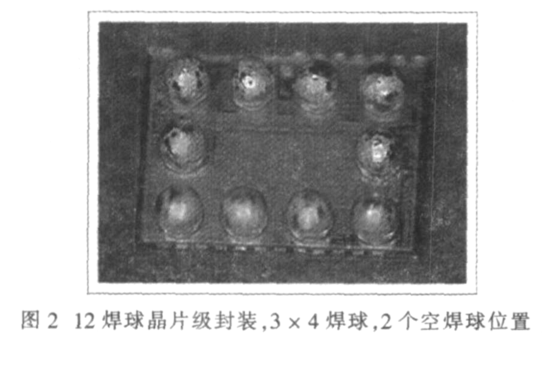
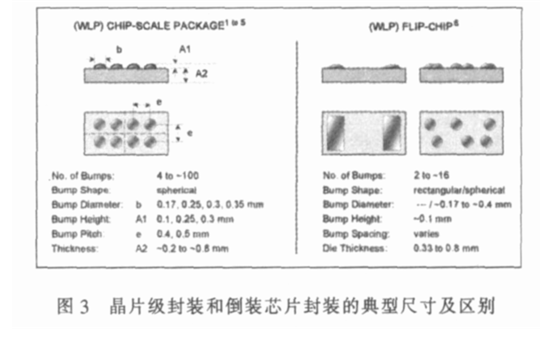

 电子发烧友App
电子发烧友App



























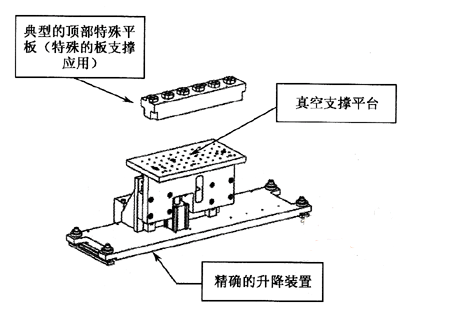




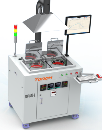

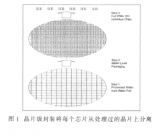














评论