LED芯片也被称为LED发光芯片,是LED灯的核心组件,其主要材料为单晶硅,也就是将单晶硅经过切割而成的晶片附在一个支架上并封装起来。其中晶片由两部分组成,一部分是P型半导体,在它里面空穴占主导地位,另一端是N型半导体,在这边主要是电子,这两种半导体连接在一起就形成一个P-N结。当电流通过导线作用于这个晶片的时候,电子就会被推向P区,在P区里电子跟空穴复合,然后就会以光子的形式发出能量,这就是LED发光的原理。
据了解,目前LED芯片结构主要有:正装、倒装、垂直三种流派,其中正装结构因低价优势而占据主要市场。然而,随着输出功率的不断提高,制约大功率LED发展的光衰较大等问题相继涌现。
正装结构由于p,n电极在LED同一侧,容易出现电流拥挤现象,并且由于蓝宝石衬底导热性差,严重阻碍了热量的散失。在长时间使用过程中,因为散热不好而导致的高温,影响到硅胶的性能和透过率,从而造成较大的光输出功率衰减。
相较于正装LED,垂直芯片结构采用高热导率的衬底(Si、Ge和Cu等衬底)取代蓝宝石衬底,在很大程度上提高散热效率;垂直结构的LED芯片的两个电极分别在LED外延层的两侧,通过n电极,使得电流几乎全部垂直流过LED外延层,横向流动的电流极少,可以避免局部高温。但是目前垂直结构制备工艺中,蓝宝石剥离工艺较难,制约了产业化发展进程。
而倒装技术可以细分为两类,一类是在蓝宝石芯片基础上倒装,蓝宝石衬底保留,利于散热,但是电流密度提升并不明显;另一类是倒装结构并剥离了衬底材料,可以大幅度提升电流密度。
倒装技术最早出现于2007年,由封装公司首先进行产品运用,并最先运用在照明领域。而倒装芯片之所以被称为“倒装”则是相对于传统的金属线键合连接方式(Wire Bonding)与植球后的工艺而言的。传统的通过金属线键合与基板连接的芯片电气面朝上,而倒装芯片的电气面朝下,相当于将前者翻转过来,故称其为“倒装芯片”。
由于P型GaN传导性能不佳,为获得良好的电流扩展,需要通过蒸镀技术在P区表面形成一层Ni-Au组成的金属电极层。P区引线通过该层金属薄膜引出。为获得好的电流扩展,Ni-Au金属电极层就不能太薄。为此,器件的发光效率就会受到很大影响,通常要同时兼顾电流扩展与出光效率二个因素。但无论在什麼情况下,金属薄膜的存在,总会使透光性能变差。此外,引线焊点的存在也使器件的出光效率受到影响。采用GaNLED倒装芯片的结构可以从根本上消除上面的问题。
近年来,随着LED芯片价格和毛利率的下跌,LED芯片投资回报率逐渐降低,国外LED芯片大厂扩产趋于谨慎,国外芯片供给增长有限,国内厂商借助地方政府的支持政策,依靠资金、规模等方面的优势积极扩产,全球LED芯片产能逐渐向中国大陆转移。对于LED芯片企业而言,扩产可抢占规模化优势,利用大规模制造降低生产成本,因而在2017年各大LED芯片厂商纷纷购买设备扩大生产规模。然而,这也导致LED芯片行业竞争越发激烈。但LED芯片的制造技术和对应的封装技术共同决定了LED未来的应用前景,因此,发展倒装LED芯片必将成为了大势所趋。
编辑:fqj
-
led
+关注
关注
244文章
24779浏览量
693401 -
芯片
+关注
关注
463文章
54631浏览量
470909
发布评论请先 登录
一篇讲清楚 Claude 的三种使用模式:Chat、Cowork、Code 到底有啥区别?
CMOS芯片共面度偏差,白光干涉测量解决倒装、固晶受力不均

星海FR系列三种封装快恢复二极管DO-15、DO-201AD、R-6的全面对比与应用解析

像这种受电端/负载端的电压诱骗芯片和电源端//负载端的协议芯片有什么区别,没搞懂
伺服电机的三种制动方式有什么区别?


【干货】一文带你了解CAN、Modbus与LoRa三种通信协议的区别

TC377配置SMU FSP时,如何配置频率参数;三种模式有何区别,配置上有何区别?
MEMS中的三种测温方式




 芯片的三种封装结构:正装、垂直、倒装有什么区别
芯片的三种封装结构:正装、垂直、倒装有什么区别



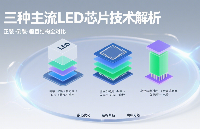
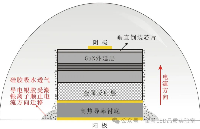



评论