使用负偏压的萃取电极将离子从离子源内的等离子体中抽出,并将其加速到大约50keV的能量。
![的头像]() FindRF 发表于
FindRF 发表于 05-29 09:37
•1725次阅读
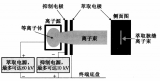
高压直流电源用于加速离子,大约为200kV的DC电源供应系统被装配在注入机内。为了通过离子源产生离子....
![的头像]() FindRF 发表于
FindRF 发表于 05-26 14:44
•4353次阅读
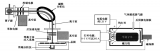
高温炉广泛用于进行注入后的热退火。高温炉的退火处理是一个批量过程,在850摄氏度至1000摄氏度情况....
![的头像]() FindRF 发表于
FindRF 发表于 05-22 09:56
•7715次阅读

高电流的硅或错离子注入将严重破坏单晶体的晶格结构,并在晶圆表面附近产生非晶态层。
![的头像]() FindRF 发表于
FindRF 发表于 05-19 09:22
•6212次阅读
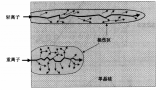
离子在非晶态材料内的投影射程通常遵循高斯分布,即所谓的常态分布。单晶硅中的晶格原子整齐排列,而且在特....
![的头像]() FindRF 发表于
FindRF 发表于 05-15 09:01
•2411次阅读

离子注入是一种向衬底中引入可控制数量的杂质,以改变其电学性能的方法。它是一个物理过程,不发生化学反应....
![的头像]() FindRF 发表于
FindRF 发表于 05-12 16:00
•12372次阅读
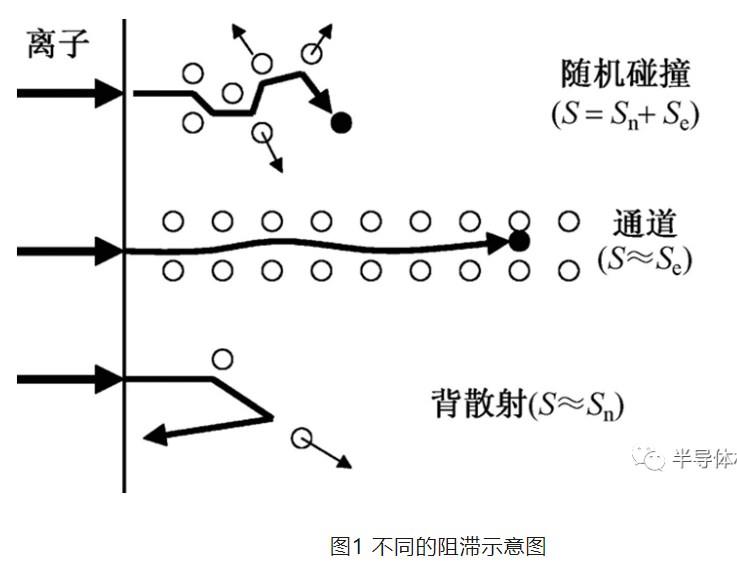
离子注入过程提供了比扩散过程更好的掺杂工艺控制(见下表)。例如,掺杂物浓度和结深在扩散过程中无法独立....
![的头像]() FindRF 发表于
FindRF 发表于 05-08 11:19
•4816次阅读

半导体材料最重要的特性之一是导电率可以通过掺杂物控制。集成电路制造过程中,半导体材料(如硅、错或1E....
![的头像]() FindRF 发表于
FindRF 发表于 05-04 11:12
•5642次阅读
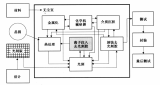
等离子体均匀性和等离子体位置的控制在未来更加重要。对于成熟的技术节点,高的产量、低的成本是与现有生产....
![的头像]() FindRF 发表于
FindRF 发表于 04-21 09:20
•3902次阅读
压力主要控制刻蚀均匀性和刻蚀轮廓,同时也能影响刻蚀速率和选择性。改变压力会改变电子和离子的平均自由程....
![的头像]() FindRF 发表于
FindRF 发表于 04-17 10:36
•4828次阅读
金属刻蚀具有良好的轮廓控制、残余物控制,防止金属腐蚀很重要。金属刻蚀时铝中如果 有少量铜就会引起残余....
![的头像]() FindRF 发表于
FindRF 发表于 04-10 09:40
•6896次阅读
下图显示了Intel的第6代晶体管(6T)SRAM尺寸缩小时间表,以及多晶硅栅刻蚀技术后从90nm到....
![的头像]() FindRF 发表于
FindRF 发表于 04-03 09:39
•7238次阅读
FinFET三维器件也可以用体硅衬底制作,这需要更好地控制单晶硅刻蚀工艺,如CD、深度和轮廓。
![的头像]() FindRF 发表于
FindRF 发表于 03-30 09:39
•6031次阅读
从下图中可以看出结合使用XeF2气流和氯离子轰击的刻蚀速率最高,明显高于这两种工艺单独使用时的刻蚀速....
![的头像]() FindRF 发表于
FindRF 发表于 02-23 17:17
•6823次阅读
刻蚀有三种:纯化学刻蚀、纯物理刻蚀,以及介于两者之间的反应式离子刻蚀(ReactiveIonEtch....
![的头像]() FindRF 发表于
FindRF 发表于 02-20 09:45
•5684次阅读
铝刻蚀可以使用多种不同的酸,其中最普遍的混合液是以磷酸(H3P04,80%)、醋酸(CH3COOH,....
![的头像]() FindRF 发表于
FindRF 发表于 02-17 09:44
•3796次阅读
单晶硅刻蚀用来形成相邻晶体管间的绝缘区,多晶硅刻蚀用于形成栅极和局部连线。
![的头像]() FindRF 发表于
FindRF 发表于 02-13 11:13
•13112次阅读

磷酸硅(Si3(PO4)4)和氨气(NH3)这两种副产品都可以溶于水。LOCOS工艺的场区氧化层生成....
![的头像]() FindRF 发表于
FindRF 发表于 02-13 11:11
•5391次阅读
湿法刻蚀利用化学溶液溶解晶圆表面的材料,达到制作器件和电路的要求。湿法刻蚀化学反应的生成物是气体、液....
![的头像]() FindRF 发表于
FindRF 发表于 02-10 11:03
•7799次阅读
刻蚀速率是测量刻蚀物质被移除的速率。由于刻蚀速率直接影响刻蚀的产量,因此刻蚀速率是一个重要参数。
![的头像]() FindRF 发表于
FindRF 发表于 02-06 15:06
•8190次阅读
刻蚀是移除晶圆表面材料,达到IC设计要求的一种工艺过程。刻蚀有两种:一种为图形 化刻蚀,这种刻蚀能将....
![的头像]() FindRF 发表于
FindRF 发表于 02-01 09:09
•4486次阅读
在ICP反应室中加入射频偏压系统就可以产生自偏压并控制离子的轰击能量。由于在高密度等离子体中的离子轰....
![的头像]() FindRF 发表于
FindRF 发表于 01-15 14:45
•3541次阅读
电介质薄膜经常使用氧气溅射刻蚀反应室进行某些处理,例如在间隙填充前首先在间隙边缘形成倾斜的侧壁,以及....
![的头像]() FindRF 发表于
FindRF 发表于 01-08 10:19
•1821次阅读
与湿式刻蚀比较,等离子体刻蚀较少使用化学试剂,因此也减少了化学药品的成本和处理费用。
![的头像]() FindRF 发表于
FindRF 发表于 12-29 17:28
•4384次阅读
CVD过程中,不仅在晶圆表面出现沉积,工艺室的零件和反应室的墙壁上也都会有沉积。
![的头像]() FindRF 发表于
FindRF 发表于 12-27 15:34
•4311次阅读
下图显示了在一个不对称电极等离子体源中的电压情况,这两个电极具有不同面积。电流的连续性将产生所谓的自....
![的头像]() FindRF 发表于
FindRF 发表于 12-19 15:11
•11389次阅读
低频功率时,离子所获得的能量比在高频功率获得的能量稍高。低频使离子有较多的反应时间,所以能把离子加速....
![的头像]() FindRF 发表于
FindRF 发表于 12-07 17:00
•4867次阅读
当两个电极通过射频高电压时,它们之间就产生一个交流电场。如果射频功率足够高,自由电子受到交流电场的影....
![的头像]() FindRF 发表于
FindRF 发表于 11-21 10:24
•4254次阅读
RTCVD过程可以用来沉积多晶硅、氮化硅和二氧化硅,例如在浅沟槽隔离工艺中使用CVD氧化硅填充沟槽。
![的头像]() FindRF 发表于
FindRF 发表于 11-08 09:52
•1653次阅读
RTCVD过程是在一个单晶圆、冷壁式的反应室中进行的加热CVD工艺,具有快速改变温 度并精确控制温度....
![的头像]() FindRF 发表于
FindRF 发表于 11-01 10:05
•5911次阅读