金属刻蚀具有良好的轮廓控制、残余物控制,防止金属腐蚀很重要。金属刻蚀时铝中如果有少量铜就会引起残余物问题,因为CuCl2的挥发性极低且会停留在晶圆表面。可以通过物理的离子轰击将Cud?从表面移除掉,或通过化学性刻蚀在CuCl2的下方形成底切将CuCl2从表面移除。
由于CuCl2微粒和晶圆表面都因为等离子体带负电,所以必须通过静电力将CuCl2从表面移除。晶圆暴露于大气之前必须先剥除光刻胶,否则沉积在PR和侧壁上的残留氯元素会和H2O发生反应形成HC1,进而造成金属腐蚀问题。
对于HKMG工艺的先栅法,需要刻蚀介质硬掩膜栅堆积薄膜、,多晶硅和TiN薄膜(见下图)。刻蚀工艺与一般多晶硅栅刻蚀工艺类似,第一步为利用突破刻蚀过程图形化介质硬掩膜;然后为主要刻蚀工艺,使用氟等离子体去除多晶硅;金属刻蚀过程使用Cl或HBr具有对覆盖层有较高选择性的TiN和高左电介质层。
对于多晶硅栅刻蚀,可以加入氧气以提高对二氧化硅的刻蚀选择性。然而,对于金属栅刻蚀,在等离子体中增加氧气可能会导致TiN的氧化,形成二氧化钛并导致栅金属损失。
TiN的刻蚀也需要图形化铜低k互连ULK介电质的硬掩膜,如下图所示。
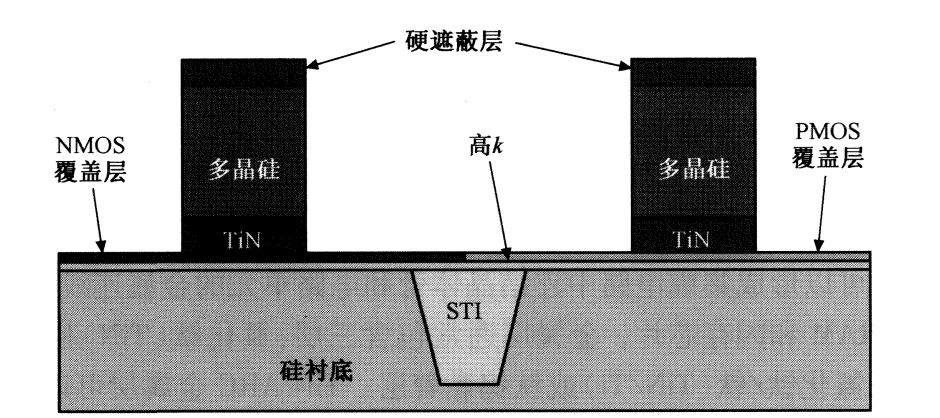
去光刻胶
刻蚀结束之后,光刻胶必须被去除。去光刻胶使用湿法或干法过程。干法去除光刻胶通常使用氧气。水蒸气通常附加在等离子体中以提供额外的氧化剂去除光刻胶和氢自由基,从而能够除去侧壁和光刻胶中的氯元素。
对于金属刻蚀,当晶圆暴露在潮湿空气中之前,刻蚀之后的去光刻胶非常重要。这是因为大气中的水汽会和侧壁沉积物中的氯反应生成盐酸,进而刻蚀铝造成金属腐蚀。在去光刻胶过程中使用的基本化学反应为:

下图显示了具有远程等离子体源的去除光刻胶反应室示意图。这个反应室可以和刻蚀室放在同一工作线上以便在相同的主机内进行光刻胶去除。
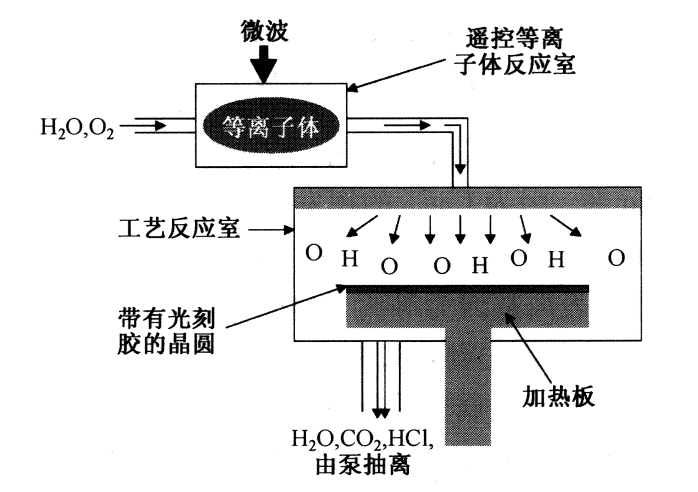
干法化学刻蚀
干法化学刻蚀可以使用加热后不稳定的化学气体,如XeF2和O3,或利用远程等离子体RP( Remote Plasma)源在远端等离子体室中产生自由基,再将自由基注入反应室中。由于这些不稳定气体非常昂贵并难以存储,所以IC生产较常使用远程等离子体过程。
通过远程等离子体源并利用离子轰击产生的等离子体可以在晶圆表面上形成化学性强的自由基,所以干法化学刻蚀能应用在薄膜剥除刻蚀中。干法化学刻蚀优于湿法化学刻蚀之处在于它能和另一座RIE反应室设在同一台机器的生产线上,从而能够用临场方式处理晶圆并提高产量。
所谓酒杯状接触窗就是其中的一个例子(见下图)。等离子体刻蚀室能和RIE反应室放置于同一个大型主机上。首先,晶圆在RP刻蚀室中进行等向性刻蚀,然后再转移到RIE反应室中进行非等向性刻蚀。RP刻蚀的其他应用包括在LOCOS过程中的氮化硅层剥除及多晶硅缓冲层LOCOS(PBL)过程中的氮化硅和多晶硅层剥除。
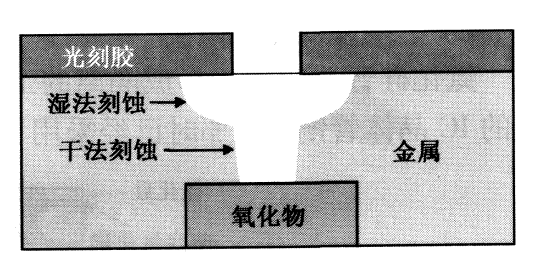
审核编辑:刘清
-
半导体
+关注
关注
339文章
31560浏览量
268020 -
晶圆
+关注
关注
53文章
5483浏览量
132938 -
HKMG
+关注
关注
0文章
10浏览量
13046 -
等离子技术
+关注
关注
0文章
20浏览量
8252
原文标题:半导体行业(一百六十七)之刻蚀工艺(十八)
文章出处:【微信号:FindRF,微信公众号:FindRF】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录



 半导体行业之刻蚀工艺介绍
半导体行业之刻蚀工艺介绍

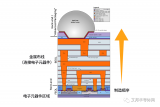





评论